文 / 徐芳露 , 司馬朝坦,沈力
一. 引言
硅光芯片基于絕緣襯底上硅(Silicon-On-Insulator,SOI)平臺, 兼容互補金屬氧化物半導體 (Complementary Metal OxideSemiconductor,CMOS) 微電子制備工藝,因此同時具備了 CMOS 技術超大規模邏輯、超高精度制造的特性和光子技術超高速率、超低功耗的優勢。
硅光芯片中芯層硅與包層二氧化硅的折射率對比度大,能將光限制在很小尺寸的芯片中。使用共封裝光學技術(Co-Packaged Optics,CPO)可以將光芯片與存儲、計算電路共同封裝,減小光電部件之間的距離,實現光電一體化,這將在進一步減小體積、功耗、單位速率成本的同時提高系統的穩定性。隨著大數據、人工智能、遠程醫療、物聯網、電子商務、5G 通信的不斷發展,全球的數據流量在 2016 年至 2021 年間爆發式地增長了 200%。在超高數據容量的驅動下,傳統的電芯片制程逐漸接近 10 nm 尺寸,CMOS 工藝即將遇到物理極限,導致摩爾定律失效。業界普遍認為硅光芯片有機結合了成熟微電子和光電子技術,既減小了芯片尺寸,降低成本、功耗,又提高了可靠性,有望成為“超越摩爾”的高速信息引擎。 ?
二. 發展現狀
光模塊作為光通信系統中的核心器件,其市場規模逐年呈爆發式增長。根據 Yole 的數據,全球光模塊市場規模 2020 年約為 96 億美元,預計到 2026 年至少翻一番。在傳輸速率方面,Omdia預測未來幾年隨著帶寬需求的不斷提升,100?Gb/s、200?Gb/s、400 Gb/s 光模塊仍將保有最大的市場占有量,目前市場上還沒有量產的 800 Gb/s 光模塊,預計將在 2023 年實現商用,在 2025 年實現規模部署。
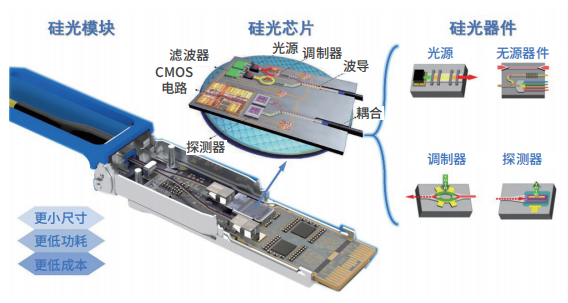
圖1 硅光模塊結構[1]
如圖 1 所示,光模塊由電芯片和光芯片構成,其中光芯片根據功能分為:光發射芯片、接收芯片、收發集成芯片、探測器陣列芯片、調制器陣列芯片等等。過去光芯片由分立器件例如Ⅲ - Ⅴ族半導體激光器芯片、高速電路芯片、基于 PLC(平面光波導)平臺的無源光器件組裝而成,光器件之間由光纖或自由空間元件連接,盡管性能較好但龐大的總體積使得其應用場景較為受限,基于此,集成光電芯片的概念應運而生。得益于激光器增益材料,早期以Ⅲ - Ⅴ族材料——磷化銦(InP)為襯底的集成光芯片得到了迅速發展。InP 基100 Gb/s、400 Gb/s 的光模塊已經較為成熟,Infinera 公司已研發出 1.12 Tb/s InP 基光模塊。但 InP 的原材料 In 是稀有元素,InP 光芯片成本難以降低,且通信光波在 InP 光芯片中的損耗較大。

圖2 硅光模塊在總光模塊市場份額的占比預測[2]
相比于 InP 光芯片,以硅為襯底的光芯片——硅光芯片以材料成本低廉、無源器件的易實現性、低功耗、高集成度、與 CMOS 工藝相契合等特點受到了眾多企業、學者的關注。圖 2 所示為 Lightcounting 公司預測的硅光模塊在總光模塊市場份額的占比預測,可以看出硅光模塊市場占比率將會逐年提升。自 2010 年 Intel 開發出首個 50 Gb/s 超短距硅基集成光收發芯片后,硅光芯片開始進入產業化階段。根據行業調查機構的預測,2020 年硅光模塊市場規模為 7.4 億美元,到 2024 年僅 100?Gb/s-400 Gb/s 硅光模塊市場容量即可達到 55 億美元,在整個光通信模塊市場占比達到 1/3 以上。目前 100 Gb/s 硅光模塊已成熟應用,400 Gb/s 硅光模塊正在進入規模化商用階段,800 Gb/s 硅光模塊已研制成功,下一步將向著 1.6 Tb/s 發展。一般而言,為了提升傳輸速率,通常采用以下三種方案:
1)提高激光器的調制速率,以提高傳輸信號的單通道速率;
2)采用 PAM4、QPSK、16QAM、64QAM等高階調制格式,可以在波特率不變的情況下提升比特率;
3)采用時分復用、波分復用等復用技術。 以上三種方案的應用對硅光芯片中核心的光器件性能也提出了更高的要求。 ?
三. 硅光芯片和模塊的關鍵技術
硅光模塊按照功能主要分為光發射和接收模塊,將發射、接收光芯片與電驅動芯片集成在一起則構成收發一體化光模塊。光模塊中的光電轉換過程為:發射端將輸入的電信號處理后,通過驅動芯片電驅動激光器發射出調制后的光信號,隨后光信號經過波導 - 光纖耦合器進入光纖中傳輸;傳輸完成后再次耦合進接收光模塊的接收光芯片中,由光電探測器將光信號轉變為電信號,最后對電信號進行分析處理。硅光芯片中的光器件分為有源器件和無源器件,有源器件包括激光器、調制器和光電探測器;無源器件包括平面波導、光柵或邊緣耦合器等。基于這些元器件,可以構成光發射 / 接收芯片,并開展陣列化的應用,最終通過光子集成技術(Photonic IntegratedCircuit, PIC)來實現硅光芯片。根據集成的元器件是否采用同種材料制成,光子集成可以分為混合集成和單片集成。當前的硅光器件依然處于初步的集成階段,從異質材料集成向單片集成演進。如圖 3 所示。

圖3 硅光模塊集成方案??
核心硅光芯片器件
(1)硅基激光器
硅基激光器指集成在以硅為襯底的光芯片上的激光器,常用的硅基激光器按照結構劃分主要有:垂直腔面發射激光器(Vertical-Cavity Surface-Emitting Laser, VCSEL)、法布里 - 珀羅腔激光器(Fabry-Perot,FP)、分布式布拉格反射激光器(Distributed Bragg reflector,DBR)、分布式反饋激光器(Distributed Feedback,DFB)和電吸收調制激光器(Electro absorption modulated distributed feedback laser,EML)。
VCSEL成本最低,但發光角度大、輸出光場為多模,這限制了其只能在 500 m 的短距離場景下使用。在 FP 激光器中內置布拉格光柵,對輸出光進行更精準的濾波,則構成了 DBR 或 DFB 激光器,濾波后形成單縱模輸出,可以將傳輸距離從 20 km提升至 40 km 以上,應用在傳輸網、無線基站、數據中心內部互聯。DFB 和 DBR 激光器在窄線寬、高邊模抑制率具有相似的特性,但 DFB 激光器具有較大的無跳模調諧范圍,調諧系數更一致,光譜特性均一性更好;DBR 的光柵并不是分布在整個有源區,可以實現更大的電流輸入,因此輸出功率會比 DFB 大一些,但會引入較大的功率 、電流噪聲、造成功率抖動。這三種激光器均使用直接調制方式,即通過改變激光器電壓將電信號加載至光波上。
EML 由激光器與外調制器構成,例如電吸收調制器(Electro Absorption Modulator ,EAM):通過控制電吸收芯片的電壓將電信號加載至激光器不間斷輸出的光波上。這種加載信號的方式被稱為外調制技術。該方式大大提高了激光器的壽命、穩定性、調制效率,降低了啁啾,更適合長距傳輸,但成本較高,主要在高速遠距骨干網、城域網、數據中心互聯中使用。對于超長距離的數據傳輸,需要使用密集波分復用技術(Dense Wavelength Division Multiplexing ,DWDM)、高階信號調制格式等方式擴容,這需要光源擁有多個波長、小波長間隔、窄線寬等特性,因此對硅基集成可調諧窄線寬激光器的優化也十分重要。
目前硅基激光器的制作材料主要以 III-V 族半導體材料為主,包括銻化鎵 (GaSb)、砷化鎵(GaAs)、磷化銦 (InP)、硫化鋅 (ZnS) 等。因此如何實現Ⅲ - Ⅴ族激光器與硅光芯片的耦合是關鍵問題,主流的工藝方案有片上倒裝焊集成、片上異質鍵合集成和片上直接外延生長集成。片上倒裝焊將制作好的激光器倒裝焊在已含有硅光器件的硅光芯片上,這種工藝成本低且比較成熟,但貼裝的精度需求高、時間成本較大、集成度低。片上異質鍵合集成根據是否使用粘合劑分為直接鍵合和粘結鍵合,將沒有結構的Ⅲ - Ⅴ族材料直接“貼合”在已加工好硅光器件的硅光芯片上,再將 III-V 族材料塊體加工為激光器,這樣制作的激光器發出的光可通過倏逝波耦合的方式高效耦合進硅光子回路。如圖 4(a)?[3]為片上異質鍵合激光器的端面圖,圖 4(b)[4]為DFB激光器的結構。
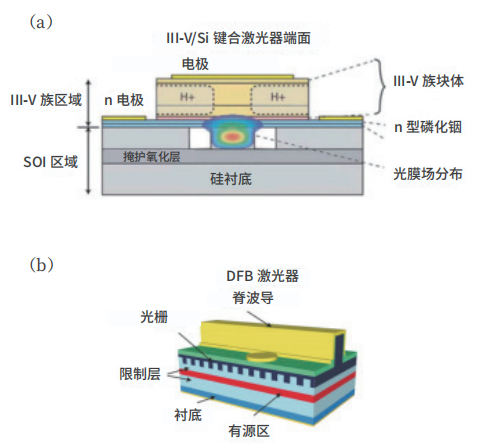
圖4 (a) III-V /Si 異質鍵合激光器端面結構[3]?(b)DFB 激光器結構[4] 該方案制作工藝較為復雜、輸出功率不高,位置準確性主要由刻蝕精度確定,目前 Intel 已利用該技術實現異質集成硅光芯片的大規模量產。直接外延生長集成技術是對制作好的硅晶圓開槽,直至單晶硅襯底,而后使用選取外延的方式在單晶硅襯底上生長 III-V 族材料,此工藝也被叫做單片集成技術。由于硅與 III-V 族材料之間材料特性例如晶格、熱膨脹系數、極化的不同,易導致生長的 III-V 族材料缺點密度大,因此直接外延生長集成技術的工藝難度大,但損耗低、易于封裝、可靠性強、集成度高,被認為是未來實現硅光大規模生產的一種最可行的方案。
(2)硅光調制器
隨著通信速率的進一步提升,單通道調制速率 50 Gb/s 成為直接調制技術的瓶頸,因此 EML 需求越來越多,外調制器也成為研發重點之一。在數據中心對 400 Gb/s 及以上光網絡連接的需求上 , 硅光模塊較傳統光模塊更具有優勢。集成在硅光芯片上的調制器——硅光調制器,根據調制機制分為電光調制器和熱光調制器,通信光芯片中一般使用調制速率更大的電光調制器。硅光調制器根據調制原理分為基于等離子色散效應的電折射率調制和基于弗蘭之——克爾德什效應或量子限制斯塔克效應的電吸收調制。電流通過橫向或縱向 PN 結、之字形、交趾形等電學結構注入,光學結構大多使用有兩種:微環諧振腔和馬赫曾德爾結構(Mach-Zehnder Modulator ,MZM),如圖 5 所示?[5][6]。
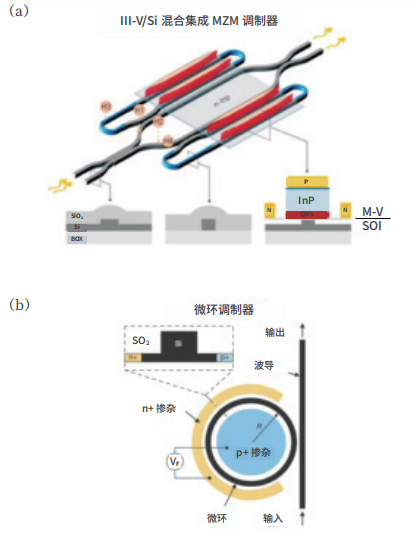
圖5 (a) III-V /Si 混合集成 MZM 調制器[5]?(b) 微環調制器結構[6]
基于微環諧振腔結構的硅光調制工作原理為:電流輸入改變波導折射率,引起微環諧振腔的諧振波長變化,從而對指定波長實現強度調制。對于基于 MZM 光學結構的硅光調制器而言,電致波導折射率變化后,不同的波導折射率使得 MZM 結構兩臂中的光束產生相位差,兩束不同相位的光束合束后發生干涉,實現光強度調制。國家信息光電子創新中心肖希等人利用摻雜優化技術使硅基 MZM 調制速率高達 60 Gb/s。硅光調制器集成度高、消光比較高、損耗低、驅動電壓小、但線性度差,因此目前大多使用混合集成調制器,通過異質鍵合、外延等技術,將成熟的鈮酸鋰調制器、InP 調制器、有機物調制器集成到硅基上,可以實現微米量級大小,調制效率可以達到全硅調制器的 5 倍以上。 綜合看來,硅光調制器技術較為成熟,基于硅基襯底的混合集成調制器可以進一步提高調制器的性能。
(3)光電探測器
光電探測器將接收的高速光信號轉變為電信號,但由于硅 1.1 μm 以上的光波透明,單體硅無法制作探測器。目前集成在硅基片上的高頻探測器主要有混合集成 III-V 族和硅鍺混合探測器,圖 6[7]?中展示的探測器為垂直 PN 二極管結構。混合集成 III-V 族探測器耦合效率高、靈敏度高、響應快;硅鍺探測器性能也很優越,且器件制備技術與 CMOS 工藝兼容,更適合大規模集成,是目前的主流方案。硅鍺探測芯片分為 PIN(二極管探測器)和 APD(雪崩二極管探測器)。PIN 二極管靈敏度相對較低,應用于中短距離的光通信傳輸;APD具有更高的探測靈敏度,適用于更長的距離。
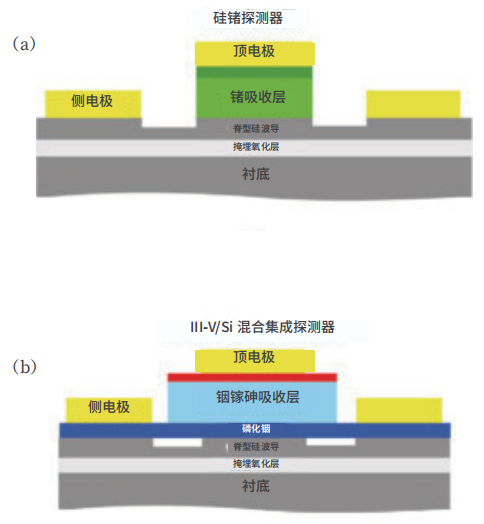
圖6 (a) 垂直 PN 二極管結構硅鍺混合探測器截面圖 (b) 垂直 PN 二極管結構 III-V/Si 混合集成探測器截面圖[7]
(4)無源復用技術
為了提高通信容量,通常采用復用技術把多個低速信道組合成一個高速信道,常見復用方式有波分復用、偏振復用、模式復用等。波分復用技術在目前硅光芯片產品中已經開始使用,基于光束干涉來產生多個通信信道。最常見的多光束干涉波分復用器件主要有陣列波導光柵(Arrayed Waveguide Grating,AWG)、刻蝕衍射光柵(Etched Diffracted Grating,EDG)、微環諧振器(micro ring resonator,MRR)、中階梯光柵(echelle grating,EG)等。微環諧振器為獲得平頂通帶,通常需要級聯多個微環形成高階微環諧振器。而微環相對于其他類型的復用器件,對溫度敏感性更高。AWG和 EDG 則是基于多光束干涉原理,但目前還有較多局限,如存在插損較高、器件尺寸偏大、各通道熱串擾會使器件性能嚴重退化等問題。
設計、封裝和耦合工藝
硅光產品整體生產流程包括設計、制造、封裝三大過程,圖 7 是硅光芯片設計制備測試封裝流程圖。近年來在制造和設計技術瓶頸逐漸取得突破,封裝成為出貨量和良率受制的主要因素。設計環節主要是負責硅光模塊的電路圖與內部結構的規劃。行業內模仿微電子設計方式,融合光學仿真與工藝設計套件(Process Design Kit,PDK),推出簡化光電開發環境(electronic/photonic design automation,EPDA)。該軟件的推出有助于硅光技術在設計環節向微電子工藝靠攏,進一步發揮出微電子工藝的規模效應。制造環節主要負責將晶圓加工成硅光芯片,并完成相應器件的封裝和測試。目前內部制造工廠(Foundry,Fab)與開放式 Fab 兩種制造模式并行,內部 Fab 以 IBM、Intel 為代表,除激光芯片外,設計、硅基芯片加工、封測均由公司自身完成。開放式 Fab 模式由實驗室提供設計方案,由大規模流片代工廠實現制造、封裝過程。
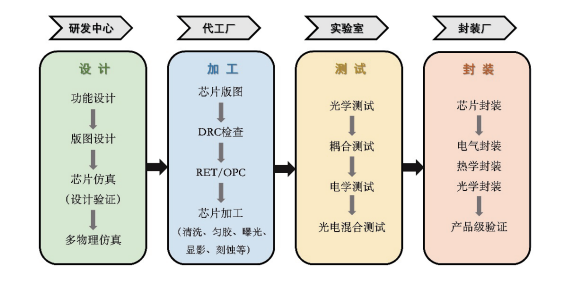
圖7 硅光芯片設計制備測試封裝流程圖 (DRC 檢查 : 設計規則檢查、RET/OPC: 掩膜版增強技術 / 光學鄰近校正技術 )
四. 硅光芯片的未來主要應用場景展望
硅光技術是后摩爾時代核心技術之一,硅光芯片的未來應用場景較為廣泛,應用也從傳統的數據通信、電信光互聯向多個領域拓展。例如,生物傳感、激光雷達、光計算、光量子等方向均出現了基于硅光芯片的解決方案。隨著我國“東數西算工程”的全面啟動,數據中心和超級計算、以及 5G 高速移動通訊時代大帶寬前傳對高速光模塊的需求會持續擴大。除此之外,硅光芯片的非通信市場也在慢慢成長。硅光芯片可用于環境測量、識別和傳感,在機器視覺和激光雷達、化學分析、氣體探測、血液分析和可穿戴感知設備方面具有潛在的應用前景。圖 8 總結了未來硅光芯片主要的應用場景。
從硅光產業鏈的整體發展現狀來看,前期主要由海外 Intel、思科(收購 Acacia 等)、IBM 引領,近年來國內的廠商也緊密跟隨,發展也較為迅速。目前國內在硅光產業領域有華為海思、武漢光迅和南京希烽光電等少數公司在積極研究,某些技術儲備已達到世界先進水平,是一個可以“并跑”甚至“領跑”的芯片領域,機遇十分難得。
作者簡介
徐芳露,華中科技大學武漢光電國家研究中心碩士研究生,主要研究方向為高速大帶寬硅基光芯片;
司馬朝坦,華中科技大學光學與電子信息學院和武漢光電國家研究中心副教授,博士生導師,長期從事平面集成波導和光學氣體傳感研究;
沈力,華中科技大學武漢光電國家研究中心光學與電子信息學院副教授,博士生導師,長期從事硅光電子集成器件和特種光纖研發工作。
參考文獻:
1.https://www.intel.com/content/www/us/en/architecture-and-technology/silicon-photonics/silicon-photonics-overview.html
2. https://www.lightcounting.com/
3.?Fang A W, Park H , Cohen O,?et al?.Electrically pumped hybrid AlGaInAs-silicon evanescent laser[J]. Optics express,2006, 14(20): 9203-9210.
4. 陸丹 , 楊秋露 , 王皓 , 等 . 通信波段半導體分布反饋激光器 [J]. 中國激光 , 2020, 47(7): 0701001.
5. 李金野 , 于麗娟 . 寬帶電光調制器的研究現狀與新型硅基混合集成調制器的發展趨勢 [J]. ZTETECHNOLOGY JOURNAL, 2017: 19.
6. Xu Q, Schmidt B, Pradhan S,?et al?.Micrometre-scale silicon electro-optic?modulator[J]. nature, 2005, 435(7040): 325-327.
7. Piels M, Bowers J E. Photodetectors forsilicon photonic integrated circuits[J].Photodetectors, 2016: 3-20.
編輯:黃飛
?
 電子發燒友App
電子發燒友App












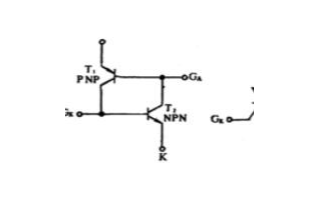
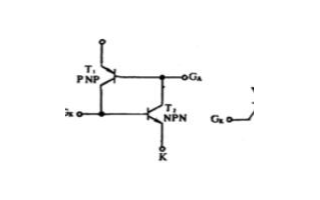


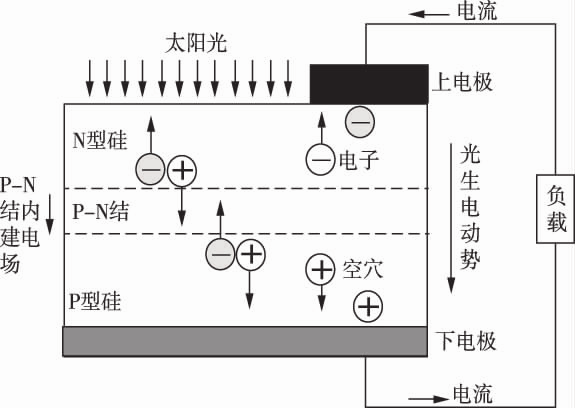












評論