任務要求:
了解微電子封裝中的引線鍵合工藝,學習金絲引線鍵合原理,開發引線鍵合工藝仿真方法,通過數據統計分析和仿真結果,分析得出引線鍵合工序關鍵工藝參數和參數窗口,并給出工藝參數和鍵合質量之間的關系
2024-03-10 14:14:51
共讀好書 王強翔 李文濤 苗國策 吳思宇 (南京國博電子股份有限公司) 摘要: 本文重點研究了金屬陶瓷功率管膠黏劑封裝工藝中膠黏劑的固化溫度、時間、壓力等主要工藝參數對黏結效果的影響。通過溫度循環
2024-03-05 08:40:35 66
66 
隨著移動、網絡和消費類電子設備更新換代,電子產品的功能越來越多、體積越來越小,對于半導體封裝的性能要求不斷提高。如何在更薄、更小的外形尺寸下實現更高更快的數據傳輸成為了一個關鍵挑戰。由于移動設備需要
2024-03-04 10:06:21 176
176 
半導體工藝主要是應用微細加工技術、膜技術,把芯片及其他要素在各個區域中充分連接,如:基板、框架等區域中,有利于引出接線端子,通過可塑性絕緣介質后灌封固定,使其形成一個整體,以立體結構方式呈現,最終形成半導體封裝工藝。
2024-03-01 10:30:17 130
130 
為適應異構集成技術的應用背景,封裝天線的實現技術也應有所變化,利用封裝工藝的優點以實現更佳的性能。
2024-02-29 11:11:30 157
157 
共讀好書 張鎏 苑明星 楊小渝 (重慶市聲光電有限公司) 摘 要: 對半導體封裝工藝的研究,先探析半導體工藝概述,能對其工作原理有一定的了解與掌握;再考慮半導體封裝工藝流程,目的是在作業階段嚴謹
2024-02-25 11:58:10 275
275 
密性等。本文介紹了五種用于MEMS封裝的封帽工藝技術,即平行縫焊、釬焊、激光焊接、超聲焊接和膠粘封帽。總結了不同封帽工藝的特點以及不同MEMS器件對封帽工藝的選擇。本文還介紹了幾種常用的吸附劑類型,針對吸附劑易于飽和問題,給出了封帽工藝解決方案,探
2024-02-25 08:39:28 171
171 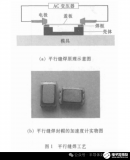
今天我們聊聊半導體產品的封裝工藝,一提到“封裝”,大家不難就會想到“包裝”,但是,封裝可不能簡單的就認為等同于包裝的哦
2024-02-23 14:42:34 437
437 
Flip Chip封裝工藝,也稱為芯片倒裝封裝技術,是一種將集成電路芯片倒裝在載板或基板上的封裝方式。Flip Chip的英文名稱直譯為“翻轉芯片”,其思想源自于50年代的熱電偶焊接技術,而真正
2024-02-20 14:48:01 239
239 倒裝芯片技術,也被稱為FC封裝技術,是一種先進的集成電路封裝技術。在傳統封裝技術中,芯片被封裝在底部,并通過金線連接到封裝基板上。而倒裝芯片技術則將芯片直接翻轉并安裝在封裝基板上,然后使用微小的焊點
2024-02-19 12:29:08 480
480 
。相較于傳統的穿孔工藝,SMT工藝具有尺寸小、重量輕、性能穩定、生產效率高等優勢,成為現代電子制造的主流工藝。 SMT貼裝工藝主要分為手工貼裝和自動化貼裝兩種。 手工貼裝是一種傳統的貼裝方式,操作人員根據元器件的位置和方向,將元器件逐一放置在PCB上,然后進行
2024-02-01 10:59:59 377
377 DFN封裝是一種先進的電子元件封裝工藝,與SMD封裝相比,DFN封裝提供了更高的靈活性和穩定性。
2024-01-28 17:24:55 1392
1392 LGA和BGA是兩種常見的封裝工藝,它們在集成電路封裝中起著重要的作用。
2024-01-24 18:10:55 712
712 在本文中,我們將重點介紹半導體封裝的另一種主要方法——晶圓級封裝(WLP)。本文將探討晶圓級封裝的五項基本工藝,包括:光刻(Photolithography)工藝、濺射(Sputtering)工藝
2024-01-24 09:39:09 335
335 
半導體芯片在作為產品發布之前要經過測試以篩選出有缺陷的產品。每個芯片必須通過的 “封裝”工藝才能成為完美的半導體產品。封裝主要作用是電氣連接和保護半導體芯片免受元件影響。
2024-01-17 10:28:47 250
250 
在晶圓制作完成后,會出貨給封裝廠,封裝廠再將一粒粒的芯片封裝起來。我這里所說的傳統封裝是指以打線為主的封裝方式,比如DIP,QFP,SOP,QFN等,不包括倒裝。這里就簡單介紹一下傳統封裝的工藝流程及工藝特點。
2024-01-05 09:56:11 630
630 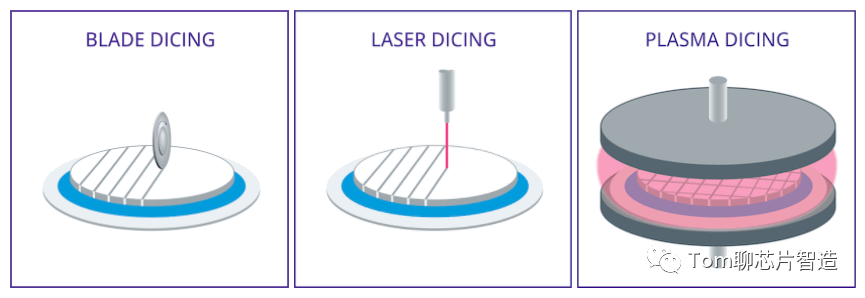
。 1.選擇合適的封裝材料和工藝 在封裝電子器件時,選擇合適的封裝材料和工藝非常重要。首先,封裝材料應具有高耐熱性和低揮發性。常用的封裝材料包括熱塑性塑料、環氧樹脂等。其次,封裝工藝要控制好溫度、濕度和時間等參
2024-01-04 13:54:01 219
219 IGBT模塊的封裝技術難度高,高可靠性設計和封裝工藝控制是其技術難點。IGBT模塊具有使用時間長的特點,汽車級模塊的使用時間可達15年。因此在封裝過程中,模塊對產品的可靠性和質量穩定性要求非常高。高可靠性設計需要考慮材料匹配、高效散熱、低寄生參數、高集成度。
2023-12-29 09:45:05 596
596 
LED顯示屏行業發展至今,已經出現過多種生產封裝工藝,小間距市場目前以SMT貼片技術為主,在微間距市場,COB封裝技術憑借更高像素密度,更精密的顯示效果,越來越獲得市場認可。
2023-12-27 09:46:21 828
828 隨著半導體技術的不斷發展,封裝工藝也面臨著一系列挑戰。本文將探討其中一個重要的挑戰,并提出一種化解該挑戰的工藝方法。
2023-12-11 14:53:37 177
177 芯片鍵合(die bonding)工藝,采用這種封裝工藝可在劃片工藝之后將從晶圓上切割的芯片黏貼在封裝基板(引線框架或印刷電路板)上。
2023-12-07 10:33:30 2182
2182 
免受物理性或化學性損壞。然而,半導體封裝的作用并不止于此。本文將詳述封裝技術的不同等級、作用和演變過程。半導體封裝工藝的四個等級電子封裝技術與器件的硬件結構有關。這
2023-12-02 08:10:57 347
347 
隨著晶圓級封裝技術的不斷提升,眾多芯片設計及封測公司開始思考并嘗試采用晶圓級封裝技術替代傳統封裝。其中HRP(Heat?Re-distribution?Packaging)晶圓級先進封裝工藝
2023-11-30 09:23:24 1120
1120 
IGBT模塊的封裝技術難度高,高可靠性設計和封裝工藝控制是其技術難點。
2023-11-21 15:49:45 673
673 
芯片的封裝工藝始于將晶圓分離成單個的芯片。劃片有兩種方法:劃片分離或鋸片分離。
2023-11-09 14:15:38 462
462 在上篇文章中介紹了扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝(Fan-Out WLCSP)、重新分配層(RDL)封裝、倒片(Flip Chip)封裝,這篇文章著重介紹硅通孔(TSV)封裝工藝。
2023-11-08 10:05:53 1826
1826 
芯片鍵合,作為切割工藝的后道工序,是將芯片固定到基板(substrate)上的一道工藝。引線鍵合(wire bonding)則作為芯片鍵合的下道工序,是確保電信號傳輸的一個過程。wire bonding是最常見一種鍵合方式。
2023-11-07 10:04:53 1298
1298 
各種PCB板的組裝,本篇為大家介紹各種PCB板SMT組裝工藝流程的應用場景。 01 單面純貼片工藝 應用場景:
2023-11-01 10:25:04 620
620 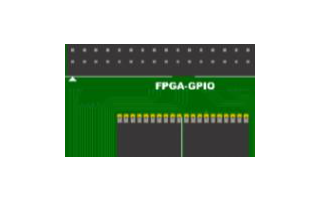
AuSn焊料是一種常用于封裝微電子器件的材料,其低溫焊接特性使其在對敏感器件和高溫敏感材料的封裝中備受歡迎。本文旨在探討AuSn焊料在低溫真空封裝工藝中的應用,以及該工藝的研究進展和應用前景。
2023-10-30 14:32:39 720
720 
封裝(packaging,PKG):主要是在半導體制造的后道工程中完成的。即利用膜技術及微細連接技術,將半導體元器件及其他構成要素在框架或基板上布置、固定及連接,引出接線端子,并通過塑性絕緣介質灌封固定,構成整體主體結構的工藝。
2023-10-27 16:21:32 948
948 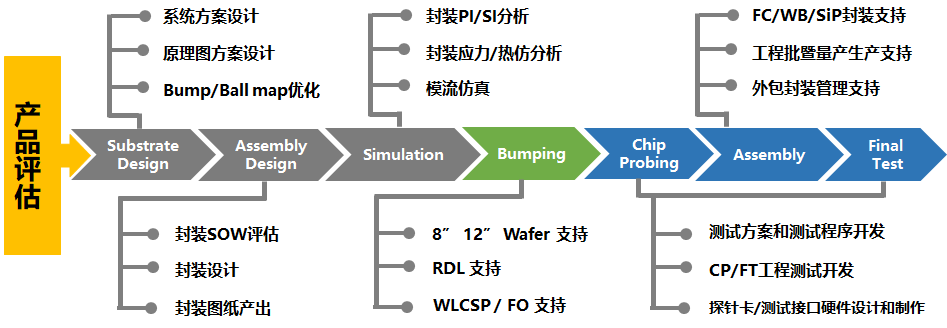
扇出型晶圓級封裝技術的優勢在于能夠利用高密度布線制造工藝,形成功率損耗更低、功能性更強的芯片封裝結構,讓系統級封裝(System in a Package, SiP)和3D芯片封裝更愿意采用扇出型晶圓級封裝工藝。
2023-10-25 15:16:14 314
314 
Bumping工藝是一種先進的封裝工藝,而Sputter是Bumping工藝的第一道工序,其重要程度可想而知。Sputter的膜厚直接影響Bumping的質量,所以必須控制好Sputter的膜厚及均勻性是非常關鍵。
2023-10-23 11:18:18 475
475 
面無元件。
04雙面混裝工藝
A面錫膏工藝+回流焊
B面錫膏工藝+回流焊+波峰焊
應用場景: A面插件元件+B面貼片元件,且B面貼片器件較多小封裝尺寸,如0402的電阻電容等。
A紅膠工藝
B面紅膠
2023-10-20 10:33:59
面無元件。
04雙面混裝工藝
A面錫膏工藝+回流焊
B面錫膏工藝+回流焊+波峰焊
應用場景: A面插件元件+B面貼片元件,且B面貼片器件較多小封裝尺寸,如0402的電阻電容等。
A紅膠工藝
B面紅膠
2023-10-20 10:31:48
各種電子元器件,所以這使得SMT組裝貼片加工顯得尤為重要。 電子產品各式各樣,PCB板種類眾多,SMT貼片加工也需不同的工藝流程,才能應對各種PCB板的組裝,本篇為大家介紹各種PCB板SMT組裝工藝流程的應用場景。 01單面純貼片工藝 應用場景:僅
2023-10-20 10:30:27 259
259 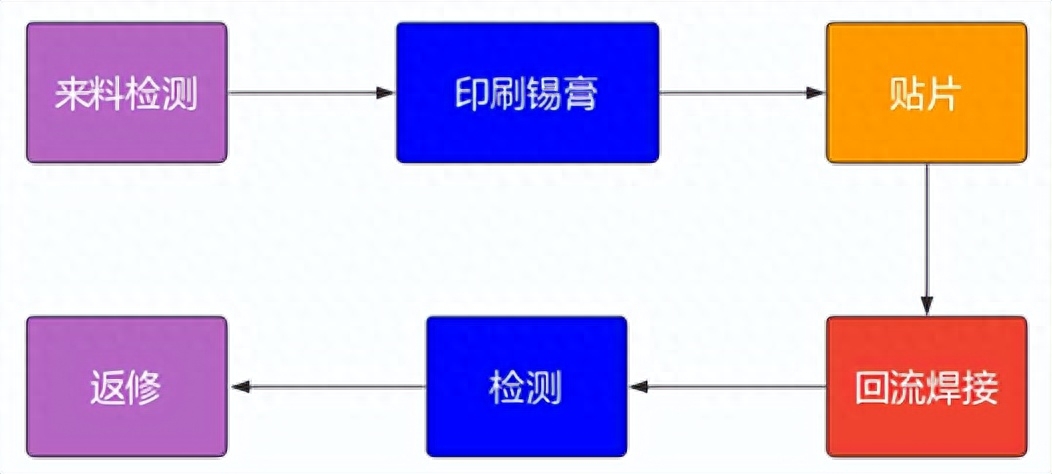
由鈦、銅和鎳組成,則鈦層作為黏附層,銅層作為載流層,鎳層作為阻擋層。因此,UBM對確保倒片封裝的質量及可靠性十分重要。在RDL和WLCSP等封裝工藝中,金屬層的作用主要是形成金屬引線,因此通常由可提高粘性的黏附層及載流層構成。
2023-10-20 09:42:21 2737
2737 
LED透明屏的生產工藝比LED格柵屏難很多,所以LED透明屏價格也會比led格柵屏貴很多。一般LED透明屏價格在5千左右,而LED格柵屏在3千左右。不過具體價格還有結合具體要求看。
2023-10-18 18:00:05 705
705 晶圓級封裝是指晶圓切割前的工藝。晶圓級封裝分為扇入型晶圓級芯片封裝(Fan-In WLCSP)和扇出型晶圓級芯片封裝(Fan-Out WLCSP),其特點是在整個封裝過程中,晶圓始終保持完整。
2023-10-18 09:31:05 1339
1339 
,B面無元件。
四、雙面混裝工藝
1、A面錫膏工藝+回流焊,B面錫膏工藝+回流焊+波峰焊
應用場景: A面插件元件+B面貼片元件,且B面貼片器件較多小封裝尺寸,如0402的電阻電容等。
2、A紅膠
2023-10-17 18:10:08
在上篇文章中我們講述了傳統封裝方法組裝工藝的其中四個步驟,這回繼續介紹剩下的四個步驟吧~
2023-10-17 14:33:22 471
471 
圖1顯示了塑料封裝的組裝工藝,塑料封裝是一種傳統封裝方法,分為引線框架封裝(Leadframe Package)和基板封裝(Substrate Package)。這兩種封裝工藝的前半部分流程相同,而后半部分流程則在引腳連接方式上存在差異。
2023-10-17 14:28:56 743
743 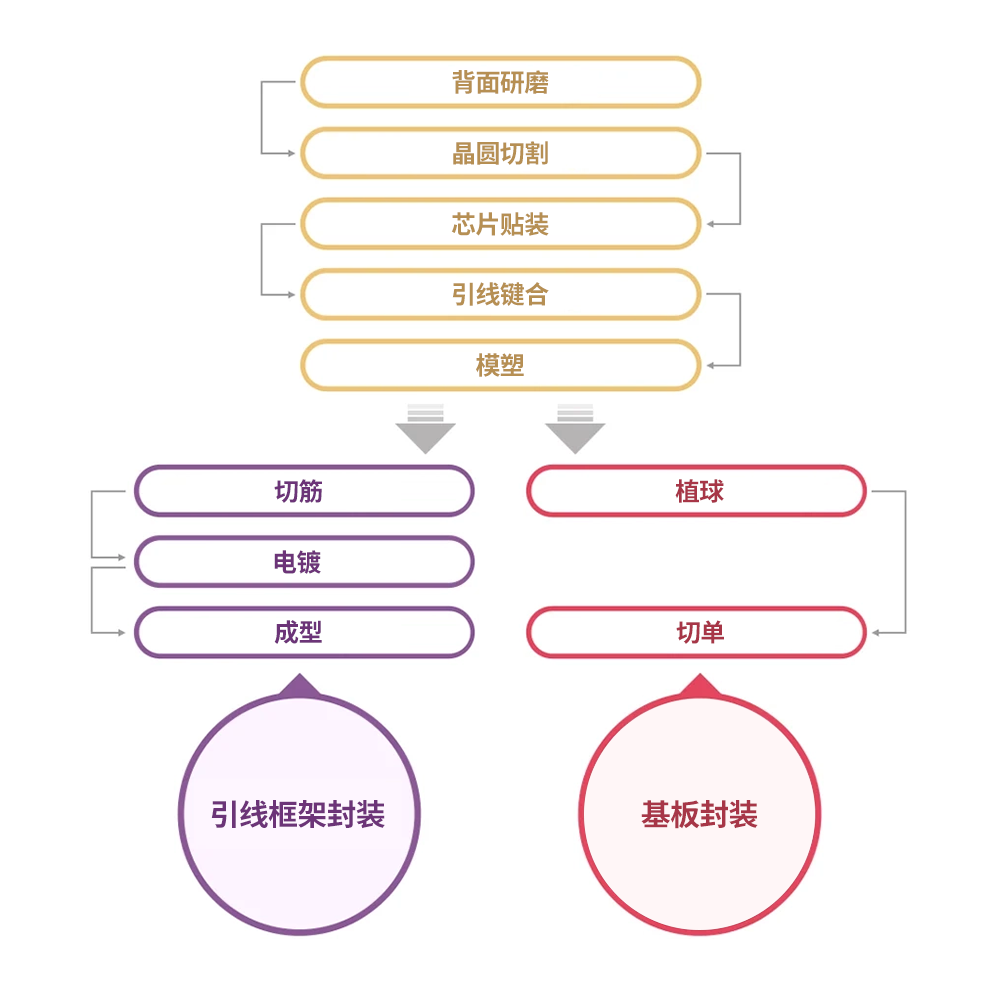
半導體封裝技術的發展一直都是電子行業持續創新的重要驅動力。隨著集成電路技術的發展,半導體封裝技術也經歷了從基礎的封裝到高密度、高性能的封裝的演變。本文將介紹半導體封裝工藝的四個等級,以助讀者更好地理解這一關鍵技術。
2023-10-09 09:31:55 933
933 
簡單介紹倒裝芯片封裝工藝過程中選擇錫膏的基本知識
2023-09-27 08:59:00 320
320 
工藝是組裝制造的過程,是電子組裝工程投資能否合理收回和增值的方法和保證,也是整個SMT技術應用的中心。工藝是否合理和優化,決定了組裝制造的過程的效率和設備能力的發揮,同時也保證和決定產品品質的關鍵之一。
2023-09-18 15:20:43 251
251 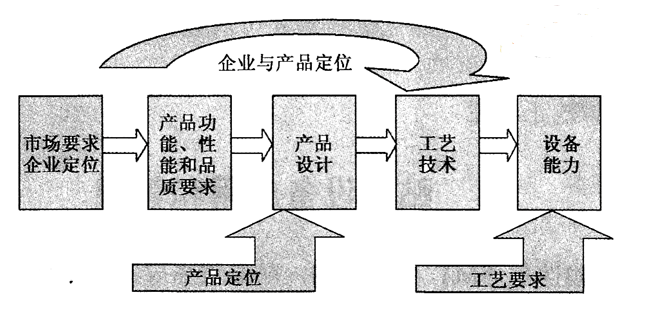
隨著汽車工業向電動化、智能化方向發展,車載電子系統在汽車中的比重逐年增加,而芯片封裝則是其中的關鍵環節。本文將帶您深入了解汽車芯片的封裝工藝,解析其背后的技術細節。
2023-08-28 09:16:48 984
984 
封裝技術是一種將芯片與承載基板連接固定、引出管腳并將其塑封成整體功率器件或模塊的工藝,主要起到電氣連接、結構支持和保護、提供散熱途徑等作用[4]。封裝作為模塊集成的核心環節,封裝材料、工藝和結構直接影響到功率模塊的熱、電和電磁干擾等特性。
2023-08-24 11:31:34 1050
1050 
四面無引線扁平封裝(Quad Flat No-lead Package, QFN)屬于表面貼裝型封裝, 是一種無引腳且呈方形的封裝, 其封裝四側有對外電氣連接的導電焊盤(引腳),引腳節距一般為0.65mm、0.5mm、0.4mm、0. 35mm。
2023-08-21 17:31:41 1382
1382 
從事半導體行業,尤其是半導體封裝行業的人,總繞不開幾種封裝工藝,那就是芯片粘接、引線鍵合、倒裝連接技術。
2023-08-21 11:05:14 524
524 
半導體:生產過程主要可分為(晶圓制造 Wafer Fabrication) 、(封裝工序 Packaging)、(測試工序 Test) 幾個步驟。
2023-08-17 11:12:32 786
786 
電子封裝技術與器件的硬件結構有關。這些硬件結構包括有源元件1(如半導體)和無源元件2(如電阻器和電容器3)。因此,電子封裝技術涵蓋的范圍較廣,可分為0級封裝到3級封裝等四個不同等級。圖1展示了半導體封裝工藝的整個流程。
2023-08-01 16:45:03 576
576 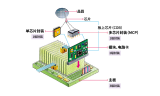
從事半導體行業,尤其是半導體封裝行業的人,總繞不開幾種封裝工藝,那就是芯片粘接、引線鍵合、倒裝連接技術。
2023-08-01 11:48:08 1174
1174 
BGA (Ball Grid Array)-球狀引腳柵格陣列封裝技術,高密度表面裝配封裝技術。在封裝的底部,引腳都成球狀并排列成一個類似于格 子的圖案,由此命名為BGA。目前的主板控制芯片組多采用此類封裝技術,材料多為陶瓷。
2023-08-01 09:24:50 1336
1336 
QFN、DFN封裝是一種先進的封裝形式,即雙框架芯片封裝。它具有小體積、高密度、熱導性好等優點,被廣泛應用于集成電路封裝領域。QFN、DFN封裝工藝包括以下幾個步驟:芯片切割:使用劃片機等設備將芯片
2023-07-24 09:30:23 950
950 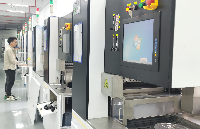
電機的制造過程中,電機殼體封裝是一個非常重要的環節,它不僅能夠保護電機的內部部件,還能夠提高電機的性能和使用壽命。因此,電機殼體封裝工藝的研究對于電機制造業的發展具有重要的意義。目前,國內外關于電機殼體封裝工藝的研究已經取得了一定的進展。
2023-07-21 17:15:32 439
439 圖1為半導體封裝方法的不同分類,大致可以分為兩種:傳統封裝和晶圓級(Wafer-Level)封裝。傳統封裝首先將晶圓切割成芯片,然后對芯片進行封裝;而晶圓級封裝則是先在晶圓上進行部分或全部封裝,之后再將其切割成單件。
2023-07-21 10:19:19 879
879 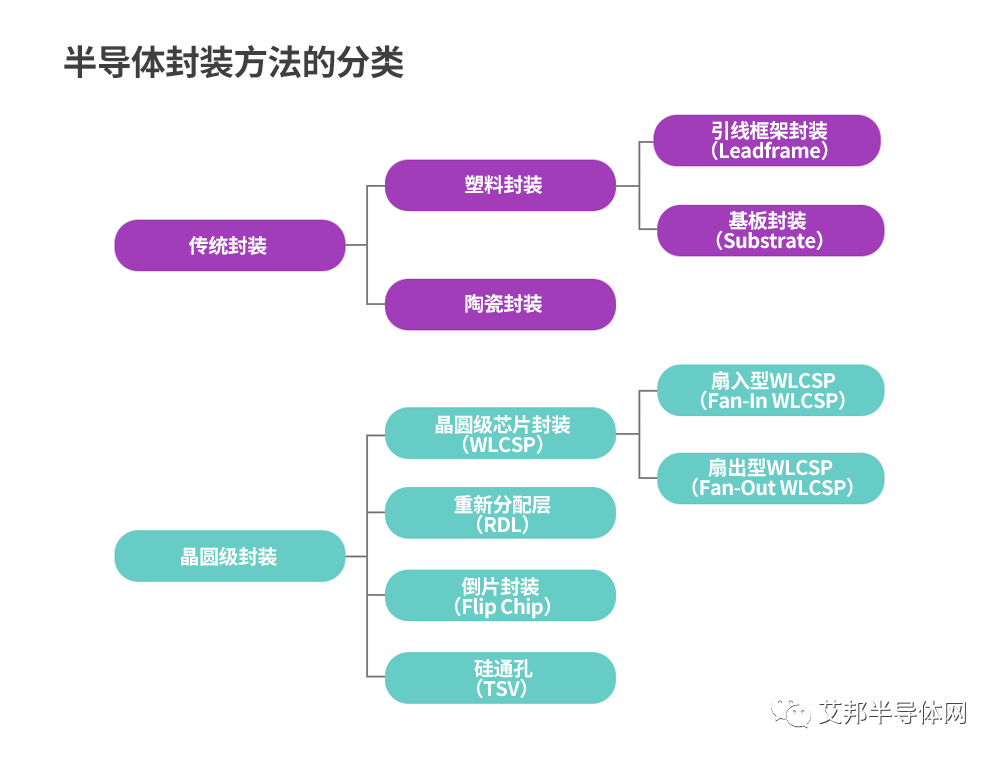
從事半導體行業,尤其是半導體封裝行業的人,總繞不開幾種封裝工藝,那就是芯片粘接、引線鍵合、倒裝連接技術。
2023-07-21 10:08:08 3124
3124 
半導體:生產過程主要可分為(晶圓制造 Wafer Fabrication) 、(封裝工序 Packaging)、(測試工序 Test) 幾個步驟。
2023-07-19 09:47:49 1347
1347 
半導體后封裝工藝及設備介紹
2023-07-13 11:43:20 8
8 QFN封裝工藝流程包括以下步驟磨片:對晶圓廠出來的圓片進行減薄處理,方便在有限的空間中進行封裝。劃片:將圓片上成千上萬個獨立功能的芯片進行切割分離。裝片:將芯片裝入QFN封裝殼中。焊線:將芯片與殼體
2023-06-27 15:30:52 766
766 
半導體:生產過程主要可分為(晶圓制造 Wafer Fabrication) 、(封裝工序 Packaging)、(測試工序 Test) 幾個步驟。
2023-06-27 14:15:20 1230
1230 
當我們購買電子產品時,比如手機、電視或計算機,這些設備內部都有一個重要的組成部分,那就是半導體芯片。半導體芯片是由許多微小的電子元件組成的,為了保護和使用這些芯片,它們需要經過一個被稱為封裝的工藝流程。下面是半導體芯片封裝的通俗易懂的工藝流程。
2023-06-26 13:50:43 1571
1571 “封裝工藝(Encapsulation Process)”用于進行包裝密封,是指用某種材料包裹半導體芯片以保護其免受外部環境影響,這一步驟同時也是為保護物件所具有的“輕、薄、短、小”特征而設計。封裝工藝
2023-06-26 09:24:36 4612
4612 
半導體芯片是如何封裝的?這是一個很好的問題。半導體芯片通常需要被封裝起來才能使用。封裝工藝的目標是將裸露的芯片保護起來,同時連接它們到外部引腳,以便于在電路板等設備中使用。
2023-06-21 14:33:56 1350
1350 隨著科技的快速發展,集成電路芯片的性能不斷提高,器件尺寸不斷縮小,然而引腳數卻越來越多。傳統的核心板封裝工藝已經很難滿足對小尺寸、多引腳的需求,亟需使用更先進的封裝工藝——BGA。廣州致遠電子
2023-06-21 10:01:02 273
273 
隨著科技的快速發展,集成電路芯片的性能不斷提高,器件尺寸不斷縮小,然而引腳數卻越來越多。傳統的核心板封裝工藝已經很難滿足對小尺寸、多引腳的需求,亟需使用更先進的封裝工藝——BGA。 廣州致遠電子
2023-06-20 11:50:01 325
325 
IGBT 功率模塊基本的封裝工藝詳細講解,可以作為工藝工程師的一個參考和指導。
絲網印刷目的:
將錫膏按設定圖形印刷于DBC銅板表面,為自動貼片做好前期準備
設備:
BS1300半自動對位SMT錫漿絲印機
2023-06-19 17:06:41 0
0 本應用筆記討論了ADI公司的電源模塊LGA封裝,并提供了PCB設計和電路板組裝工藝指南。
2023-06-13 17:34:04 3999
3999 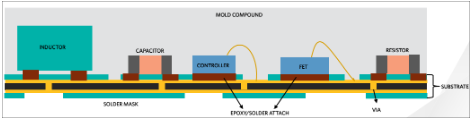
IC Package (IC的封裝形 式)
Package--封裝體:
?指芯片(Die)和不同類型的框架(L/F )和塑封料(EMC)形成的不同外形的封裝體。
2023-06-13 12:54:22 673
673 
電子封裝技術與器件的硬件結構有關。這些硬件結構包括有源元件1(如半導體)和無源元件2(如電阻器和電容器3)。因此,電子封裝技術涵蓋的范圍較廣,可分為0級封裝到3級封裝等四個不同等級。
2023-05-31 16:39:19 2186
2186 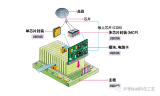
電子發燒友網站提供《F5G全光網安裝工藝和施工指南.pdf》資料免費下載
2023-05-23 10:44:33 9
9 ? SIDE VIEW Typical? Assembly Process Flow FOL– Front of Line前段工藝 FOL– Front of Line? ?Wafer 【Wafer
2023-05-23 09:56:41 2139
2139 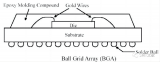
在封裝工藝中,砂輪劃片機確實扮演著重要的角色。它的主要功能是對準和切割,以確保芯片被準確地放置在電路板上的正確位置。砂輪劃片機使用高速旋轉的砂輪來對芯片進行切割,這種技術能夠實現高精度的切割,并且
2023-05-22 10:41:05 324
324 
系統級封裝(system in package,SIP)是指將不同種類的元件,通過不同種技術,混載于同一封裝體內,由此構成系統集成封裝形式。該定義是通過不斷演變、逐漸形成的。開始是單芯片封裝體中加
2023-05-19 10:31:30 932
932 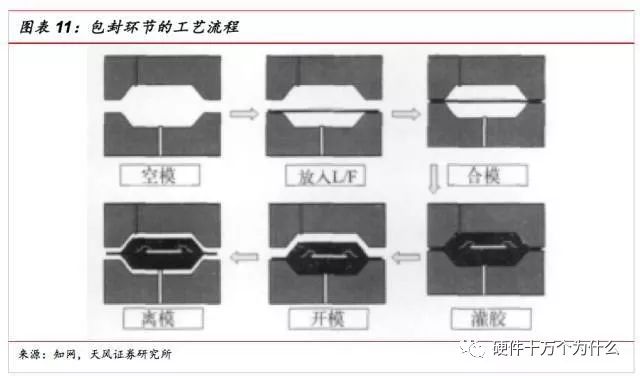
系統級封裝(system in package,SIP)是指將不同種類的元件,通過不同種技術,混載于同一封裝體內,由此構成系統集成封裝形式。該定義是通過不斷演變、逐漸形成的。開始是單芯片封裝體中加
2023-05-19 10:31:05 829
829 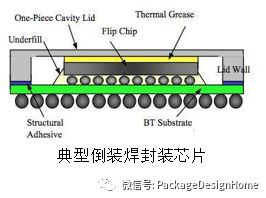
Package--封裝體:
指芯片(Die)和不同類型的框架(L/F)和塑封料(EMC)形成的不同外形的封裝體。
IC Package種類很多,可以按以下標準分類:
?按封裝材料劃分為:金屬封裝、陶瓷封裝、塑料封裝
2023-05-19 09:36:49 2686
2686 
電子封裝技術是系統封裝技術的重要內容,是系統封裝技術的重要技術基礎。它要求在最小影響電子芯片電氣性能的同時對這些芯片提供保護、供電、冷卻、并提供外部世界的電氣與機械聯系等。本文將從發展現狀和未來發展趨勢兩個方面對當前電子封裝技術加以闡述,使大家對封裝技術的重要性及其意義有大致的了解。
2023-05-19 09:33:42 801
801 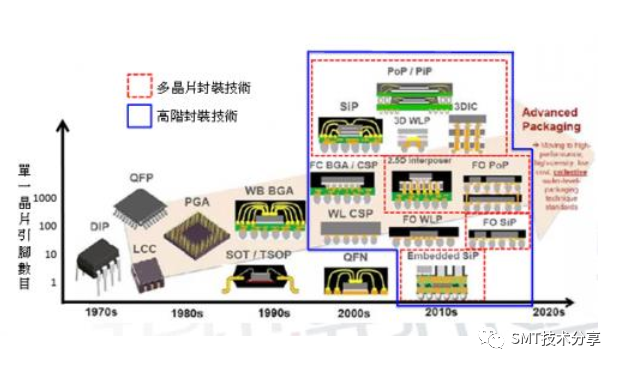
系統級封裝 (System in Package, SiP)是指將單個或多個芯片與各類元件通過系統設計及特定的封裝工藝集成于單一封裝體或模塊,從而實現具完整功能的電路集成,如圖 7-115 所示
2023-05-10 16:54:32 826
826 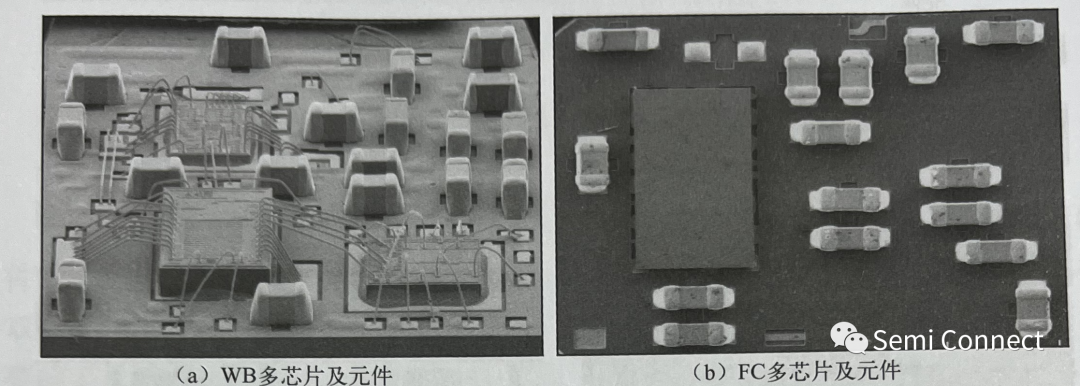
1300NM
金屬封裝工藝是指采用金屬外殼作為封裝殼體或底座,在其內部安裝芯片或基板并進行鍵合連接,外引線通過金屬-玻璃(或陶瓷)組裝工藝穿過金屬外殼,將內部元件的功能引出、外部電源信號等輸人的一種電子
2023-05-09 11:23:07
板級埋人式封裝是一種在基板制造工藝的基礎上融合芯片封裝工藝及 SMT工藝的集成封裝技術,既可以是單芯片封裝、多芯片封裝,也可以是模組封裝、堆疊封裝。與傳統封裝中在基板表面貼裝芯片或元件不同,板級埋人式封裝直接將芯片或元件嵌人基板中間,因此它具有更短的互連路徑、更小的體積、更優的電熱性能及更高的集成度。
2023-05-09 10:21:53 833
833 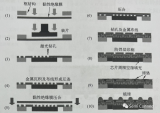
三維封裝通過非 WB 互連技術實現芯片間的高密度封裝,為微電子系統封裝在三維空間開辟了一個新的發展方向,可以有效地滿足高功能芯片超輕、超薄、高性能、低功耗及低成本的需求"。該技術主要應用在高速計算、網絡和GPU 等系統芯片中。傳統二維封裝與三維封裝對比示意圖如圖所示。
2023-05-08 16:58:24 1893
1893 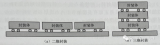
將半導體芯片壓焊區與框架引腳之間用鋁線連接起來的封裝工藝技術!季豐電子所擁有的ASM綁定焊線機AB550為桌面式焊線機,其為全自動超聲波焊線機,應用于細鋁線的引線鍵合,主要應用于COB及PCB領域。
2023-05-08 12:38:51 2924
2924 
硅通孔(TSV) 是當前技術先進性最高的封裝互連技術之一。基于 TSV 封裝的核心工藝包括 TSV 制造、RDL/微凸點加工、襯底減薄、圓片鍵合與薄圓片拿持等。
2023-05-08 10:35:24 2024
2024 
扇出型圓片級封裝(FoWLP)是圓園片級封裝中的一種。相對于傳統封裝圓片級封裝具有不需要引線框、基板等介質的特點,因此可以實現更輕、薄短、小的封裝。扇出型圓片級封裝也可以支持多芯片、2.5D/3D
2023-05-08 10:33:17 1071
1071 
疊層封裝 (Package on Package, PoP)是指在個處于底部具有高集成度的邏輯封裝件上再疊加另一個與之相匹配的大容量存儲器封裝件,形成一個新的封裝整體。這種新的高密度封裝形式,主要
2023-05-06 15:05:10 885
885 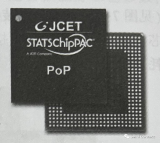
倒裝芯片工藝是指通過在芯片的I/0 焊盤上直接沉積,或者通過 RDL 布線后沉積凸塊(包括錫鉛球、無鉛錫球、銅桂凸點及金凸點等),然后將芯片翻轉,進行加熱,使熔融的焊料與基板或框架相結合,將芯片的 I/0 扇出成所需求的封裝過程。倒裝芯片封裝產品示意圖如圖所示。
2023-04-28 09:51:34 3701
3701 
金屬封裝工藝是指采用金屬外殼作為封裝殼體或底座,在其內部安裝芯片或基板并進行鍵合連接,外引線通過金屬-玻璃(或陶瓷)組裝工藝穿過金屬外殼
2023-04-21 11:42:34 2376
2376 球柵陣列 (Ball Crid Array, BGA)封裝在封裝基板底部植球,以此作為電路的 I/O接口,因此大大提升了 IC 的接口數量,并因其I/O間距較大,使得其SMT 失效率大幅降低。自20
2023-04-21 09:58:47 1340
1340 四面無引線扁平 (Ouad Flat No-lead Package, QFN)封裝屬于表面貼裝利封裝,是一種無引腳且星方形的封裝,其封裝四側有對外電氣連接的導電焊盤(引腳),引腳節距一般
2023-04-19 15:40:10 3520
3520 
小外形封裝 (Small Outine Package, SOP)器件屬于引腳從封裝體兩側子出呈翼狀的表面貼裝器件,其封裝結構分 為嵌人式和外露式兩種。
2023-04-18 11:34:20 3273
3273 我們以光模塊的封裝為例,TOSA 和 ROSA 的主要封裝工藝包括 TO 同軸封裝、蝶形封裝、COB 封裝和 BOX 封裝。
2023-04-13 10:27:36 3358
3358 隨著科技的飛速發展,芯片在現代電子設備中扮演著越來越重要的角色。芯片封裝是電子制造領域的關鍵環節,它將裸片與外部電氣連接,保護內部電路,提高芯片的可靠性和性能。本文將詳細介紹芯片封裝的工藝流程,以便更好地理解芯片封裝在電子制造業中的重要性。
2023-04-12 10:53:30 1719
1719 
和基板介質間還要具有較高的粘附性能。 BGA封裝技術通常采用引線鍵合、等離子清洗、模塑封裝、裝配焊料球、回流焊等工藝流程。引線鍵合PBGA的封裝工藝流程包括PBGA基板的制備和封裝工藝
2023-04-11 15:52:37
Package--封裝體:指芯片(Die)和不同類型的框架(L/F)和塑封料(EMC)形成的不同外形的封裝體
。>IC Package種類很多,可以按以下標準分類:·按封裝材料劃分為:金屬封裝、陶瓷封裝、塑料封裝
2023-04-10 11:49:29 3
3 PCB生產商的通孔插裝工藝模板的印刷方法有幾種?
2023-04-06 16:12:14
部分場景的應用需求。基于此,部分廠商改變封裝賽道,選擇布局COB等技術,也有部分廠商選擇在SMD技術上進行改良,其中GOB技術就屬于SMD封裝工藝改良之后的迭代技術,那么配合
2023-03-30 14:29:48 1176
1176 
作為半導體制造的后工序,封裝工藝包含背面研磨(Back Grinding)、劃片(Dicing)、芯片鍵合(Die Bonding)、引線鍵合(Wire Bonding)及成型(Molding)等步驟。
2023-03-27 09:33:37 7224
7224
 電子發燒友App
電子發燒友App














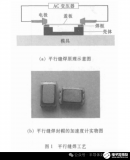




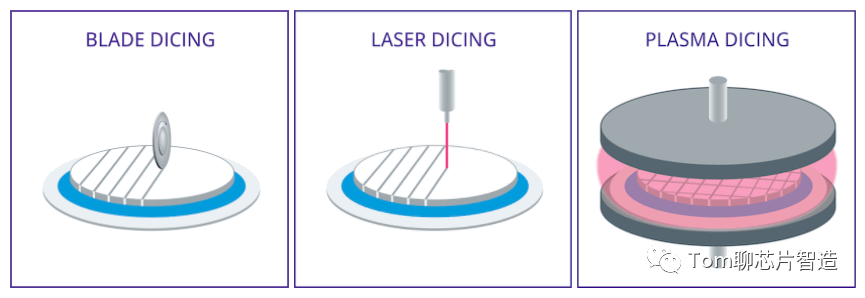







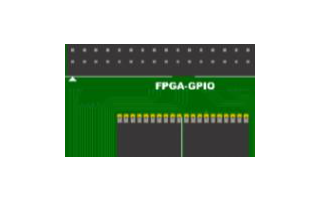

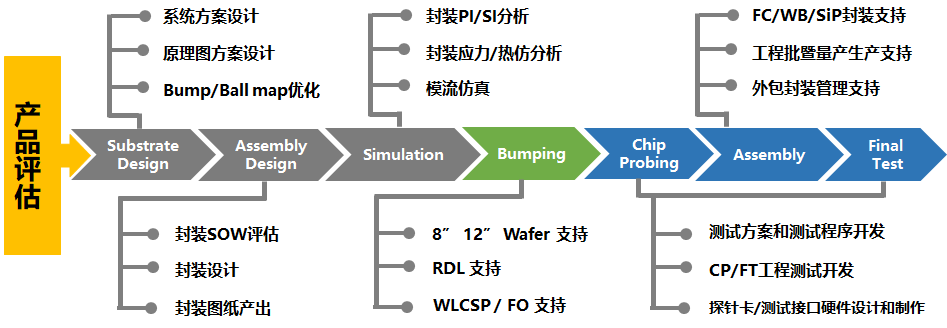


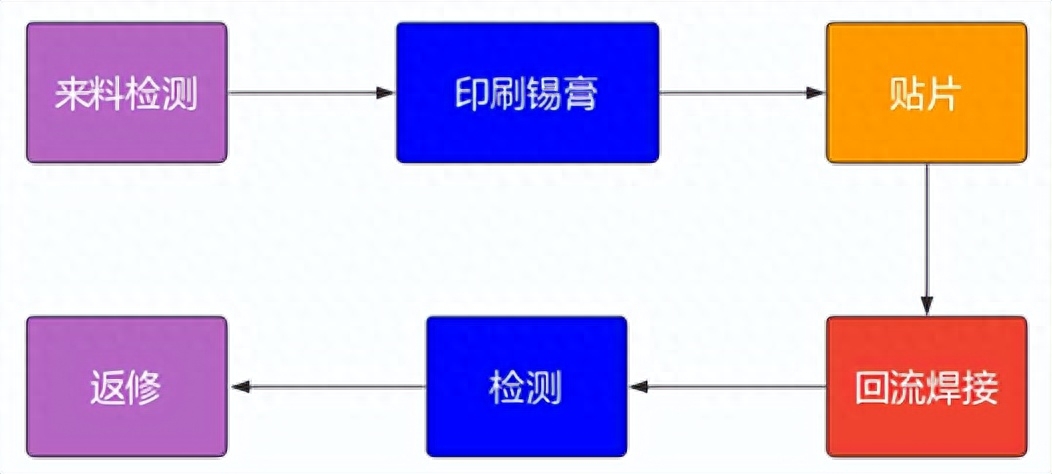



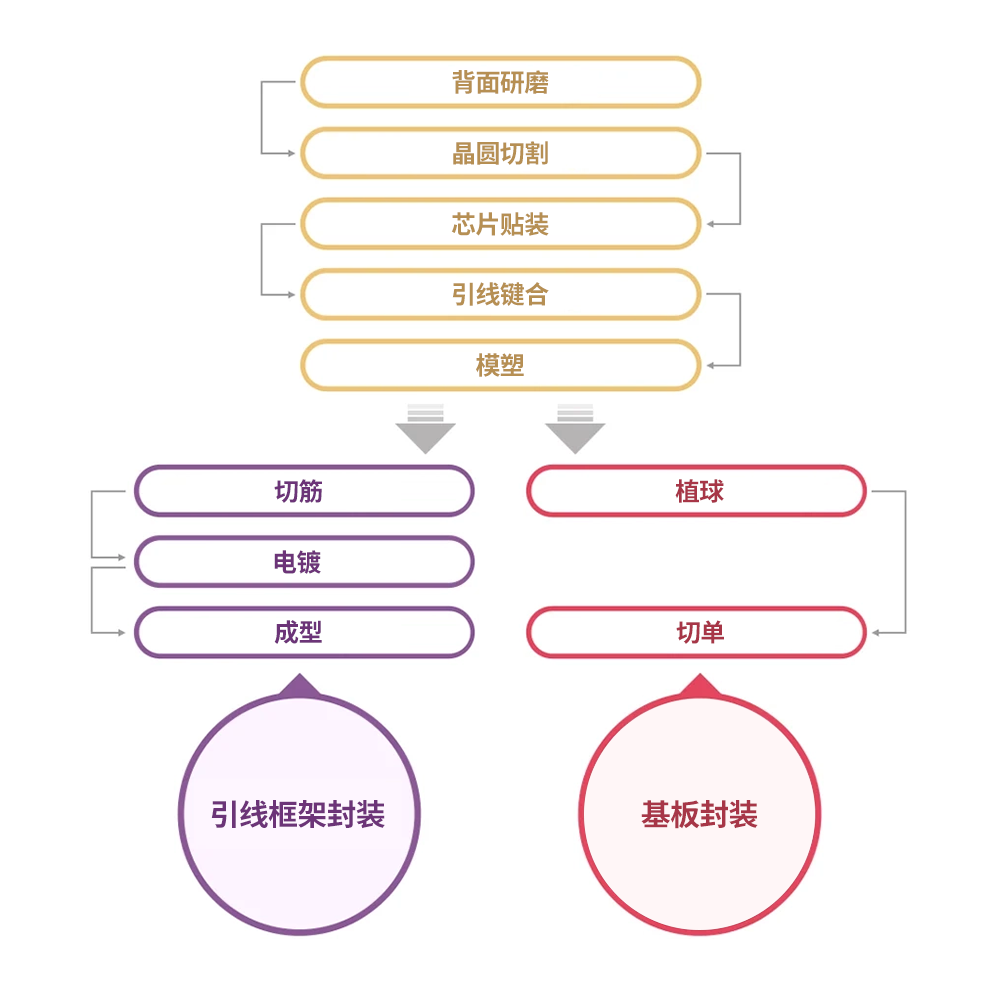


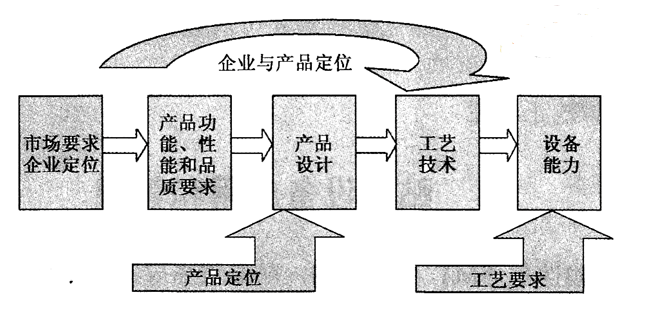






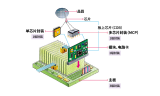


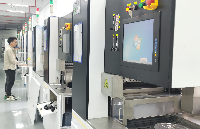
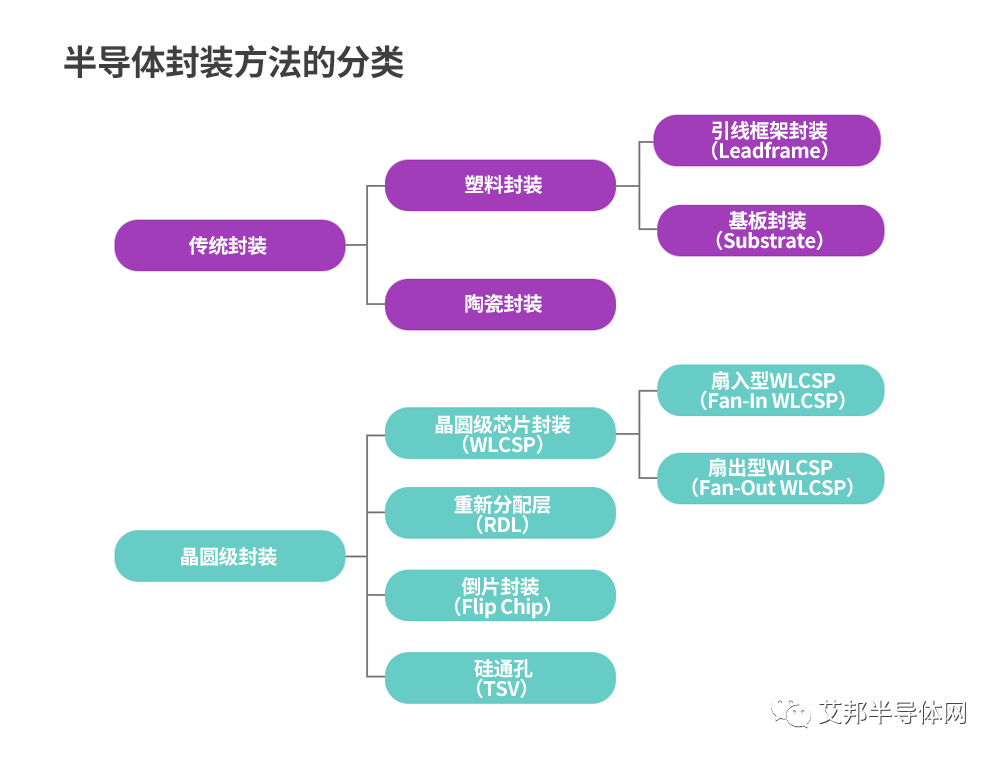








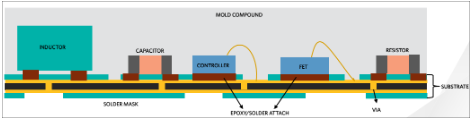


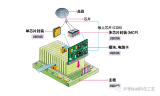
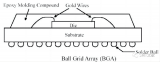

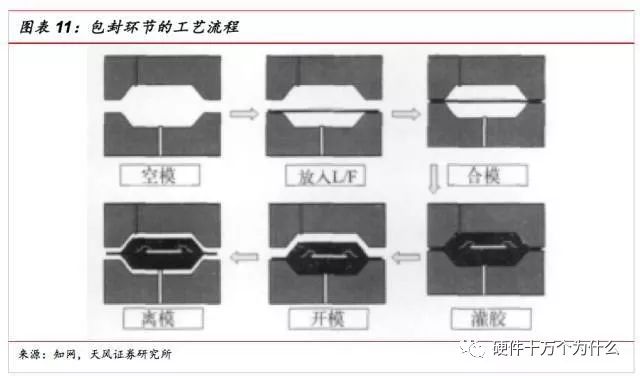
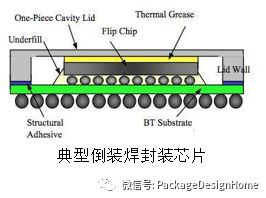

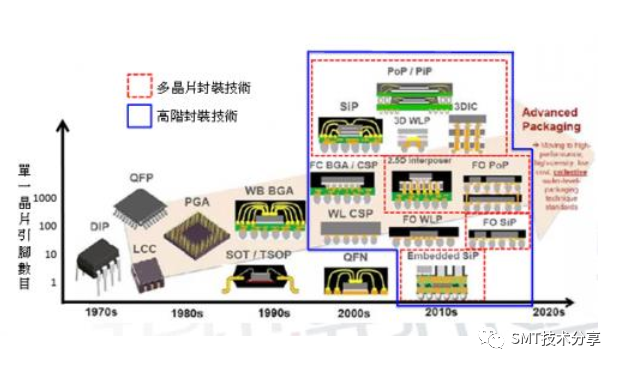
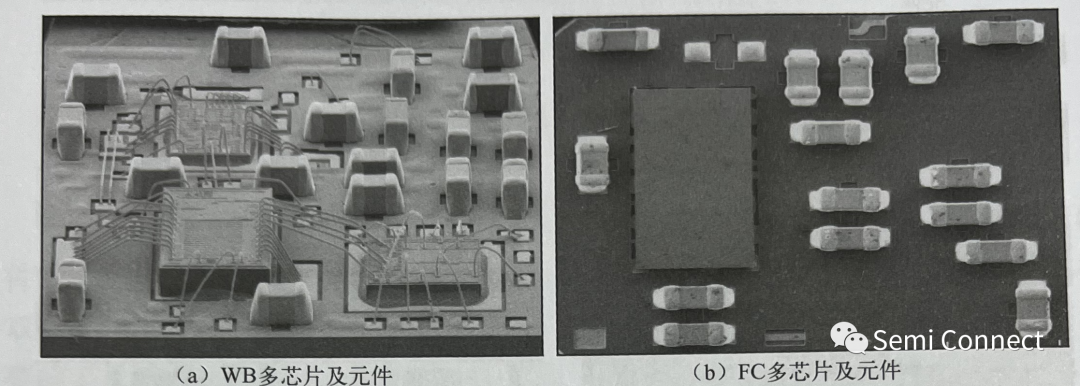
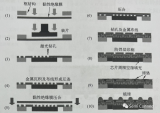
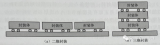



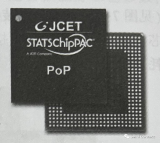













評論