現(xiàn)代電子產(chǎn)品一直朝著細(xì)線和超薄的方向發(fā)展,應(yīng)用電子元件越來越小。此外,越來越多的具有細(xì)間距IC(集成電路)封裝的電子元件已經(jīng)組裝在PCB(印刷電路板)上,尤其是BGA(球柵陣列)和CSP(芯片級封裝)元件。元件間距從0.65mm和0.5mm轉(zhuǎn)換為0.4mm或更小; PCB厚度從1.6mm和1.2mm到1.0mm,0.8mm或0.6mm或更小; PCB層數(shù)從雙面或8層分為12層,18層或更多層; BGA安裝模式,從單個(gè)安裝到POP(封裝上的封裝)。上面提到的所有開發(fā)一直在挑戰(zhàn)我們的PCB制造和PCBA能力,然而,BGA的焊接質(zhì)量是一個(gè)關(guān)鍵因素,一旦一個(gè)程序得到不充分的關(guān)注或者做出不合適的措施,就會導(dǎo)致BGA裂縫。 。在BGA上出現(xiàn)裂縫的最常見位置是焊盤和焊盤底部的焊接連接。一般來說,裂縫最多發(fā)生在BGA元件的四個(gè)角,然后是四個(gè)邊,因?yàn)樗鼈兂惺艿膽?yīng)力最大。
將解釋導(dǎo)致BGA焊接出現(xiàn)裂紋的原因在以下段落中。
低質(zhì)量的PCB導(dǎo)致BGA裂縫
?錯(cuò)誤選取T g 和T d
從鉛制造到無鉛制造,回流焊接和由于SMT(表面貼裝技術(shù))組裝要求,波峰焊接溫度必須提高。有些人只是認(rèn)為可以選擇具有高T g (玻璃化轉(zhuǎn)變溫度)的基板材料用于PCB板。他們只是認(rèn)為管理和控制Z軸擴(kuò)展至關(guān)重要。主要目的是阻止分層厚電路板和14層或更多PCB,并阻止PTH(鍍通孔)出現(xiàn)裂縫,因?yàn)镻CB的Z軸擴(kuò)展很大程度上會導(dǎo)致PTH孔在回流或波峰焊接過程中斷壁。然而,除非T d (分解溫度)被認(rèn)為完全解決了PCB裂縫問題,否則T g 無法抵消無鉛工藝過程中產(chǎn)生的裂縫。 IPC中涉及PCB基板材料的三個(gè)T d 水平:310°C,325°C和340°C。
總之,在此過程中,基質(zhì)材料測定,T g 和T d 越高越好。但PCB制造成本是一個(gè)必不可少的考慮因素,基于這種基礎(chǔ)材料應(yīng)該選擇具有令人滿意的T g 和T d 的基板材料。
?預(yù)浸料中凝膠含量不足
外層和內(nèi)層之間使用的預(yù)浸料中凝膠含量不足會導(dǎo)致銅箔在高溫下產(chǎn)生氣泡。
?不合適的銅型材選擇
通常,普通型材分為三類:標(biāo)準(zhǔn)型材,低型材和非常低的型材。標(biāo)準(zhǔn)型材不含銅板的規(guī)定,因?yàn)檎澈闲愿叩^高的型材往往會導(dǎo)致蝕刻不良,這進(jìn)一步降低了線寬和阻抗控制的穩(wěn)定性。較低的輪廓調(diào)節(jié)最大輪廓SPEC為0.4mil(10.2μm)。到目前為止,大多數(shù)PCB制造商都在利用較低的外形。非常低的輪廓調(diào)節(jié)最大輪廓SPEC為0.2mil(5.1μm),這通常僅用于PCB制造中,具有特殊的細(xì)線要求,例如2mil走線寬度。
?低執(zhí)行PCB層壓
每當(dāng)?shù)蛷?qiáng)度PCB層壓發(fā)生時(shí),黑色素或褐化不足都會導(dǎo)致粘附性差。
?低性能焊料掩模顯影或表面處理
低性能焊料掩模顯影或表面光潔度會導(dǎo)致焊接缺陷。例如,當(dāng)OSP膜太厚或太薄,接收不合適的預(yù)處理或經(jīng)過太長的保持時(shí)間時(shí),往往會產(chǎn)生表面氧化。
?BGA焊盤太小大小
在設(shè)計(jì)階段,當(dāng)BGA焊盤尺寸太小時(shí),可能是由于過蝕刻或沒有蝕刻因子的補(bǔ)償值而發(fā)生。
BGA的不受信任的材料和布局
?當(dāng)BGA進(jìn)料的基材Z軸膨脹太大時(shí),它具有低剝離強(qiáng)度和T d 太低,這兩種情況都可能導(dǎo)致錫裂縫。
?真空包裝在IQC(進(jìn)貨質(zhì)量控制)檢查后未實(shí)施,真空包裝破損在焊接前將BGA粘合劑焊接到電路板表面兩個(gè)多小時(shí)之前,所有這些都會導(dǎo)致焊接不良。
?在BGA布局期間,焊盤尺寸永遠(yuǎn)不會太小除特殊情況下使用的襯墊外,襯墊尺寸絕不能低于BGA的半間距減去2密耳。此外,BGA四角的焊盤尺寸應(yīng)比焊盤大1m。
?BGA的四個(gè)角最好設(shè)計(jì)成SMD(焊接掩模定義)因?yàn)榉糯驜GA基底和焊盤周圍的焊接掩模蓋的存在將顯著改善焊盤的抗裂性。由于使用焊接掩模定義焊接,焊接只能覆蓋表面而忽略側(cè)面,這導(dǎo)致焊接連接強(qiáng)度比銅定義焊接更差。
?采用ENIG表面處理的PCB會導(dǎo)致產(chǎn)生裂縫BGA焊接連接更容易。 ENIG永遠(yuǎn)不能在BGA上使用,其焊盤厚度低11mil,OSP更合適。
過程控制不足或裝配條件不足
?在模板設(shè)計(jì)階段,BGA組件的四個(gè)角和每個(gè)側(cè)面應(yīng)比墊的厚度大1mil到2mil。模板開口尺寸應(yīng)根據(jù)BGA組件的規(guī)格設(shè)計(jì),包括間距,BGA焊球和焊球成分。
?在印刷過程中,支撐銷不應(yīng)對抗BGA由于BGA焊盤的污染,阻止假焊接和枕頭效應(yīng)。此外,還必須特別注意印刷刮刀壓力和印刷質(zhì)量控制。
?安裝階段應(yīng)強(qiáng)調(diào)拾取器BGA的晶圓位置,元件厚度設(shè)置和拾取壓力量。
?在IR回流過程中存在更多裂縫的機(jī)會,需要特別注意:
a。在雙面PCB制造過程中,必須考慮PCB變形程度。在回流焊接過程中可以使用夾具,并且必須仔細(xì)考慮夾具的基板,因?yàn)樗赡芤蚋邷睾屠鋮s而收縮。
b。必須仔細(xì)檢查進(jìn)來的BGA組件,看是否在焊球上發(fā)生下沉。此外,焊球的合金成分和BGA基板材料的Z軸膨脹與PCB板之間的兼容性。
-
BGA
+關(guān)注
關(guān)注
5文章
549瀏覽量
47057 -
PCB打樣
+關(guān)注
關(guān)注
17文章
2968瀏覽量
21833 -
華強(qiáng)PCB
+關(guān)注
關(guān)注
8文章
1831瀏覽量
27944
發(fā)布評論請先 登錄
相關(guān)推薦
BGA焊接前的準(zhǔn)備工作
常見的BGA焊接不良現(xiàn)象有哪些?如何處理
BGA焊接失效分析
探究BGA封裝焊接:常見缺陷與異常解析
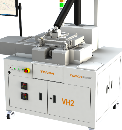
驅(qū)動(dòng)芯片在應(yīng)用中的常見問題分析與解決

PCBA焊接疑難解析:克服常見問題的有效策略
BGA封裝常見故障及解決方法
BGA芯片焊接全攻略:從準(zhǔn)備到實(shí)戰(zhàn)的詳盡指南





 BGA焊接常見問題分析
BGA焊接常見問題分析











評論