常規(guī)PCB的線路是突起于基材的,但也有些客戶要求線路與基材介質(zhì)盡可能平齊,降低線路突出裸露的程度。這類產(chǎn)品的特點(diǎn)通常為厚銅,且線寬線距都較大,需要對線路進(jìn)行介質(zhì)填充。本文將介紹一種通過樹脂填充方式實現(xiàn)PCB線路與基材平齊的制造工藝,可使此類厚銅產(chǎn)品的線路相對基材突出<15um,線路間隙填膠飽滿,并滿足可靠性等常規(guī)使用需求。
若PCB上的觸點(diǎn)或線路需要與器件反復(fù)接觸,隨著產(chǎn)品工作時間的推移,其表面金屬會出現(xiàn)一定的磨損,從而導(dǎo)致接觸不良的情況。于是有客戶提出線路與基材平齊的PCB制作需求,避免板面裸露的金屬層過度磨損。此類產(chǎn)品通常面銅較厚,線寬線距較大,因此較為簡單的一種制作方案是在線路間填充樹脂作為介質(zhì),故本文將介紹樹脂作為介質(zhì)材料填充線路的制板方案。
線路與基材平齊PCB的制作要點(diǎn)
線路與基材平齊PCB的產(chǎn)品,其面銅較厚,通常大于3oz,而線寬線距也較寬松,通常是大于8mil/8mil,比較利于填膠操作。填膠方面客戶通常要求線路邊緣突出膠層不得高于15um,并且填膠部位的中心凹陷也不得低于10um,如下圖1所示。除了要滿足常規(guī)PCB的要求,在可靠性方面,熱沖擊測試也不得出現(xiàn)分層爆板,膠層開裂等情況。
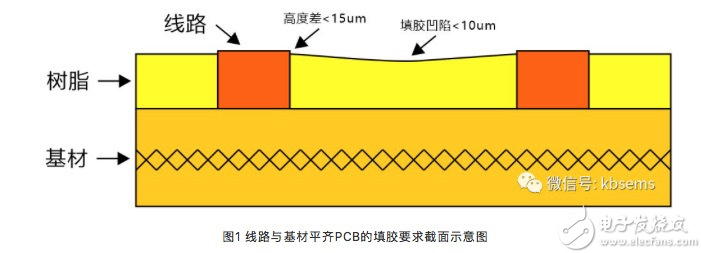
從上述的制板要求來看,此類PCB要求線路間填滿樹脂,且填膠部位的中心凹陷不得過大,而通過提升膠含量使樹脂溢出能較好地避免凹陷問題產(chǎn)生,但對除膠提出了較大的挑戰(zhàn)。除膠的方式通常有激光除膠和磨板除膠,然而對于大面積線路和較厚的膠層,選擇磨板除膠更為合適,但在磨板除膠的過程中,可能會出現(xiàn)銅層磨得過薄的情況。此外,填膠過程可能會因為線距和銅厚及樹脂特性出現(xiàn)局部的氣泡或填膠不充分,導(dǎo)致產(chǎn)品可靠性受到影響。
線路與基材平齊PCB的線路填膠與除膠
一、線路填膠
填膠作為該產(chǎn)品的制板難點(diǎn)之一,其作業(yè)質(zhì)量與樹脂種類、銅厚高度和線路間距緊密相關(guān)。通常樹脂粘稠度越低,表面銅厚越薄,線路間距越寬,則填膠越充分且不容易出現(xiàn)氣泡。因此在決定使用某種樹脂進(jìn)行填膠前,要進(jìn)行試驗摸清此類樹脂的填膠性能。
這里以4oz銅厚為例,對設(shè)計了不同的線距的試驗板進(jìn)行某樹脂的填膠效果測試,從8mil開始逐步提升線距,可得效果如下表所示。
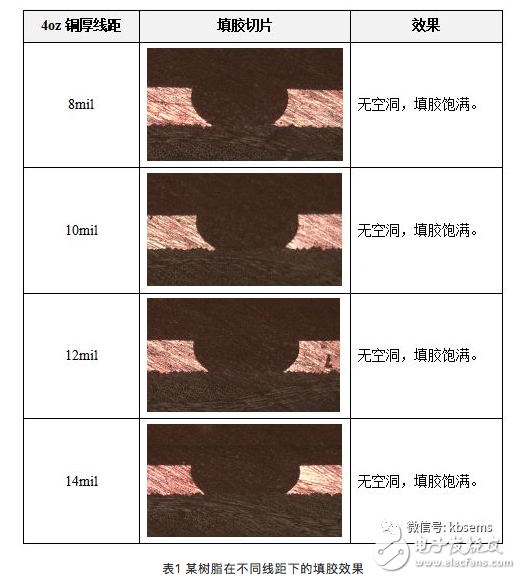
可見該測試還是比較理想的,在8mil線距以上均實現(xiàn)了飽滿填膠,但需要指出的是當(dāng)產(chǎn)品的銅厚增加或線距縮小時,或是樹脂更換品種類型,都需要重新測定其填膠能力,以確保生產(chǎn)能力滿足填膠需求。
二、板面除膠
盡管在填膠的過程中使樹脂溢出,能有效避免填膠中心區(qū)域凹陷,但過多的溢膠會給除膠過程增加難度。采用磨板除膠加工[1],通常可以先用砂帶研磨機(jī)對整板進(jìn)行打磨,再用手動打磨設(shè)備對局部殘膠打磨。加工思路在于整板打磨削減整體的膠層厚度,直到表面線路的銅皮裸露,后續(xù)對局部殘膠手工打磨,能清除較厚殘膠并降低銅面的磨損程度,如下圖2所示。
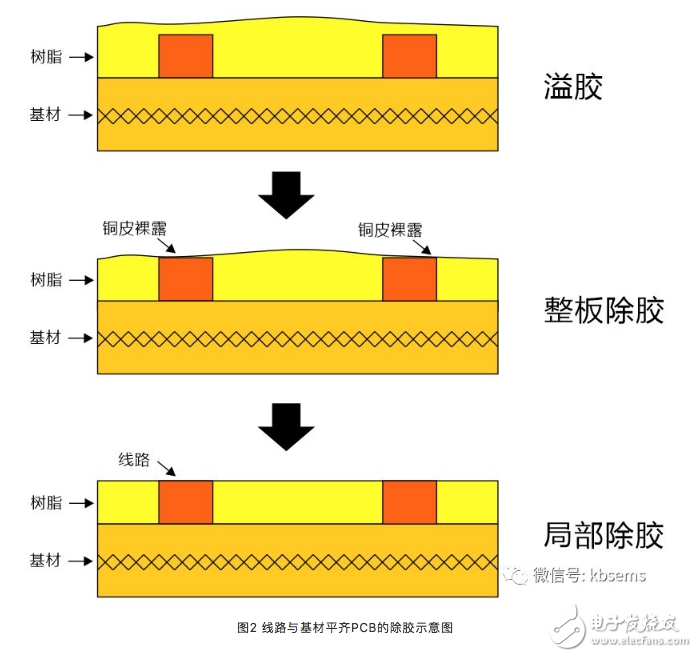
實際磨板除膠過程中,最糟糕的情況莫過于板面出現(xiàn)局部銅皮裸露時,還有大面積殘膠需要手工處理,顯然這樣做工作量極大。為了減少這樣的情況,填膠過程中就應(yīng)該管控好溢膠厚度及其表面的均勻性,如優(yōu)化刮膠工藝或填膠后靜置一段時間,待膠層平順后再進(jìn)行后工序加工。
線路與基材平齊PCB的制程設(shè)計
通過對以上的難題及解決方案的描述,大致的制板流程已經(jīng)開始清晰,這里就以多層板結(jié)構(gòu)為例,對線路與基材平齊PCB的大體流程設(shè)計如下圖3所示。

此流程的設(shè)計與常規(guī)PCB產(chǎn)品制作的區(qū)別在于,外層銅厚的底銅幾乎就是成品銅厚。基于這個特點(diǎn)展開的外線和孔加工工序,大致是先對厚底銅蝕刻出線路,然后對線路進(jìn)行樹脂填充,接著鉆通孔并孔金屬化,再單獨(dú)鍍孔提升孔銅厚度,最后蝕刻填膠部位的薄銅層。從而滿足常規(guī)PCB制作要求及線路與基材平齊的要求,如下圖4所示。
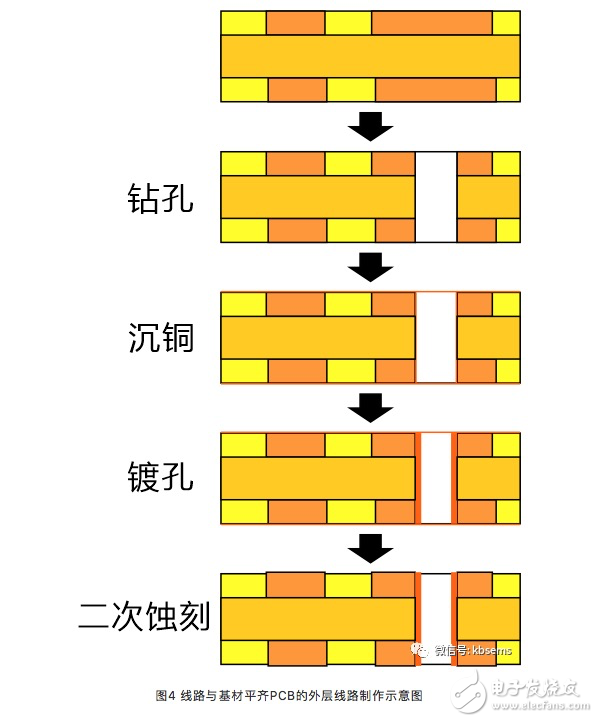
此外當(dāng)客戶對產(chǎn)品平整度的要求包含了表面處理,則需要對銅面高度的處理流程進(jìn)行適當(dāng)?shù)恼{(diào)整,以滿足表面處理后的平整度需求。
加工效果
根據(jù)上述流程制作樣板,并制作樣品切片,收集若干個樣品的基材與線路頂端高度差,得到了如下表2所示數(shù)據(jù),樣板與切片如下圖5所示。
可見該線路與基材平齊PCB樣品是滿足高度差<15um的要求的,實際上若對磨板流程及孔金屬化流程進(jìn)一步優(yōu)化,有利于得到更小的高度差,從而獲得更好的平整度。
此外,還對完成的線路與基材平齊PCB樣品進(jìn)行288℃熱沖擊10s三次測試,可得其外觀及切片如下圖5所示,可見產(chǎn)品未出現(xiàn)分層爆板狀況,填膠部位效果良好,并未出現(xiàn)開裂。
綜上,此類線路與基材平齊PCB的重點(diǎn)在于使線路與基材加工出平齊的效果,而加工關(guān)鍵在于影響著產(chǎn)品可靠性的填膠與除膠處理工序,此外產(chǎn)品加工平整度還仰賴于外層線路和表面處理流程的緊密配合。
當(dāng)前此類產(chǎn)品披露的相關(guān)文獻(xiàn)較少,本課題為解決此類產(chǎn)品制作過程中的問題作出的一些設(shè)想與嘗試多少有欠妥之處。然而在產(chǎn)品差異化倍增的現(xiàn)今,客戶的需求就是我們研究工作的靈感來源與精神動力,新的探索永無止步。
-
pcb
+關(guān)注
關(guān)注
4326文章
23161瀏覽量
399984 -
線路
+關(guān)注
關(guān)注
2文章
141瀏覽量
20877
發(fā)布評論請先 登錄
相關(guān)推薦




 線路與基材平齊PCB的制程設(shè)計
線路與基材平齊PCB的制程設(shè)計










評論