昨天,荷蘭***大廠ASML發(fā)布了其2018年的財報。數(shù)據(jù)顯示,公司2018全年銷售額為109億歐元,凈收入為26億歐元,預(yù)計2019年第一季度銷售額約為21億歐元,毛利率約為40%。
ASML總裁兼首席執(zhí)行官Peter Wennink還表示:“。在第四季度,我們收到五份EUV訂單。2019年,客戶有著對30個EUV系統(tǒng)的需求,這些出貨量將包括DRAM客戶的第一批量產(chǎn)系統(tǒng)。預(yù)計2019年我們的EUV掃描儀生產(chǎn)的芯片將開始供消費者和企業(yè)使用。”
他們還指出,公司將在今年推出新一代的EUV光刻設(shè)備NXE:3400C,規(guī)格為每小時170片晶圓,可用率超過90%。該系統(tǒng)將于2019年下半年提供給客戶。目前,ASML主流的EUV設(shè)備機型是NXE:3400B,在合作伙伴的工廠中已經(jīng)實現(xiàn)了125WPH的產(chǎn)能。
據(jù)ASML介紹,這個新設(shè)備是以“NXE:3400B”為基礎(chǔ),首次開發(fā)降低重合誤差的版本,而在后續(xù)的發(fā)展則是是以“降低重合誤差版本”為基礎(chǔ),開發(fā)提高“吐出量”(生產(chǎn)性能)的版本。在持續(xù)降低重合誤差的同時,ASML還在繼續(xù)開發(fā)提高產(chǎn)能的新版本,ASML還沒有公布新版本的型號,出貨時間預(yù)計在2021年的下半年,新版本應(yīng)該會承擔(dān)3nm的量產(chǎn)工作吧。

而據(jù)媒體報道,下一代EUV(極紫外)曝光技術(shù)的發(fā)展正在全面發(fā)展,這種技術(shù)將使得半導(dǎo)體邏輯和DRAM的小型化和高密度化成為可能。如果發(fā)展順利進行,在2020年下半年,最先進的半導(dǎo)體工藝可以受益于新的設(shè)備。他們指出,在“當(dāng)前一代”EUV曝光技術(shù)中,3nm代半導(dǎo)體邏輯有望成為小型化的極限。但在“下一代”EUV曝光技術(shù)出來之后,則讓2納米,甚至1.4納米成為可能。
ASML預(yù)估,在2021年底之前將裝配NAV為0.55的EUV曝光設(shè)備的原型系統(tǒng),大規(guī)模生產(chǎn)系統(tǒng)的出貨計劃于2024年開始。
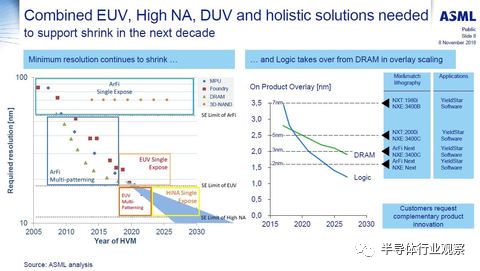
EUV光刻技術(shù)發(fā)展態(tài)勢
光刻(lithography)為集成電路微細(xì)化的最關(guān)鍵技術(shù)。當(dāng)前在16/14nm節(jié)點乃至10及7nm節(jié)點,芯片制造商普遍還在使用193nm ArF浸潤式***+多重成像技術(shù),但采用多重成像技術(shù)后將增加曝光次數(shù),導(dǎo)致成本顯著上升及良率、產(chǎn)出下降等問題。根據(jù)相關(guān)企業(yè)的規(guī)劃,在7/5nm節(jié)點,芯片生產(chǎn)將導(dǎo)入極紫外(EUV)光刻技術(shù),EUV光刻使用13.5nm波長的極紫外光,能夠形成更為精細(xì)的曝光圖像。芯片廠商計劃將EUV光刻應(yīng)用到最困難的光刻工序,即金屬1層以及過孔生成工序,而其他大部分工序則仍將延用193nm ArF浸潤式***+多重成像來制作。據(jù)EUV***生產(chǎn)商阿斯麥(ASML)稱,相比浸潤式光刻+三重成像技術(shù),EUV光刻技術(shù)能夠?qū)⒔饘賹拥闹谱鞒杀窘档?%,過孔的制作成本降低28%。
EUV光刻的關(guān)鍵技術(shù)包括EUV光源和高數(shù)值孔徑(NA)鏡頭,前者關(guān)乎***的吞吐量(Throughput),后者關(guān)乎***的分辨率(Resolution)和套刻誤差(Overlay)能力等。目前,全球EUV***生產(chǎn)基本上由荷蘭阿斯麥公司所壟斷,其最新 NXE:3400B EUV機型,采用245W光源,在實驗條件下,未使用掩膜保護膜(pellicle),已實現(xiàn)每小時曝光140片晶圓的吞吐量;該機型在用戶端的測試中,可達到每小時曝光125片晶圓的吞吐量,套刻誤差2nm;按照阿斯麥公司EUV技術(shù)路線規(guī)劃,公司將在2018年底前,通過技術(shù)升級使NXE:3400B EUV機型的套刻誤差減小到1.7nm以下,滿足5nm制程的工藝需求;在2019年中,采用250W EUV光源,達到每小時145片晶圓的量產(chǎn)吞吐量;在2020年,推出升級版的NXE:3400C EUV機型,采用250W EUV光源達到155片/時的量產(chǎn)吞吐量。總體上,目前的250W EUV光源已經(jīng)可以滿足7nm甚至5nm制程的要求,但針對下一代的EUV光源仍有待開發(fā)。據(jù)估算,在3nm技術(shù)節(jié)點,對EUV光源的功率要求將提升到500W,到了1nm技術(shù)節(jié)點,光源功率要求甚至將達到1KW。
高數(shù)值孔徑(High-NA)光學(xué)系統(tǒng)方面,由于極紫外光會被所有材料(包括各種氣體)吸收,因此極紫外光光刻必需在真空環(huán)境下,并且使用反射式透鏡進行。目前,阿斯麥公司已開發(fā)出數(shù)值孔徑為0.33的EUV***鏡頭,阿斯麥正在為3nm及以下制程采開發(fā)更高數(shù)值孔徑(NA)光學(xué)系統(tǒng),公司與卡爾蔡司公司合作開發(fā)的數(shù)值孔徑為0.5的光學(xué)系統(tǒng),預(yù)計在2023-2024年后量產(chǎn),該光學(xué)系統(tǒng)分辨率(Resolution)和生產(chǎn)時的套刻誤差(Overlay)比現(xiàn)有系統(tǒng)高出70%,每小時可以處理 185 片晶圓。
除***之外,EUV光刻要在芯片量產(chǎn)中應(yīng)用仍有一些技術(shù)問題有待進一步解決,如:光刻膠、掩膜、掩膜保護薄膜(pellicle)。
光刻膠方面,要實現(xiàn)大規(guī)模量產(chǎn)要求光刻膠的照射反應(yīng)劑量水平必須不高于20mJ/cm2。而目前要想得到完美的成像,EUV光刻膠的照射劑量普遍需要達到30-40mJ/cm2。在30mJ/cm2劑量水平,250w光源的EUV***每小時吞吐量只能達到90片,顯著低于理想的125片。由于EUV光刻產(chǎn)生的一些光子隨機效應(yīng),要想降低光刻膠的照射劑量水平仍需克服一系列挑戰(zhàn)。其中之一是所謂的光子發(fā)射噪聲現(xiàn)象。光子是光的基本粒子,成像過程中照射光光子數(shù)量的變化會影響EUV光刻膠的性能,因此會產(chǎn)生一些不希望有的成像缺陷,比如:線邊緣粗糙(line-edge roughness:LER)等。
光掩膜版,EUV光刻使用鏡面反射光而不是用透鏡折射光,因此EUV光刻采用的光掩膜版也需要改成反射型,改用覆蓋在基體上的硅和鉬層來制作。同時,EUV光刻對光掩膜版的準(zhǔn)確度、精密度、復(fù)雜度要求比以往更高。當(dāng)前制作掩膜版普遍使用的可變形狀電子束設(shè)備(VSB),其寫入時間成為最大的挑戰(zhàn),解決方案之一是采用多束電子束設(shè)備。包括IMS公司、NuFlare公司等已在開發(fā)相關(guān)多束電子束產(chǎn)品,多束電子束設(shè)備能夠提高光掩膜版制作效率,降低成本,還有助于提高光掩膜版的良率。未來,大部分EUV光掩膜版仍可以使用可變形狀電子束設(shè)備來制作,但是對少數(shù)復(fù)雜芯片而言,要想保持加工速度,必須使用多束電子束設(shè)備。
EUV薄膜,EUV薄膜作為光掩膜的保護層,提供阻隔外界污染的實體屏障,可以防止微塵或揮發(fā)氣體污染光掩膜表面,減少光掩膜使用時的清潔和檢驗。阿斯麥公司已經(jīng)開發(fā)出83%透射率的薄膜,在采用245W光源,測試可達到100 片晶圓/時吞吐量,阿斯麥的目標(biāo)是開發(fā)出透射率90%的透明薄膜,可承受300W的EUV光源,實現(xiàn)125片晶圓/時的吞吐量。
初期,EUV光刻還是主要應(yīng)用于高端邏輯芯片、存儲芯片的生產(chǎn),主要芯片企業(yè)已相繼宣布了各自導(dǎo)入EUV光刻的計劃。
-
光刻機
+關(guān)注
關(guān)注
31文章
1158瀏覽量
47587 -
ASML
+關(guān)注
關(guān)注
7文章
721瀏覽量
41353
原文標(biāo)題:熱點 | ASML今年將推新一代EUV光刻機,產(chǎn)能為每小時170片
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
光刻機巨頭ASML業(yè)績暴雷,芯片迎來新一輪“寒流”?
組成光刻機的各個分系統(tǒng)介紹
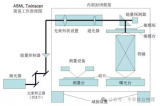
日本首臺EUV光刻機就位
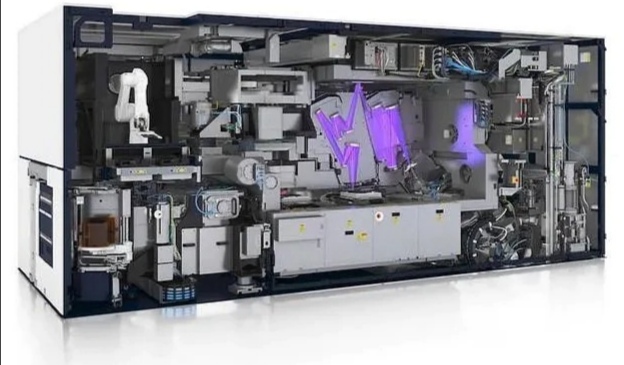
ASML擬于2030年推出Hyper-NA EUV光刻機,將芯片密度限制再縮小
后門!ASML可遠程鎖光刻機!
ASML考慮推出通用EUV光刻平臺
臺積電A16制程采用EUV光刻機,2026年下半年量產(chǎn)
ASML發(fā)貨第二臺High NA EUV光刻機,已成功印刷10nm線寬圖案
英特爾突破技術(shù)壁壘:首臺商用High NA EUV光刻機成功組裝
阿斯麥(ASML)公司首臺高數(shù)值孔徑EUV光刻機實現(xiàn)突破性成果

光刻機的發(fā)展歷程及工藝流程
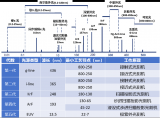
ASML 首臺新款 EUV 光刻機 Twinscan NXE:3800E 完成安裝





 ASML將推產(chǎn)能為每小時170片的新一代EUV光刻機
ASML將推產(chǎn)能為每小時170片的新一代EUV光刻機











評論