新型鍵合材料對于在高級半導體制造工藝中保持超薄晶圓的完整性至關重要。有了新型材料的配合,臨時鍵合在晶圓減薄工藝中愈發成為可能。
隨著半導體晶圓制程對縮小特征尺寸和引入全尺寸3D集成需求高漲,晶圓越來越薄。雖然現在已經有了將晶圓減薄至低于100微米的工藝,但獲得更薄晶圓(<50 μm)的代價卻是令它們變得極度脆弱,因為深度的減薄工藝和后端的金屬化工藝會給超薄晶圓施加額外應力,從而導致翹曲或斷裂。
晶圓減薄工藝包括用聚合物鍵合材料,將器件晶圓暫時接合到承載晶圓上,并通過苛刻的后端穩定晶圓工藝來支撐超薄的器件襯底。至于剝離技術,三種主流的剝離晶片襯底的方法有:熱滑動剝離、機械剝離和激光剝離,其中發展最迅速的為后兩種剝離技術。
下表整理了三種剝離方法的主要特性:

熱滑動剝離、機械剝離和激光剝離法正成為下一代超薄半導體晶圓的關鍵推動力。三種方法各有優勢,技術工藝也在不斷取得進步,為先進封裝應用領域帶來創新推動力。下一代超薄晶圓制造業中,臨時鍵合正在飛速發展,這些剝離方法也將在半導體行業得到更多的應用。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
相關推薦
,滿足晶圓的翹曲度的要求。但封裝的時候則是薄一點更好,所以要處理到100~200um左右的厚度,就要用到減薄
![的頭像]() 發表于
發表于 12-24 17:58
?474次閱讀
工藝中常用的材料包括:
芯片粘結劑:作為漿料涂覆到晶圓背面,之后再烘干。采用這種方法,成本較低,同時可以控制鍵合層厚度并且提高單位時間產量。
WBC膠水:其成分
![的頭像]() 發表于
發表于 12-19 09:54
?358次閱讀

基于石英玻璃外延GaN的工藝改進方法主要包括以下幾個方面:
一、晶圓片制備優化
多次減薄處理:
采用不同材料的漿液和磨盤對石英玻璃進行多次
![的頭像]() 發表于
發表于 12-06 14:11
?363次閱讀

去除晶圓鍵合邊緣缺陷的方法主要包括以下幾種:
一、化學氣相淀積與平坦化工藝
方法概述:
提供待鍵合的晶
![的頭像]() 發表于
發表于 12-04 11:30
?342次閱讀

將兩個晶圓永久性或臨時地粘接在一起的膠黏材料。 怎么鍵合與解鍵合? 如上圖,鍵合過程: 1.清潔
![的頭像]() 發表于
發表于 11-14 17:04
?811次閱讀

近日,武漢芯豐精密科技有限公司宣布,其自主研發的第二臺12寸超精密晶圓減薄機已成功交付客戶。這一里程碑事件標志著芯豐精密在高端晶
![的頭像]() 發表于
發表于 10-28 17:18
?595次閱讀
晶圓鍵合技術是一種先進的半導體制造工藝,它通過將兩塊或多塊晶圓在一定的
![的頭像]() 發表于
發表于 10-21 16:51
?676次閱讀
電子發燒友網站提供《2.5薄型晶圓組件90°彎曲.pdf》資料免費下載
發表于 09-03 14:21
?0次下載
在本系列第七篇文章中,介紹了晶圓級封裝的基本流程。本篇文章將側重介紹不同晶圓級封裝方法所涉及的各項工藝。
![的頭像]() 發表于
發表于 08-21 15:10
?1922次閱讀

近日,國內領先的半導體設備制造商晶盛機電傳來振奮人心的消息,其自主研發的新型WGP12T減薄拋光設備成功攻克了12英寸晶圓
![的頭像]() 發表于
發表于 08-12 15:10
?754次閱讀
Luminex machines set a new standard when it comes to flexibility, cost-effectiveness, and throughput "臨時鍵合和解鍵合是基板
![的頭像]() 發表于
發表于 05-29 17:39
?592次閱讀
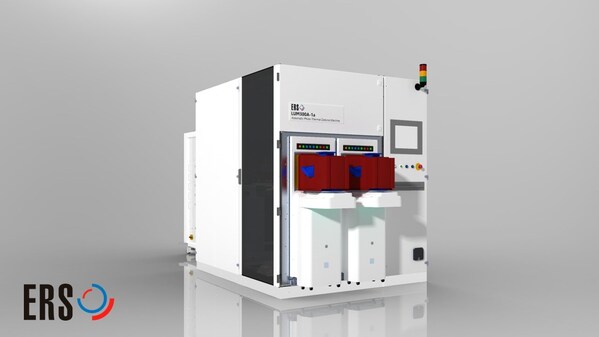
的容量和功能。在過去的幾十年中,基于薄晶圓 ( 通常厚度小于 100 μm) 的硅穿孔(Through-Silicon Via,TSV) 技術已經實現了 3D-IC 封裝。但是由于薄
![的頭像]() 發表于
發表于 03-29 08:37
?1278次閱讀
晶圓與載板分離。 當前,激光拆鍵合是主要的拆鍵合技術發展方向。激光拆鍵合技術是將臨時
![的頭像]() 發表于
發表于 03-26 00:23
?3073次閱讀

芯片堆疊封裝存在著4項挑戰,分別為晶圓級對準精度、鍵合完整性、晶圓減
發表于 02-21 13:58
?5980次閱讀

晶圓鍵合是一種將兩片或多片半導體晶片通過特定的工藝條件,使其緊密結合并形成一個整體的技術。這種技術在微電子、光電子以及MEMS(微機電系統)等領域有著廣泛的應用。
![的頭像]() 發表于
發表于 02-21 09:48
?2173次閱讀


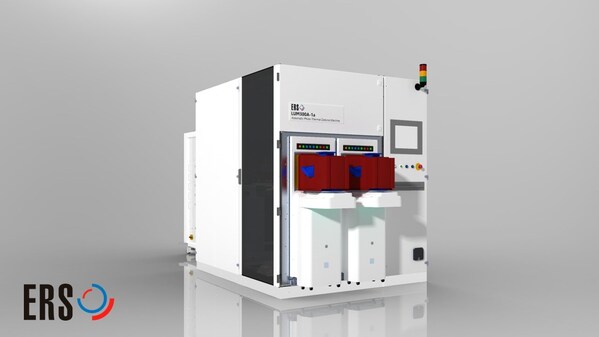





 臨時鍵合在晶圓減薄工藝中將愈發成為可能
臨時鍵合在晶圓減薄工藝中將愈發成為可能















評論