在半導體產業蓬勃發展的當下,晶圓作為芯片制造的基礎材料,其質量把控貫穿整個生產流程。其中,晶圓的 BOW(彎曲度)測量精度對于確保后續工藝的順利進行以及芯片性能的穩定性起著舉足輕重的作用。而不同的真空吸附方式,作為晶圓測量環節中的關鍵支撐技術,對 BOW 測量結果有著千差萬別的影響。
一、全表面真空吸附方式
全表面真空吸附是最為傳統且應用廣泛的一種方式。其原理是利用均勻分布在吸盤表面的微小氣孔,通過抽真空,使晶圓整個底面與吸盤緊密貼合。從穩定性角度來看,這種吸附方式無疑具有顯著優勢。在測量過程中,晶圓能夠被牢牢固定在既定位置,幾乎不會出現位移或晃動現象,為高精度測量儀器提供了穩定的操作平臺。
然而,當聚焦于晶圓 BOW 測量時,問題逐漸浮現。由于晶圓與吸盤大面積緊密接觸,吸盤施加的壓力均勻覆蓋整個晶圓底面。對于一些本身存在微小熱應力或內部應力不均衡的晶圓,這種均勻壓力會在一定程度上 “強制” 晶圓趨于平整。例如,在經歷高溫退火工藝后的晶圓,其中心區域因熱擴散速率與周邊不一致,往往會產生一定程度的凸起或凹陷,即 BOW 現象。但在全表面真空吸附下,該凸起或凹陷被吸盤的均壓部分抵消,測量探頭所獲取的 BOW 值相較于晶圓的真實彎曲程度偏小。據實驗數據統計,在某些特定工藝制程后的晶圓測量中,全表面真空吸附導致的 BOW 測量誤差可達 15% - 25%,這無疑會給后續基于測量數據的工藝調整帶來誤導,增加芯片制造的不良率風險。
二、邊緣點真空吸附方式
與全表面吸附截然不同,邊緣點真空吸附僅在晶圓邊緣選取幾個特定的點位布置真空吸嘴。這種設計的初衷是最大程度減少對晶圓中心區域的影響,讓晶圓內部應力能夠自由釋放,以期望在測量時呈現出最真實的 BOW 狀態。
在實際操作中,邊緣點真空吸附確實在展現晶圓原始 BOW 特性方面有一定成效。當晶圓因前期制造工藝積累了復雜的內部應力,如在多層膜沉積工藝后,不同膜層材料的熱膨脹系數差異引發晶圓翹曲,邊緣點吸附能夠避免過度約束,使得測量設備能夠探測到相對真實的彎曲情況。
但其短板同樣明顯 —— 穩定性不足。由于僅依靠少數幾個點提供吸附力,在外界輕微震動干擾下,晶圓極易發生位移或微小轉動。在高精度的 BOW 測量場景中,哪怕是幾微米的位置偏差,都可能導致測量探頭與晶圓接觸點的壓力分布改變,進而使測量結果出現較大波動。實驗室模擬產線環境測試發現,邊緣點真空吸附方式下,多次測量同一晶圓的 BOW 值偏差標準差可達 5 微米以上,這對于如今納米級精度要求的半導體工藝而言,是難以接受的誤差范圍,嚴重影響了測量數據的可靠性與重復性。
三、環形真空吸附方式
環形真空吸附作為一種折中的創新方案,近年來備受關注。它在晶圓邊緣靠近圓周處設計了一定寬度的環形真空吸附區域。
一方面,環形吸附繼承了全表面吸附的穩定性優勢,通過連續的環形吸力,能夠穩固地固定晶圓,抵御測量環境中的震動、氣流擾動等不利因素,確保晶圓在多次測量過程中的位置重復性良好,偏差可控制在極小范圍內,滿足先進半導體制造工藝對測量穩定性的嚴苛訴求。
另一方面,相較于全表面吸附,其避開了晶圓中心大面積區域,使得晶圓因重力、內部應力等產生的 BOW 能夠自然呈現。以化學機械拋光(CMP)工藝后的晶圓為例,由于研磨過程的不均勻性,晶圓中心易出現局部彎曲。環形真空吸附下,測量儀器能夠精準捕捉到這種細微彎曲變化,相比全表面吸附,BOW 測量精度可提升 10% - 20%,為工藝優化提供了更具參考價值的數據。
四、復合型真空吸附方式探索
隨著半導體技術向更高精度、更復雜工藝邁進,單一的真空吸附方式愈發難以滿足需求。目前,科研人員正在探索復合型真空吸附方式,例如結合邊緣點吸附的應力釋放優勢與環形吸附的穩定性特點,通過智能控制系統動態調整不同區域的吸附力。在晶圓初始定位階段,采用邊緣點吸附讓晶圓自然舒展,初步測量整體 BOW 趨勢;隨后切換至環形吸附,強化固定效果進行高精度測量。這種復合型方式有望進一步降低 BOW 測量誤差,推動半導體制造產業邁向新高度。
綜上所述,不同的真空吸附方式在測量晶圓 BOW 時各有利弊。從傳統的全表面、邊緣點吸附到新興的環形吸附以及未來的復合型吸附,技術的迭代始終圍繞著如何在確保測量穩定性的同時,最大程度還原晶圓真實的 BOW 狀態。只有精準把握每種吸附方式的特性與影響,持續創新優化,才能為半導體芯片制造的高質量發展奠定堅實基礎。
五、高通量晶圓測厚系統
高通量晶圓測厚系統以光學相干層析成像原理,可解決晶圓/晶片厚度TTV(Total Thickness Variation,總厚度偏差)、BOW(彎曲度)、WARP(翹曲度),TIR(Total Indicated Reading 總指示讀數,STIR(Site Total Indicated Reading 局部總指示讀數),LTV(Local Thickness Variation 局部厚度偏差)等這類技術指標。



高通量晶圓測厚系統,全新采用的第三代可調諧掃頻激光技術,相比傳統上下雙探頭對射掃描方式;可一次性測量所有平面度及厚度參數。

1,靈活適用更復雜的材料,從輕摻到重摻 P 型硅 (P++),碳化硅,藍寶石,玻璃,鈮酸鋰等晶圓材料。

重摻型硅(強吸收晶圓的前后表面探測)

粗糙的晶圓表面,(點掃描的第三代掃頻激光,相比靠光譜探測方案,不易受到光譜中相鄰單位的串擾噪聲影響,因而對測量粗糙表面晶圓)

低反射的碳化硅(SiC)和鈮酸鋰(LiNbO3);(通過對偏振效應的補償,加強對低反射晶圓表面測量的信噪比)

絕緣體上硅(SOI)和MEMS,可同時測量多 層 結 構,厚 度 可 從μm級到數百μm 級不等。

可用于測量各類薄膜厚度,厚度最薄可低至 4 μm ,精度可達1nm。
可調諧掃頻激光的“溫漂”處理能力,體現在極端工作環境中抗干擾能力強,充分提高重復性測量能力。
4,采用第三代高速掃頻可調諧激光器,一改過去傳統SLD寬頻低相干光源的干涉模式,解決了由于相干長度短,而重度依賴“主動式減震平臺”的情況。卓越的抗干擾,實現小型化設計,同時也可兼容匹配EFEM系統實現產線自動化集成測量。


5,靈活的運動控制方式,可兼容2英寸到12英寸方片和圓片測量。
-
晶圓
+關注
關注
52文章
4973瀏覽量
128312 -
測量
+關注
關注
10文章
4938瀏覽量
111808 -
真空
+關注
關注
0文章
70瀏覽量
15238
發布評論請先 登錄
相關推薦
【Aworks申請】適用于粗糙表面的真空吸附式隧道工況檢測爬壁機器人系統
真空吸取在貼裝技術中的應用原理
真空吸附式分頁機產品特點
晶圓靜電吸附(ESC)詳解
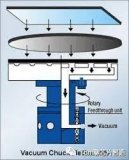
真空吸取及其在貼裝技術中應用
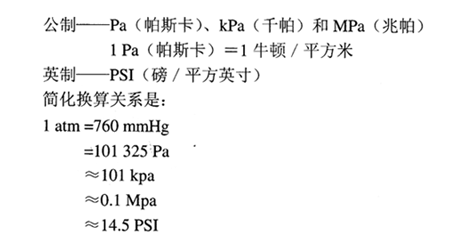
中圖儀器全自動晶圓檢測機輕松測量wafer套刻偏移量
晶圓的環吸方案相比其他吸附方案,對于測量晶圓 BOW/WARP 的影響

不同的碳化硅襯底的吸附方案,對測量碳化硅襯底 BOW/WARP 的影響

特氟龍夾具的晶圓夾持方式,相比真空吸附方式,對測量晶圓 BOW 的影響





 不同的真空吸附方式,對測量晶圓 BOW 的影響
不同的真空吸附方式,對測量晶圓 BOW 的影響
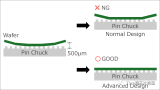










評論