加速系統(tǒng)功能擴(kuò)展
對(duì)高性能計(jì)算、下一代服務(wù)器和AI加速器的需求迅速增長(zhǎng),增加了處理更大工作負(fù)載的需求。這種不斷增加的復(fù)雜性帶來(lái)了兩個(gè)主要挑戰(zhàn):可制造性和成本。從制造角度來(lái)看,這些處理引擎正接近光刻機(jī)可以蝕刻的光罩的最大尺寸;而隨著芯片尺寸的增大和相應(yīng)的良率降低,單個(gè)芯片的成本可能會(huì)顯著增加。
戈登·摩爾曾說(shuō)過(guò):“將大型系統(tǒng)由較小的功能構(gòu)建,分別封裝并互連,可能更經(jīng)濟(jì)。”在芯片設(shè)計(jì)中,為了滿(mǎn)足性能提升的需求,行業(yè)正在從系統(tǒng)級(jí)芯片(SoC)轉(zhuǎn)向使用晶圓級(jí)封裝的系統(tǒng)級(jí)封裝(SiP)。
異構(gòu)SoC涉及在IO或核心級(jí)別對(duì)SoC進(jìn)行分區(qū),使用模塊化方法與不同的構(gòu)建塊。這提供了幾個(gè)優(yōu)勢(shì),包括支持超出光罩尺寸的SoC,提高芯片良率,并實(shí)現(xiàn)設(shè)計(jì)模塊化。然而,異構(gòu)芯片引入了新的挑戰(zhàn),包括由于芯片之間和封裝的緊密交互而增加的設(shè)計(jì)復(fù)雜性,支持跨裝配和制造過(guò)程的可測(cè)試性,以及由于芯片的接近性而進(jìn)行的熱管理。3D集成能夠?qū)崿F(xiàn)使用不同技術(shù)和材料制造的IC芯片的異構(gòu)集成,從而實(shí)現(xiàn)高性能、低成本和緊湊尺寸要求的集成、復(fù)雜和多功能微系統(tǒng)。
封裝的進(jìn)步使多芯片系統(tǒng)成為可能
需要處理大量數(shù)據(jù)的新興半導(dǎo)體應(yīng)用正在推動(dòng)先進(jìn)封裝的發(fā)展。各種先進(jìn)封裝技術(shù),包括并排放置或垂直放置,已經(jīng)成為異構(gòu)集成技術(shù)實(shí)施的一部分。2.5D和3D封裝作為重要的解決方案獲得了普及,每種技術(shù)都提供了獨(dú)特的優(yōu)勢(shì)和挑戰(zhàn),使其成為半導(dǎo)體制造商和開(kāi)發(fā)者的重要考慮因素。
在2.5D封裝中,兩個(gè)或多個(gè)芯片并排放置,通過(guò)中介層將一個(gè)芯片連接到另一個(gè)芯片。中介層充當(dāng)橋梁,連接單個(gè)芯片并提供高速通信接口,允許在單個(gè)封裝上更靈活地結(jié)合不同功能。通過(guò)在中介層上堆疊芯片,2.5D封裝減少了封裝的整體占地面積(與2D相比),使其非常適合更小和更薄的設(shè)備。中介層和橋提供了大量高密度的BUMPs和走線(xiàn),有助于增加帶寬。
在3D IC技術(shù)中,通過(guò)垂直堆疊進(jìn)行芯片連接,提高了封裝的整體性能和功能。這允許集成具有多層和多功能的芯片。特別是對(duì)于混合鍵合等3D封裝技術(shù),這種集成趨勢(shì)導(dǎo)致芯片之間的BUMPs間距急劇縮小,從而減少了相應(yīng)的互連距離和相關(guān)寄生效應(yīng)。
可擴(kuò)展性:互連
由于對(duì)更高帶寬的需求和制造過(guò)程及封裝技術(shù)的進(jìn)步,互連從傳統(tǒng)的銅uBUMP到最先進(jìn)的40um間距uBUMP,再進(jìn)一步縮小到10um(圖2)發(fā)生了顯著變化。
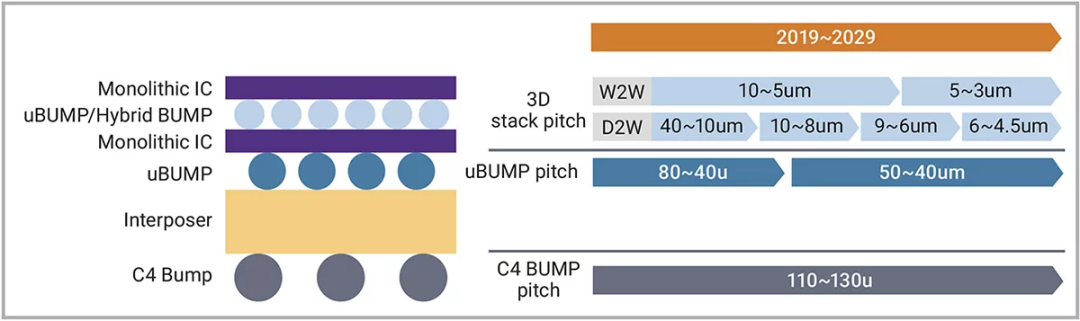
▲圖2BUMPs間距的縮小(來(lái)源:先進(jìn)封裝的現(xiàn)狀-2023年6月,Yole Intelligence)
在2.5D場(chǎng)景中,通過(guò)中介層上的重分布層(RDL)進(jìn)行芯片之間的連接,芯片之間的距離通常在100um左右。隨著3D場(chǎng)景中芯片堆疊技術(shù)的進(jìn)步,使用uBUMP進(jìn)行芯片的垂直堆疊允許芯片之間直接連接,將距離減少到不到40um。這顯著減少了基板的尺寸。此外,在3D集成中,傳輸?shù)腎O信號(hào)不再需要放置在芯片的邊緣。此外,通過(guò)在集成芯片系統(tǒng)中使用混合鍵合技術(shù)(SoIC,3D),芯片之間的垂直連接更加緊密。混合鍵合通過(guò)微小的銅對(duì)銅連接(<10um)連接芯片。混合鍵合的較小BUMPs間距允許在相同區(qū)域內(nèi)具有數(shù)千個(gè)IO通道,進(jìn)一步提高集成度和性能。這一進(jìn)步顯著提高了數(shù)據(jù)帶寬,即使在較低的工作頻率下(與2.5D相比)。因此,鑒于這一技術(shù)進(jìn)步,選擇基于簡(jiǎn)單數(shù)字IO的解決方案,如新思科技 3DIO(圖3),不僅提高了IO電路的可靠性,還在面積效率方面顯示出比串行IO更好的結(jié)果質(zhì)量。
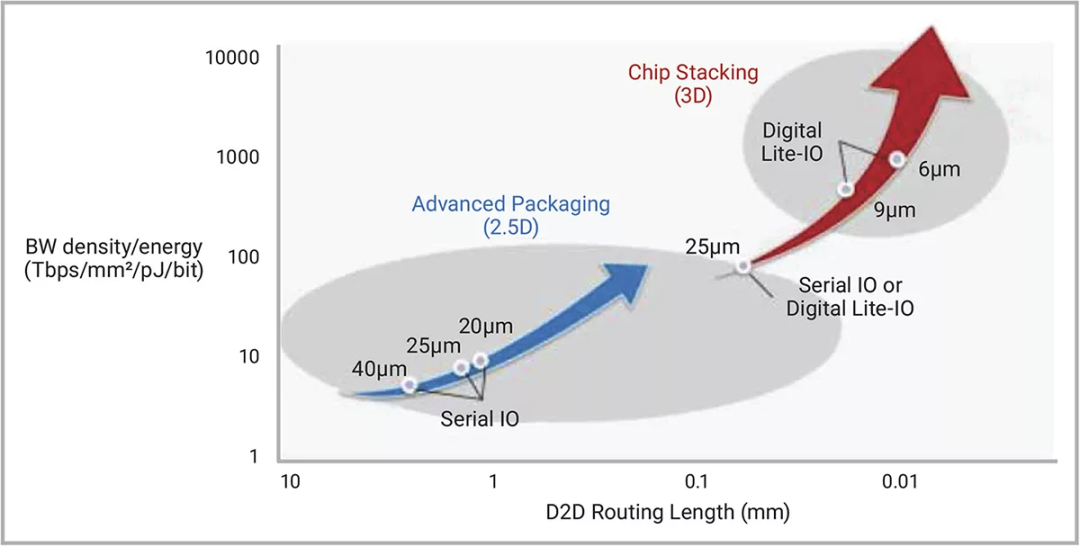
▲圖33DIC互連的全景圖(來(lái)源:3DIC時(shí)代的互連,臺(tái)積電,IEEE,2022年)
新思科技 3DIO平臺(tái)提供靈活性、可擴(kuò)展性和最佳性能
新思科技 3DIO平臺(tái)(圖4)專(zhuān)為多芯片異構(gòu)集成而調(diào)整,提供多功能解決方案,實(shí)現(xiàn)3D堆疊中功率、性能和面積(PPA)的最佳平衡,以滿(mǎn)足新興封裝需求。此外,該平臺(tái)還能加快時(shí)序收斂,這是芯片對(duì)芯片集成中的關(guān)鍵挑戰(zhàn)。
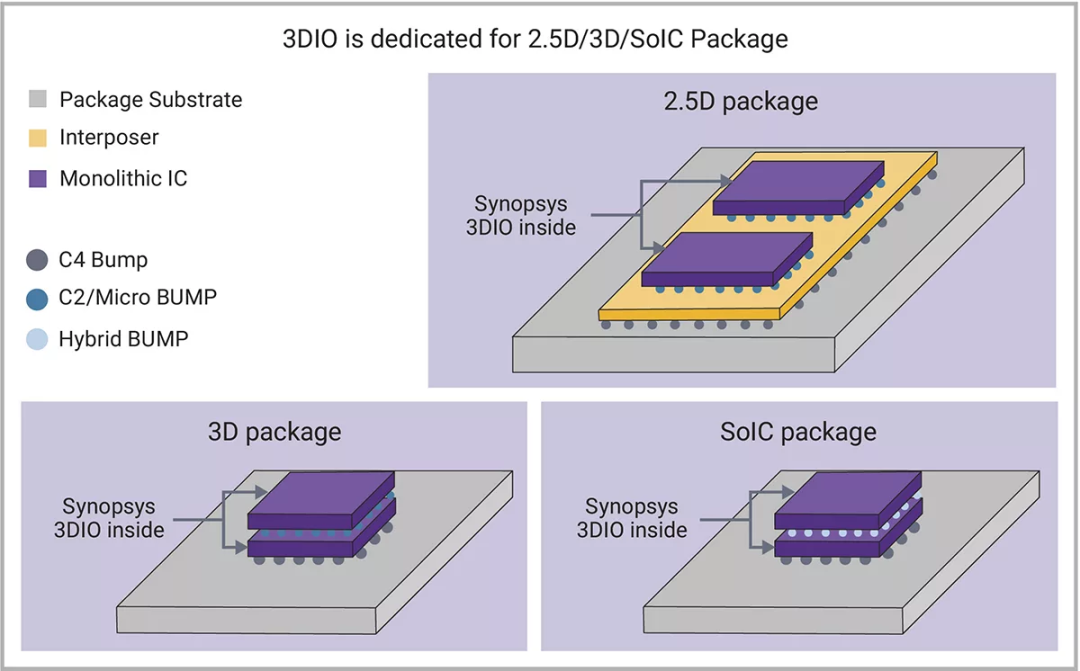
▲圖4新思科技 3DIO平臺(tái)架構(gòu)支持2.5D、3D和SoIC封裝
新思科技 3DIO平臺(tái)包括以下內(nèi)容:
新思科技可綜合3DIO包括與新思科技標(biāo)準(zhǔn)單元庫(kù)兼容的可綜合Tx/Rx單元和用于最佳ESD保護(hù)的可配置充電設(shè)備模型(CDM)。隨著IO通道數(shù)量的急劇增加,優(yōu)化的新思科技 3DIO解決方案利用自動(dòng)布置和布線(xiàn)(APR)環(huán)境直接在BUMPs上布置和布線(xiàn)IO。該解決方案支持使用微BUMP和混合BUMP的2.5D和3D封裝。新思科技 3DIO單元支持高數(shù)據(jù)速率,并提供最低功耗解決方案,面積優(yōu)化以適應(yīng)混合BUMP區(qū)域。新思科技源同步3DIO(SS3DIO)擴(kuò)展了可綜合的3DIO單元解決方案,具有時(shí)鐘轉(zhuǎn)發(fā)功能,以幫助降低比特錯(cuò)誤率(BER)并簡(jiǎn)化芯片之間的時(shí)序收斂。SS3DIO提供可擴(kuò)展性,以創(chuàng)建具有最佳PPA和ESD的自定義大小宏。TX、RX和時(shí)鐘電路支持匹配的數(shù)據(jù)和時(shí)鐘路徑,數(shù)據(jù)在發(fā)送時(shí)鐘邊沿發(fā)射,并在相應(yīng)的接收時(shí)鐘邊沿捕獲。新思科技源同步3DIO PHY是一個(gè)64位硬化PHY模塊,具有內(nèi)置冗余,優(yōu)化以實(shí)現(xiàn)最高性能。具有CLK轉(zhuǎn)發(fā)的3DIO PHY降低了BER,并簡(jiǎn)化了實(shí)現(xiàn)以及POWER/CLK/GND BUMP的最佳布置(圖5)。
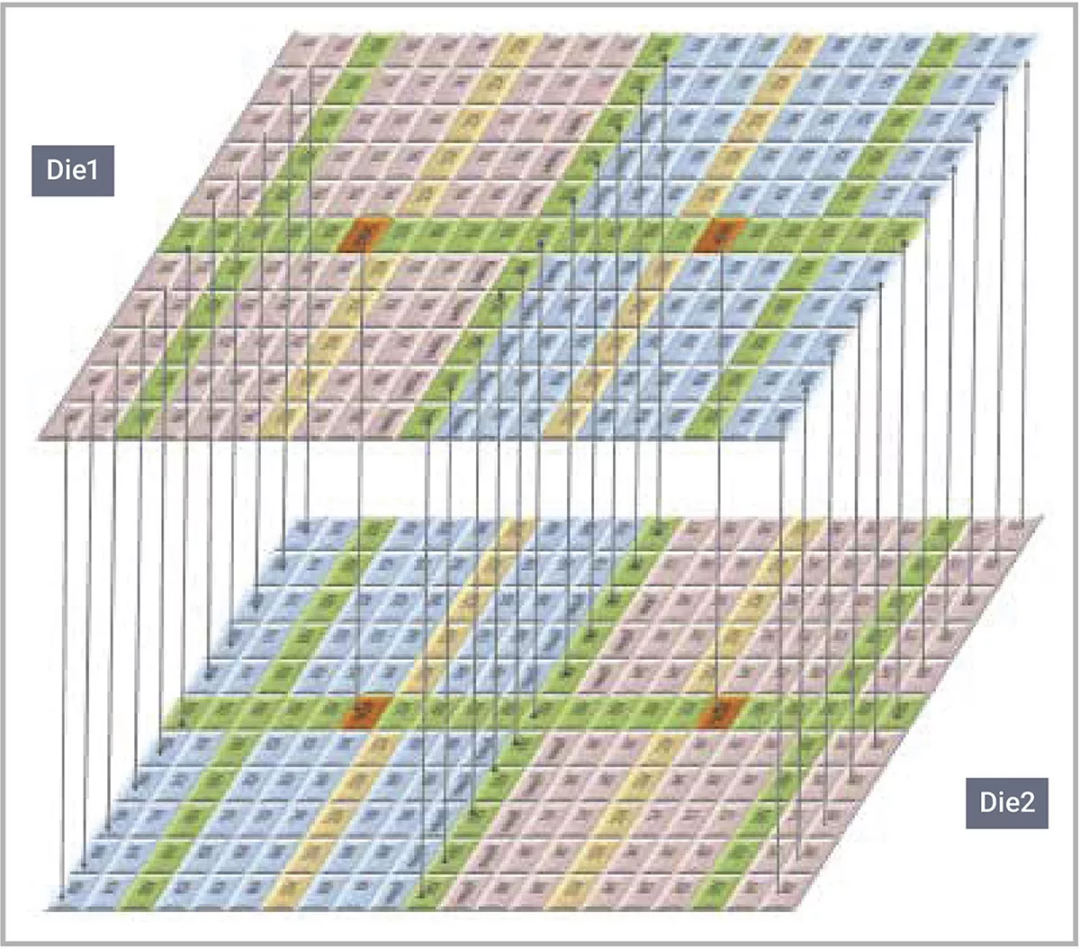
▲圖5新思科技同步3DIO PHY視圖(來(lái)源:同步3DIO PHY橫截面視圖)
結(jié)語(yǔ)
隨著封裝技術(shù)的進(jìn)步和互連密度的增加,給定芯片面積的IO通道顯著增加。相應(yīng)的IO通道長(zhǎng)度減少提高了性能,但也增加了對(duì)更精簡(jiǎn)接口的需求。新思科技 3DIO平臺(tái)為客戶(hù)提供多功能解決方案,以實(shí)現(xiàn)可調(diào)的集成多芯片設(shè)計(jì)結(jié)構(gòu)。新思科技 3DIO平臺(tái)的最優(yōu)面積經(jīng)過(guò)精心設(shè)計(jì),以適應(yīng)BUMPs,在實(shí)現(xiàn)和信號(hào)布線(xiàn)方面提供顯著優(yōu)勢(shì)。在3D堆疊技術(shù)中,用于信號(hào)傳輸?shù)脑赐綍r(shí)鐘設(shè)計(jì)可以幫助客戶(hù)實(shí)現(xiàn)更低的BER并簡(jiǎn)化時(shí)序收斂。新思科技 3DIO平臺(tái)專(zhuān)為多芯片集成而量身定制,使客戶(hù)能夠創(chuàng)建高效的芯片設(shè)計(jì),并加快上市時(shí)間,利用新思科技 3DIC編譯器加速集成并為給定技術(shù)提供優(yōu)化的PPA。除了3DIO平臺(tái)外,新思科技多芯片解決方案還包括UCIe IP和HBM3 IP。
-
soc
+關(guān)注
關(guān)注
38文章
4204瀏覽量
219085 -
封裝技術(shù)
+關(guān)注
關(guān)注
12文章
553瀏覽量
68037 -
新思科技
+關(guān)注
關(guān)注
5文章
807瀏覽量
50424 -
3D封裝
+關(guān)注
關(guān)注
7文章
135瀏覽量
27203
原文標(biāo)題:新思科技3DIO全方位解決方案,推進(jìn)2.5D/3D封裝技術(shù)
文章出處:【微信號(hào):Synopsys_CN,微信公眾號(hào):新思科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
新型2.5D和3D封裝技術(shù)的挑戰(zhàn)
異構(gòu)集成基礎(chǔ):基于工業(yè)的2.5D/3D尋徑和協(xié)同設(shè)計(jì)方法
2.5D/3D芯片-封裝-系統(tǒng)協(xié)同仿真技術(shù)研究
分享一下小芯片集成的2.5D/3D IC封裝技術(shù)
3D封裝與2.5D封裝比較
3D封裝結(jié)構(gòu)與2.5D封裝有何不同?3D IC封裝主流產(chǎn)品介紹

智原推出2.5D/3D先進(jìn)封裝服務(wù), 無(wú)縫整合小芯片
2.5D和3D封裝的差異和應(yīng)用

探秘2.5D與3D封裝技術(shù):未來(lái)電子系統(tǒng)的新篇章!

2.5D/3D封裝技術(shù)升級(jí),拉高AI芯片性能天花板
探秘2.5D與3D封裝技術(shù):未來(lái)電子系統(tǒng)的新篇章
一文理解2.5D和3D封裝技術(shù)

技術(shù)資訊 | 2.5D 與 3D 封裝





 新思科技3DIO平臺(tái)助力2.5D/3D封裝技術(shù)升級(jí)
新思科技3DIO平臺(tái)助力2.5D/3D封裝技術(shù)升級(jí)












評(píng)論