本文介紹了銅互連雙大馬士革工藝的步驟。
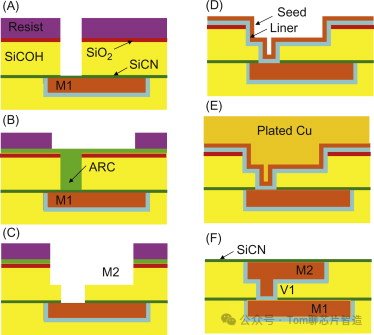
如上圖,是雙大馬士革工藝的一種流程圖。雙大馬士革所用的介質層,阻擋層材質,以及制作方法略有差別,本文以圖中的方法為例。
(A) 通孔的形成 在介質層(如SiCOH)上沉積光刻膠(Resist),并使用光刻工藝做出掩模圖形。通過干法刻蝕手段,得到通孔。
(B)制作溝槽所需的圖形 完成通孔的刻蝕后,通常會去除原來的光刻膠。旋涂抗反射層,并將通孔填滿,之后會再次涂布光刻膠,做出開槽所需的光刻膠圖形。
(C) 開溝槽 干法刻蝕除去多余的抗反射層,介質層等,并去除晶圓表面光刻膠。
(D) 沉積種子層 在刻蝕好的溝槽和通孔內,使用PVD或CVD沉積Cu種子層和阻擋層。Cu種子層用于電鍍的導電材料。阻擋層主要是Ta或TaN,用于防止銅擴散。
(E) 電鍍銅 使用電鍍工藝,將銅填充到通孔和溝槽中。銅完全填滿后,表面會有過量的銅。使用CMP工藝去除多余的銅和種子層,只保留通孔和溝槽中的銅。
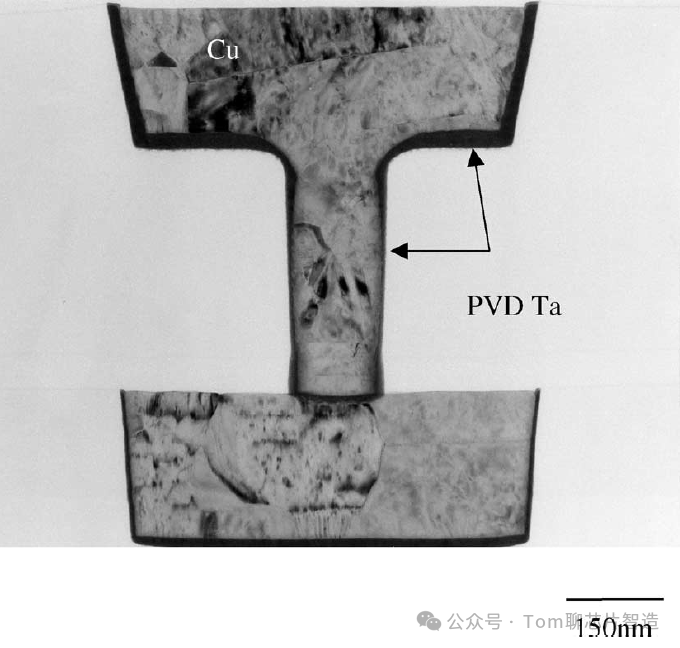
(F)cmp拋光 cmp拋光后,在表面覆蓋阻擋層。
-
電鍍銅
+關注
關注
0文章
26瀏覽量
9035 -
光刻工藝
+關注
關注
1文章
30瀏覽量
1851 -
銅
+關注
關注
0文章
3瀏覽量
1743
原文標題:銅互連雙大馬士革工藝步驟
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦

如何采用銅互連單大馬士革工藝制作超厚金屬銅集成電感的概述
12吋晶圓集成電路芯片制程工藝與工序后端BEOL的詳細資料說明
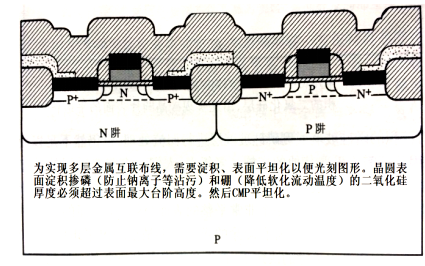
華進半導體專利再次獲評優秀獎
鋁/銅互連工藝與雙鑲嵌法(AL/Cu Interconnect and Dual Damascenes)
半大馬士革集成中引入空氣間隙結構面臨的挑戰

通過工藝建模進行后段制程金屬方案分析

銅互連,尚能飯否?

降低半導體金屬線電阻的沉積和刻蝕技術
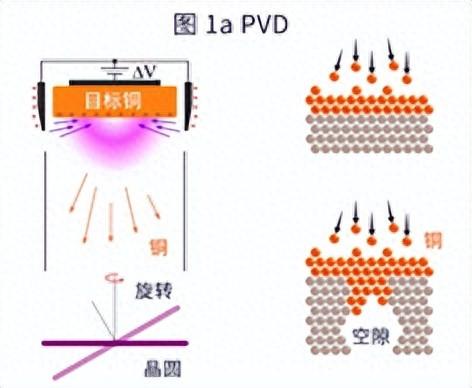
半大馬士革工藝:利用空氣隙減少寄生電容
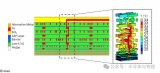
大馬士革銅互連工藝詳解





 銅互連雙大馬士革工藝的步驟
銅互連雙大馬士革工藝的步驟
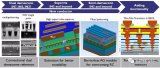
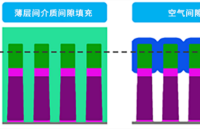

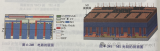










評論