與亞微米工藝類似,側墻工藝是指形成環繞多晶硅的氧化介質層,從而保護LDD 結構,防止重摻雜的源漏離子注入到LDD結構的擴展區。側墻是由兩個主要工藝步驟形成,首先淀積 ONO 結構,再利用各向異性干法刻蝕去除表面的 ONO,最終多晶硅柵側面保留一部分二氧化硅。側墻工藝不需要掩膜版,它僅僅是利用各向異性干法刻蝕的回刻形成的。
1)淀積 ONO 介質層。ONO是二氧化硅,Si3N4和二氧化硅。首先利用LPCVD淀積一層厚度約200~300A的二氧化硅層,它作為Si3N4刻蝕的停止層,另外它也可以作為緩沖層減少 Si3N4對硅的應力。再利用LPCVD 淀積一層厚度約300~400A的Si3N4層,它可以防止柵與源漏的相互漏電。最后一層二氧化硅是利用 TEOS 發生分解反應生成二氧化硅層,厚度約1200A。圖4-200所示為淀積 ONO的剖面圖。
2)側墻刻蝕。利用干法蝕刻去除二氧化硅和Si3N4,刻蝕停在底部的二氧化硅上。因為在柵兩邊的氧化物在垂直方向較厚,在蝕刻同樣厚度的情況下,拐角處留下一些不能被蝕刻的氧化物,因此形成側墻。側墻結構可以保護 LDD 結構,也可以防止柵和源漏之間發生漏電。圖4-201所示為側墻刻蝕的剖面圖。
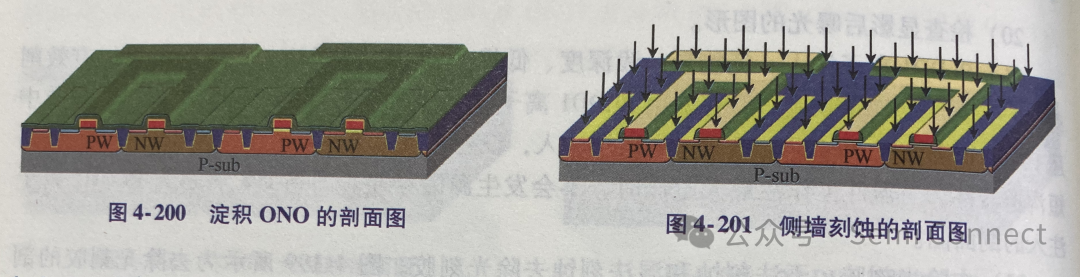
-
集成電路
+關注
關注
5392文章
11622瀏覽量
363177 -
工藝
+關注
關注
4文章
603瀏覽量
28893 -
蝕刻
+關注
關注
9文章
419瀏覽量
15508
原文標題:側墻工藝-----《集成電路制造工藝與工程應用》 溫德通 編著
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
CAD軟件中沿墻鏡像功能的使用技巧
客車鋁型材側窗對接的釬焊工藝
地下連續墻施工中的三點控制
大屏幕電視墻,大屏幕顯示墻的結構組成
杭州DLP電視墻設計和電視墻方案介紹
現代集成電路芯片14nm節點FinFET的制造工藝流程詳細資料說明

設計電視墻有竅門 這樣才是省錢又方便
LED洗墻燈的概念與特點
基于主流的體硅高κ/金屬柵FinFET工藝,提出了一種利用拐角效應





 側墻工藝是什么意思
側墻工藝是什么意思










評論