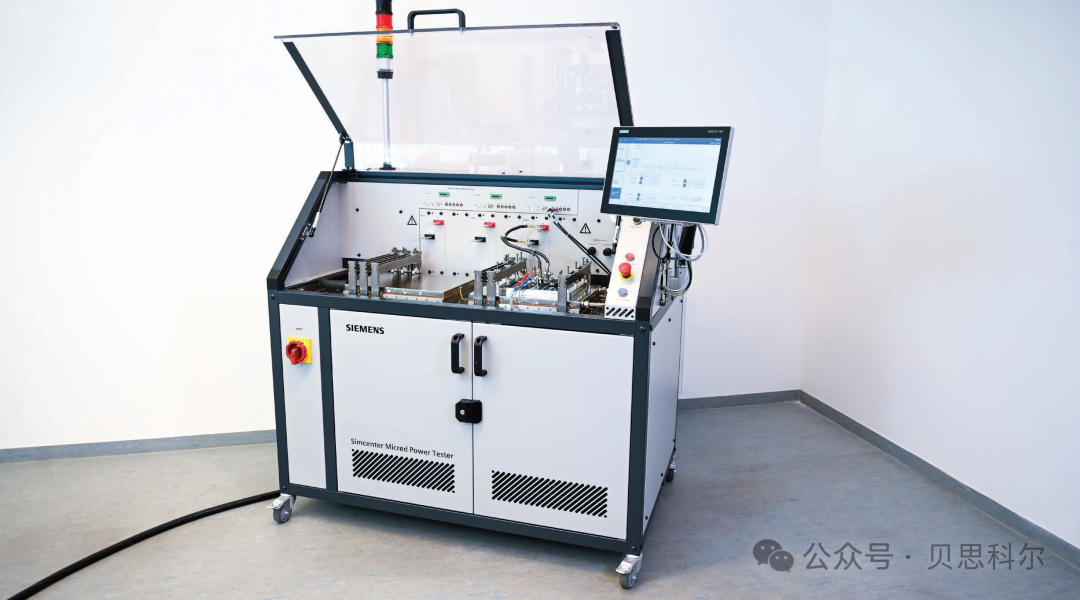
內(nèi)容摘要
消費(fèi)和工業(yè)電子系統(tǒng)的能源需求都在增加。因此,電子電力元器件供應(yīng)商和原始設(shè)備制造商(OEM)面臨著提供航空、電動(dòng)汽車、火車、發(fā)電和可再生能源生產(chǎn)所需的高可靠性系統(tǒng)的挑戰(zhàn)。SimcenterTM MicredTM Power Tester 硬件旨在通過更快地測試和診斷出電力元器件可能的故障原因,幫助應(yīng)對(duì)上述挑戰(zhàn)。下面是兩個(gè)使用絕緣柵雙極晶體管(IGBT)模塊的例子,用以說明如何解決這個(gè)問題。
序言
電力電子元器件(例如金屬氧化物半導(dǎo)體場效應(yīng)晶體管(MOSFET)、二極管、晶體管和IGBT)被廣泛用于各種產(chǎn)生、轉(zhuǎn)換和控制電能的場合。由于消費(fèi)者和工業(yè)應(yīng)用的能源需求不斷增加,功率模塊制造商所面臨的挑戰(zhàn)是要在保持高質(zhì)量和高可靠性的同時(shí),提高最大功率和電流負(fù)載能力。例如,鐵路牽引應(yīng)用的預(yù)期可靠使用壽命為30年,而對(duì)于納入到混合動(dòng)力和電動(dòng)車的功率模塊以及太陽能和風(fēng)力渦輪機(jī)的能量生產(chǎn)系統(tǒng)而言,則要求循環(huán)數(shù)達(dá)到50,000到數(shù)百萬。隨著需求變得越來越緊迫,創(chuàng)新帶來了一些新的技術(shù),例如使用具有增強(qiáng)熱傳導(dǎo)系數(shù)的陶瓷基板和帶式鍵合來取代粗封裝鍵合線,以及使用無焊料芯片粘接技術(shù)來增強(qiáng)模塊的功率循環(huán)能力等等。新的基板有助于降低溫度,載帶可載荷更大的電流,而且無焊料芯片粘接可以是燒結(jié)的銀,具有特別低的熱阻。簡言之,就是對(duì)熱流路徑進(jìn)行了改進(jìn)。但是,這些系統(tǒng)上的熱和熱-機(jī)械應(yīng)力仍然會(huì)造成相關(guān)的功率循環(huán)和散熱故障。這些應(yīng)力可能會(huì)導(dǎo)致很多問題,如封裝鍵合線降級(jí)(圖1)、焊接疲勞、疊層分層、芯片或基板破裂。傳統(tǒng)上用于電源循環(huán)故障測試的過程重復(fù)且耗時(shí)。此過程只能在事后進(jìn)行,并且必須在實(shí)驗(yàn)室中進(jìn)行,以分析封裝的內(nèi)部狀況。
圖1.損壞的IGBT模塊。
使用Simcenter Micred Power Tester
可加快測試和診斷速度
Simcenter Micred Power Tester是罕見的專為制造以及實(shí)驗(yàn)室環(huán)境設(shè)計(jì)的設(shè)備,它能夠在自動(dòng)功率循環(huán)的同時(shí)為正在發(fā)生的故障診斷生成實(shí)時(shí)分析數(shù)據(jù)(圖2)。它用于更快地完成使用壽命測試,并可提高使用電力電子模塊的應(yīng)用系統(tǒng)可靠性。

圖2.Simcenter Micred Power Tester專為半導(dǎo)體制造環(huán)境而設(shè)計(jì)。
Simcenter Micred Power Tester是用于電子元件、發(fā)光二極管(LED)和系統(tǒng)的Simcenter Micred T3STER硬件熱測量和熱特征提取技術(shù)的工業(yè)實(shí)施。Simcenter Micred Power Tester的獨(dú)特功能可以在一臺(tái)機(jī)器上同時(shí)進(jìn)行全自動(dòng)功率測試和循環(huán),而不必在此過程中拆卸下被測器件的設(shè)備。其簡單易用的觸摸屏界面方便技術(shù)人員在生產(chǎn)車間內(nèi)使用,也便于故障分析工程師在實(shí)驗(yàn)室中使用(圖3)。

圖3.Simcenter Micred Power Tester觸摸屏界面(從左到右):主屏幕、器件創(chuàng)建、在冷板上放置器件。
Simcenter Micred Power Tester可以感測電流、電壓和芯片溫度,并使用結(jié)構(gòu)函數(shù)分析來記錄封裝結(jié)構(gòu)中的變化或故障,這是分析MOSFET、IGBT和通用雙極器件的首選。機(jī)器可用于增強(qiáng)和加速封裝開發(fā)、可靠性測試,以及在生產(chǎn)前對(duì)輸入的元件進(jìn)行批量檢查。
在運(yùn)行功率循環(huán)的過程中,實(shí)時(shí)結(jié)構(gòu)函數(shù)分析顯示正在發(fā)生的故障、循環(huán)數(shù)和產(chǎn)生故障的原因,省去事后去實(shí)驗(yàn)室分析的麻煩。不再需要在多個(gè)樣品上進(jìn)行耗時(shí)的循環(huán)測試以估計(jì)降級(jí)對(duì)應(yīng)的循環(huán)數(shù)范圍。也沒有必要在該范圍內(nèi)額外增加熱測量次數(shù)來確定捕獲的降級(jí)真實(shí)存在。被測器件只需安裝連接一次,相關(guān)循環(huán)和配置從一開始即可進(jìn)行定義。
使用Simcenter Micred Power Tester,電力電子產(chǎn)品供應(yīng)商能夠?yàn)槠淇蛻粼O(shè)計(jì)出更可靠的電力電子封裝,并能提供可靠性規(guī)范。元器件設(shè)計(jì)人員和制造商能夠驗(yàn)證供應(yīng)商的可靠性規(guī)范和鑒定封裝的可靠性。負(fù)責(zé)設(shè)計(jì)和制造需要具有長期高可靠性產(chǎn)品的人員將能夠在系統(tǒng)級(jí)別進(jìn)行測試。
Simcenter Micred Power Tester旨在遵循聯(lián)合電子器件工程委員會(huì)(JEDEC)標(biāo)準(zhǔn)JESD51-1靜態(tài)測試方法。系統(tǒng)可以根據(jù)捕獲到的瞬態(tài)響應(yīng),自動(dòng)生成相應(yīng)的結(jié)構(gòu)函數(shù)。結(jié)構(gòu)函數(shù)提供通過熱阻和熱電容表示的熱傳導(dǎo)路徑的等效模型,這些模型可用于檢測結(jié)構(gòu)失效或捕捉熱傳導(dǎo)路徑中的局部熱阻。Simcenter Micred Power Tester還支持JEDEC標(biāo)準(zhǔn)JESD51-14瞬態(tài)雙界面測量以確定RthJC。組合的功率循環(huán)的過程和Rth測量模式會(huì)在使用功率循環(huán)的器件上產(chǎn)生應(yīng)力、在循環(huán)期間定期測量Rth、監(jiān)控系統(tǒng)參數(shù)(例如電壓和電流),以及自動(dòng)增加Rth測量頻率。
Simcenter Micred Power Tester生成的測試和特征提取數(shù)據(jù)可用于在熱仿真軟件Simcenter Flotherm和Simcenter FLOEFD中對(duì)詳細(xì)模型進(jìn)行校準(zhǔn)和驗(yàn)證。Simcenter是Siemens Xcelerator軟硬件和服務(wù)業(yè)務(wù)平臺(tái)的一部分。
示例:通過循環(huán)使用壽命測試IGBT模塊
電子電力模塊及其相關(guān)組件和系統(tǒng)的設(shè)計(jì)人員必須確保芯片和基板之間的熱阻盡可能地低,必須創(chuàng)建可靠的鍵合并確保芯片粘接層在產(chǎn)品的使用壽命內(nèi)能夠承受極大的熱載荷。最大載荷循環(huán)數(shù)和器件溫度/載荷條件之間的關(guān)系必須賦能較為準(zhǔn)確地估算功率模塊的使用壽命。
隨著純電動(dòng)和混合動(dòng)力車輛的問世,IGBT器件在相互作用和高壓變流器應(yīng)用領(lǐng)域已占據(jù)龍頭地位,而各種結(jié)點(diǎn)中散發(fā)的熱量對(duì)這些元器件的可靠性會(huì)有很大影響。工作過程中的高結(jié)溫和高溫度梯度會(huì)引起機(jī)械應(yīng)力,尤其是在具有不同熱膨脹系數(shù)的材料之間的接觸面上,而這可能導(dǎo)致降級(jí)甚至完全失效。
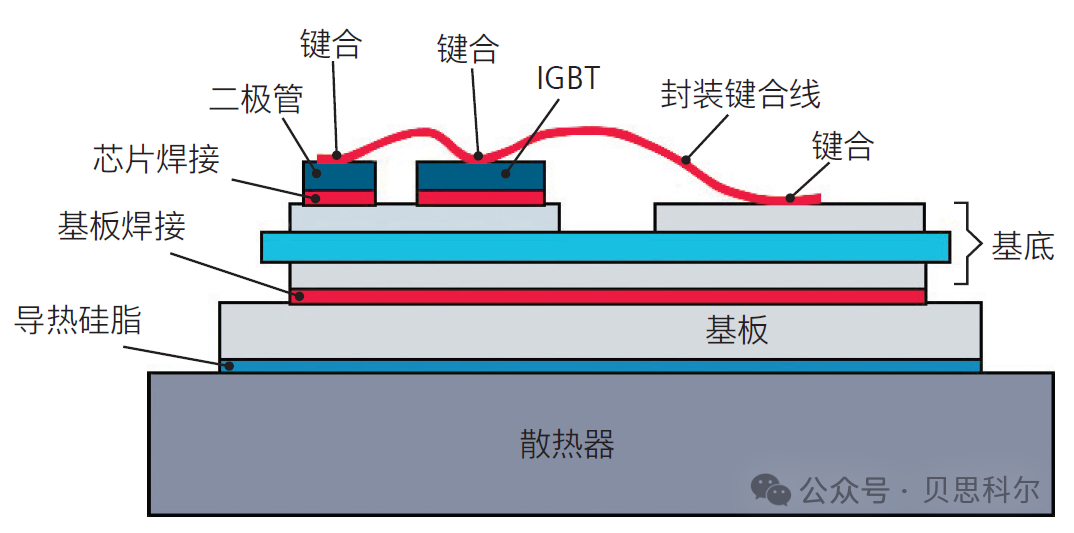
圖4.IGBT模塊的橫截面。
我們對(duì)四個(gè)包含兩個(gè)半橋的中功率IGBT模塊進(jìn)行了測試,以證明可以通過元器件的自動(dòng)功率循環(huán)獲得豐富數(shù)據(jù)。這些模塊被固定在Simcenter Micred Power Tester中集成的冷板上(采用液冷散熱),用一塊高熱導(dǎo)率導(dǎo)熱墊來盡量減小界面間的熱阻。使用由Simcenter Micred Power Tester控制的冷凍循環(huán)器,在整個(gè)實(shí)驗(yàn)過程中,冷板溫度保持在25攝氏度(°C)。
將器件的柵極連接到器件的漏極(即所謂的“放大二極管設(shè)置”),同時(shí)各個(gè)半橋使用單獨(dú)的驅(qū)動(dòng)電路供電。兩個(gè)電流源分別連接到相應(yīng)的半橋。使用一個(gè)可以快速開關(guān)的高電流源對(duì)這些器件施加階躍式功率變化。另外使用一個(gè)低電流電源為IGBT提供連續(xù)偏壓,這樣可在加熱電流關(guān)閉時(shí)測量器件溫度。
在第一組測試中,我們采用恒定的加熱和冷卻時(shí)間分別測試了四個(gè)樣品。選擇的加熱和冷卻時(shí)間分別是加熱3秒鐘和冷卻10秒鐘,在200瓦(W)功率條件下將初始溫度波動(dòng)保持在100°C左右。這樣的測試設(shè)置可以最貼切地模擬實(shí)際應(yīng)用環(huán)境,在此環(huán)境中,熱結(jié)構(gòu)的降級(jí)會(huì)導(dǎo)致結(jié)溫升高,進(jìn)而加速器件老化。
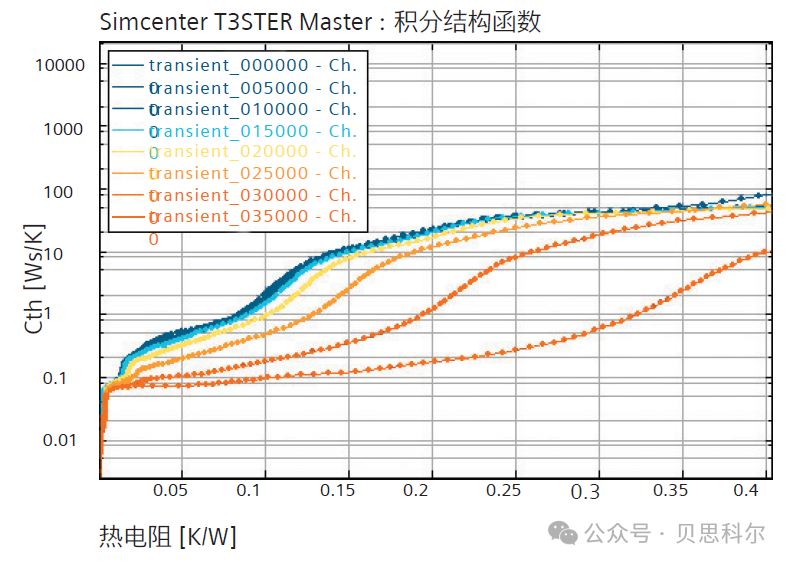
圖5.樣品0在不同時(shí)間點(diǎn)的控制測量值對(duì)應(yīng)的結(jié)構(gòu)函數(shù)。
在這四個(gè)器件中,樣品3在經(jīng)過10,000次循環(huán)后不久便失效了,遠(yuǎn)遠(yuǎn)早于其他樣品。樣品0、1和2持續(xù)時(shí)間較長,分別在經(jīng)過40,660、41,476和43,489次功率循環(huán)后失效。圖5顯示了通過瞬態(tài)熱測試(每隔5,000個(gè)循環(huán)對(duì)樣品0執(zhí)行一次測量)生成的結(jié)構(gòu)函數(shù)。0.08瓦特秒/開爾文(Ws/K)處的平坦區(qū)域?qū)?yīng)于芯片貼裝。該結(jié)構(gòu)在15,000次循環(huán)之前是穩(wěn)定的,但過了這個(gè)點(diǎn)之后,隨著熱阻持續(xù)增大,芯片粘接層出現(xiàn)明顯降級(jí),直至器件失效。導(dǎo)致器件失效的直接原因仍舊不明,但我們發(fā)現(xiàn),柵極和射極之間形成了短路,而且在芯片表面可以看到一些焦斑。
第二組測試使用完全相同的樣品,但采用由Simcenter Micred Power Tester支持的不同功率策略。模塊中的兩個(gè)半橋安裝在同一基板的不同基底上。三個(gè)器件均采用兩種封裝進(jìn)行了測試,其中被測器件中的IGBT1和IGBT3屬于同一模塊,但位于不同的半橋。
我們對(duì)IGBT1保持恒定的電流,對(duì)IGBT2保持恒定的加熱功率,對(duì)IGBT3保持恒定的結(jié)溫變化。選擇的設(shè)置能夠?yàn)樗衅骷峁┫嗤某跏冀Y(jié)點(diǎn)溫升,即對(duì)每個(gè)器件加熱3秒鐘和冷卻17秒鐘,初始加熱功率約240W,確保對(duì)比結(jié)果公平公正。對(duì)每個(gè)器件分別測量了所有循環(huán)中全部的加熱和冷卻瞬態(tài)變化,并由Simcenter Micred Power Tester對(duì)下列電學(xué)參數(shù)和熱學(xué)參數(shù)進(jìn)行了持續(xù)監(jiān)測:
開啟加熱電流時(shí)的器件電壓
上一循環(huán)中施加的加熱電流
功率階躍
關(guān)閉加熱電流之后的器件電壓
開啟加熱電流之前的器件電壓
上一功率循環(huán)期間的最高結(jié)溫
上一循環(huán)中的溫度波動(dòng)
使用加熱功率進(jìn)行標(biāo)準(zhǔn)化處理后的溫度變化
在使用10-A完成每250個(gè)循環(huán)后,測量從通電穩(wěn)態(tài)到斷電穩(wěn)態(tài)之間的全程熱瞬態(tài)變化,以創(chuàng)建結(jié)構(gòu)函數(shù)來研究熱量累積中的任何降級(jí)。同樣,持續(xù)進(jìn)行實(shí)驗(yàn),直到所有IGBT失效。
不出所料,IGBT1最先失效,因?yàn)樵谄骷导?jí)過程中我們沒有對(duì)供電功率進(jìn)行任何調(diào)節(jié)。有趣的是,在該熱結(jié)構(gòu)中,它沒有顯示出任何降級(jí)(圖6)。
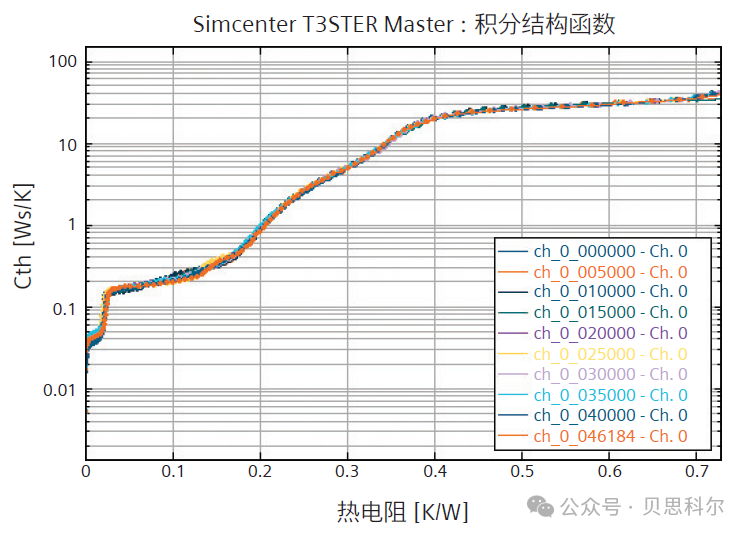
圖6.IGBT1在功率循環(huán)期間的結(jié)構(gòu)函數(shù)變化。
我們對(duì)實(shí)驗(yàn)過程中的器件電壓變化進(jìn)行了檢查。圖7顯示了IGBT1在加熱電流水平的正向電壓視為已經(jīng)歷的功率循環(huán)次數(shù)的函數(shù)。在前3000次循環(huán)中,可以觀察到電壓處于下降趨勢(shì)。導(dǎo)致初期這一變化的原因主要是器件平均溫度變化相對(duì)緩慢(只下降了5°C)。盡管器件電壓的溫度依賴性在電流低時(shí)呈現(xiàn)負(fù)特性,但在大電流水平下,正向電壓的溫度依賴性已變?yōu)檎怠?/p>

圖7.IGBT1在加熱電流水平的正向電壓與已應(yīng)用的功率循環(huán)數(shù)之間的關(guān)系。
在經(jīng)過約35,000次循環(huán)后,這一趨勢(shì)發(fā)生了變化,電壓開始緩慢升高。之后,器件電壓出現(xiàn)階躍式變化,同時(shí),上升趨勢(shì)持續(xù)加快,直至最終器件失效。電壓的增大可歸因于封裝鍵合線的降級(jí),因?yàn)榻Y(jié)構(gòu)函數(shù)并沒有變化,這也解釋了在封裝鍵合線最終脫落時(shí)電壓出現(xiàn)的階躍式變化。電壓階躍高度的持續(xù)增加是隨著封裝鍵合線數(shù)量的減少,封裝鍵合線并聯(lián)電阻的不斷增大引起的。如果采用恒定電流的策略,封裝鍵合線的斷裂會(huì)增加剩余鍵合線中的電流密度,并且加速老化。

圖8.IGBT3在加熱電流水平的正向電壓與已應(yīng)用的功率循環(huán)數(shù)之間的關(guān)系。
圖8顯示了IGBT3對(duì)應(yīng)的同類型曲線,其中,器件電壓轉(zhuǎn)為增長趨勢(shì)的時(shí)間甚至更早,但由于通過調(diào)節(jié)加熱電流保持了結(jié)溫恒定,因此加熱電流也按比例相應(yīng)地減小了。電流的降低減少了鍵合線的負(fù)載,延長了測得的壽命。
上述兩組實(shí)驗(yàn)展示了不同的失效模式,并說明了不同的功率策略以及電氣設(shè)置對(duì)失效模式可能產(chǎn)生的影響。第一組實(shí)驗(yàn)采用恒定循環(huán)時(shí)間,更貼切地反映了運(yùn)行應(yīng)用情況,證實(shí)了Simcenter Micred Power Tester能夠快速檢測出器件結(jié)構(gòu)(包括芯片貼裝和其他受損層)內(nèi)出現(xiàn)的退化現(xiàn)象。
第二組實(shí)驗(yàn)清楚地證明封裝鍵合線出現(xiàn)了降級(jí)現(xiàn)象,因?yàn)槲覀冇^察到器件的正向電壓出現(xiàn)了階躍式升高,但對(duì)于不同的供電選項(xiàng)(恒定電流、恒定加熱功率和恒定溫升),所有測試樣品的熱結(jié)構(gòu)函數(shù)都沒有發(fā)生變化。當(dāng)然,由于樣品數(shù)量較少,所以只能做出比較保守的結(jié)論。但是,在Simcenter Micred Power Tester實(shí)驗(yàn)中也可以發(fā)現(xiàn),測量結(jié)果可能因循環(huán)策略的不同而有所差異,基于某些策略而預(yù)測的功率器件使用壽命可能會(huì)高于其實(shí)際的使用壽命。
結(jié)語
可靠性是采用大功率電子產(chǎn)品的眾多行業(yè)關(guān)注的首要問題,對(duì)于元器件供應(yīng)商、系統(tǒng)供應(yīng)商和OEM而言,對(duì)這些模塊進(jìn)行壽命期內(nèi)循環(huán)測試是必不可少的。Simcenter Micred Power Tester可為模塊供電以經(jīng)受數(shù)萬次(甚至數(shù)百萬次)的循環(huán),同時(shí)提供實(shí)時(shí)進(jìn)行中的故障診斷。
從上面的例子中可以看出,Simcenter Micred Power Tester可用于輕松、清晰地識(shí)別由芯片粘接退化或鍵合線損壞引起的故障模式。這可顯著減少測試和實(shí)驗(yàn)室診斷時(shí)間,也無需進(jìn)行失效后分析或破壞性失效分析。
-
測試
+關(guān)注
關(guān)注
8文章
5375瀏覽量
127061 -
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27703瀏覽量
222628 -
高功率
+關(guān)注
關(guān)注
1文章
193瀏覽量
18449
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
LabVIEW在齒輪箱故障診斷中的應(yīng)用
復(fù)雜電子裝備潛隱性故障診斷關(guān)鍵技術(shù)研究
【下載】《模擬電路故障診斷》
GaN可靠性的測試
基于電流測試的混合電路故障診斷
GaN HEMT可靠性測試:為什么業(yè)界無法就一種測試標(biāo)準(zhǔn)達(dá)成共識(shí)
碳化硅功率器件可靠性之芯片研發(fā)及封裝篇
使用工業(yè)級(jí)熱特征提取方法提高大功率半導(dǎo)體的測試與故障診斷速度
使用工業(yè)級(jí)熱特征提取方法提高大功率半導(dǎo)體的測試與故障診斷速度
半導(dǎo)體可靠性測試有哪些

使用工業(yè)級(jí)熱特征提取方法提高大功率半導(dǎo)體的測試與故障診斷速度

龍騰半導(dǎo)體建有功率器件可靠性與應(yīng)用實(shí)驗(yàn)中心

半導(dǎo)體封裝的可靠性測試及標(biāo)準(zhǔn)介紹





 提升高功率半導(dǎo)體可靠性——使用Simcenter通過工業(yè)級(jí)熱表征加速測試和故障診斷
提升高功率半導(dǎo)體可靠性——使用Simcenter通過工業(yè)級(jí)熱表征加速測試和故障診斷










評(píng)論