荷蘭媒體 Bits&Chips 日前爆料,ASML 正探討推出通用 EUV 光刻平臺的可能性。該公司首席技術官、現擔任顧問的馬丁?范登布林克(Martin van den Brink)于最近召開的 imec ITF World 技術論壇發(fā)表講話時透露,ASML 計劃在未來十年內打造一個集成 Low NA(0.33NA)、High NA(0.55NA)以及預計達到 0.7NA 的 Hyper NA 系統的單一平臺。
范登布林克指出,更高的數值孔徑能提高光刻分辨率。他進一步解釋說,Hyper NA 光刻機將簡化先進制程生產流程,避免因使用 High NA 光刻機進行雙重圖案化導致的額外步驟及風險。
他強調,共享同一基礎平臺的多種 EUV 光刻機會降低研發(fā)成本,并方便將 Hyper-NA 機臺的技術進步推廣至數值孔徑較小的光刻機。據悉,ASML 最新款 0.33NA EUV 光刻機 NXE:3800E 已采用為 High NA 光刻機設計的高速載物臺移動系統。
此外,ASML 計劃將其 DUV 和 EUV 光刻機的晶圓吞吐量由目前的每小時 200~300 片提升至每小時 400~500 片,以提高單臺光刻機的生產效率,進而降低行業(yè)成本。
范登布林克在演講中還提及,當前人工智能的發(fā)展趨勢顯示,消費者對多樣化應用有強烈需求,但受限于能耗、計算能力和海量數據集等因素。
-
分辨率
+關注
關注
2文章
1072瀏覽量
42037 -
光刻機
+關注
關注
31文章
1157瀏覽量
47583 -
EUV
+關注
關注
8文章
608瀏覽量
86146 -
ASML
+關注
關注
7文章
720瀏覽量
41351
發(fā)布評論請先 登錄
相關推薦
光刻機巨頭ASML業(yè)績暴雷,芯片迎來新一輪“寒流”?
日本首臺EUV光刻機就位
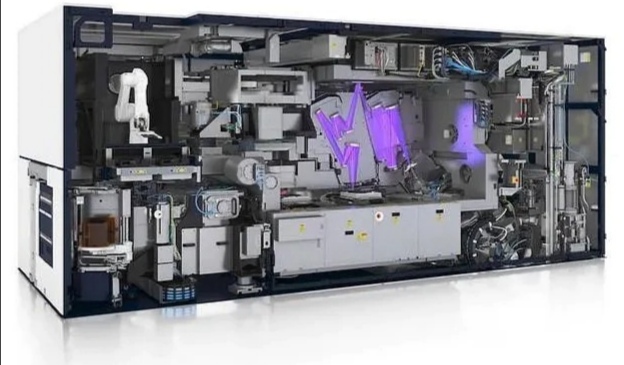
日本大學研發(fā)出新極紫外(EUV)光刻技術
ASML擬于2030年推出Hyper-NA EUV光刻機,將芯片密度限制再縮小
阿斯麥(ASML)與比利時微電子(IMEC)聯合打造的High-NA EUV光刻實驗室正式啟用
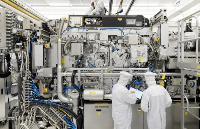
阿斯麥和IMEC聯合光刻實驗室啟用
后門!ASML可遠程鎖光刻機!
臺積電張曉強:ASML High-NA EUV成本效益是關鍵
臺積電未確定是否采購阿斯麥高數值孔徑極紫外光刻機
ASML發(fā)貨第二臺High NA EUV光刻機,已成功印刷10nm線寬圖案
英特爾率先推出業(yè)界高數值孔徑 EUV 光刻系統
英特爾突破技術壁壘:首臺商用High NA EUV光刻機成功組裝
阿斯麥(ASML)公司首臺高數值孔徑EUV光刻機實現突破性成果

ASML 首臺新款 EUV 光刻機 Twinscan NXE:3800E 完成安裝





 ASML考慮推出通用EUV光刻平臺
ASML考慮推出通用EUV光刻平臺










評論