準確、高效的仿真模型是完成虛擬仿真、實現精確設計、指導實際應用等功能的重要基礎。在電力電子電能變換領域 不同設計階段和應用背景下,對仿真模型的特性、精度和仿真速度有著不同要求。因此,根據需求提供滿足一定要求的仿真模型是建模工作的關鍵。
本文在于研究用 ANSYS icepak/Flotherm建模的時候,主要探討對芯片等材料屬性的選取與設置,以及本體模型如何構建。文中給出相關材料屬性的方法探討也同樣適用于其他CAE軟件的建模。
在利用Flotherm或者Ansys Icepak等軟件對電子產品進行熱仿真時,一個避免不了話題就是如何對各種各樣的芯片進行建模,這主要是因為芯片種類眾多,而且內部結構相當復雜。
工程師通常無法獲得芯片內部的具體結構信息,只能草草的按芯片的外形尺寸畫一個BLOCK了事。實際上,業界對此已有應對措施,這就是Compact thermal modeling-壓縮熱模型。
本文將詳細介紹元件的方塊模型,詳細模型和壓縮熱模型,講解如何在熱仿真中使用這三種模型。
元件模型分類
在熱仿真中,按照元件的建模方式,可以將元件模型分為三類,這就是方塊模型,詳細模型和壓縮熱模型。其中,壓縮模型又可以分為雙熱組模型和Delphi模型,如下圖所示。

方塊模型
方塊模型,英文寫作Cuboid,是熱仿真中最簡單的元件模型。顧名思義,即以一個與元件外形尺寸一致的方塊來代替元件,然后為此元件賦予一個集總的熱傳導系數和熱損耗來進行熱仿真,如下圖所示。

方塊模型的優點:
模型簡單,建模速度快
網格少
可以用于估計模型周圍的空氣溫度和PCB溫度
方塊建模的缺點:
無法得到元件結溫
需要估計模型集總熱傳導系數
元件溫度仿真精度不高
通過上面方塊模型的優缺點分析,我們可以得知,當一個芯片的損耗較小,發熱不是很嚴重時,且對其結溫不是很關心時,可以選擇方塊模型來進行建模。對于芯片模型的熱傳導系數,建議采用軟件材料庫內的材料,如果材料庫沒有對應的元件封裝,則建議塑膠封裝按5W/mK,陶瓷封裝按20W/mK來進行設置。如果在熱仿真中發現該方塊模型的溫度比較高,則建議采用其它建模方式來進行建模。
詳細模型
詳細模型,英文寫作Detail thermal model,很多文獻里簡稱為DTM,即Detail thermal model的縮寫。詳細模型理解起來很簡單,即按照芯片元件的外部和內部的詳細尺寸,材料建立元件模型。下圖為一QFN芯片的詳細模型與實物的對比。
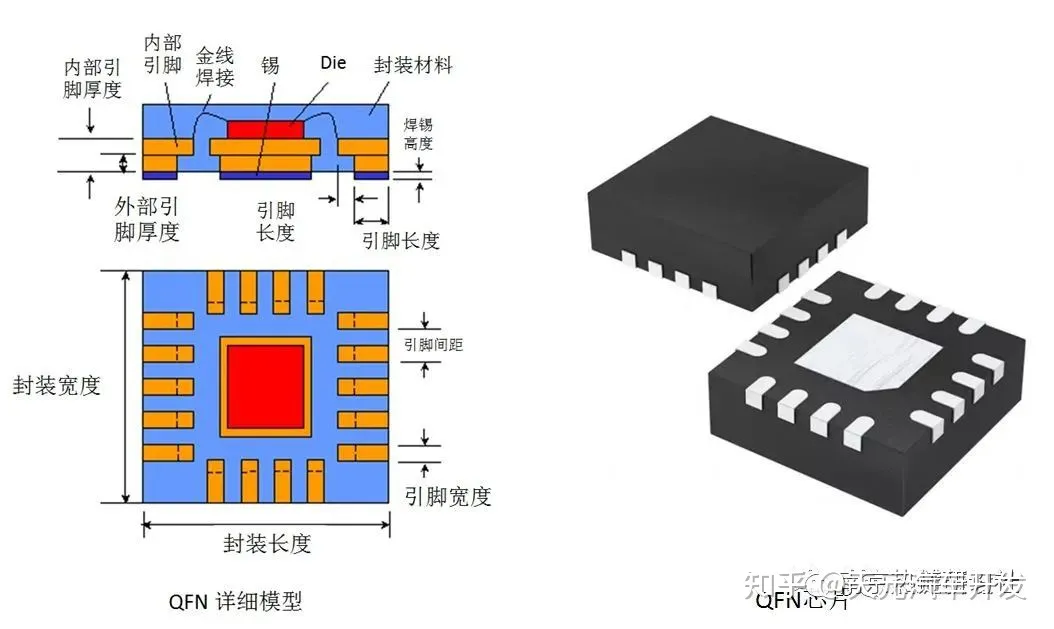
詳細模型優點:
仿真精度高
可以得到精確的結溫
可以得到精確的殼溫
詳細模型缺點:
由于芯片廠商怕泄露芯片設計,模型內部結構難以甚至不可能得到
網格非常多
通過上面的詳細模型優缺點分析,我們可以得知,雖然詳細模型的仿真精度非常高,但是由于對于系統里的仿真來說,非常難以得到芯片的內部結構信息,對于系統級的仿真來說,并不適用。通常情況下來說,僅適用芯片生產廠家使用。
壓縮熱模型
如前所述,由于方塊模型的仿真精度不高,且無法得到模型結溫,而詳細模型雖然精度高且可以得到結溫,但是對于系統級的仿真來說,又通常難以得到芯片內部結構。
有鑒于此,業界提出了壓縮熱模型這一概念并制定了相關的標準。壓縮熱模型,英語寫作Comapct thermal model,通常簡寫為CTM。壓縮熱模型這一概念是在熱阻模型的基礎上產生的,其定義如下:
元件封裝內包括一個完整的電路,且其溫度可以由內部一結點的溫度來代替,即我們通常說的元件結溫
元件安裝于PCB板上
元件內部產生的熱從元件內部流到:
元件上表面,再經過元件上表面流到空氣中或者散熱器中
元件側面
元件底面或者元件引腳,再通過元件底面和引腳流到PCB上
利用熱阻網絡來表示熱流途徑
元件每個外表面可以視作一個溫度結點,或者可以將每個外表面細分為多個溫度結點
在仿真實際中,通常根據JEDEC15標準,將壓縮熱模型分為雙熱阻模型和Delphi多熱阻模型。
雙熱阻模型
雙熱阻模型,英文為2 Resistances,簡寫為2R。在雙熱阻模型中,假定元件工作時產生的熱僅會從元件上表面和元件底面或者引腳傳出,不會從元件側面傳出。因此,可以使用元件結點到殼結點的熱阻和元件結點到PCB板的熱阻來建立元件模型。雙熱阻模型示意圖如下圖所示。
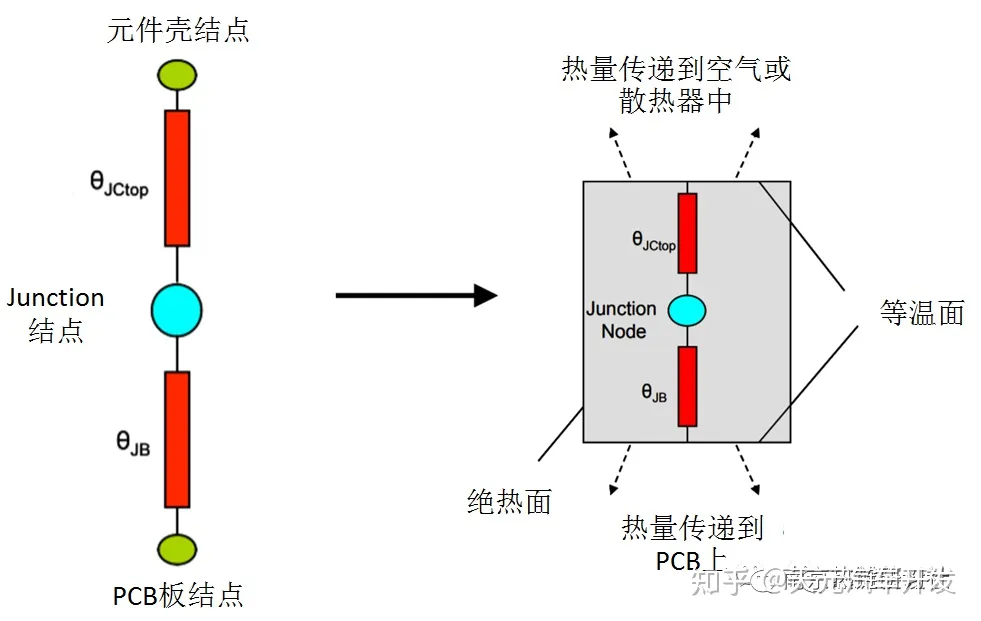
假設一塊PCB板上僅有一個元件,則當使用雙熱阻模型來對此元件進行建模時,其熱傳遞途徑如下圖所示,從圖中我們可以清晰的看出,元件結點到殼結點的熱阻和元件結點到PCB板的熱阻兩者之間為并聯關系。
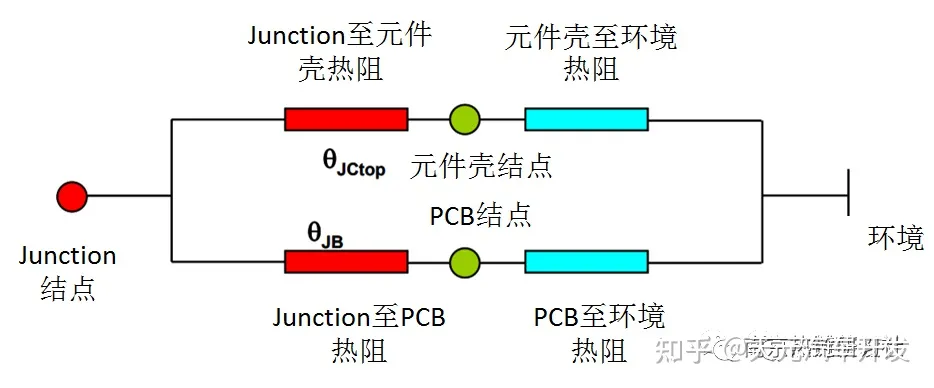
雙熱阻模型優點:
模型簡單
網格少
模型參數比較少,僅兩個,且容易得到,部分可以從芯片規格書查知或者直接向廠家索取
對于模型周圍的空氣溫度和PCB溫度,仿真精度比方塊模型高
可以得到結溫
雙熱阻模型缺點:
由于忽視了元件側面,引腳等較多的的熱傳遞途徑,仿真精度在某些情況下達不到要求
通過上面的分析,可以得出以下結論,雙熱阻模型仿真精度比方塊模型高,但是與芯片真實散熱情況還有距離。在系統級的仿真中,可以利用雙熱阻模型得到精確的芯片周圍空氣溫度和PCB板溫度,以及不是那么精確的結溫,其結溫誤差最大可達20%。
Delphi模型
Delphi模型,有時也稱之為Multi Resistances模型,即多熱阻模型。與雙熱阻模型相比,多熱阻模型增加了更多的節點,可以考慮更多的散熱途徑。下圖為一QFP芯片的Delphi模型,在此模型中,除了考慮元件頂面和底面的熱傳遞外,還增加了元件引腳到PCB的熱阻,同時更將芯片頂面和底面分為內部節點和外部節點,增加了元件結點到它們的熱阻值。
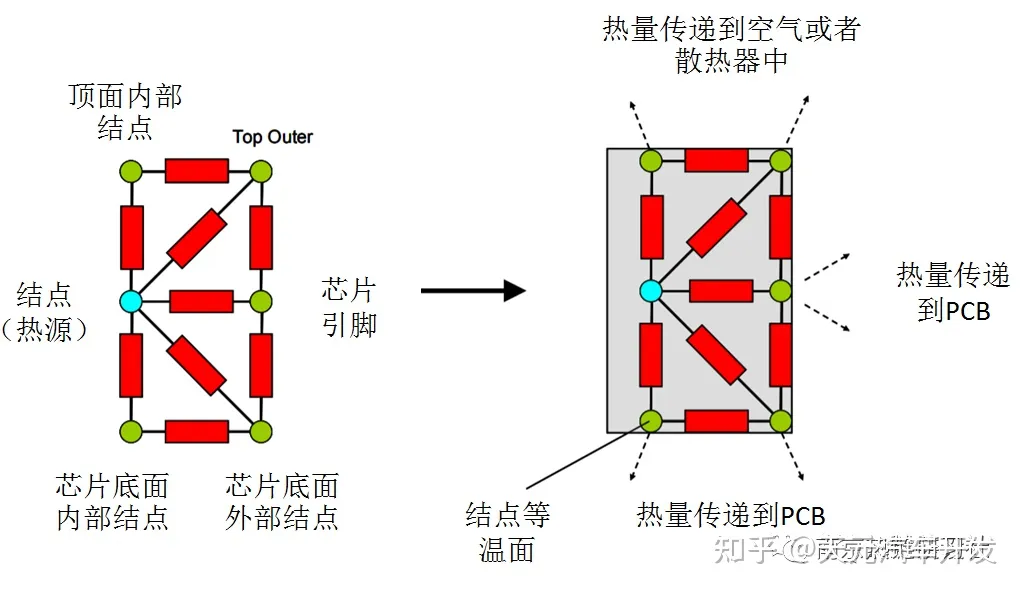
下圖為另一QFP模型的結點示意圖。
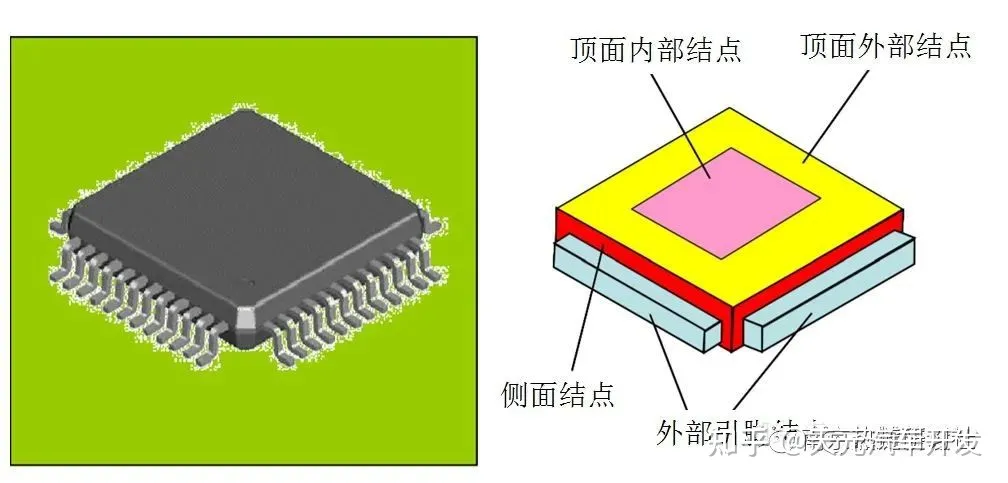
Delphi模型優點:
模型簡單
網格少
對于模型周圍的空氣溫度和PCB溫度,仿真精度比2R模型高
可以得到準確的結溫
Delphi模型缺點
需要輸入的熱阻參數較多,且不可能從芯片規格書查知,需要向廠家索取
使用Delphi模型,可以得到比較準確的元件結溫和模型周圍的空氣溫度以及PCB溫度,因此,在條件允許的情況下,應盡量向廠家索取Delphi模型或者熱阻值以進行仿真。
審核編輯 黃宇
-
芯片
+關注
關注
456文章
51170瀏覽量
427244 -
建模
+關注
關注
1文章
313瀏覽量
60854 -
CAE
+關注
關注
0文章
77瀏覽量
23498 -
熱仿真
+關注
關注
0文章
20瀏覽量
7229
發布評論請先 登錄
相關推薦
如何通過等效串聯電阻(ESR)和等效串聯電感(ESL)來優化熱回路布局設計
Simcenter FLOEFD 熱仿真分析軟件

使用PSpice仿真器對TI智能高側開關中的熱行為進行建模





 CAE熱仿真中的芯片物性等效建模方法分析
CAE熱仿真中的芯片物性等效建模方法分析





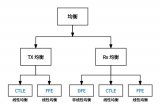










評論