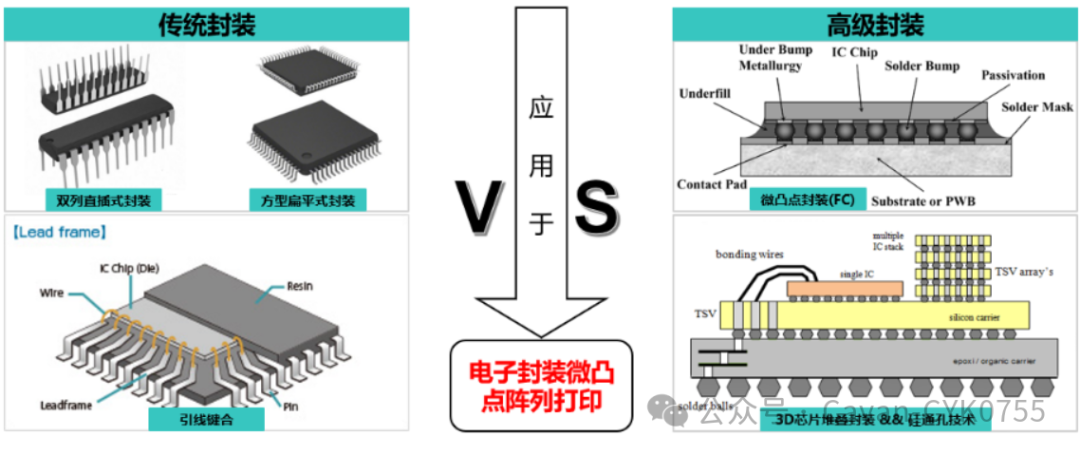 倒裝芯片技術,也被稱為FC封裝技術,是一種先進的集成電路封裝技術。在傳統封裝技術中,芯片被封裝在底部,并通過金線連接到封裝基板上。而倒裝芯片技術則將芯片直接翻轉并安裝在封裝基板上,然后使用微小的焊點或導電膠水進行連接。
倒裝芯片技術,也被稱為FC封裝技術,是一種先進的集成電路封裝技術。在傳統封裝技術中,芯片被封裝在底部,并通過金線連接到封裝基板上。而倒裝芯片技術則將芯片直接翻轉并安裝在封裝基板上,然后使用微小的焊點或導電膠水進行連接。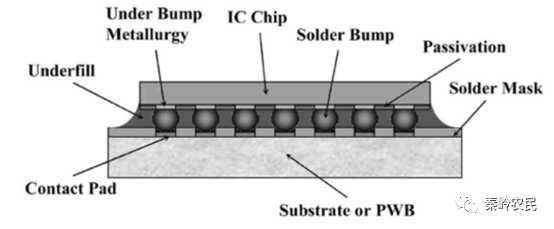 圖1 倒裝芯片封裝基本結構
圖1 倒裝芯片封裝基本結構
倒裝芯片技術優勢:尺寸更小:相比傳統封裝技術,倒裝芯片技術更加緊湊,可以顯著減小電子產品的尺寸和厚度。
電性能更好:倒裝芯片技術可以縮短電信號傳輸距離,減少電阻、電感等不良影響,提高芯片的電性能。
散熱更佳:由于芯片直接與封裝基板接觸,倒裝芯片技術可以更好地散熱,提高芯片的穩定性和可靠性。
抗沖擊性強:倒裝芯片技術中的芯片與封裝基板緊密結合,具有更高的抗沖擊性,對于移動設備和工業應用等領域具有重要意義。成本更低:倒裝芯片技術可以簡化封裝流程,減少所需材料和設備,降低生產成本。倒裝芯片技術雖然具有許多優點,但也存在一些潛在的缺點:
設計困難:倒裝芯片技術需要在設計階段考慮封裝布局和連接方式,這增加了設計復雜性和挑戰性。芯片和封裝基板之間的連接方式需要精確控制,以確保可靠性和穩定性。
成本較高:倒裝芯片技術在生產過程中需要更高級別的設備和技術,以確保倒裝芯片的準確安裝和連接。這可能導致制造成本的增加,尤其對于規模較小的生產批量而言。
散熱管理挑戰:倒裝芯片技術中,翻轉的芯片直接與封裝基板接觸,散熱困難較大。由于倒裝芯片的背面無法自由散熱,需要采取額外的散熱措施來保持芯片的溫度穩定,否則可能出現過熱的問題。
機械脆弱性:由于倒裝芯片技術中芯片直接暴露在外,容易受到機械應力和物理損傷的影響。這可能導致芯片的可靠性和壽命下降,特別是在受到震動、沖擊和彎曲等力量作用時。
可維修性差:倒裝芯片技術中,芯片直接連接在封裝基板上,一旦出現故障,更換或維修芯片將更加困難。這可能導致維修成本的增加,并且對于一些應用場景可能帶來挑戰。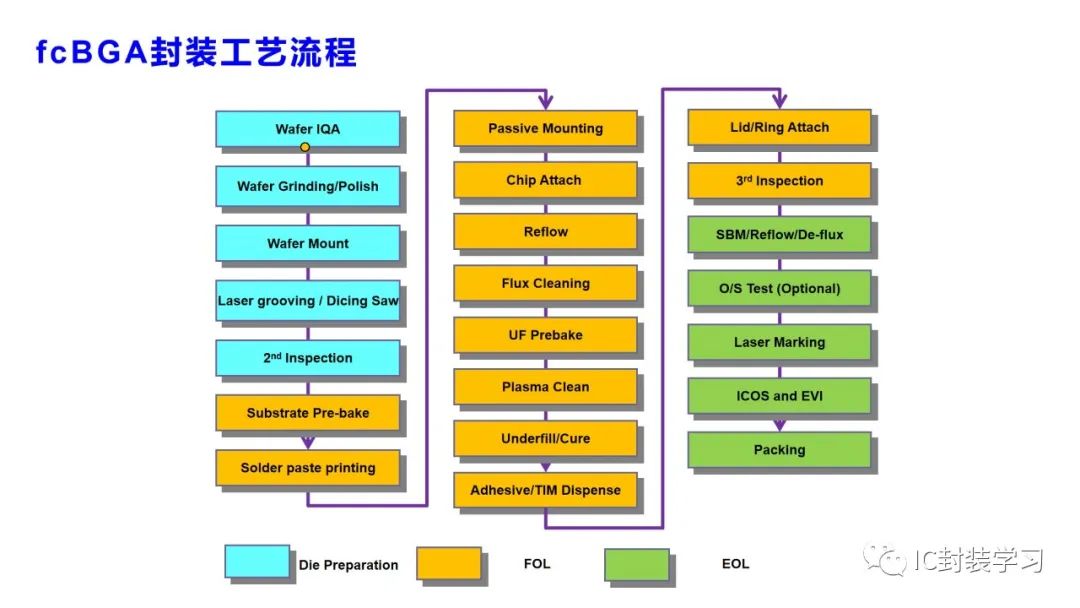


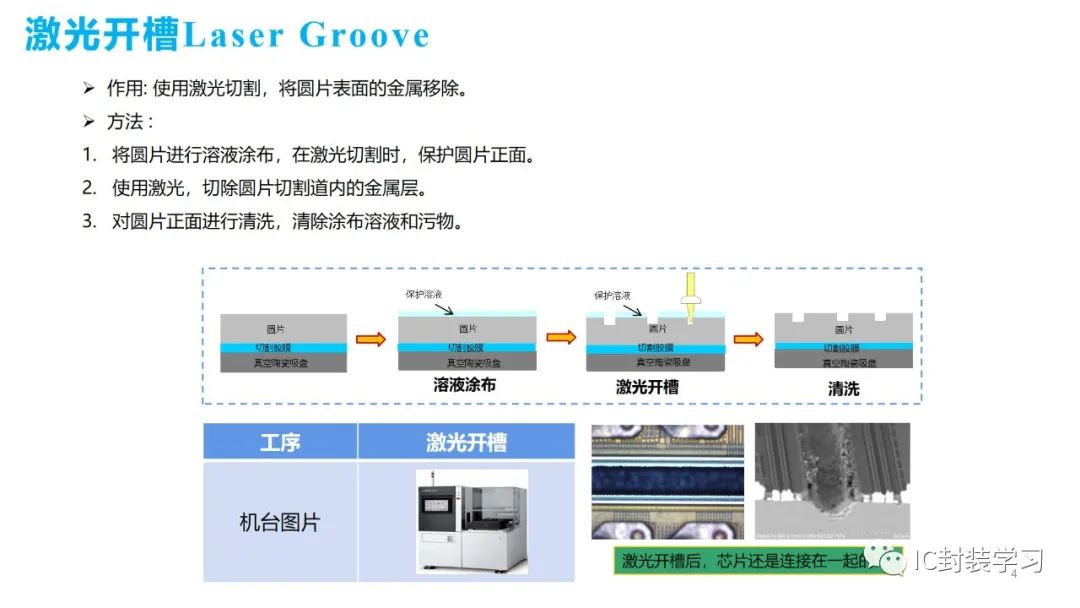
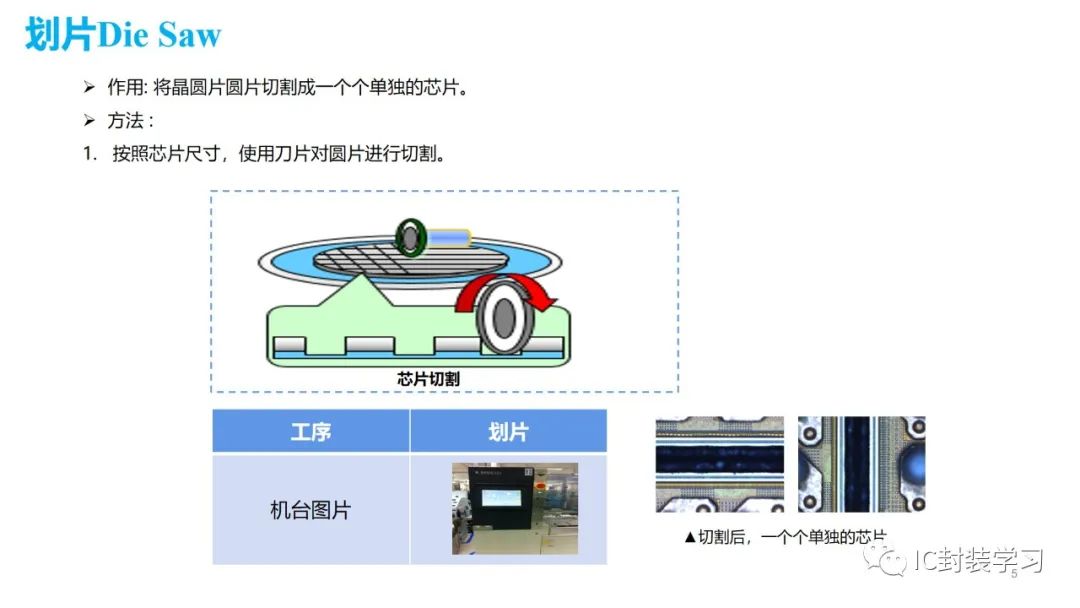
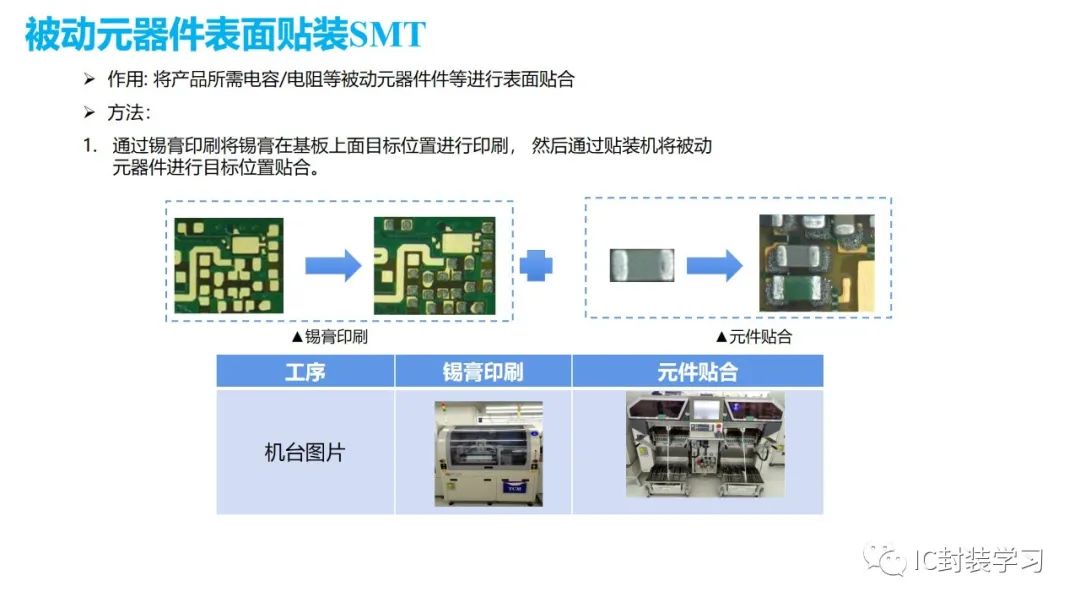
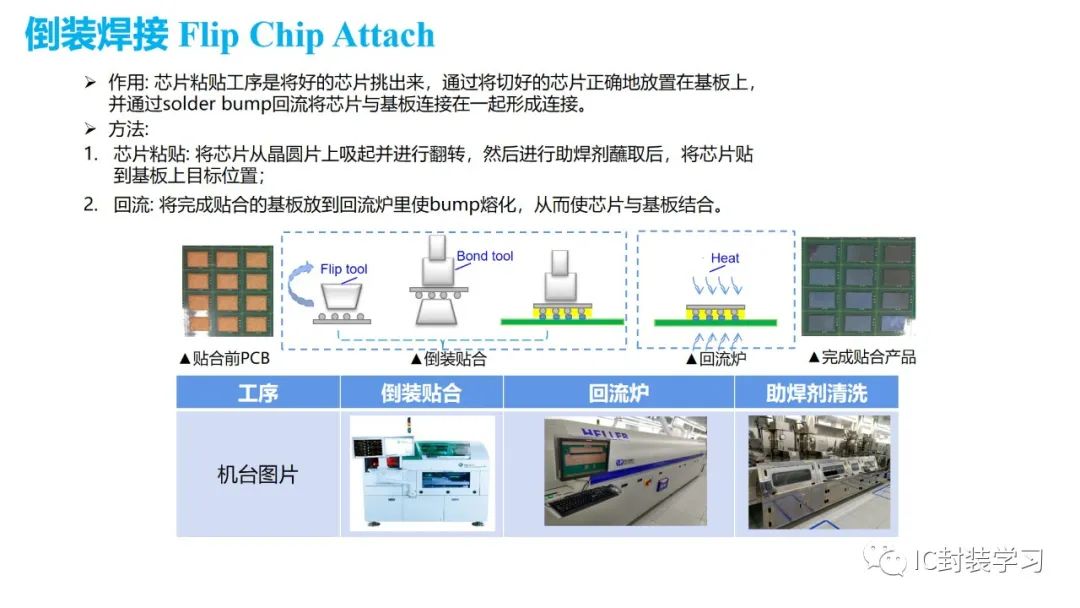
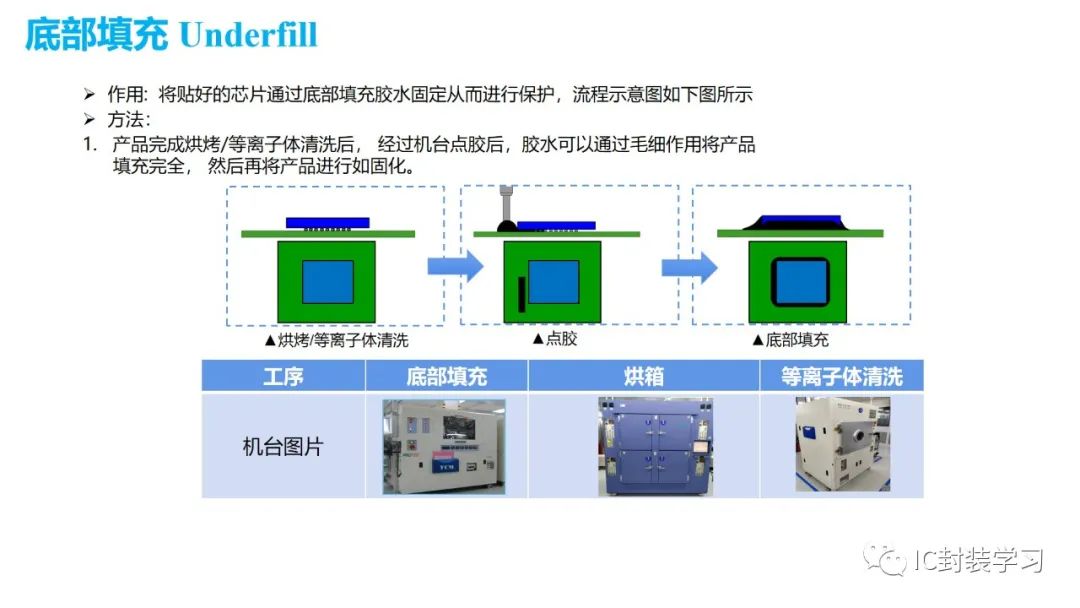
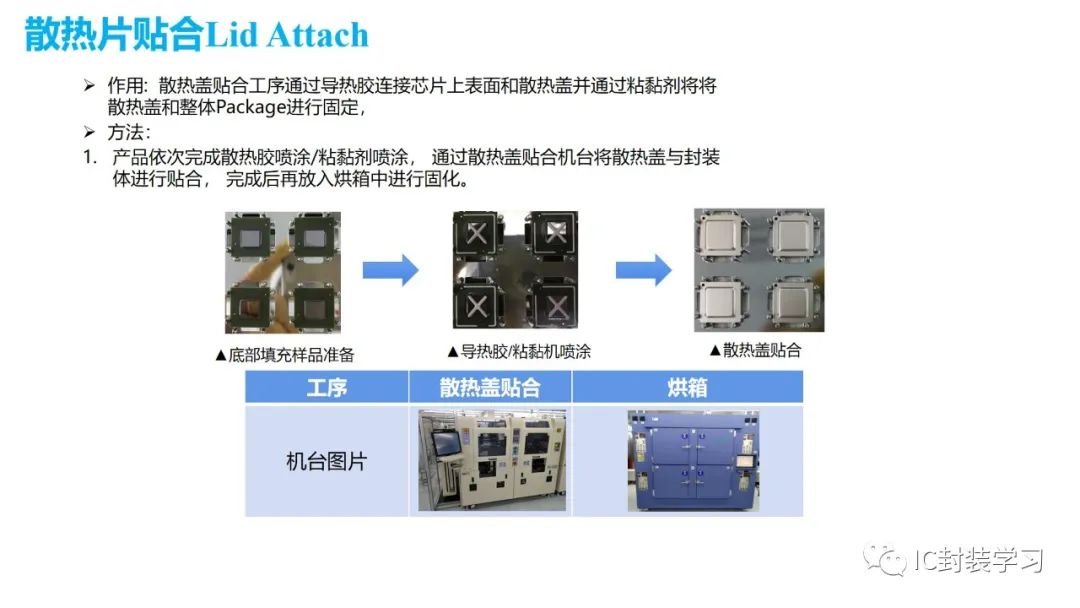
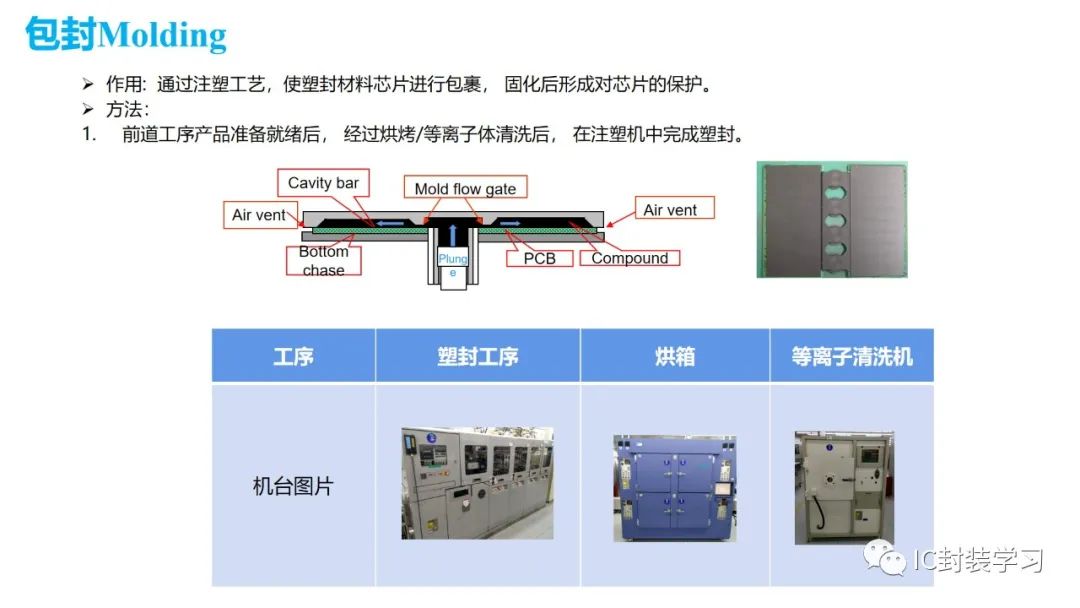
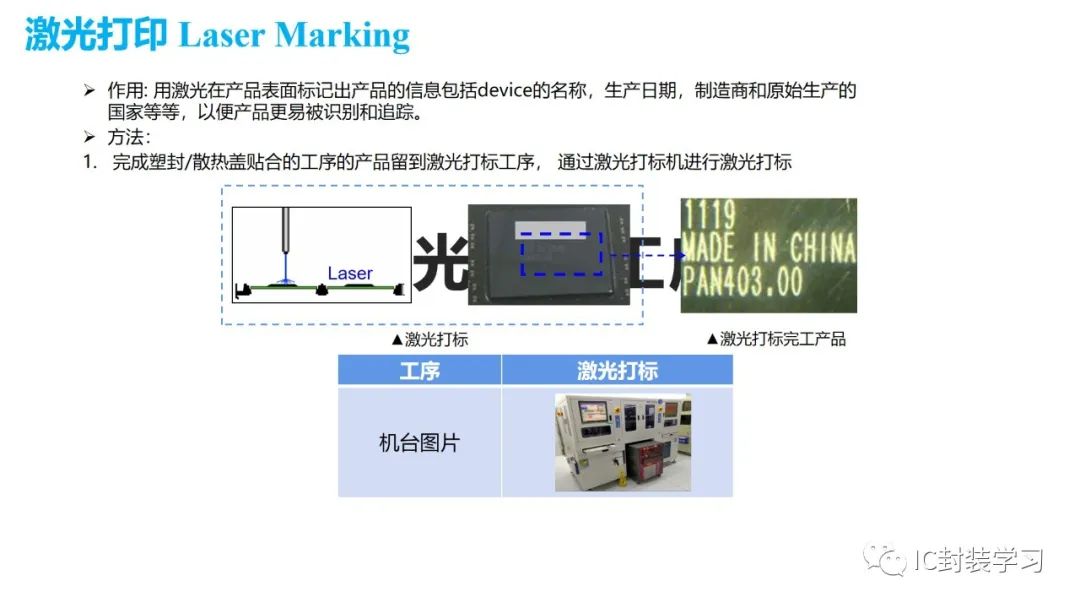
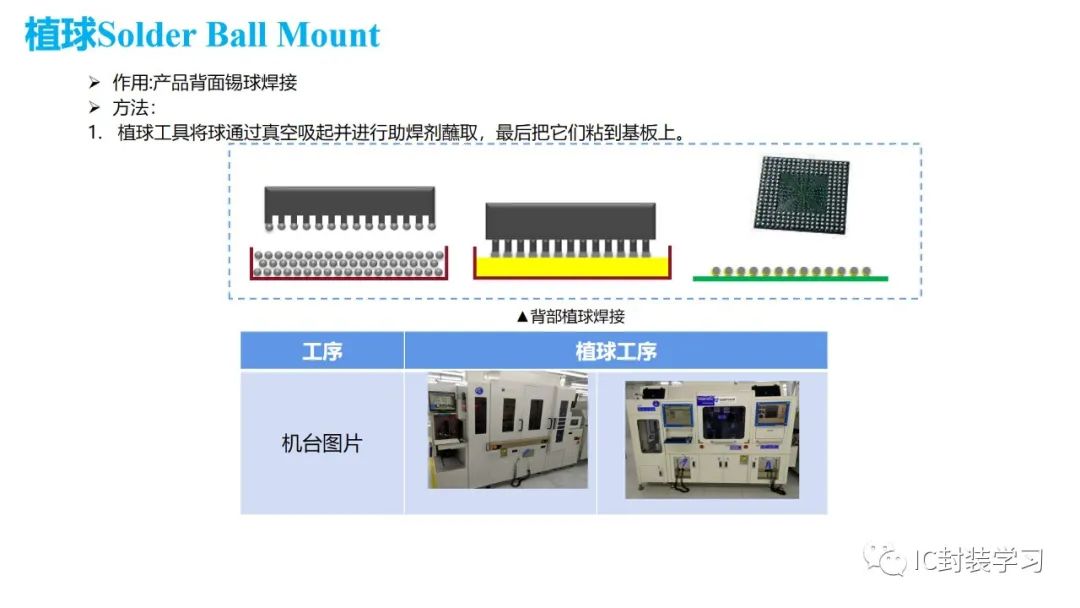

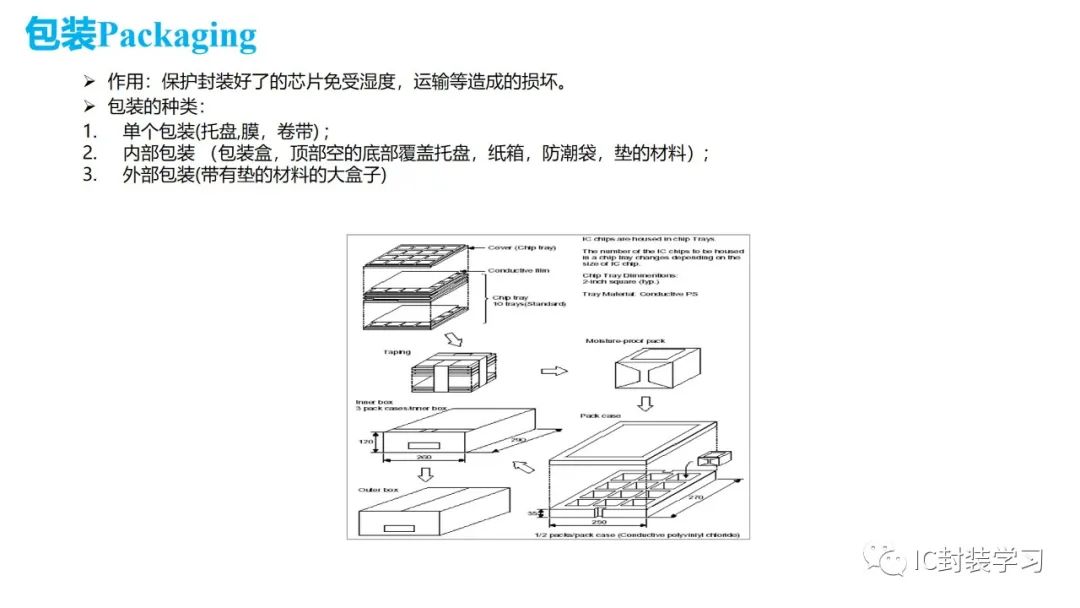
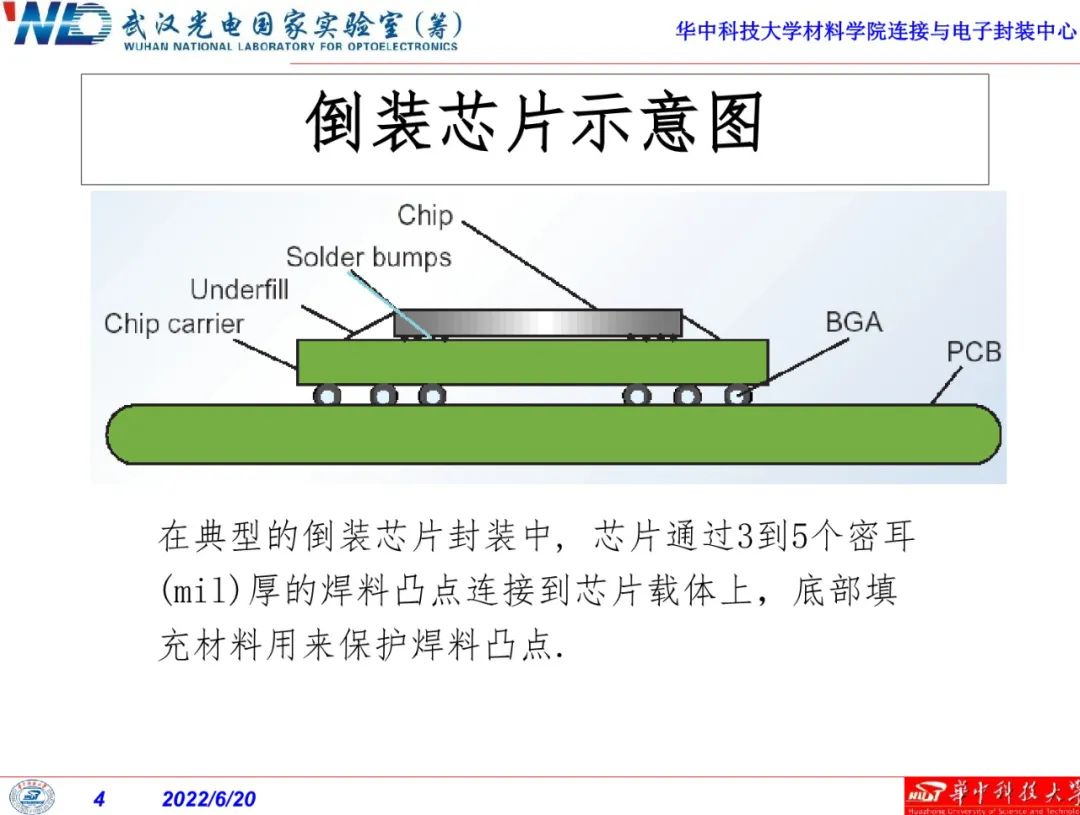












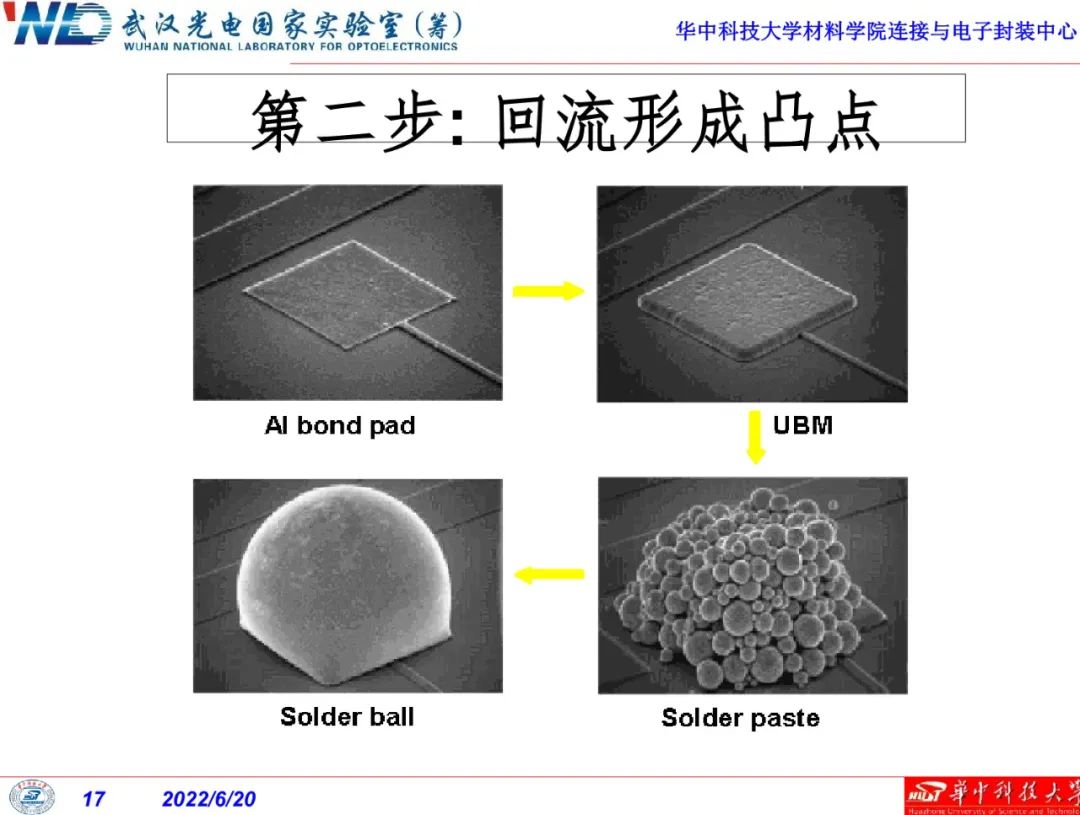
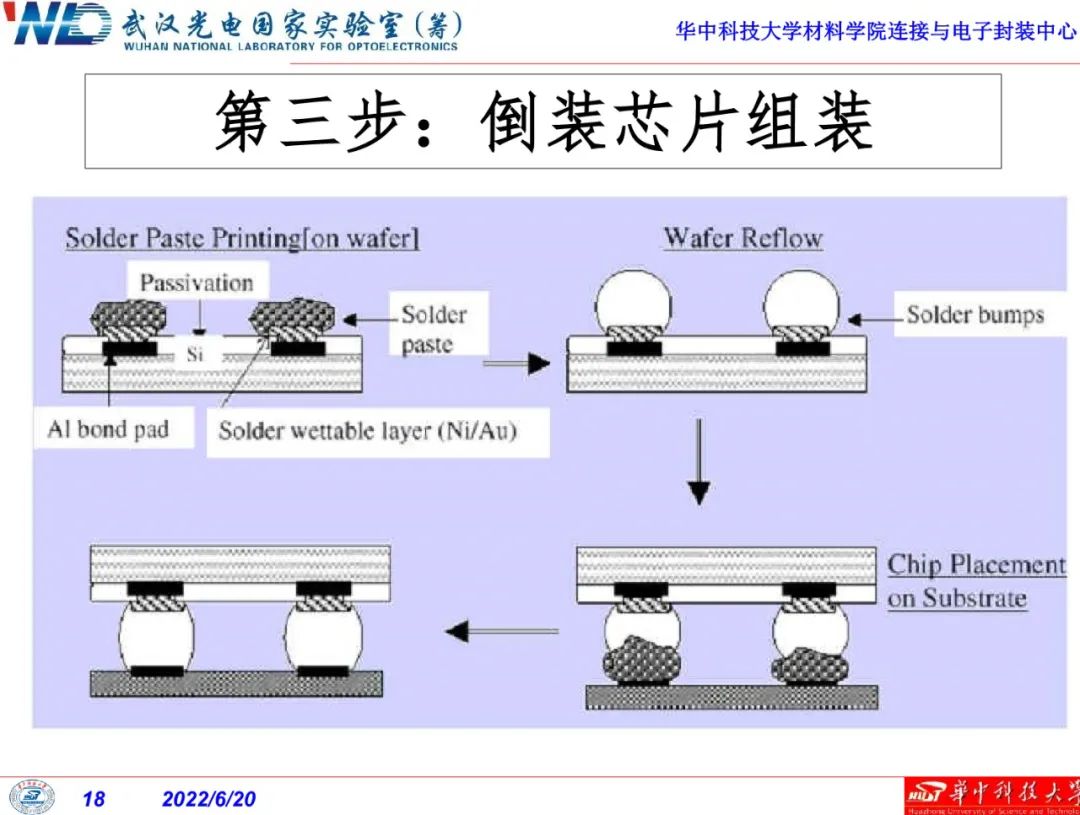
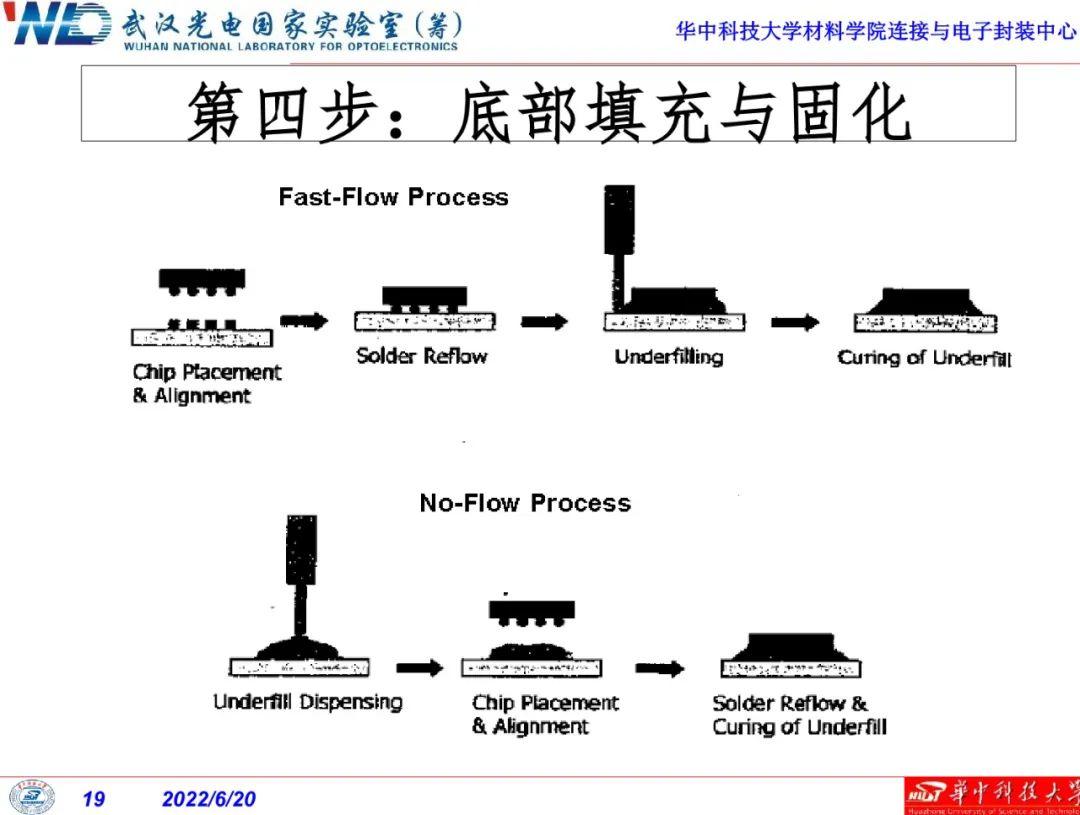
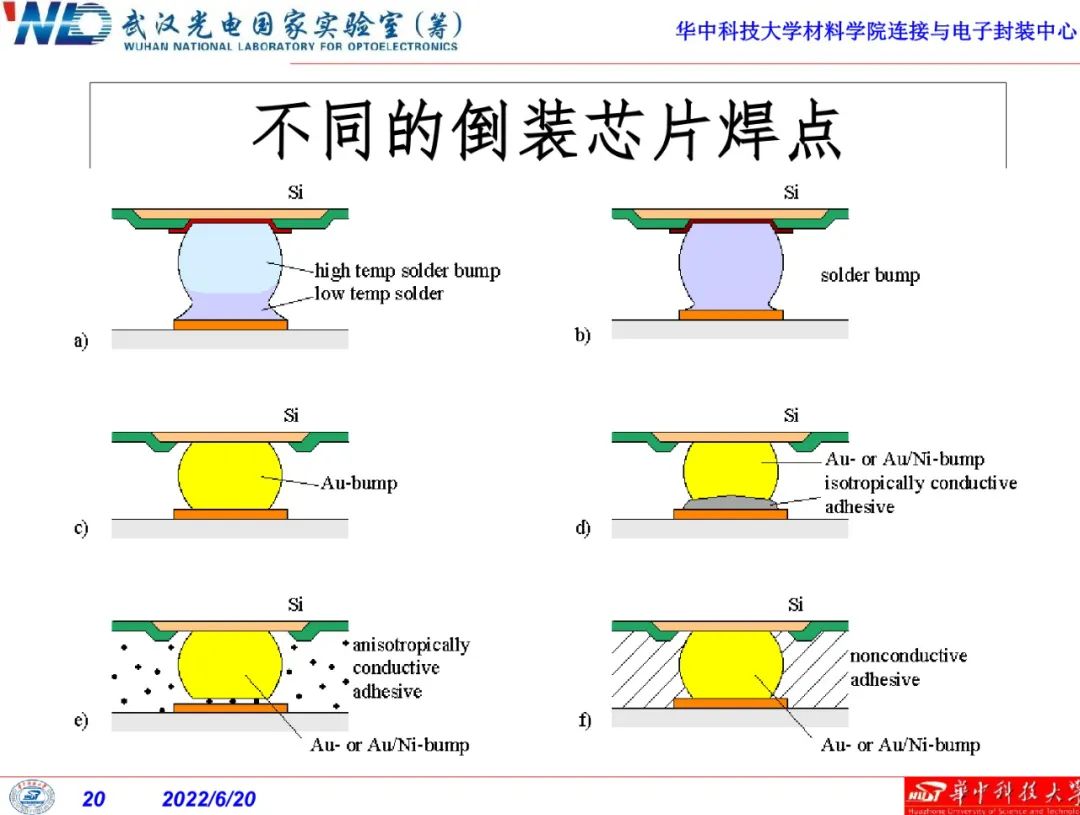
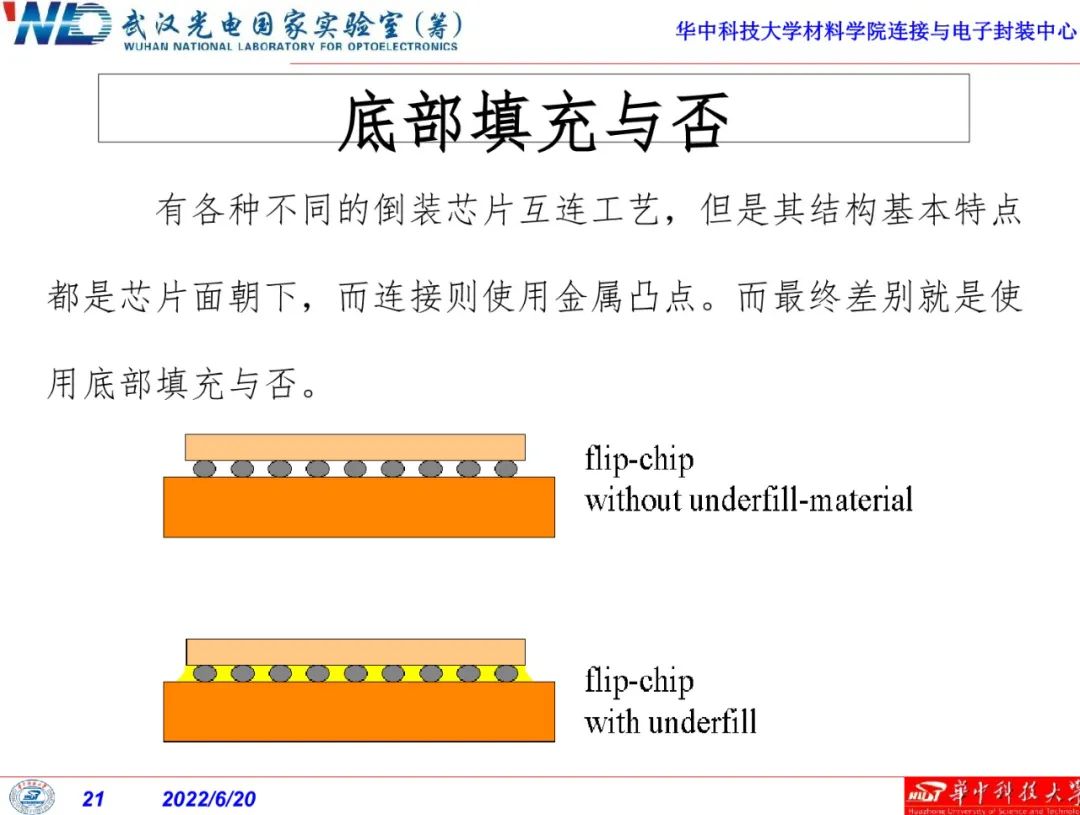






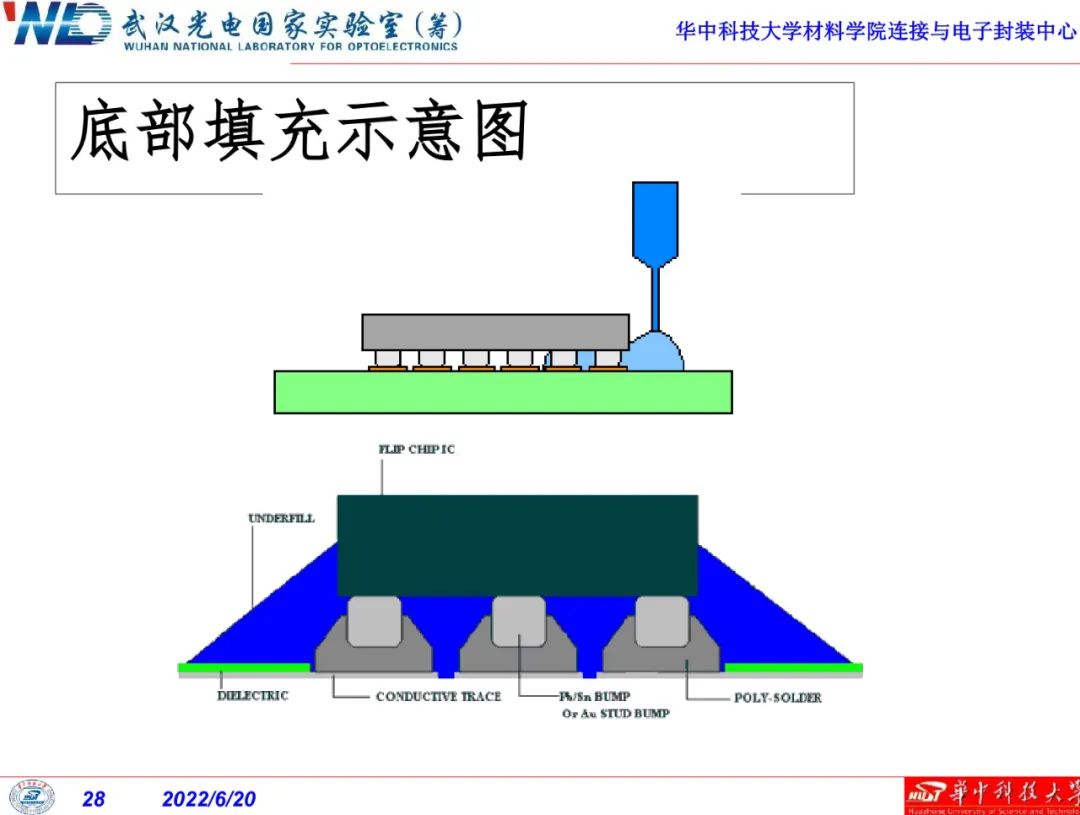

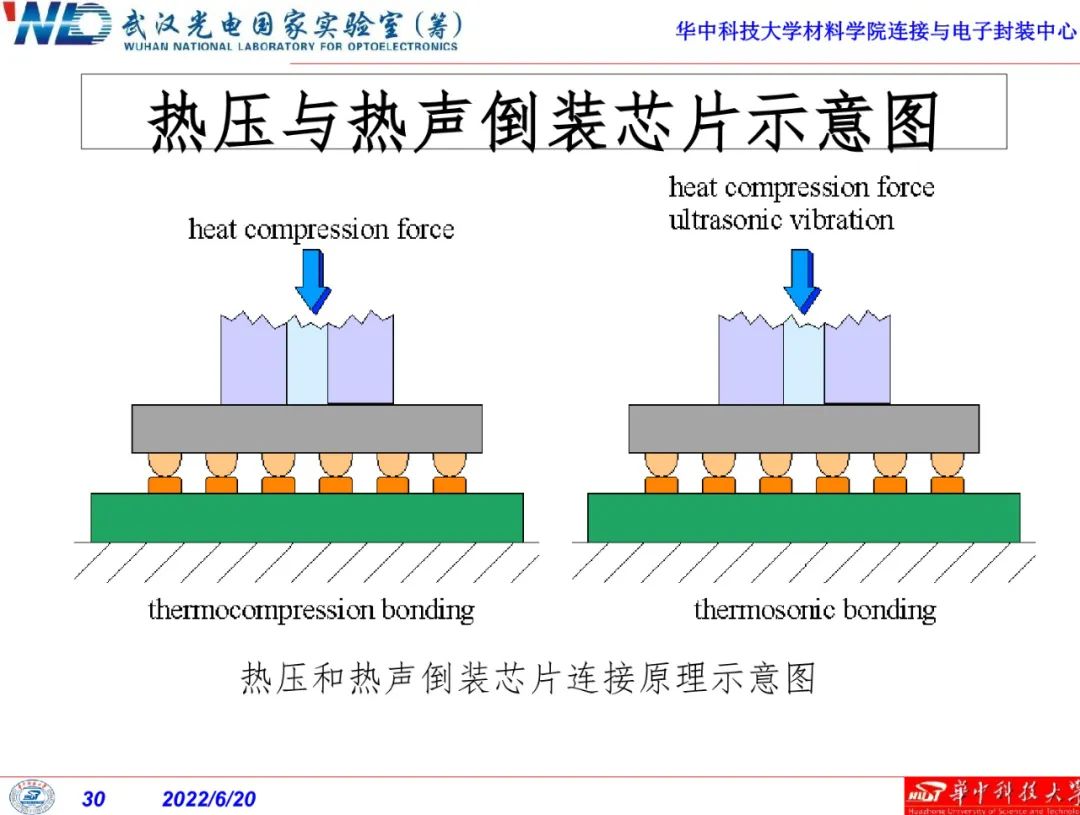















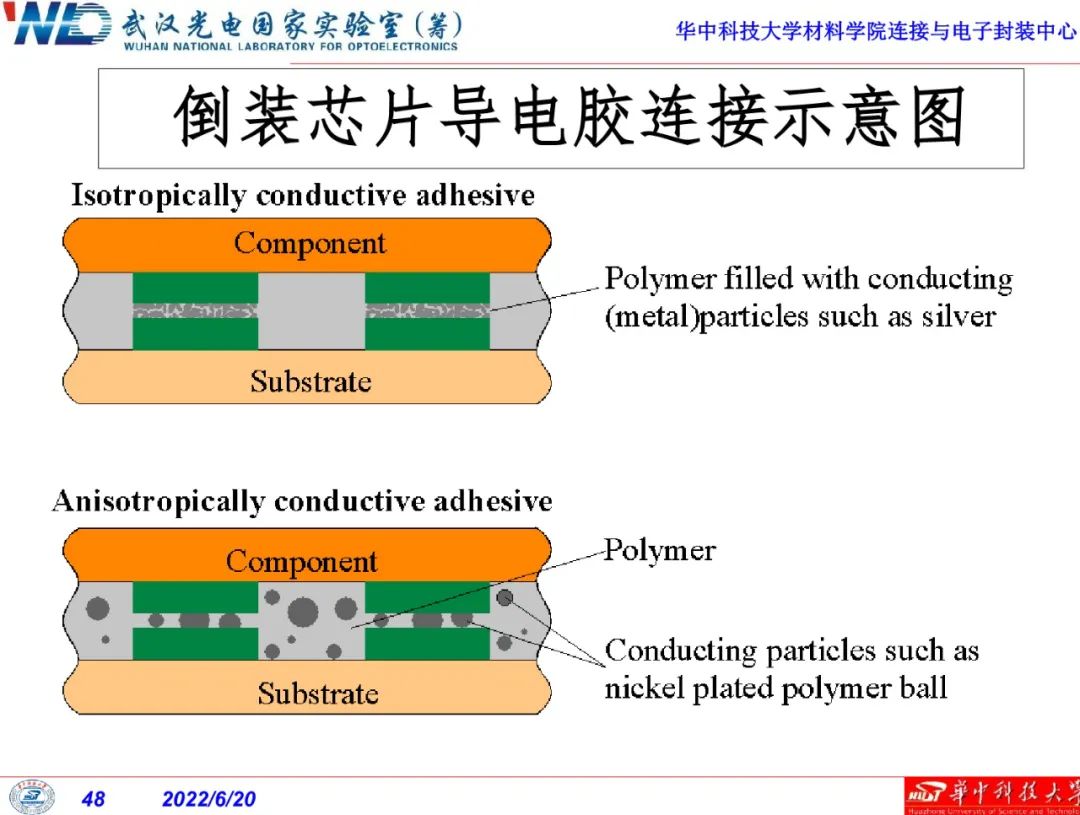




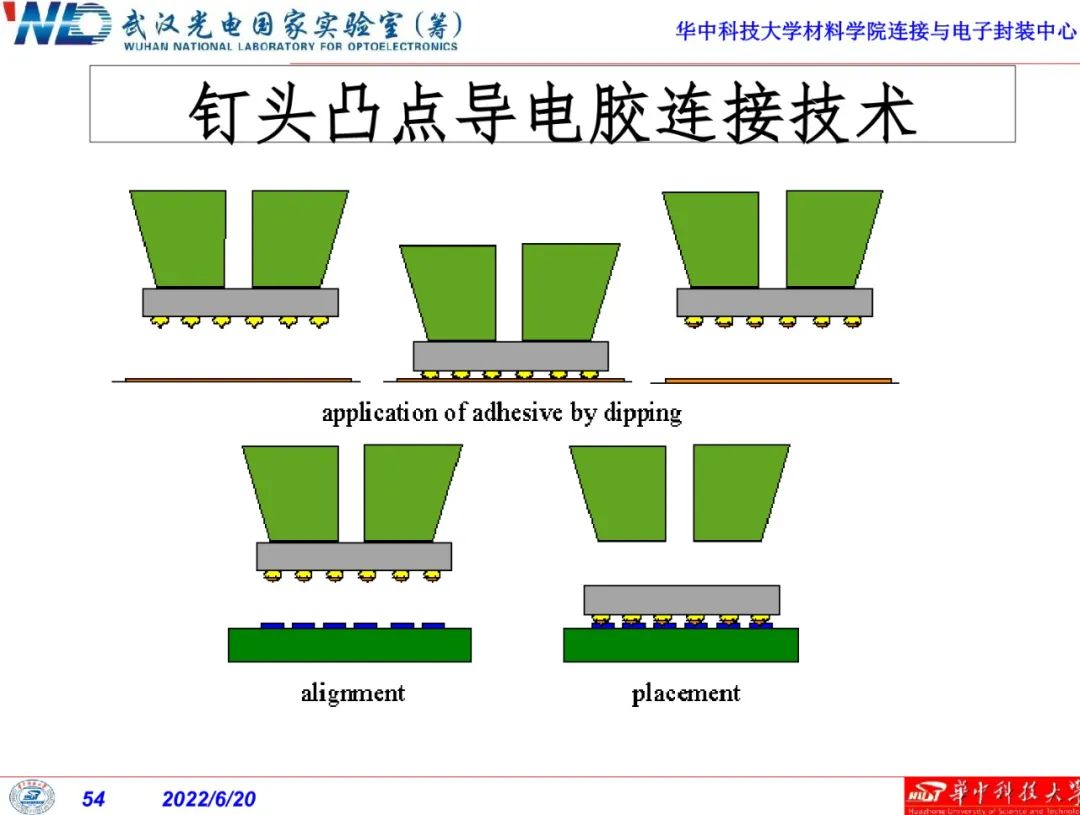




















-
芯片
+關注
關注
456文章
51170瀏覽量
427248 -
封裝
+關注
關注
127文章
7992瀏覽量
143403 -
Flip Chip
+關注
關注
0文章
4瀏覽量
6277
發布評論請先 登錄
相關推薦
功率模塊封裝工藝

倒裝芯片(flip chip)算先進封裝嗎?未來發展怎么樣?

瑞沃微:一文詳解CSP(Chip Scale Package)芯片級封裝工藝





 芯片倒裝Flip Chip封裝工藝簡介
芯片倒裝Flip Chip封裝工藝簡介

















評論