使用SEMulator3D?工藝步驟進行刻蝕終點探測
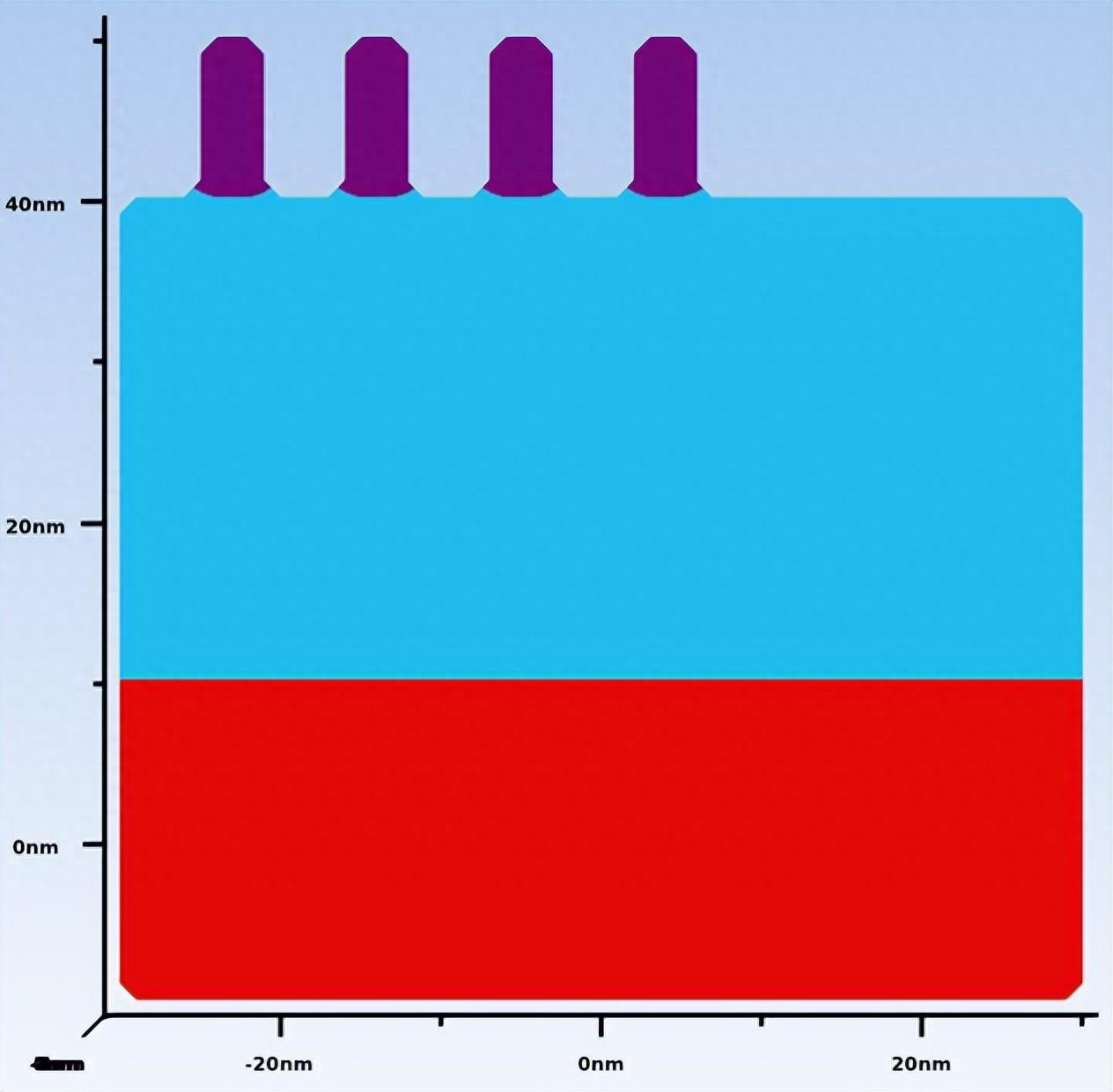
作者:泛林集團 Semiverse Solutions 部門軟件應用工程師 Pradeep Nanja
介紹
半導體行業一直專注于使用先進的刻蝕設備和技術來實現圖形的微縮與先進技術的開發。隨著半導體器件尺寸縮減、工藝復雜程度提升,制造工藝中刻蝕工藝波動的影響將變得明顯。刻蝕終點探測用于確定刻蝕工藝是否完成、且沒有剩余材料可供刻蝕。這類終點探測有助于最大限度地減少刻蝕速率波動的影響。
刻蝕終點探測需要在刻蝕工藝中進行傳感器和計量學測量。當出現特定的傳感器測量結果或閾值時,可指示刻蝕設備停止刻蝕操作。如果已無材料可供刻蝕,底層材料(甚至整個器件或晶圓)就會遭受損壞,從而極大影響良率[1],因此可靠的終點探測在刻蝕工藝中十分重要。半導體行業需要可以在刻蝕工藝中為工藝監測和控制提供關鍵信息的測量設備。目前,為了提升良率,晶圓刻蝕工藝使用獨立測量設備和原位(內置)傳感器測量。相比獨立測量,原位測量可對刻蝕相關工藝(如刻蝕終點探測)進行實時監測和控制。
使用 SEMulator3D?工藝步驟進行刻蝕終點探測
通過構建一系列包含虛擬刻蝕步驟、變量、流程和循環的“虛擬”工藝,可使用 SEMulator3D 模擬原位刻蝕終點探測。流程循環用于在固定時間內重復工藝步驟,加強工藝流程控制(如自動工藝控制)的靈活性[2]。為模擬控制流程,可使用 "For Loop" 或 "Until Loop"(就像計算機編程)設置一定數量的循環。在刻蝕終點探測中,可使用 "Until Loop",因為它滿足“已無材料可供刻蝕”的條件。在循環中,用戶可以在循環索引的幫助下確認完成的循環數量。此外,SEMulator3D 能進行“虛擬測量”,幫助追蹤并實時更新刻蝕工藝循環中的材料厚度。通過結合虛擬測量薄膜厚度估測和流程循環索引,用戶可以在每個循環后準確獲取原位材料刻蝕深度的測量結果。
用 SEMulator3D 模擬刻蝕終點探測的示例
初始設定
在一個簡單示例中,我們的布局圖像顯示處于密集區的四個鰭片和密集區右側的隔離區(見圖1)。我們想測量隔離區的材料完成刻蝕時密集區的刻蝕深度。我們將用于建模的區域用藍框顯示,其中有四個鰭片(紅色顯示)需要制造。此外,我們框出了黃色和綠色的測量區域,將在其中分別測量隔離區的薄膜厚度 (MEA_ISO_FT) 和溝槽區的刻蝕深度 (MEA_TRENCH_FT)。工藝流程的第一步是使用 20nm 厚的硅晶體層(紅色)、30nm 的氧化物(淺藍色)和 10nm 的光刻膠(紫色)進行晶圓設定(圖2)。我們曝光鰭片圖形,并對使用基本模型刻蝕對光刻膠進行刻蝕,使用特定等離子體角度分布的可視性刻蝕對氧化物材料進行刻蝕。氧化物對光刻膠的選擇比是100比1。我們在 SEMulator3D 中使用可視性刻蝕模型來觀察隔離區和有鰭片的密集區之間是否有厚度上的差異。
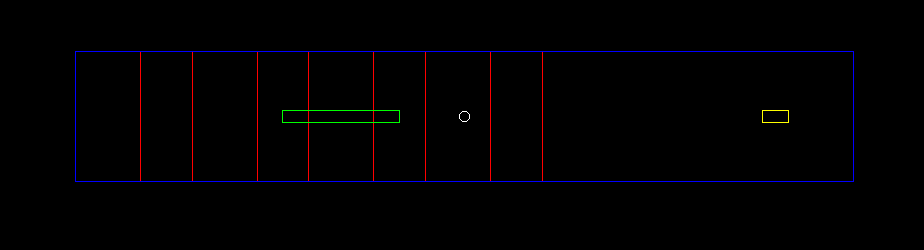
圖1:模型邊界區域(藍色),其中包含四個鰭片(紅色)和用于測量隔離區(黃色)和溝槽區(綠色)薄膜厚度的兩個測量區域
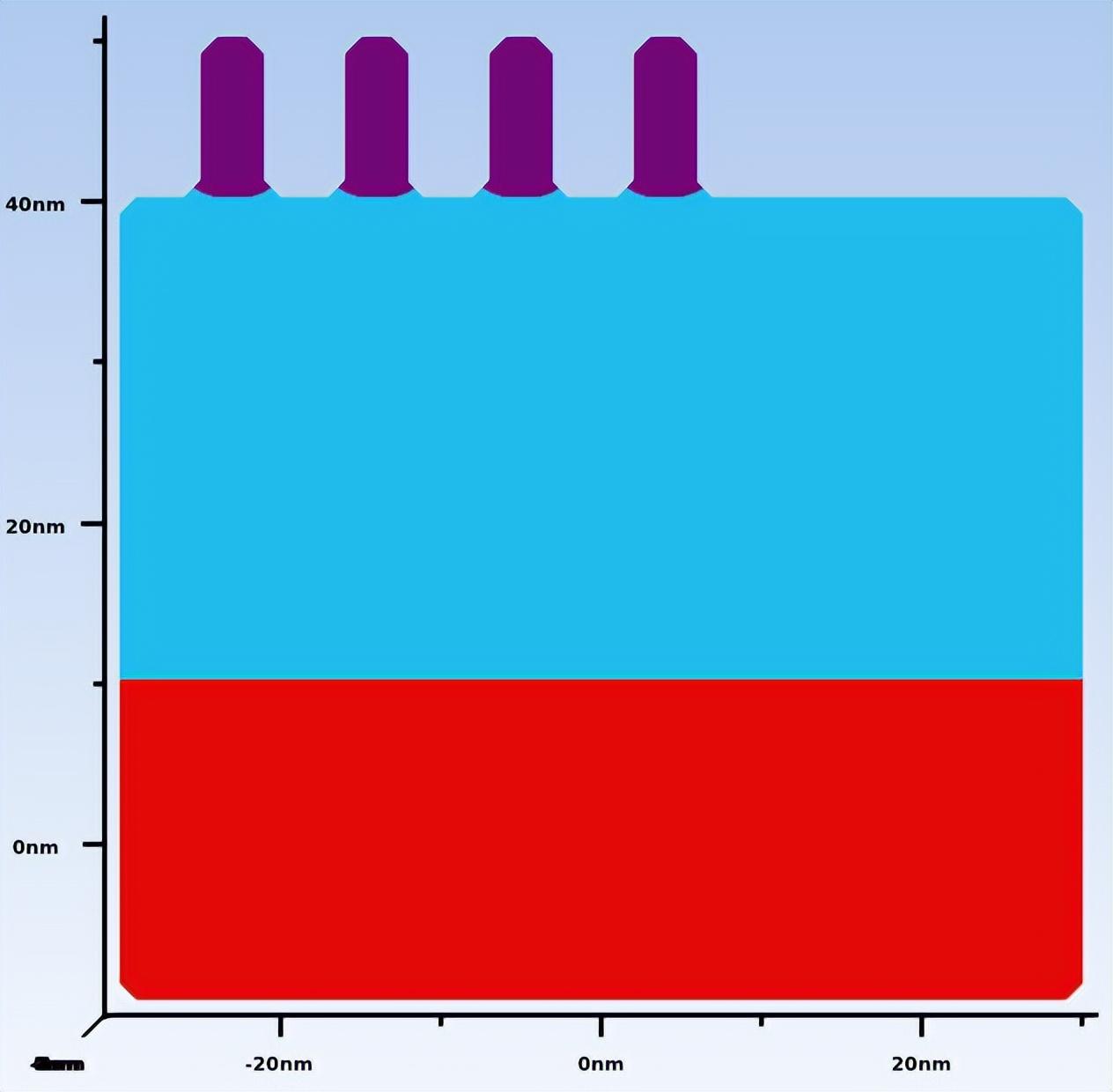
圖2:SEMulator3D 模型,硅晶體(紅色)、氧化物(淺藍色)和在光刻膠中顯影的四個鰭片(紫色)
SEMulator3D 刻蝕終點探測循環
SEMulator3D 的工藝流程使用 Until Loop 循環流程。我們將測量隔離區的材料厚度,并在隔離氧化物薄膜耗盡、即厚度為0時 (MEA_ISO_FT==0) 停止該工藝。在這個循環中,每個循環我們每隔 1nm 對氧化物材料進行1秒的刻蝕,并同時測量此時隔離區氧化物薄膜厚度。此外,我們將在每次循環后追蹤兩個鰭片間溝槽區的刻蝕深度。這個循環索引有助于追蹤刻蝕循環的重復次數(圖3)。

圖3:SEMulator3D 刻蝕終點探測模擬中的循環流程
結果
對隔離薄膜進行刻蝕,直至其剩余 20nm、10nm 和 0nm 深度的模擬結果如圖4所示。模型中計算出隔離薄膜厚度的測量結果,以及兩個鰭片間溝槽區的刻蝕深度。

圖4:隔離區薄膜厚度剩余 20nm、10nm 和 0nm 的工藝模擬流程,及相應從光刻膠底部開始的溝槽刻蝕深度
我們對循環模型進行近30次重復后,觀察到隔離區的薄膜厚度已經達到0,并能追蹤到溝槽區氧化物的刻蝕深度(當隔離區被完全刻蝕時,密集區 30nm 的氧化物已被刻蝕 28.4nm)。
結論
SEMulator3D 可用來創建刻蝕終點探測工藝的虛擬模型。這項技術可用來確定哪些材料在刻蝕工藝中被完全去除,也可測量刻蝕后剩下的材料(取決于刻蝕類型)。使用這一方法可成功模擬原位刻蝕深度控制。使用類似方法,也可以進行其他類型的自動工藝控制,例如深度反應離子刻蝕 (DRIE) 或高密度等離子體化學氣相沉積 (HDP-CVD) 工藝控制。
參考資料:
[1] Derbyshire, Katherine. In Situ Metrology for Real-Time Process Control, Semiconductor Online, 10 July 1998, https://www.semiconductoronline.com/doc/in-situ-metrology-for-real-time-process-contr-0001.
[2] SEMulator3D V10 Documentation: Sequences, Loops, Variables, etc.
審核編輯 黃宇
-
探測
+關注
關注
0文章
211瀏覽量
20391 -
測量
+關注
關注
10文章
4938瀏覽量
111812 -
刻蝕
+關注
關注
2文章
192瀏覽量
13178
發布評論請先 登錄
相關推薦
什么是原子層刻蝕
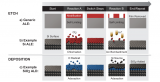
等離子體刻蝕和濕法刻蝕有什么區別
半導體濕法刻蝕殘留物的原理
芯片濕法刻蝕方法有哪些
ALE的刻蝕原理?
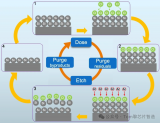
腔室壓力對刻蝕的影響

芯片制造中的濕法刻蝕和干法刻蝕

濕法刻蝕步驟有哪些
刻蝕工藝的參數有哪些

PDMS濕法刻蝕與軟刻蝕的區別
離子束刻蝕機物理量傳感器 MEMS 刻蝕應用
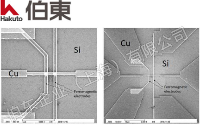
電流探頭與示波器:毫安電流的探測與測量

淺談刻蝕的終點控制

什么是線刻蝕 干法線刻蝕的常見形貌介紹





 為刻蝕終點探測進行原位測量
為刻蝕終點探測進行原位測量
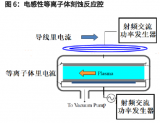










評論