4H-SiC概述(生長、特性、應用)、Bulk及外延層缺陷、光致發光/拉曼光譜法/DLTS/μ-PCD/KOH熔融/光學顯微鏡,TEM,SEM/散射光等表征方法。
報告詳細內容
■ 介紹
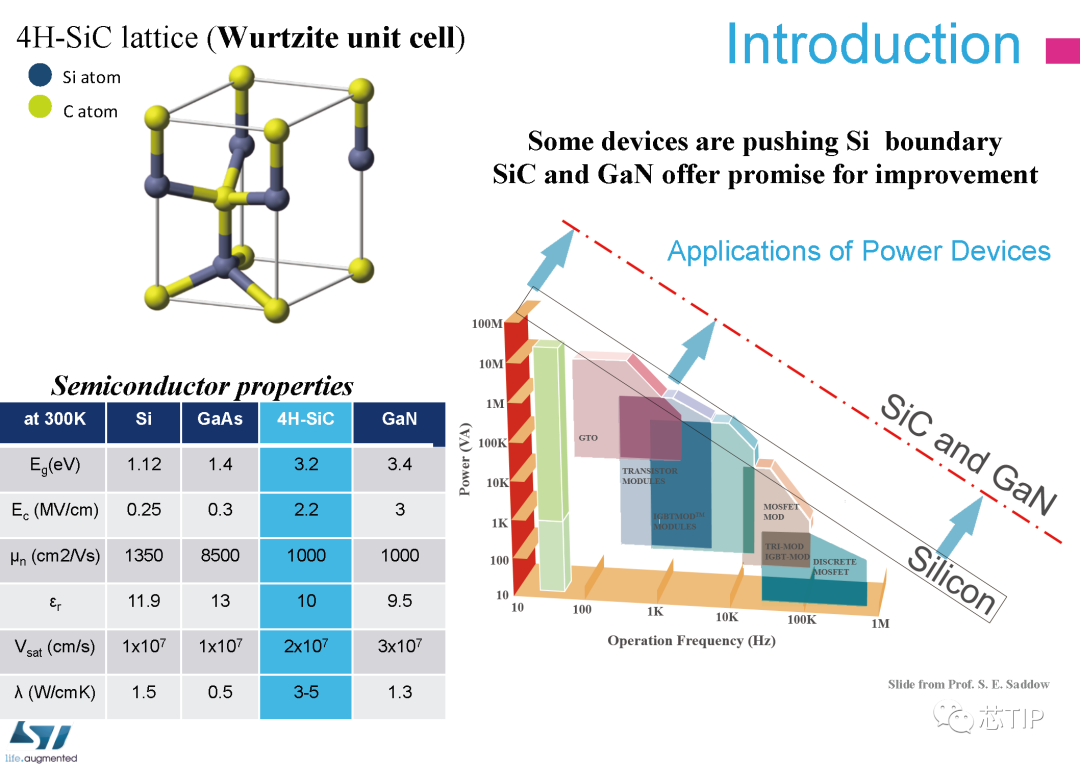
? 一些器件正在突破Si的界限,SiC和GaN提供了改進的希望。
■ 介紹

? 生長方法:
PVT - 塊體(厚、高摻雜)
CVD - 外延(薄膜,中低摻雜)
■ Bulk缺陷
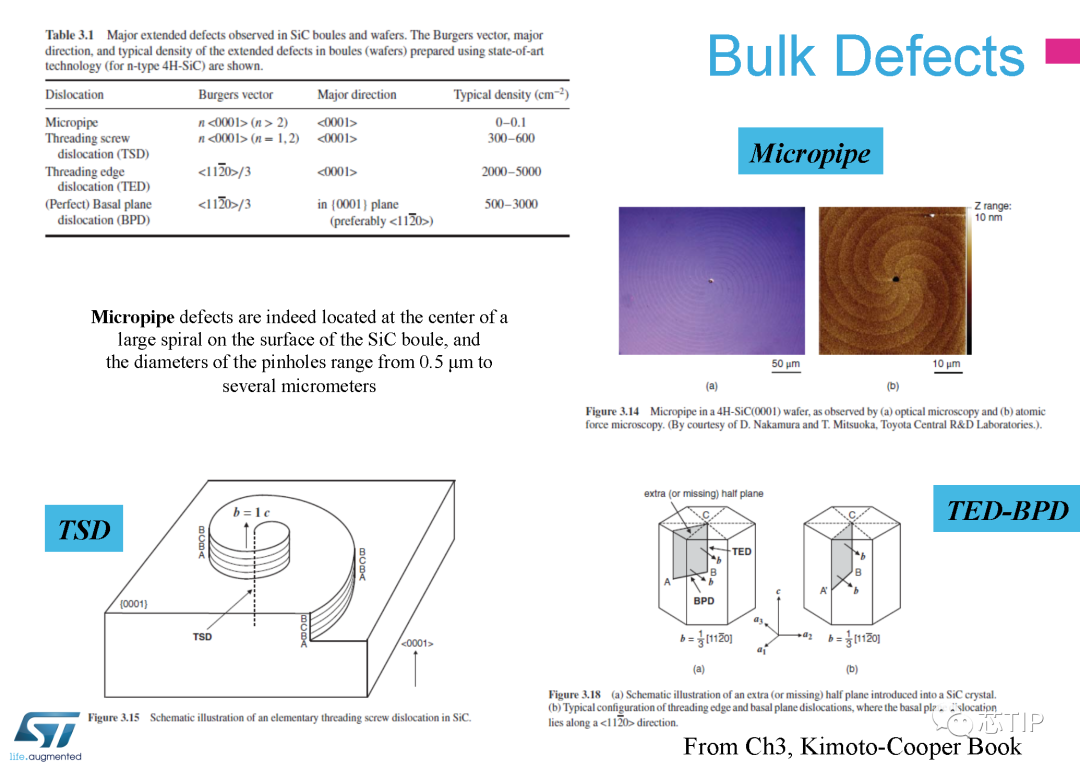
? 微管
微管缺陷確實位于SiC晶錠表面一個大螺旋的中心,針孔的直徑從0.5微米到幾微米不等
? TSD
? TED-BPD
■ 升華生長的多型控制

? 晶錠生長過程中的多型體混合——轉換、聚結、成核——在TSD周圍發生螺旋生長,以彌補多型體的不匹配
■ 晶錠生長過程中的 BPD 生成

? 由于晶格參數的變化,摻雜物的變化會影響BPD的產生
? 減少應力可以減少BPD的產生
? 大多數TED是由生長過程中沿生長方向的BPD轉化而形成的
■ TSD的產生和消除

? EPD = TSD+TED+BPD
■ 減少缺陷(Bulk)
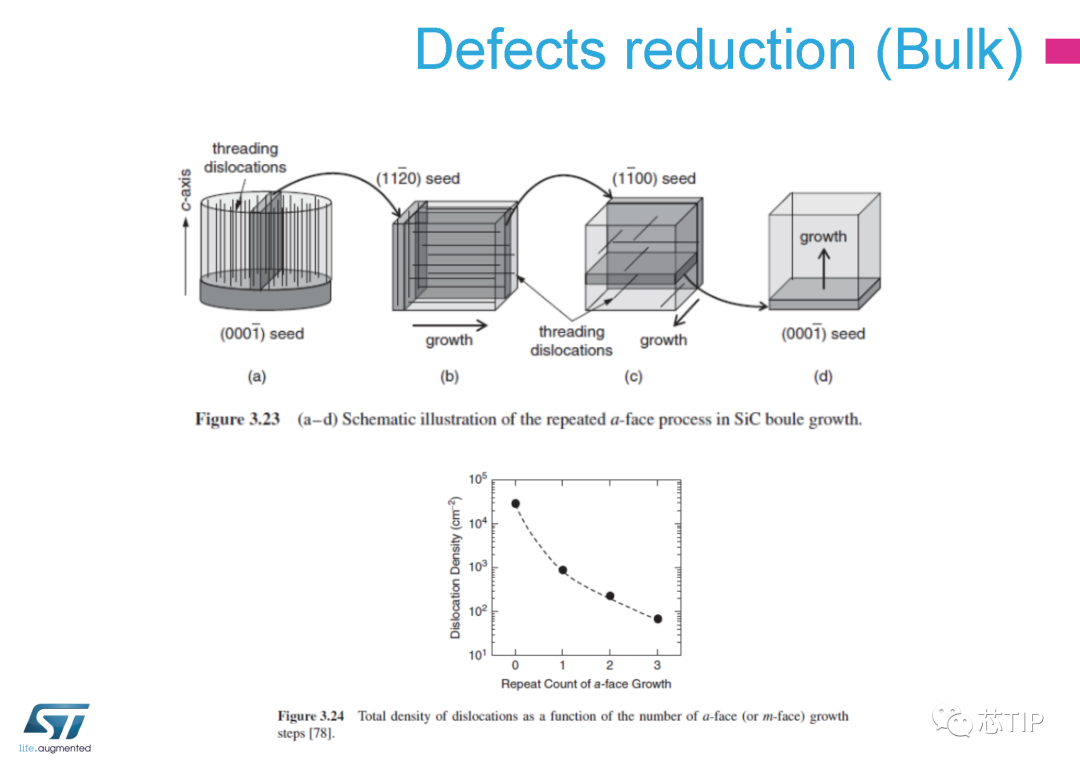
■ 外延缺陷
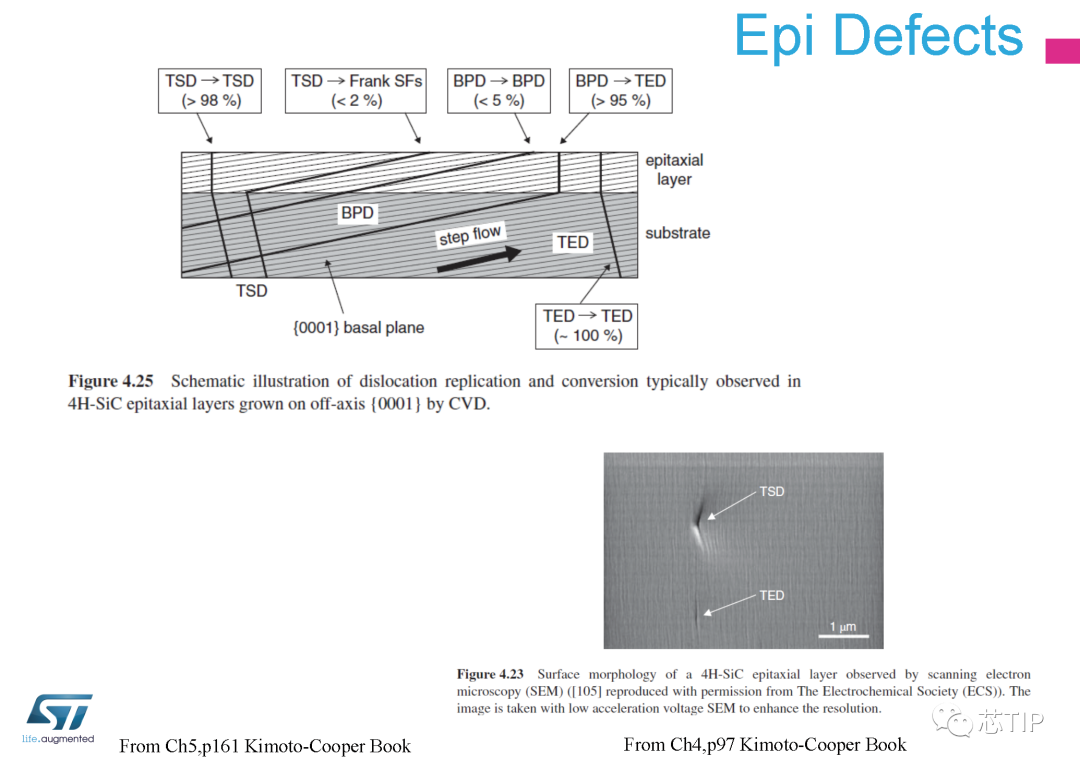
■ 外延缺陷
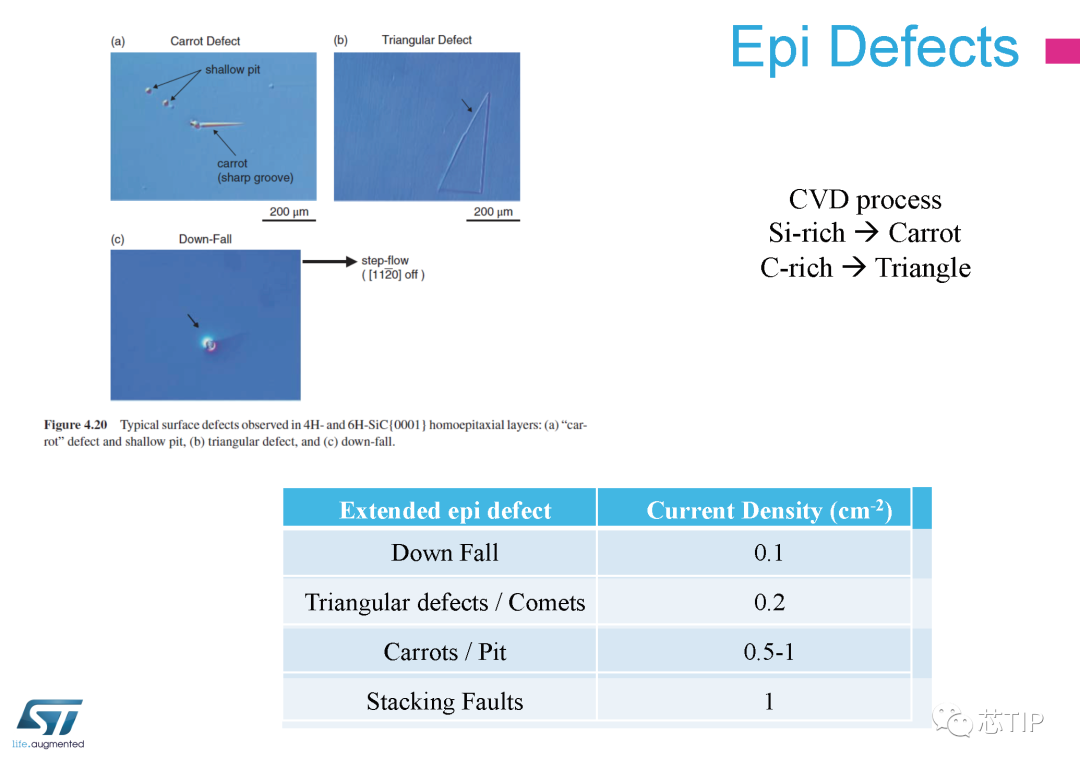
? 化學氣相沉積工藝
富Si——胡蘿卜缺陷
富C——三角缺陷
■ 位錯與外延缺陷
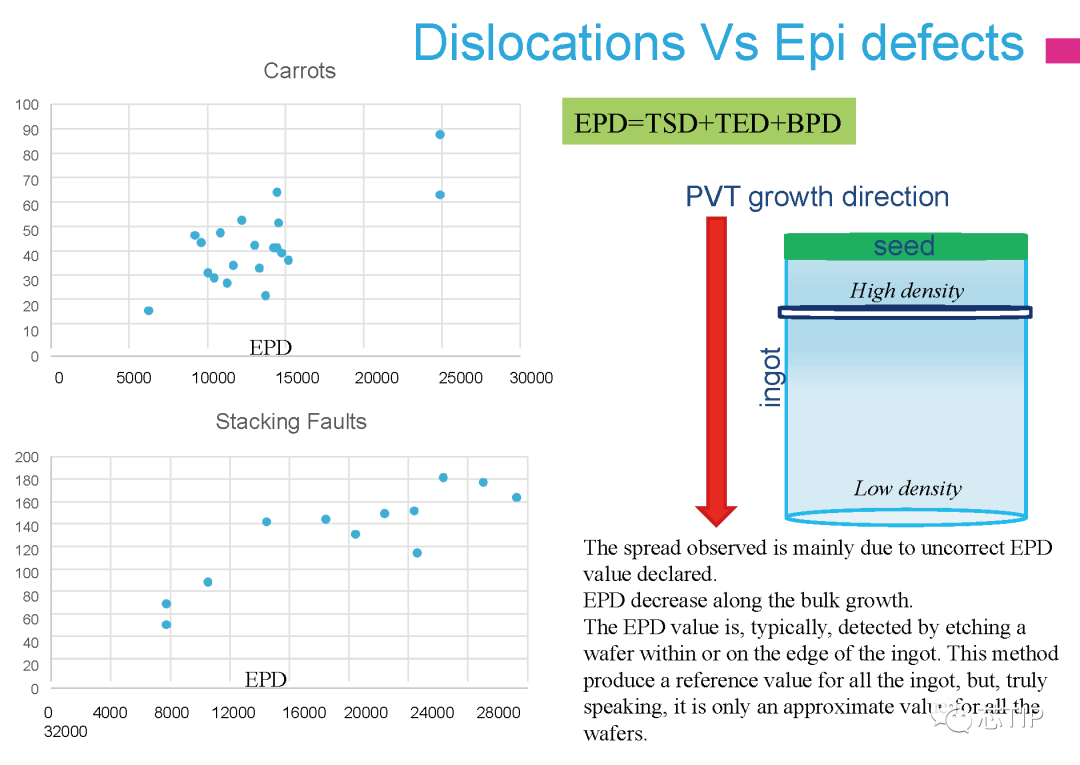
? EPD隨體量增長而減少
? EPD 值通常通過在晶錠內部或邊緣上蝕刻晶片來檢測。
? 這種方法對所有的晶錠產生了一個參考值,但實際上,它只是對所有晶片的一個近似值
■ 外延缺陷:臺階聚集和粗糙度

? 外延工藝參數
? 對設備性能沒有相關影響
? 關鍵生長參數:溫度、生長速率、Si/C
■ 堆垛層錯

■ 外延缺陷對器件的影響
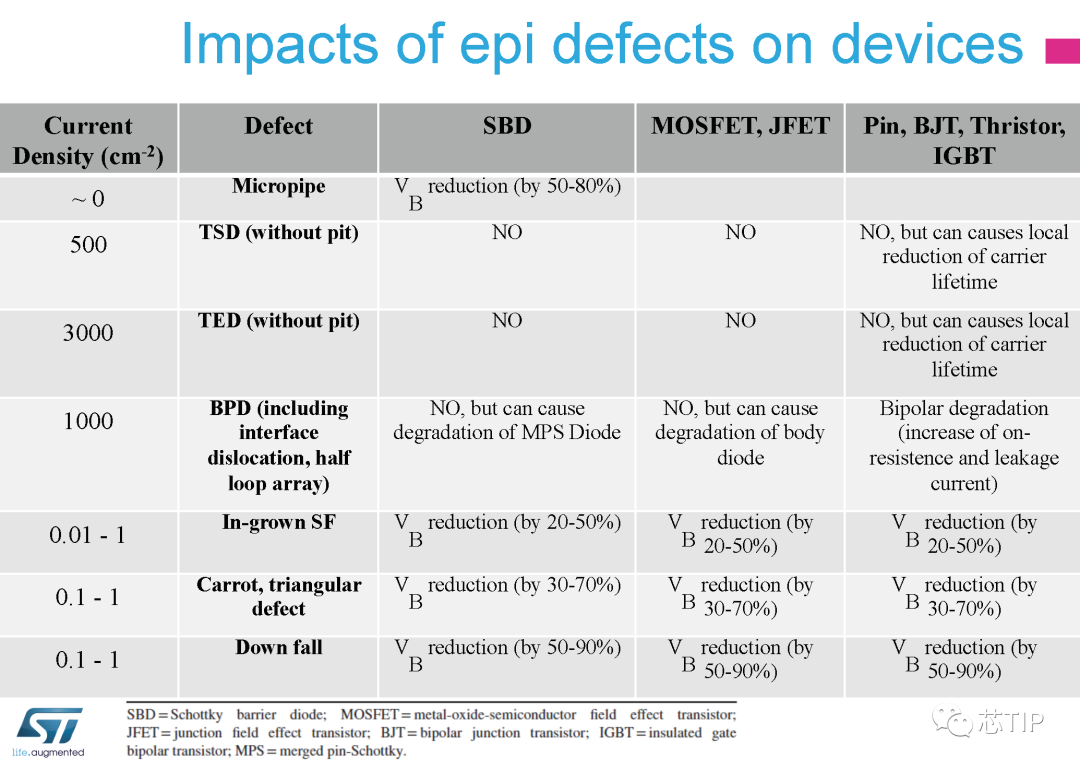
■ 微型光致發光和微型拉曼設置
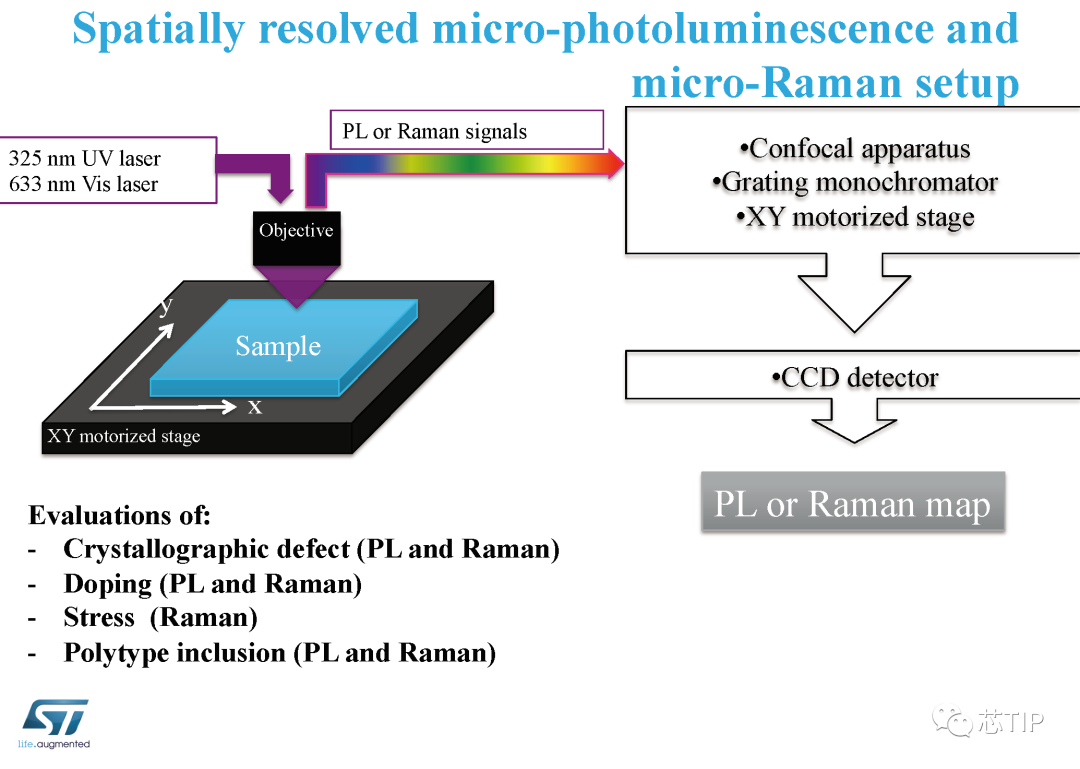
? 晶體缺陷(PL 和拉曼)
? 摻雜(PL 和拉曼)
? 應力(拉曼)
? 多型夾雜物(PL 和拉曼)
■ 堆垛層錯/摻雜/應力
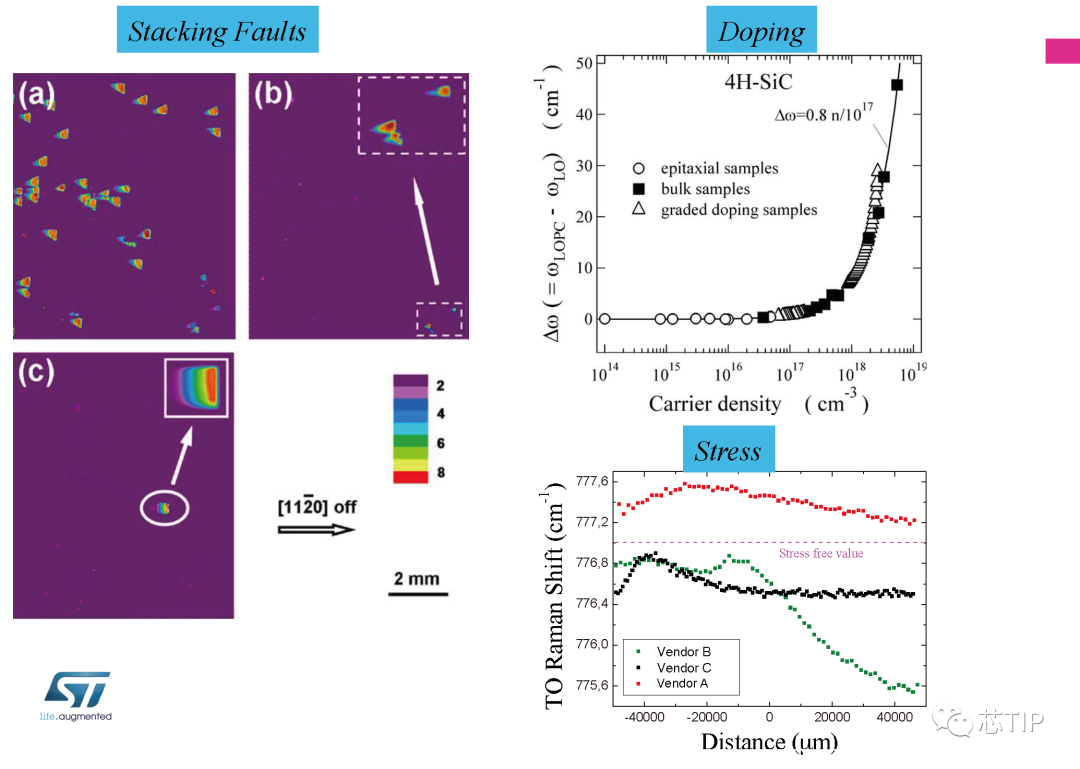
■ 多型夾雜物分析 (HeNe)

■ 點缺陷

■ μ-PCD 和 DLTS 方法
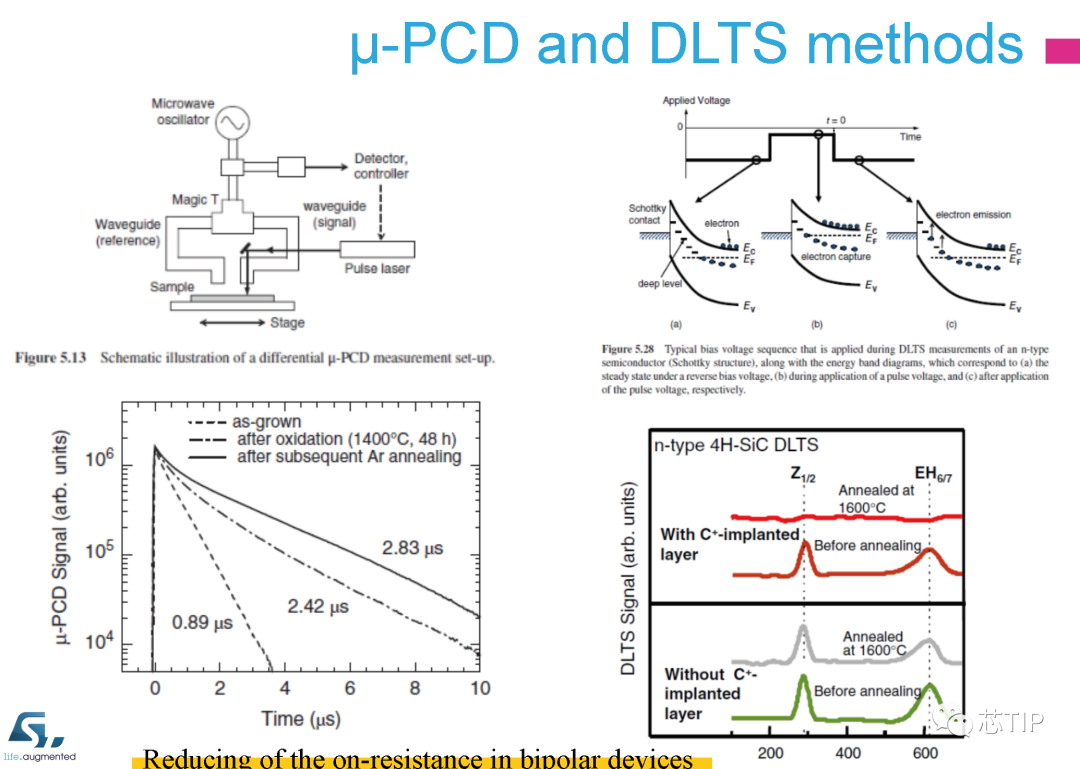
■ 離子注入致缺陷

? 離子注入過程對晶格產生損傷
? 通過在高溫 (T > 1600 °C) 下進行退火,晶體被部分回收
? 然而,缺陷的聚集仍然存在并通過 PL 表征觀察到
? 正在對離子劑量和退火溫度進行優化
■ 坎德拉工具(散射光)
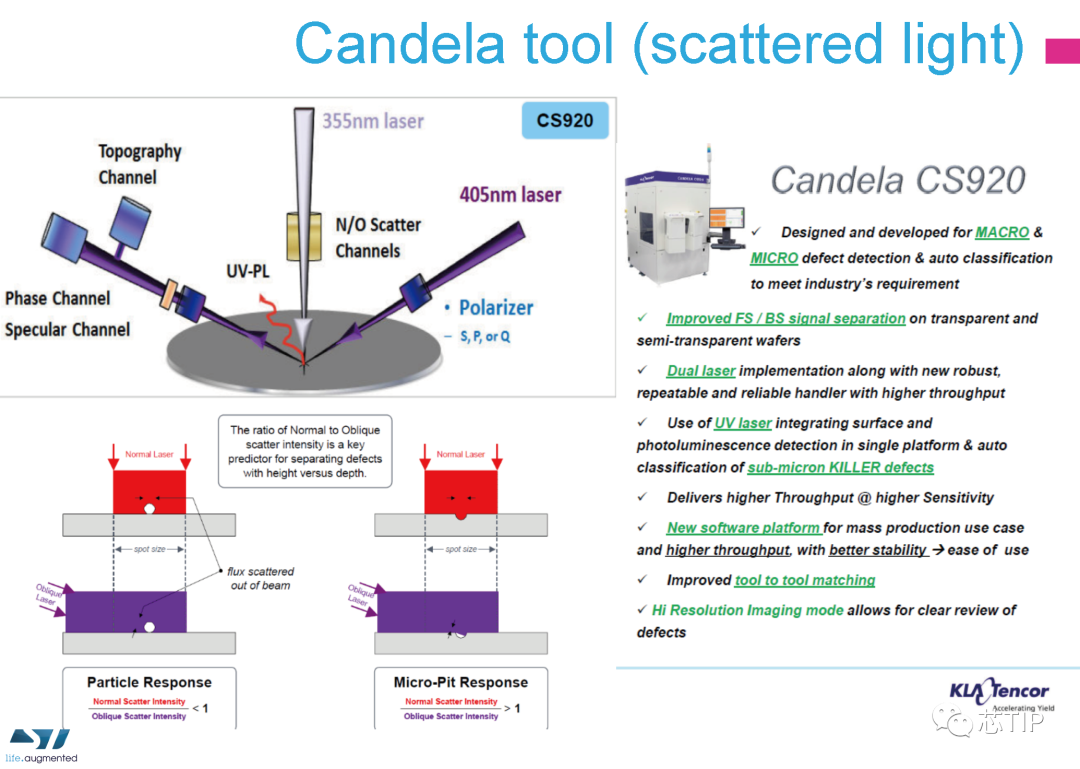
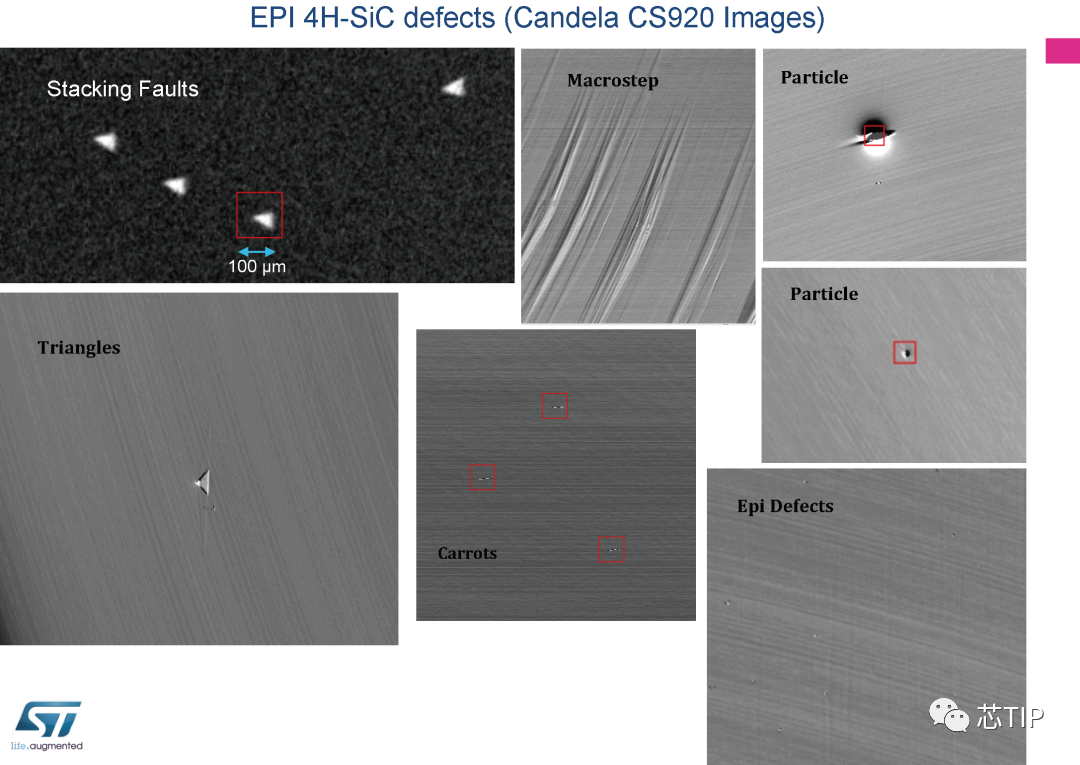
■ 總結

? 持續的質量改進
? 表征技術的廣泛選擇
? 來自不同供應商的不同質量
? 非破壞性 VS 破壞性表征方法(位錯密度)
審核編輯:劉清
-
SEM
+關注
關注
0文章
234瀏覽量
14499 -
SiC
+關注
關注
29文章
2892瀏覽量
62943 -
TEM
+關注
關注
0文章
89瀏覽量
10447 -
拉曼光譜
+關注
關注
0文章
86瀏覽量
2779
原文標題:「芯報告」4H-SiC缺陷(cr.意法半導體)
文章出處:【微信號:CloudBrain-TT,微信公眾號:云腦智庫】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
改善4H-SiC晶圓表面缺陷的高壓碳化硅解決方案

SiC功率器件性能和可靠性的提升
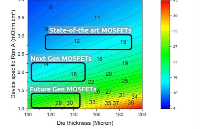
4H-SiC離子注入層的歐姆接觸的制備
SiC器件中SiC材料的物性和特征,功率器件的特征,SiC MOSFET特征概述

基于簡單的支架多片4H-SiC化學氣相沉積同質外延生長
8英寸導電型4H-SiC單晶襯底制備與表征
天科合達談八英寸SiC
SiC的物性和特征
如何降低SiC/SiO?界面缺陷
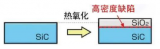
國產CVD設備在4H-SiC襯底上的同質外延實驗

控制多晶硅(poly-Si)/4H-SiC異質結二極管能壘高度(ΦB)的方法
合盛新材料8英寸導電型4H-SiC襯底項目全線貫通
磨料形貌及分散介質對4H碳化硅晶片研磨質量有哪些影響





 4H-SiC缺陷概述
4H-SiC缺陷概述
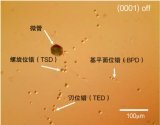










評論