引言
基于GaN的高電子遷移率,晶體管,憑借其高擊穿電壓、大帶隙和高電子載流子速度,應用于高頻放大器和高壓功率開關中。就器件制造而言,GaN的相關材料,如AlGaN,憑借其物理和化學穩定性,為等離子體蝕刻技術提供了典型應用。蝕刻工藝對器件特性有著較大的影響,尤其是在精確控制蝕刻深度和較小化等離子體損傷的情況下影響較大。
場效應晶體管中凹陷柵極結構的電流水平和動態電流崩潰特性或二極管在很大程度上取決于蝕刻表面的凹陷深度和陷阱狀態。盡管傳統的等離子體蝕刻方法,例如反應離子蝕刻(RIE)和電感耦合等離子體(ICP)-RIE,但涉及(Al)GaN的O2等離子體氧化結合基于HCl:H2O溶液的氧化物去除的數字蝕刻工藝由于相關的低蝕刻損傷和容易控制凹陷深度而受到相當大的關注。
然而,由于等離子體氧化和濕法蝕刻工藝的結合,該工藝是勞動密集型的,并且涉及低蝕刻速率。在這種情況下,原子層蝕刻(ALE)工藝的實現是原位數字蝕刻工藝,并且具有相對高的蝕刻速率和低的蝕刻損傷,是可取的。為了利用ALE工藝的優點,必須優化工藝條件以較小化等離子體引起的蝕刻損傷,并獲得自限制特性以精確控制蝕刻深度。
實驗與討論
ALE工藝在ICP蝕刻系統中進行,其中使用氦背面冷卻系統將卡盤溫度設定為5℃,并且使用渦輪泵抽空腔室。詳細的系統圖如圖所示1。
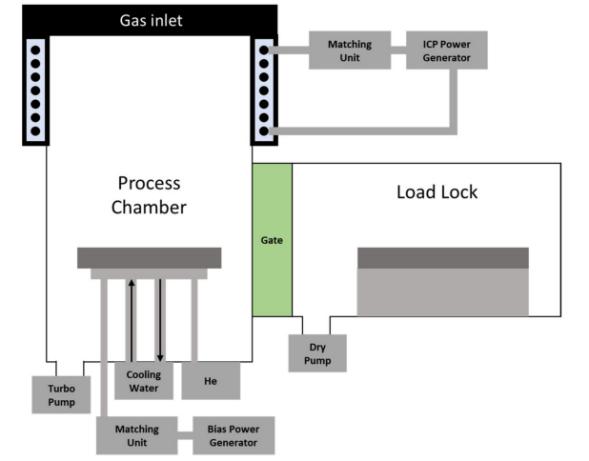 圖1:電感耦合等離子體(ICP)蝕刻器示意圖
圖1:電感耦合等離子體(ICP)蝕刻器示意圖使用O2等離子體氧化AlGaN層,并且使用BCl3等離子體去除氧化層。O2和BCl3的氣體流速分別為50和10sccm。在O2和BCl3等離子體步驟之后,進行泵送步驟30秒,以避免任何殘余O2或BCl3氣體污染樣品。
O2和BCl3等離子體處理過程中的壓力分別為50毫托和10毫托,研究了ICP和偏置功率對DC自偏置的影響,如圖所示2。觀察到DC自偏壓分別隨著偏壓功率和ICP功率的增加而增加和減少。盡管考慮到無法消除的浮動電勢,在系統中測量的DC自偏置值似乎太低,但是很明顯,用較低的偏置功率和較高的ICP功率可以實現較低的DC自偏置。在系統中無法測量浮動電位的準確評估。
使用在蝕刻的n-GaN表面上制造的肖特基二極管來評估蝕刻損傷。我們采用的n-GaN-on-Si晶圓由300 nm n-GaN漂移層(a-Si摻雜濃度為2.5 1017 cm)、700 nm高摻雜n-GaN接觸層(a-Si摻雜濃度為(2–3)1018 cm3)、3900 nm GaN緩沖層和Si襯底組成。使用丙酮、甲醇和異丙醇進行溶劑清洗,開始制造裝置。
隨后,沉積200 nm的SiNx鈍化層作為掩模層。隨后通過Ti/Al金屬化和在N2環境氣氛中在550℃快速熱退火1分鐘形成歐姆接觸。通過20 W的基于SF6的RIE打開SiNx層,并且通過使用兩種不同的方法,即ALE和數字蝕刻,將暴露的GaN層蝕刻到5 nm的深度。在SiNx開口工藝之后,通過電子槍蒸發沉積Ni/Au (40/200 nm)金屬電極。圓形電極的直徑為50 m,并與同心觸點隔開15 m的間隙。裝置橫截面如圖所示7。
結論
在ICP-RIE系統中使用O2和BCl3等離子體的ALE被開發以實現具有低蝕刻損傷的自限制蝕刻工藝。O2等離子體步驟的ALE工藝條件如下:400 W的ICP功率、3W的偏壓功率、50 mTorr的室壓、4V的DC自偏壓和60s的等離子體時間。BCl3等離子體步驟的ALE工藝條件包括400W的ICP功率、2W的偏壓功率、10mTorr的室壓、3.8V的DC自偏壓和45s的等離子體時間,這導致0.7nm/周期的蝕刻速率。
使用包括AFM、PL和XPS在內的各種評估方法對蝕刻損傷進行了研究,并將嵌入式肖特基二極管的I-V特性與使用O2等離子體氧化和基于HCl溶液的氧化物去除的傳統數字蝕刻工藝獲得的I-V特性進行了比較。
與使用O2等離子體和HCl溶液的傳統數字蝕刻工藝相比,使用O2和BCl3等離子體的ALE導致肖特基二極管的更好的電特性,以及更高的PL強度、增加的N/(Al + Ga)比和更平滑的蝕刻表面。此外,ALE技術表現出優異的自限制特性,并確保蝕刻深度和循環次數之間的高線性。提出的ALE工藝被認為有希望應用于(Al)GaN腐蝕,其中腐蝕深度的精確控制和低腐蝕損傷是必要的。
審核編輯 黃宇
-
蝕刻
+關注
關注
9文章
419瀏覽量
15508 -
GaN
+關注
關注
19文章
1965瀏覽量
74233 -
離子
+關注
關注
0文章
102瀏覽量
17137
發布評論請先 登錄
相關推薦
金屬蝕刻殘留物對對等離子體成分和均勻性的影響
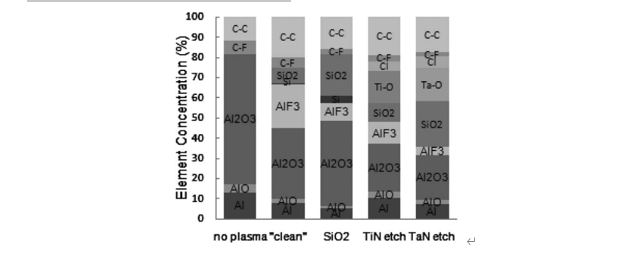
等離子體蝕刻和沉積問題的解決方案
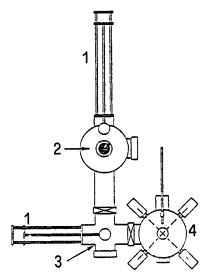
PCB多層板等離子體處理技術
PCB電路板等離子體切割機蝕孔工藝技術
PCB板制作工藝中的等離子體加工技術
PCB多層板等離子體處理技術
低溫等離子體廢氣處理系統
TDK|低溫等離子體技術的應用
等離子體應用
電磁波在等離子體層中衰減的數值分析
空間等離子體鞘層的時域特性研究





 針對氧氣(O2)和三氯化硼(BCl3)等離子體進行原子層蝕刻的研究
針對氧氣(O2)和三氯化硼(BCl3)等離子體進行原子層蝕刻的研究
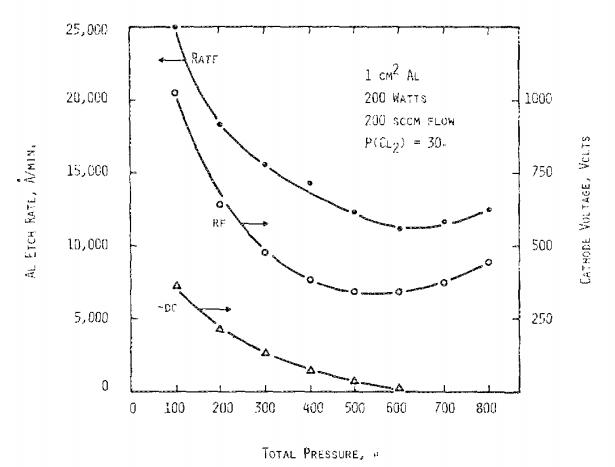
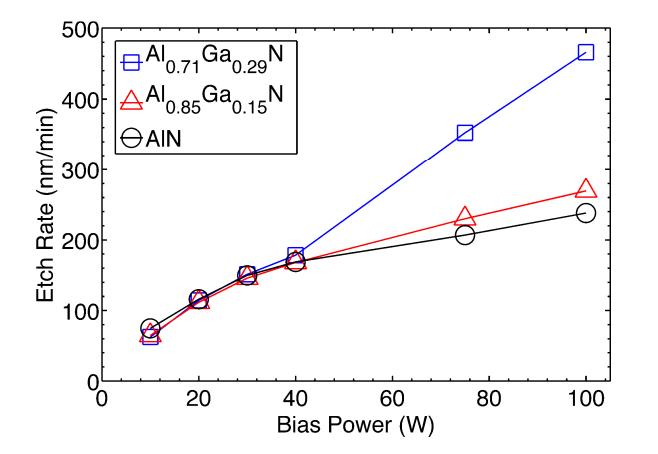
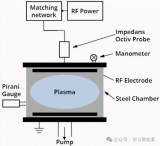










評論