上篇文章提到用于 IC 封裝的再分布層(RDL)技術(shù)Redistribution layer, RDL 的基本概念是將 I/O 焊盤的位置分配到芯片的其他位置,即用RDL轉(zhuǎn)接到錫球焊接的著陸焊盤位置,如下圖所示:

以下一種或多種情況可能需要這樣做:
a) I/O 焊盤可能太小或太緊而無法放置可靠的焊接連接;
b) I/O 焊盤可能需要放置在更靠近芯片中心的位置以減少熱應(yīng)力;
c) 其他幾何要求(如將非對稱 I/O 布局轉(zhuǎn)換為對稱焊盤布局)可能需要 RDL。
RDL 的基本制造流程非常簡單,包括:
a) 創(chuàng)建嵌入 PI 材料中的銅引線,以將 I/O 焊盤重新布線到其著陸焊盤位置,這里主要有三步:
1)在晶圓表面頂部形成第一介電(永久)層,該層僅在 I/O 焊盤上方打開。通常,使用聚合物薄膜,例如BCB或聚酰亞胺(PI)作為絕緣體。
2)創(chuàng)建從 I/O 焊盤到著陸焊盤的銅引線。這將需要創(chuàng)建一個種子層,通常是TiW和Cu,通過臨時光刻膠創(chuàng)建“電鍍模板”,然后電化學(xué)沉積(ECD)銅引線,最后剝離光刻膠并蝕刻種子層。
3)創(chuàng)建第二個介電層。該層用于保護裸露的銅免受腐蝕,并定義著陸焊盤。
b) 在著陸焊盤頂部創(chuàng)建微凸塊(ubump, UBM),以創(chuàng)建與焊料的可靠連接,通常使用各種金屬和這些金屬的堆疊,如 Ti、Cu、Ni、Pd、Ag、Au、它主要作為焊料向金屬再分布層的擴散阻擋金屬。這些金屬可以通過ECD或濺射產(chǎn)生。無論哪種方式,都需要通過臨時光刻膠創(chuàng)建“電鍍模板”或“蝕刻模板”;
c) 最后,將可焊接金屬放在 UBM 頂部。可焊接金屬,如 SnAgCu、AuSn、PbSn,可以在 UBM 頂部形成。這可以通過 ECD 或焊球(Ball drop,BG)來完成。
窄間距RDL(Redistribution Layer)技術(shù)是一種在集成電路封裝中常用的技術(shù),用于實現(xiàn)芯片與封裝之間的連接。RDL層通常由金屬線構(gòu)成,其主要功能是將芯片上的信號和電源引腳布線映射到封裝上的引腳,以滿足高密度、高性能應(yīng)用的需求。
窄間距RDL技術(shù)的特點是在芯片和封裝之間采用了非常小的間隔距離進行布線,可以實現(xiàn)更高的引腳密度和較短的電信號傳輸路徑,從而提高了電路性能和可靠性。
窄間距RDL技術(shù)主要包括以下幾個方面的關(guān)鍵技術(shù):
- 多層金屬線:通過在RDL層中使用多層金屬線,可以實現(xiàn)更多的引腳布線和更高的信號密度。
- 超細線寬和間距:采用先進的制造工藝,使得RDL層的金屬線寬度和間距可以達到亞微米級別,從而實現(xiàn)更高的集成度。
- 低介電常數(shù)材料:選擇低介電常數(shù)的材料作為RDL層的絕緣材料,可以減小信號傳輸?shù)难舆t和損耗,提高電路性能。
- 高密度布線規(guī)則:通過優(yōu)化布線規(guī)則和算法,實現(xiàn)更高的引腳密度和更緊湊的布線結(jié)構(gòu),使得整個系統(tǒng)的功耗、面積和性能得到優(yōu)化。
下圖顯示了窄間距RDL的橫截面示意圖:
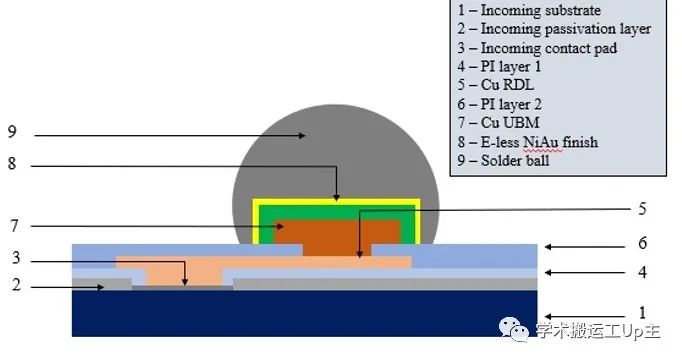
有三種不同的方案可以實現(xiàn)窄間距RDL,并且UBM之前工藝和標準流程相同,在UBM之前完成的工藝截面圖如下圖所示:
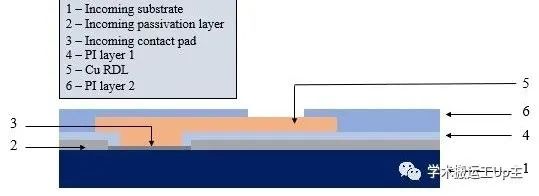
1)Cu BUM & 錫球焊
按照與前面介紹類似的工藝流程創(chuàng)建Cu UBM,通過成錫球陣列焊或錫球噴射在其上焊錫球都可行。錫球焊,如下圖所示,無論是單獨完成(滾珠噴射)還是在傳質(zhì)過程中完成,都被稱為實現(xiàn)緊密間距的可靠和快速過程。使用錫球焊的另一個好處是,幾乎任何可以形成焊球的金屬,包括三元金屬;
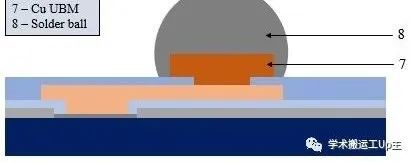
2) Cu UBM & 化學(xué)鍍NiAu & 錫球焊
在Cu UBM頂部沉積化學(xué)鍍的NiAu,首先要對Cu UBM表面進行預(yù)處理。首先,氧化銅被銅蝕刻劑去除,并沉積一層薄薄的鈀 (Pd) 種子層。然后,Cu UBM化學(xué)鍍上一層Ni(自催化),然后通過氧化還原反應(yīng)機制浸入Au。
隨著化學(xué)鍍鎳在橫向以及高度或厚度上的生長,原來的Cu UBM直徑會略有擴大,UBM直徑的擴大可以估計為鎳高度的2倍。這為滿足回流焊后所需的焊球高度提供了一定的靈活性。通過控制 Ni 厚度來調(diào)整化學(xué)鍍 Ni 直徑,可以創(chuàng)建不同的 UBM 直徑,從而影響焊接高度。完成化學(xué)鍍 NiAu 表面處理后,使用相同的方法將助焊劑和焊球放置在 UBM 頂部,即 GBP 或焊料噴射。
與1)相比,方案2)中的Cu UBM覆蓋有NiAu層,并為Cu UBM提供了防腐蝕保護的額外好處,如下圖所示:
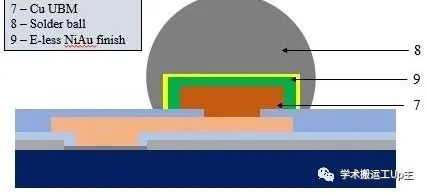
3)Cu柱 & SnAg cap
在焊盤的頂部創(chuàng)建帶有錫銀(SnAg cap)蓋帽的銅柱,如下圖所示。其中Cu柱和SnAg帽是在同一電鍍工具中通過電鍍工藝完成的。使用此方案,可以省略化學(xué)鍍 NiAu 和錫球焊的過程。此方案也適用于相對較小的銅柱直徑和小間距應(yīng)用,且需要更厚的臨時光刻膠,因為整體柱的高度可達 100 μm。
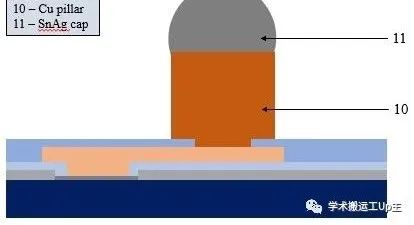
該方案的缺點是焊料合金選擇的限制。SnAg合金中的Ag百分比通常通過改變SnAg電解液中的Ag濃度或SnAg鍍層電流密度將其控制在1.5%至2.5%的范圍內(nèi)。
窄間距RDL技術(shù)在高性能芯片封裝中起著重要的作用,它可以支持更高的帶寬、更低的延遲和更高的集成度。這些特點使得窄間距RDL技術(shù)在高速通信、人工智能、云計算等領(lǐng)域得到廣泛應(yīng)用。
-
芯片
+關(guān)注
關(guān)注
456文章
51164瀏覽量
427200 -
集成電路
+關(guān)注
關(guān)注
5392文章
11621瀏覽量
363160 -
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27697瀏覽量
222593 -
IC封裝
+關(guān)注
關(guān)注
4文章
185瀏覽量
26815 -
晶圓級封裝
+關(guān)注
關(guān)注
5文章
33瀏覽量
11549
發(fā)布評論請先 登錄
相關(guān)推薦
一種新型RDL PoP扇出晶圓級封裝工藝芯片到晶圓鍵合技術(shù)





 晶圓級封裝中的窄間距RDL技術(shù)
晶圓級封裝中的窄間距RDL技術(shù)















評論