下面對電場積分,我們看看隨著 增長,即耗盡區(qū)深度的增長,柱面結與平面結所承受電壓分布的差異。
增長,即耗盡區(qū)深度的增長,柱面結與平面結所承受電壓分布的差異。
因為電壓主要由摻雜濃度更低的基區(qū)來承受,所以在耗盡區(qū)內對(7-3)從PN結邊界到耗盡區(qū) 積分,即得到電壓分布
積分,即得到電壓分布 ,
,

回顧《IGBT中的若干PN結》,對于平面PN結,電壓分布表達式為


對于1200V器件,假設其襯底濃度 為
為 ,可以看出來,柱面結所延展出來的耗盡區(qū),其電壓增長速度遠遠高于平面結,所以必須采用多個柱面結來分擔電壓。
,可以看出來,柱面結所延展出來的耗盡區(qū),其電壓增長速度遠遠高于平面結,所以必須采用多個柱面結來分擔電壓。
以上,我們討論了柱面結相較平面結的變化趨勢,發(fā)現(xiàn)其差異已經如此之大。實際上對于芯片四個角落的PN結,其形貌為球面結,上述差異會進一步擴大,相同電壓情況下,PN結界面的電場差別更大(后面我們會進行計算),這在IGBT設計過程中必須要仔細斟酌。
下面我們再分析一下柱面結和平面結的雪崩電壓差異。PN結的雪崩電壓指的是PN結發(fā)生雪崩擊穿時所對應的電壓值。
之所以會發(fā)生雪崩擊穿,是因為載流子(電子或者空穴)在耗盡區(qū)中被電場加速,這個過程中可能會與低能量的電子(本來處于禁帶)發(fā)生碰撞,而將其激發(fā)到導帶,成為新的載流子。
在《微觀電流》一章中,我們對這個過程進行過描述。顯然,當載流子能量足夠大,使其碰撞產生的新的載流子數(shù)量大于復合的載流子數(shù)量,那么這個碰撞過程就會持續(xù)積累,最終發(fā)生“雪崩”而損壞。
雪崩過程通常用碰撞電離率 來描述,其物理意義為載流子在耗盡區(qū)中經過1cm所碰撞產生的電子空穴對。
來描述,其物理意義為載流子在耗盡區(qū)中經過1cm所碰撞產生的電子空穴對。
假如1個電子進入耗盡區(qū),很容易推測,當這個電子穿過整個耗盡區(qū)過程中,其碰撞產生的電子數(shù)量多余1個,那么就會發(fā)生雪崩效應。
這個過程用數(shù)學表達式描述即為 ,以此為條件我們就可以計算出來平面結和柱面結的雪崩電場值。
,以此為條件我們就可以計算出來平面結和柱面結的雪崩電場值。
碰撞電離率一般為經驗表達式,其中常用的一種簡化表達式為:

先看平面結,其電場表達式為 ,帶入(7-9)并對
,帶入(7-9)并對 在整個耗盡區(qū)進行積分,
在整個耗盡區(qū)進行積分,

同樣,對于1200V的IGBT,假設PN結深 ,襯底濃度
,襯底濃度 為
為 ,求解(7-10),可以得到雪崩時的耗盡區(qū)寬度
,求解(7-10),可以得到雪崩時的耗盡區(qū)寬度 ,相應的電場即為雪崩電場,即
,相應的電場即為雪崩電場,即

再看柱面結,其電場分布表達式為(7-3),帶入(7-9),

求解(7-12),得到 ,明顯小于平面結的耗盡區(qū)寬度,相應的電場即為雪崩電場,即
,明顯小于平面結的耗盡區(qū)寬度,相應的電場即為雪崩電場,即

對照(7-11)和(7-13),按碰撞電離的經驗公式(7-9)所計算出來的雪崩擊穿電場有所不同,但在同一個數(shù)量級,這個計算過程是可信的。
因此,柱面結雪崩時的耗盡區(qū)僅為40 ,而平面結雪崩時的耗盡區(qū)卻可以達到175
,而平面結雪崩時的耗盡區(qū)卻可以達到175 柱面結雪崩時的耗盡區(qū)寬度遠遠小于平面結。
柱面結雪崩時的耗盡區(qū)寬度遠遠小于平面結。
將雪崩電場所對應的耗盡區(qū)寬度 分別帶入(7-7)和(7-8),并將摻雜濃度設定為8e13(1200V規(guī)格),可以得到平面結和柱面結在雪崩時所對應的耐壓分別為1920V和250V。
分別帶入(7-7)和(7-8),并將摻雜濃度設定為8e13(1200V規(guī)格),可以得到平面結和柱面結在雪崩時所對應的耐壓分別為1920V和250V。
以上,我們詳細討論了平面結和柱面結的耐壓差異的原因,并結合1200V-IGBT的摻雜濃度,計算了具體的雪崩電場和耐受電壓。按照相同邏輯,結合球坐標系,對球面結的雪崩電場和耐受電壓進行計算。
-
IGBT
+關注
關注
1269文章
3834瀏覽量
250080 -
PN結
+關注
關注
8文章
483瀏覽量
48911 -
擊穿電壓
+關注
關注
1文章
59瀏覽量
9061 -
載流子
+關注
關注
0文章
134瀏覽量
7693
發(fā)布評論請先 登錄
相關推薦
瑞薩600V耐壓超結MOSFET 導通電阻僅為150mΩ
超級結MOSFET
[中階科普向]PN結曲率效應——邊緣結構
基于碰撞電離率的平行平面結和晶閘管的研究
逆阻型IGBT的相關知識點介紹
高耐壓超級結MOSFET的種類與特征
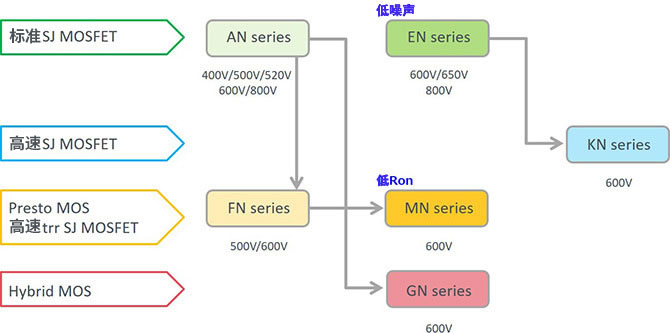




 IGBT的終端耐壓結構—平面結和柱面結的耐壓差異(2)
IGBT的終端耐壓結構—平面結和柱面結的耐壓差異(2)
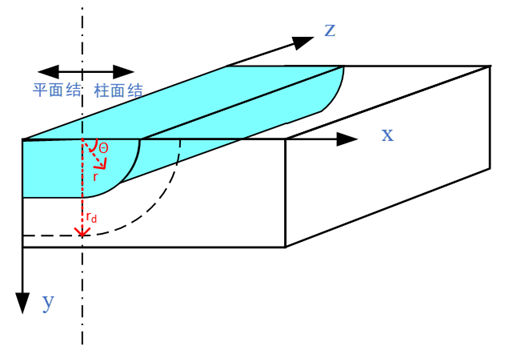













評論