大約兩、三年前,多芯片(Multi-Die)系統在行業中還較為罕見,當時僅有少數公司探索基于2.5D中介層的設計。然而,隨著高性能計算的興起,越來越多的公司開始競相轉向2.5D,以及3D。Multi-Die系統快速發展。所以如果現在你還不了解Multi-Die系統的原理、本質和作用,那么你可能會顯得有點落后了。
無論是探索Multi-Die系統,還是在設計中實施架構,開發者都需要了解整個半導體供應鏈生態系統的來龍去脈,才能夠更從容的在架構中創造出更好的設計。在新思科技最近組織的一次行業座談會中,來自Ansys、博世、英特爾、三星以及新思科技內部的專家,共同探討了Multi-Die系統迅速普及的原因,未來將面臨的挑戰,以及各個大廠是如何挖掘Multi-Die系統潛力等多個精彩話題。
01.Multi-Die系統:起于但卻不止于高性能計算
誠然,高性能計算是Multi-Die系統興起的重要推動力,所有這些新的AI應用、大型語言模型(LLM),如ChatGPT,他們要處理的工作量是巨大的,迫切需要更高效的計算方式。應用程序中的性能需求每兩年增長800倍,這顯然是摩爾定律所無法實現的。
而Multi-Die技術在解決核心擴展問題和當前2D單芯片的限制方面具有顯著優勢,新思科技負責Multi-Die系統解決方案資深產品總監Shekhar Kapoor認為,從技術和成本角度來看,Multi-Die系統正在解決當下行業內的四大挑戰:“
1)技術擴增的難題,摩爾定律的回報遞減;
2)掩膜版的大小無法持續增加;
3)新制程節點的成本不斷攀升,良率也隨著芯片的增大變得越來越低;
4)SoC中數據的傳入、傳出需求巨大,如何讓數據和存儲靠的更近?”
利用Multi-Die系統能實現異構集成,并且利用較小Chiplet實現更高良率,更小的外形尺寸和緊湊的封裝,降低系統的功耗和成本。Ansys半導體產品研發主管Murat Becer指出:“3DIC正在經歷爆炸性增長,我們預計今年3DIC設計的數量將是去年的3倍左右。”
正是由于Multi-Die系統的這些優勢,業界開始思考如何將其應用在更多領域。而在眾多應用中,快速發展的汽車市場,以及處理器逐漸走到物理極限的移動設備,則是Multi-Die系統的兩個潛在的應用市場。
正如我們所看到的,汽車行業正在從L1、L2向著L3、L4的自動駕駛等級邁進,要滿足這些日益增長的自動駕駛需求,你不能將一排排的計算機直接放進汽車中,而是需要切實考慮它的外形尺寸,以便提供合適的處理能力和能效,這就推動了對Multi-Die技術的采納。“隨著未來汽車轉向軟件定義汽車,汽車中代碼量不斷激增,當今的汽車中可能有100~1億行代碼,到2030年底,代碼行數可能會增長到現在的3-5倍,達到接近8億行。但汽車行業具有一定規模,我們不可能為每輛車設計專用芯片。因此,我們非常希望能夠將這些Chiplet技術應用到汽車中,把其他行業最新最好的技術在整個汽車產品組合上實現可擴展性。”博世半導體部門Michael Schafferi強調。
“雖然移動設備市場還在觀望,但他們在面對外形尺寸和掩膜版的挑戰時也是沒有選擇的。”新思科技的Shekhar Kapoor表示,他們研究了100多個涵蓋各種封裝類型和各種應用的Multi-Die項目,發現包括政府在內的數十億美元的資金已經投入到了這一領域,未來Multi-Die系統的采用速度將大幅加快。三星負責先進封裝業務開發副總裁Cheolmin Park表示:“我們不難發現,出于成本考慮,移動市場希望將不同的功能分解為高級節點和更經濟的節點,因此也開始嘗試實施Multi-Die系統。”
總而言之,人們已經開始發揮創造力,嘗試利用先進封裝能力和Multi-Die系統來實現他們的需求,更多市場的普及和應用只是早晚的問題。
因此,隨著多個行業對速度更快、功耗更低、帶寬更高的半導體的巨大需求,未來我們可能會在AI、機器學習、CPU、GPU和移動應用中看到Multi-Die系統的部署。Multi-Die系統將是各領域的廠商,從成本甚至是產品的角度通過創造差異化而獲益的大好機會。
02.Multi-Die系統自身發展面臨哪些挑戰?
雖然Multi-Die技術解決了當下的一些行業痛點,但其自身發展也面臨著新的挑戰。假如放眼全球,我們可能會看到通常Chiplet設計整合僅僅在個別的公司所實現。就目前而言,Multi-Die系統并不適用于所有項目,一方面因為其成本和復雜性方面的因素,另一方面是Multi-Die系統還處于發展階段,在知識和經驗上的缺口還需行業共同努力填補。
英特爾架構、設計和技術解決方案副總裁Lalithe Immaneni也強調,在EDA領域,Multi-Die系統面臨三大挑戰:“
1)對于Multi-Die系統而言,EDA不僅僅是執行和構建這些3DIC結構,更多的在于協同設計和架構。
2)配套的IP如何開發?UCIe是一個良好的開端,遵循JEDEC標準的HBM是另一個例子。
3)如何大批量生產這些Multi-Die系統?這就輪到封裝大顯身手了,這也是封裝的黃金發展時代。”
Ansys的Murat Becer補充到:“3DIC技術的發展對EDA提出了多維挑戰,不僅包括電源完整性和信號完整性,還有大規模集成設計引起的熱管理問題和信號完整性分析的復雜性。EDA社區必須提升多物理場、多尺度的建模與仿真能力來設計這些復雜系統,并確保其高效生產。”
面對上述這些挑戰,僅憑一家公司是無法解決的,行業合作是未來的關鍵。只有各個環節的供應鏈廠商建立起合作關系,協同驗證芯片、3D系統和封裝,才能使3DIC設計、簽核和制造取得成功。
03.Multi-Die生態系統:可以在標準化中合作,在實現方面競爭
天下大勢,分久必合,合久必分。我們不難看到,在整個半導體行業,越來越多的重新融合正在發生,代工廠和設計廠商之間的聯系愈發密切,代工廠除生產制造外,加入了更多物理場和新方法相關的專業知識。Ansys、三星、英特爾、博世和新思科技也正在緊密合作,并在設計周期的幾個關鍵環節進行合作。
博世的Michael Schafferi強調:“面對半導體短缺暴露出的供應鏈脆弱性,我們要想將多個Chiplet整合到單一封裝中,對于Multi-Die系統的良好發展,我們的愿景是建立一個開放的生態系統,實現真正有彈性的供應鏈。要達成這一愿景,就需要廣泛的標準支持。在標準建立方面,我期待并希望業界熱衷于與合作伙伴甚至競爭對手真正的合作,建立統一的標準。我們在標準化方面合作,但是可以在實現方面競爭。”
說到標準,UCIe是Die-to-Die連接標準方面的一個很好的例子,UCIe為封裝級互聯、IO和技術方面帶來了大量的專業知識。而要想Multi-Die系統的大規模采用和發展,這還遠遠不夠。
三星的Cheolmin指出:“鑒于當下先進封裝的重要性越來越凸顯,為了實現規模經濟并向客戶提供價值,我們需要探索如何將封裝流程標準化,還有構建、限定它的方法,以及進入類似汽車等特定細分市場的方法等等。”
英特爾的Lalithe Immaneni也表示:“UCIe正在不斷適應3DIC,并提高超高密度互聯、小于25微米的凸塊兼具、更快的速度。除此之外,在裸片內存連接等方面還需要進一步標準化,比如HBM4;在EDA領域,可互操作性的EDA標準也非常關鍵;在制造設備領域,當我們把來自各個供應商的Chiplet、封裝組合在一起時,也應當需要滿足一定的標準規格。”
“關于IP復用,是否應該有一個針對所有這些3D堆疊的3D優化IP、3D強化IP,以支持正在涉及到的各種配置,例如面對面和面對背配置,我們是否需要一個棧上垂直通信的標準協議?”新思科技Shekhar談到上述關于新標準的制定。
因此,整個行業應共同努力,推動集成EDA工具標準、Die-to-Die IP連接標準、制造和封裝標準,乃至研究設備兼容性標準的發展,以加快這些Multi-Die系統的上市時間(TTM)并提高效率。
04.加速Multi-Die系統的采用,還有哪些捷徑?
裸片或Chiplet是Multi-Die系統的基本組成部分,它們常常在不同的制程節點上或由不同的代工廠制造。那么,在Chiplet市場中是否可能存在使IP復用更簡單或更具可擴展性的可能?這是否能加速Multi-Die系統的進一步發展?
對此問題,Ansys的Murat表示:“如果產業界緊密合作,創建一個chiplet庫,芯片公司就可以從這個庫中挑選合適的Chiplet并將其整合到自己的3DIC設計中。此外,每個Chiplet都應該真正包含基于物理的模型,以實現3DIC級別的多物理場驗證。
英特爾Lalithe對于建立一個富有成效的Chiplet生態系統持積極態度。利用來自不同供應商在各工藝節點上驗證的IP,可以顯著提速產品上市。復用性、可擴展性以及在降低成本和提升性能方面,Chiplet生態系統提供了更多可能。
“驅動IP復用有兩大因素:第一是成本,第二是上市時間。”博世的Michael對此進一步解釋道,“首先,你會發現Chiplet的開發成本非常高,能夠復用于多個行業Chiplet的公司將處于更有利的位置;在當今時代,時間就是金錢,中國汽車市場的發展速度驚人,我們必須要及時跟上潮流。”
但歸根結底,對于Multi-Die系統的長遠發展,長期可靠性是至關重要的因素。要達到這一目標,需要整個供應鏈進行層層把關。
Ansys的Murat Becer強調了兩點:“首先,要確保Multi-Die系統的設計和驗證方法足夠可信,通過多物理場驗證和跨平臺合作,確保系統的可靠性;其次,針對3DIC系統的特殊性,由于設計自由度和參數的顯著提升,高效的早期原型設計至關重要。”
“如果你觀察Multi-Die系統的整體構成,就會發現可靠性、良率、安全性,所有這些問題都開始凸顯,整個系統中最弱的部分決定了整體的表現。”新思科技的Shekhar指出,需要用全局的眼光看待問題,不僅必須確保每個部分的可靠性,還要確保整個系統的可靠性,對所有裸片進行更復雜的模型管理。比如,一個簡單的雙裸片、一個中介層和一個封裝,他們各自有95%的良率,但是放在一起,最終只有80%的良率。在Chiplet庫中,Chiplet可能來自不同的供應商,這可能會增加其可靠性方面的挑戰,那么它必須具有可追溯性、監測數據、安全簽名等。關于這些,新思科技的siliconDASH數據分析技術將可以用來分析、校對和合并來自不同來源的所有數據。
三星的Cheolmin Park指出:“Multi-Die系統和先進封裝引入的新組件,比如硅通孔(TSV)和封裝層面的組件,都是新挑戰。這些系統的帶寬、凸塊數量以及連通性都比以前有了質的飛躍,再加上熱管理的復雜性,這要求我們從性能、功耗和可靠性角度全面理解組件間的相互作用。為此,我們需要在EDA合作伙伴的工具集中包含這些因素,以便在客戶現場測試前就能預測組件和封裝級別的長期可靠性。這就要求我們與EDA供應商緊密合作,并盡可能透明地交換數據集。”
05.總結
在這場關于Multi-Die系統綜合問題的討論中,行業專家們的見解讓我們得以了解現在Multi-Die發展的來龍去脈,并窺見了未來的輪廓。這些觀點不僅呈現了一個技術進步迅猛的行業圖景,而且也描繪了一個需要創新思維和跨學科合作的未來。面對Multi-Die系統所引領的新技術革命的浪潮,行業正在步入一個以系統為核心,合作共贏為基石的新時代。隨著云計算和人工智能的融入,我們可以預見,無論是在設計理念、生產流程還是最終產品方面,未來都將呈現前所未有的變化。正如這些專家所展示的那樣,不斷的創新和適應,將是推動行業發展、迎接挑戰的不竭動力。
-
Multi
+關注
關注
0文章
16瀏覽量
8596 -
人工智能
+關注
關注
1796文章
47683瀏覽量
240302 -
生態系統
+關注
關注
0文章
704瀏覽量
20784
原文標題:Multi-Die系統,掀起新一輪技術革命!
文章出處:【微信號:算力基建,微信公眾號:算力基建】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
互聯網掀起新的一輪自動化工業革命
討論壓電式雨量監測新裝置是怎樣引領雨量監測新一輪技術革命的??一組參數告訴你!
發起硬盤效能新革命 希捷強推Multi Actuator技術
阿里騰訊7000億元加碼新基建,在新一輪技術革命中搶占話語權
2023是否會成為Multi-Die的騰飛之年?
芯片革命:Multi-Die系統引領電子設計進階之路
設計更簡單,運行更穩健,UCIe標準如何“拿捏”Multi-Die系統?
如何成功實現Multi-Die系統的方法學和技術
Multi-Die系統驗證很難嗎?Multi-Die系統驗證的三大挑戰
利用Multi-Die設計的AI數據中心芯片對40G UCIe IP的需求
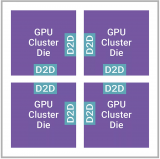




 Multi-Die系統,掀起新一輪技術革命!
Multi-Die系統,掀起新一輪技術革命!










評論