以IGBT、MOSFET為主的電力電子器件通常具有十分廣泛的應(yīng)用,但廣泛的應(yīng)用場(chǎng)景也意味著可能會(huì)出現(xiàn)各種各樣令人頭疼的失效情況,進(jìn)而導(dǎo)致機(jī)械設(shè)備發(fā)生故障!
因此,正確分析電力電子器件的失效情況,對(duì)于提高電力電子器件的應(yīng)用可靠性顯得尤為重要。
01
失效分析簡(jiǎn)介
失效分析的過程一般是指根據(jù)失效模式和現(xiàn)象,通過分析和驗(yàn)證,模擬重現(xiàn)失效的現(xiàn)象,找出失效的原因,挖掘出失效的機(jī)理的過程。
器件失效是指其功能完全或部分喪失、參數(shù)漂移,或間歇性出現(xiàn)以上情況。失效模式是產(chǎn)品失效的外在宏觀表現(xiàn),有開路、短路、時(shí)開時(shí)斷、功能異常、參數(shù)漂移等。按照失效機(jī)理,失效可分為結(jié)構(gòu)性失效、熱失效、電失效、腐蝕失效等。
1、結(jié)構(gòu)性失效
指產(chǎn)品的結(jié)構(gòu)由于材料損傷或蛻變而造成的失效,如疲勞斷裂、磨損、變形等。主要由結(jié)構(gòu)材料特性及受到的機(jī)械應(yīng)力造成,有時(shí)候也和熱應(yīng)力和電應(yīng)力有關(guān)。
2、熱失效
指產(chǎn)品由于過熱或急劇溫度變化而導(dǎo)致的燒毀、熔融、蒸發(fā)、遷移、斷裂等失效。主要由熱應(yīng)力造成,往往也與產(chǎn)品的結(jié)構(gòu)設(shè)計(jì)、材料選擇有關(guān)。
3、電失效
產(chǎn)品由于過電或長(zhǎng)期電應(yīng)力作用而導(dǎo)致的燒毀、熔融、參數(shù)漂移或退化等失效。主要由電應(yīng)力造成,但與材料缺陷、結(jié)構(gòu)密切相關(guān)。
4、腐蝕性失效
指產(chǎn)品受到化學(xué)腐蝕、電化學(xué)腐蝕,或材料出現(xiàn)老化、變質(zhì)而造成的失效。主要由腐蝕性物質(zhì)(如酸、堿等)的侵入或殘留造成,也與外部的溫度、濕度、電壓等因素有關(guān)。
通過確認(rèn)失效模式、分析失效機(jī)理,明確失效原因,最終給出預(yù)防對(duì)策,可以減少或避免失效的再次發(fā)生。失效分析對(duì)產(chǎn)品的生產(chǎn)和使用都具有重要的意義。
02
失效分析流程
失效分析的原則是先進(jìn)行非破壞性分析,后進(jìn)行破壞性分析;先外部分析,后內(nèi)部(解剖)分析;先調(diào)查了解與失效有關(guān)的情況(應(yīng)用條件、失效現(xiàn)象等),后分析失效器件。

03
失效分析常用技術(shù)
在開展失效分析時(shí),一定是和相應(yīng)的技術(shù)手段和設(shè)備手段密不可分的。常用技術(shù)手段分為以下幾類:
1、電氣測(cè)試技術(shù)
對(duì)失效現(xiàn)象、失效模式進(jìn)行確認(rèn),以及在失效激發(fā)及驗(yàn)證試驗(yàn)前后的電性能測(cè)試。例如在進(jìn)行芯片損傷外觀鑒定之前,可進(jìn)行IV測(cè)試,得到損傷器件的靜態(tài)特性參數(shù),初步確定失效情況;
2、顯微形貌和顯微結(jié)構(gòu)分析技術(shù)
在微米和納米尺度對(duì)元器件進(jìn)行觀察和分析,以發(fā)現(xiàn)器件內(nèi)部的失效現(xiàn)象和區(qū)域。顯微形貌分析技術(shù)包括光學(xué)顯微(OM)分析、掃描電子顯微(SEM)分析、透射電子顯微(TEM)分析等。顯微結(jié)構(gòu)分析技術(shù)包括以X射線顯微透視、掃描聲學(xué)顯微(SAM)探測(cè)為代表的無損顯微結(jié)構(gòu)探測(cè)技術(shù)。
3、物理性能探測(cè)技術(shù)
對(duì)器件在特定狀態(tài)下激發(fā)產(chǎn)生的微量光熱磁等信息進(jìn)行提取和分析,已確定失效部位、分析失效機(jī)理。技術(shù)包括電子束測(cè)試(EBT)、微光探測(cè)、顯微紅外熱像、顯微磁感應(yīng)技術(shù)等。
4、微區(qū)成分分析技術(shù)
用來對(duì)內(nèi)部微小區(qū)域的微量成分進(jìn)行分析。技術(shù)包括能量散射譜儀(EDS)、俄歇電子譜法(AES)、二次離子質(zhì)譜法(SIMS)、X射線光電子譜法(XPS)、傅里葉紅外光譜儀(FT-IR)、內(nèi)部氣氛分析法(IVA)等。
5、應(yīng)力驗(yàn)證技術(shù)
基本手段如開展透射顯微鏡(TEM)分析時(shí),就需要采用聚焦離子束(FIB)對(duì)器件進(jìn)行定點(diǎn)取樣和提取。有時(shí)需要開展一些應(yīng)力試驗(yàn)來激發(fā)失效、復(fù)現(xiàn)失效模式或觀察在應(yīng)力條件下失效的變化趨勢(shì)。
6、解剖制樣技術(shù)
實(shí)現(xiàn)芯片表面和內(nèi)部的可觀察性和可探測(cè)性。例如開封技術(shù)、半導(dǎo)體芯片表面去鈍化和去層間介質(zhì)、機(jī)械剖面制備技術(shù)和染色技術(shù)等。
04
功率器件常見失效現(xiàn)象
1、過壓
集電極-發(fā)射極過壓時(shí),在芯片周圍會(huì)出現(xiàn)大范圍燒毀的痕跡。原因可能包括關(guān)斷浪涌電壓、母線電壓上升、控制信號(hào)異常、外部的浪涌電壓(雷電浪涌等)等。
柵極-發(fā)射極過壓時(shí),柵極bonding線或是集成柵極極電阻周圍會(huì)有燒毀的痕跡。原因可能包括靜電、柵極驅(qū)動(dòng)回路異常、柵極震蕩、外部浪涌等。
2、過流
過電流脈沖時(shí),bonding線和發(fā)射極交接處會(huì)有燒毀的痕跡。原因可能包括過電流保護(hù)不工作、串聯(lián)支路短路、輸出短路或輸出接地等。
3、超出反偏安全工作區(qū)
芯片正面可看到燒熔的洞。原因可能包括集電極-發(fā)射極間過壓、器件過流等。
4、過溫
芯片表面出現(xiàn)鋁層熔化、bonding線燒熔、芯片底部焊錫溢出等現(xiàn)象。原因可能是開關(guān)頻率異常增大、開關(guān)時(shí)間過長(zhǎng)、散熱不良引起的導(dǎo)通損耗增加、開關(guān)損耗增加、接觸面熱阻增大、外殼溫度上升等。
5、功率循環(huán)、熱循環(huán)疲勞
出現(xiàn)bonding線脫落的現(xiàn)象,是由于熱膨脹系數(shù)不同而產(chǎn)生的應(yīng)力,導(dǎo)致鋁線剝落。熱循環(huán)疲勞也會(huì)使位于底板和絕緣基片間的焊接層破裂。
以上就是對(duì)失效分析過程簡(jiǎn)單介紹的所有內(nèi)容啦。
-
紅外光譜儀
+關(guān)注
關(guān)注
1文章
63瀏覽量
10285 -
SAM
+關(guān)注
關(guān)注
0文章
113瀏覽量
33578 -
失效分析
+關(guān)注
關(guān)注
18文章
219瀏覽量
66481 -
TEM
+關(guān)注
關(guān)注
0文章
89瀏覽量
10447 -
EDS
+關(guān)注
關(guān)注
0文章
96瀏覽量
11589
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
什么是電阻器的失效模式?失效機(jī)理深度分析必看
電容器的常見失效模式和失效機(jī)理【上】
失效分析分類有哪些?
IC失效分析培訓(xùn).ppt
電容的失效模式和失效機(jī)理
元器件失效了怎么分析? 如何找到失效原因?
電子產(chǎn)品的失效原因分析
失效分析常用的設(shè)備及功能
從安全工作區(qū)探討IGBT的失效機(jī)理
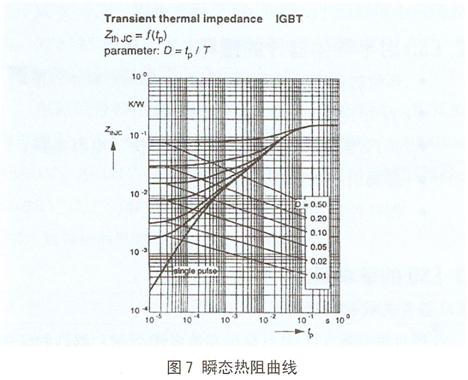
失效分析基礎(chǔ)學(xué)習(xí)

電容失效模式和失效機(jī)理分析
電阻器常見的失效模式與失效機(jī)理





 失效分析的原因、機(jī)理及其過程介紹
失效分析的原因、機(jī)理及其過程介紹











評(píng)論