本文作者:安森美電源方案部汽車(chē)主驅(qū)逆變器半導(dǎo)體中國(guó)區(qū)負(fù)責(zé)人Bryan Lu
前面的文章,和大家分享了安森美(onsemi)在襯底和外延的概況,同時(shí)也分享了安森美在器件開(kāi)發(fā)的一些特點(diǎn)和進(jìn)展(直達(dá)鏈接一文為您揭秘碳化硅芯片的設(shè)計(jì)和制造),到這里大家對(duì)于SiC的產(chǎn)業(yè)鏈已經(jīng)有一定的了解了。也就是從襯底到芯片,對(duì)于一個(gè)SiC功率器件來(lái)說(shuō)只是完成了一半的工作,還有剩下一半就是這次我們要分享的封裝。好的封裝才能把SiC的性能發(fā)揮出來(lái),這次我們會(huì)從AQG324這個(gè)測(cè)試標(biāo)準(zhǔn)的角度來(lái)看芯片和封裝的開(kāi)發(fā)與驗(yàn)證。
圖一是SSDC模塊的剖面示意圖,圖二是整個(gè)SSDC模塊的結(jié)構(gòu)圖,從圖一和圖二我們可以發(fā)現(xiàn)這個(gè)用在主驅(qū)的功率模塊還是比較復(fù)雜的,里面包含了許多的零部件。我們?cè)趺幢WC這個(gè)SSDC功率模塊能在汽車(chē)的應(yīng)用環(huán)境下達(dá)到預(yù)期的工作壽命?

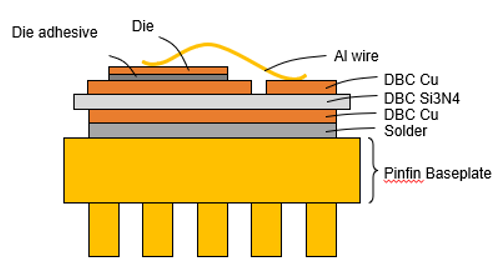
圖一:SSDC模塊剖面示意圖

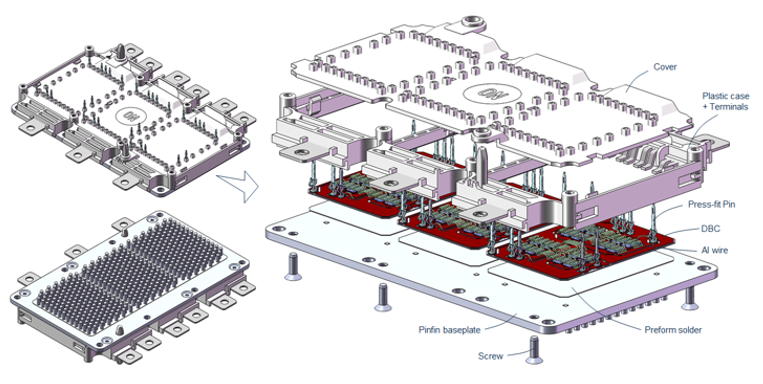
圖二:SSDC模塊的結(jié)構(gòu)圖
相信很多的汽車(chē)主驅(qū)相關(guān)的工程師和廣大行業(yè)從業(yè)人員都了解到,汽車(chē)功率模塊的開(kāi)發(fā)過(guò)程中有一個(gè)非常重要的測(cè)試標(biāo)準(zhǔn),這就是AQG324,它是歐洲電力電子中心(European Center for Power Electronics)主導(dǎo)的測(cè)試標(biāo)準(zhǔn),AQG324代表了一個(gè)基于最佳實(shí)踐和卓越需求的行業(yè)指南。它是汽車(chē)功率模塊的一個(gè)基本標(biāo)準(zhǔn),也就是說(shuō)是個(gè)門(mén)檻,只有完成了根據(jù)它的測(cè)試規(guī)范設(shè)計(jì)的測(cè)試計(jì)劃才能得到廣大的車(chē)廠認(rèn)可。所以滿(mǎn)足AQG324只是一個(gè)基本的要求。由于它是一個(gè)行業(yè)標(biāo)準(zhǔn)不是強(qiáng)制性的,最終的決定權(quán)取決于最終的用戶(hù)。安森美所有的汽車(chē)級(jí)SiC功率模塊都是通過(guò)了AQG324的測(cè)試規(guī)范。新研發(fā)的SiC功率模塊則完全滿(mǎn)足最新的AQG324規(guī)范。AQG324目前最新版本是發(fā)布于31.05.2021,這個(gè)版本比之前的多了一些針對(duì)SiC的內(nèi)容,這一部分附加的部分是針對(duì)SiC等三代半半導(dǎo)體的,前面的測(cè)試規(guī)范是針對(duì)硅基半導(dǎo)體。所以當(dāng)前的絕大多數(shù)做車(chē)規(guī)功率模塊的廠家都會(huì)也都要研究這個(gè)測(cè)試規(guī)范。圖三是安森美最新的SiC功率模塊AQG324兼容性。

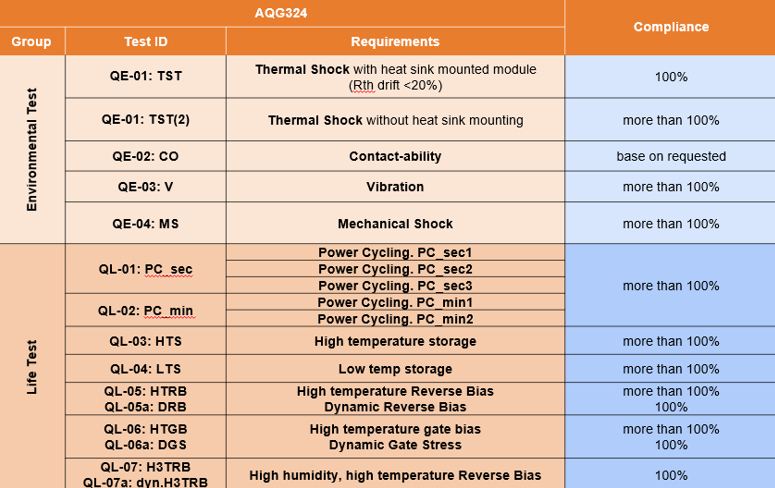
圖三:安森美AQG324規(guī)范兼容性
為了方便理解封裝的測(cè)試開(kāi)發(fā),用圖四的項(xiàng)目開(kāi)發(fā)表為例子,這樣會(huì)有助于理解整個(gè)模塊的開(kāi)發(fā)流程。

圖四:項(xiàng)目開(kāi)發(fā)簡(jiǎn)表
我們會(huì)發(fā)現(xiàn)在項(xiàng)目開(kāi)始之后會(huì)做不同的DOE,還有不同的前期的驗(yàn)證測(cè)試計(jì)劃,最后才開(kāi)始正式的AQG324,實(shí)際的項(xiàng)目會(huì)遠(yuǎn)比這個(gè)復(fù)雜,這里僅僅是一個(gè)簡(jiǎn)單的示意。為什么我們需要這些流程?AQG324都有哪些內(nèi)容?
其實(shí)所有的前期驗(yàn)證測(cè)試都是基于AQG324的測(cè)試標(biāo)準(zhǔn)針對(duì)特定的一些項(xiàng)目展開(kāi)的,當(dāng)這些項(xiàng)目都滿(mǎn)足要求之后才會(huì)正式的開(kāi)始制作B樣,開(kāi)始進(jìn)行完整的AQG324測(cè)試,樣品通過(guò)測(cè)試之后就能得到C樣,然后開(kāi)始準(zhǔn)備量產(chǎn)相關(guān)工作。圖五是AQG324里的模塊測(cè)試相關(guān)項(xiàng)。


圖五:AQG324模塊測(cè)試相關(guān)項(xiàng)
最左邊一列可以說(shuō)就是AQG324的測(cè)試項(xiàng)目,至于具體的測(cè)試條件和開(kāi)發(fā)的模塊等有關(guān)系。這些都是Si的測(cè)試項(xiàng)。下面把AQG324大致展開(kāi)來(lái)看一下,它都測(cè)試哪些內(nèi)容,它背后的邏輯是怎樣的。圖六是AQG324的框架,從這個(gè)AQG324的框架我們可以看出它的背后的邏輯。


圖六:AGQ324框架
首先特性測(cè)試確保參加測(cè)試的模塊的基本特性,建立一個(gè)特性參數(shù)的標(biāo)準(zhǔn),用來(lái)和后面的一些壽命相關(guān)測(cè)試比對(duì),作為失效的判斷標(biāo)準(zhǔn)。環(huán)境測(cè)試則側(cè)重于一些機(jī)械特性相關(guān)的測(cè)試。壽命測(cè)試則從各方面考核了模塊封裝以及芯片的可靠性,并且通過(guò)功率循環(huán)測(cè)試結(jié)合汽車(chē)廠商的路譜(mission profile)可以計(jì)算出功率模塊的壽命。這個(gè)就是AQG324的一個(gè)目的,通過(guò)一系列的測(cè)試來(lái)推算出功率模塊的使用壽命。
圖七是平面結(jié)構(gòu)的SiC結(jié)構(gòu)示意圖以及SiC功率模塊的結(jié)構(gòu)示意圖。從圖七(a)可以看到芯片也是一層一層的堆疊起來(lái)的,一般MOS的芯片差不多在15-20層之間。AQG324的壽命測(cè)試?yán)锏腍TGB,HTRB以及H3TRB和HTSL/LTS等主要是對(duì)SiC的芯片各層進(jìn)行了測(cè)試,而功率循環(huán)則是向上文所展開(kāi)的那樣對(duì)芯片和下面的陶瓷基板以及散熱基板的連接部分進(jìn)行了測(cè)試。其實(shí)測(cè)試只是最后的驗(yàn)證考核的手段之一,整個(gè)項(xiàng)目從一開(kāi)始就要針對(duì)這些測(cè)試可能會(huì)照成的失效進(jìn)行有針對(duì)性的設(shè)計(jì)。所以從芯片的研發(fā)、生產(chǎn)的工藝以及模塊的研發(fā)和生產(chǎn)工藝都要針對(duì)AGQ324來(lái)展開(kāi)。這也就是我們常說(shuō)的“design for Quality”。

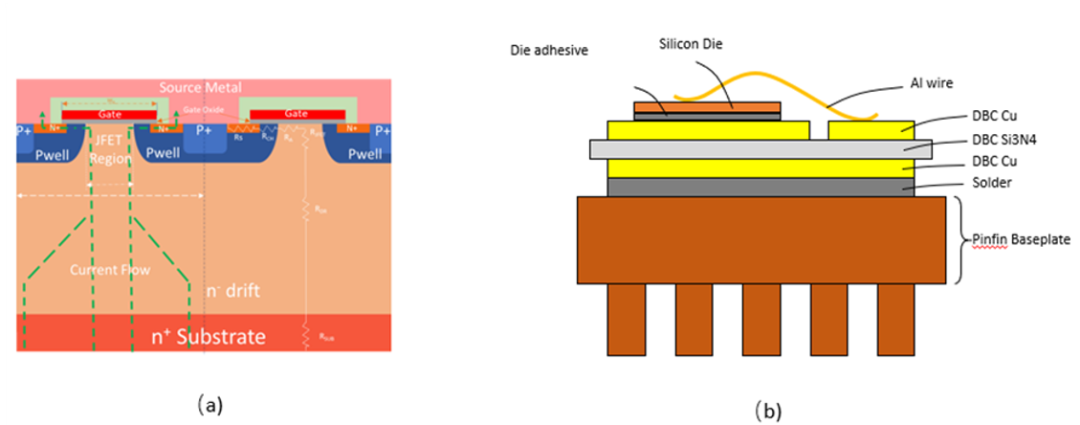
圖七:SiC芯片結(jié)合和SiC功率模塊結(jié)構(gòu)
圖八是硅基功率模塊和WBG功率模塊差異部分,它們的差異主要是集中在壽命測(cè)試相關(guān)的項(xiàng)目。


圖八:AQG324Si和SiC測(cè)試差異
下面我們將從功率循環(huán)、高溫反偏、高低溫反偏等幾個(gè)方面來(lái)展開(kāi),看看在AQG324測(cè)試中對(duì)SiC功率模塊的哪些方面進(jìn)行了測(cè)試,有哪些方面的挑戰(zhàn)。
功率循環(huán)測(cè)試 Power Cycling
這里有兩個(gè)條件一個(gè)是分鐘級(jí)別的一個(gè)是秒級(jí)的。我們可以從圖八的溫度曲線看出它們的差異。

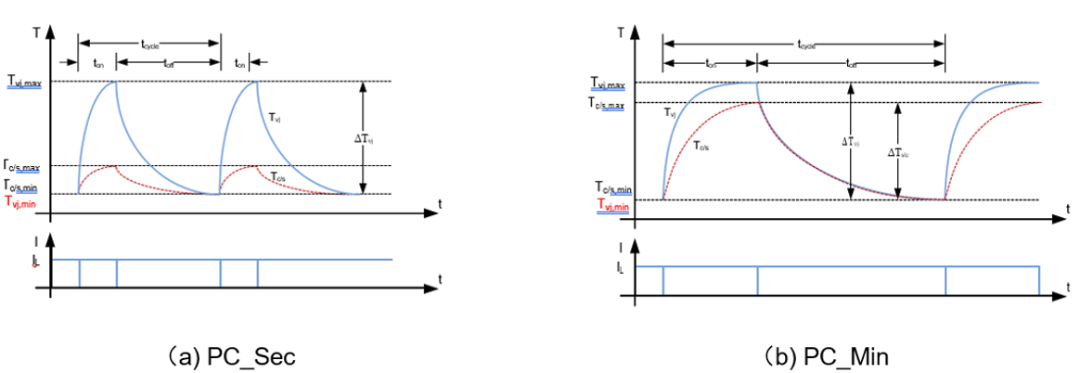
圖九:PC_Sec Vs PC_Min
-
在秒級(jí)的功率循環(huán)里,由于Ton和Toff的時(shí)間比較短,所以可以看到芯片的節(jié)溫會(huì)上升比較快,但是Tc也就是外殼的溫度上升比較緩慢,這樣的沖擊其實(shí)對(duì)于和芯片接觸的地方相對(duì)來(lái)說(shuō)會(huì)集中一些,也就是主要側(cè)重于測(cè)試芯片bonding和芯片與下面基板焊接的可靠性。
-
在分鐘級(jí)別的功率循環(huán)里,由于開(kāi)關(guān)周期比較長(zhǎng),所以Tc的變化會(huì)比較大,同時(shí)溫度也是以Tc為準(zhǔn),這樣的話(huà)對(duì)于基板和下面的散熱器的焊接處的沖擊相對(duì)會(huì)大一些,所以我們可以理解為它側(cè)重于測(cè)試基板和下面的散熱器的焊接性能。
這兩個(gè)功率循環(huán)的測(cè)試,對(duì)于Si和SiC來(lái)說(shuō),是相似的,但是由于SiC可以承受更高的工作溫度,現(xiàn)在有不少的廠家在針對(duì)SiC的功率循環(huán)測(cè)試?yán)锇裈vjmax=200度也加到了測(cè)試條件里。安森美的SiC功率模塊新的也都有做一些針對(duì)性的測(cè)試。由于SiC芯片和IGBT芯片相比面積要小不少,所以熱阻也要大不少,在這里對(duì)于SiC芯片的互聯(lián)技術(shù)就提出了一定的挑戰(zhàn),這里就包含了SiC的源極的互連,傳統(tǒng)的bonding線,它們的功率循環(huán)的次數(shù)和相同條件下的比如clip的焊接等方法比就要略差一些。
功率循環(huán)還有一個(gè)作用就是可以把生產(chǎn)工藝中的一些致命缺陷暴露出來(lái),由于整個(gè)芯片是由成千上萬(wàn)個(gè)基礎(chǔ)的開(kāi)關(guān)單元構(gòu)成的,這些單元中任一個(gè)單元如果有一些致命的缺陷,那么在功率循環(huán)中會(huì)加速它們的老化然后導(dǎo)致失效,從而導(dǎo)致整個(gè)功率循環(huán)次數(shù)降低。
圖十是節(jié)選自AQG324的一些典型的功率循環(huán)失效模式。從這里我們可以清晰的看到秒級(jí)功率循環(huán)導(dǎo)致的bonding線脫落,芯片的金屬層退化導(dǎo)致焊接質(zhì)量下降。分鐘級(jí)的功率循環(huán)導(dǎo)致的DBC裂痕等失效現(xiàn)象。

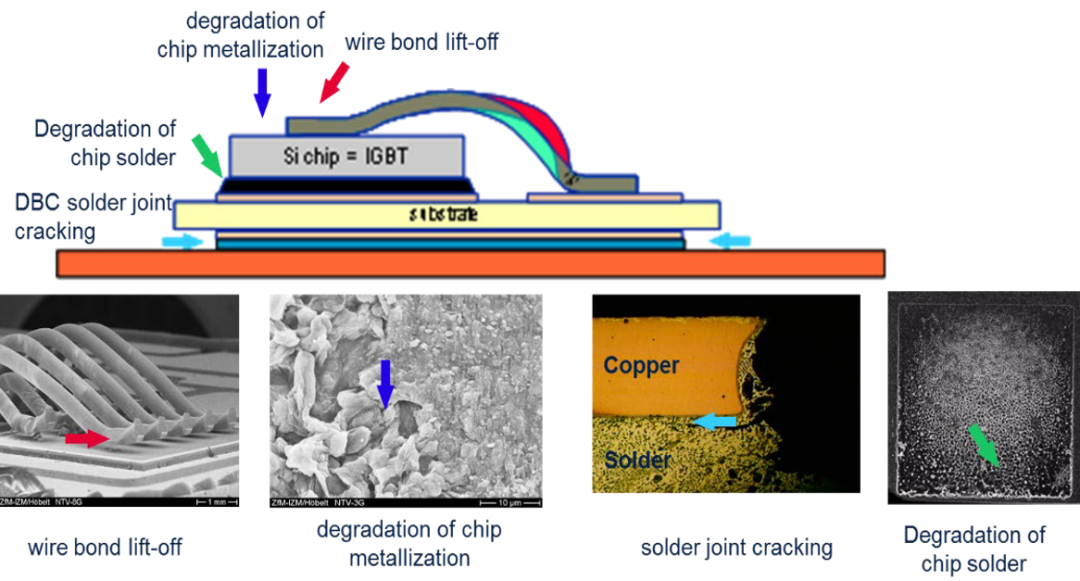
圖十:典型的功率循環(huán)失效模式
High-temperature gate bias(HTGB)高溫柵極偏壓測(cè)試
由于SiC的Vgs在偏壓的條件下會(huì)隨著時(shí)間的累加而漂移,因此HTGB可以模擬加速條件下的工作狀態(tài),用于芯片的可靠性驗(yàn)證和門(mén)極的可靠性監(jiān)測(cè)。并且可以發(fā)現(xiàn)由于生產(chǎn)過(guò)程中導(dǎo)致的一些材料污染。對(duì)于Si和SiC器件和模塊來(lái)說(shuō)HTGB都是強(qiáng)制要求的。
Dynamic gate stress (DGS)室溫下的DGS測(cè)試對(duì)于SiC功率模塊來(lái)說(shuō)是必須的,現(xiàn)在這個(gè)測(cè)試的條件還在討論當(dāng)中還沒(méi)有最終定稿。這個(gè)測(cè)試不僅僅涉及到芯片也涉及到模塊,因?yàn)楝F(xiàn)在的SiC功率模塊大多數(shù)都有多個(gè)SiC的芯片來(lái)并聯(lián)達(dá)到大電流的輸出能力,那么模塊的layout也會(huì)影響到芯片的Vgs,這也是為什么針對(duì)SiC功率模塊必須要考慮DGS測(cè)試。如果設(shè)計(jì)的不好,在動(dòng)態(tài)條件下SiC的Vgs會(huì)飄移同時(shí)也會(huì)導(dǎo)致Rdson增加進(jìn)而導(dǎo)致效率降低。

圖十一:Dynamic gate stress 
我們?cè)趫D十二可以看懂不同的失效模式,這些都可以通過(guò)HTGB和DGS測(cè)試發(fā)現(xiàn)。

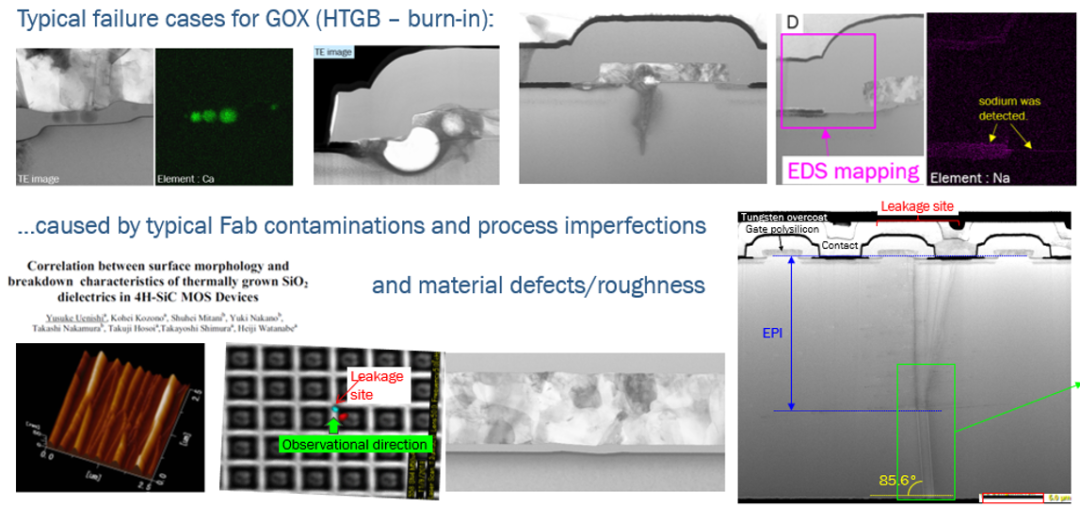
圖十二:各種HTGB失效模式
High-temperature reverse bias (HTRB)可以很好的檢測(cè)出來(lái)芯片的鈍化層結(jié)構(gòu)或者是芯片的終端結(jié)構(gòu)的缺陷,同時(shí)生產(chǎn)中或者封裝材料里的有害的一些離子污染也可以通過(guò)這個(gè)測(cè)試發(fā)現(xiàn),同時(shí)由于功率模塊的不同的材料間的溫度膨脹系數(shù)也會(huì)導(dǎo)致芯片的鈍化層完整性受到破壞,這個(gè)測(cè)試對(duì)于Si或者SiC來(lái)說(shuō)是相似的,但是對(duì)于SiC的模塊來(lái)說(shuō)動(dòng)態(tài)的反偏測(cè)試是強(qiáng)烈建議的。
Dynamic reverse bias (DRB)DRB對(duì)于IGBT是不做要求的,需要注意的一點(diǎn)是對(duì)于DRB,如果在AECQ101沒(méi)有做過(guò)這個(gè)測(cè)試,那么在SiC的功率模塊是必須要做的。這個(gè)測(cè)試的目的是通過(guò)高dv/dt對(duì)內(nèi)部鈍化層結(jié)構(gòu)進(jìn)行充放電進(jìn)而使芯片加速老化。


圖十三:Dynamic reverse bias
High-humidity, high-temperature reverse bias (H3TRB)這個(gè)測(cè)試為了驗(yàn)證整個(gè)模塊結(jié)構(gòu)中的薄弱環(huán)節(jié),包括功率半導(dǎo)體本身。大多數(shù)模塊設(shè)計(jì)很難做到完全密封。半導(dǎo)體芯片和接合線嵌入可滲透濕氣的硅膠中。這允許濕氣隨著時(shí)間的推移也到達(dá)鈍化層。芯片鈍化層結(jié)構(gòu)或鈍化拓?fù)浣Y(jié)構(gòu)中的弱點(diǎn)以及芯片邊緣密封中的弱點(diǎn)在濕度的影響下受到負(fù)載的不同影響。污染物也可以通過(guò)濕氣傳輸轉(zhuǎn)移到關(guān)鍵區(qū)域,從而導(dǎo)致失效。
對(duì)于 H3TRB是Si和SiC差別比較大的地方。圖十四是針對(duì)SiC的H3TRB的測(cè)試條件。它和針對(duì)Si的IGBT的條件差別就是加在器件上的電壓不一樣。Si的要求是強(qiáng)制要求80V,而SiC則是必須80%的VDSmax。


圖十四:SiC H3TRB
圖十五我們可以看到在H3TRB測(cè)試中由于器件的設(shè)計(jì)或者模塊封裝原因?qū)е碌囊恍┦АR舱f(shuō)明這個(gè)測(cè)試是比較有效的可以發(fā)現(xiàn)edge terminal設(shè)計(jì)、封裝、鈍化層等等方面的缺陷。

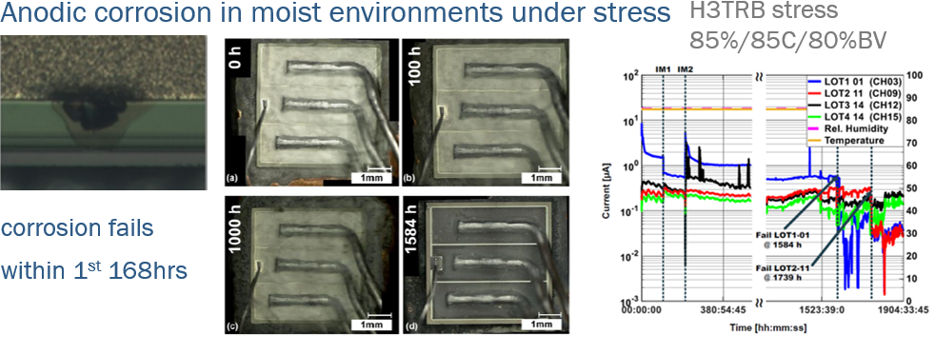
圖十五:H3TRB缺陷
(dyn.H3TRB)這個(gè)測(cè)試是專(zhuān)門(mén)針對(duì)SiC功率模塊的,該測(cè)試是SiC模塊技術(shù)的附加通用芯片可靠性測(cè)試。這個(gè)測(cè)試項(xiàng)目還沒(méi)最終定稿。由于SiC的dv/dt比IGBT等Si器件要高很多,所以針對(duì)這個(gè)高dv/dt條件下,芯片和模塊的薄弱環(huán)節(jié)是否能被檢測(cè)出來(lái)?這個(gè)標(biāo)準(zhǔn)還在探索中。當(dāng)然即使是這樣,安森美最新的SiC功率模塊也都會(huì)進(jìn)行相關(guān)的測(cè)試。

圖十六:dyn.H3TRB
下面的兩項(xiàng)目前還在研究當(dāng)中:
-
High-temperature forward bias (HTFB)
-
Dynamic forward bias (DHTFB)
從上面的文章我們可以發(fā)現(xiàn)針對(duì)SiC功率模塊的測(cè)試標(biāo)準(zhǔn)還沒(méi)有定稿,還有一些項(xiàng)目沒(méi)有完全確定,這是因?yàn)镾iC的應(yīng)用和器件還在發(fā)展中。安森美作為一家垂直整合了整個(gè)SiC供應(yīng)鏈的IDM,也在密切的關(guān)注和跟隨著AQG324的發(fā)展,并在最新的產(chǎn)品開(kāi)發(fā)中應(yīng)用它來(lái)保證自己的產(chǎn)品的可靠性。
通過(guò)上文的分析我們了解到了AQG324測(cè)試標(biāo)準(zhǔn)從各方面測(cè)試了SiC功率模塊的性能,里面涉及到芯片和封裝等,它是一個(gè)比較全面的測(cè)試。但是一個(gè)功率模塊通過(guò)AQG324的測(cè)試,僅僅代表了整個(gè)功率模塊的工藝等通過(guò)了基本的測(cè)試和驗(yàn)證。整個(gè)模塊的可靠性是通過(guò)芯片研發(fā)、芯片工藝、模塊研發(fā)、模塊工藝、封裝和測(cè)試等一個(gè)完整體系的保證,不是簡(jiǎn)單的某一個(gè)步驟能保證的。
下面的兩個(gè)功率模塊是安森美前兩年量產(chǎn)的SiC功率模塊。圖十六是塑封半橋的SiC功率模塊,圖十七是SSDC的三相橋模塊。目前都已經(jīng)在各大車(chē)廠獲得了廣泛的應(yīng)用。說(shuō)明了安森美的SiC功率模塊在經(jīng)過(guò)AQG324測(cè)試之后表現(xiàn)出來(lái)的質(zhì)量穩(wěn)定性獲得了相關(guān)客戶(hù)的認(rèn)可。
圖十七:半橋塑封SiC功率模塊
圖十八:三相橋SSDC 900V SiC功率模塊
明日研討會(huì)預(yù)告-AQG324對(duì)SiC模塊封裝和器件帶來(lái)的挑戰(zhàn)隨著SiC在主驅(qū)應(yīng)用逐漸普及,很多客戶(hù)新的設(shè)計(jì)都有考慮使用SiC模塊;與此同時(shí)SiC功率模塊的可靠性測(cè)試的標(biāo)準(zhǔn)也在進(jìn)一步的更新。安森美的SiC功率模塊在開(kāi)發(fā)過(guò)程中遵循最新的AQG324標(biāo)準(zhǔn),新的標(biāo)準(zhǔn)對(duì)于SiC的開(kāi)發(fā)和可靠性提出了一些新的需求,安森美從模塊和芯片開(kāi)發(fā),測(cè)試和生產(chǎn)的角度來(lái)理解這些需求,針對(duì)性的去開(kāi)發(fā)和優(yōu)化,將有助于提升產(chǎn)品的可靠性。

掃碼報(bào)名預(yù)約聽(tīng)會(huì)
時(shí)間:
2023年07月25日 10:00
關(guān)鍵要點(diǎn):
1. Si和SiC在AGQ324種測(cè)試的差異
2. SiC的芯片可靠性測(cè)試
3. SiC芯片和模塊銀燒結(jié)需求
4. SiC芯片和模塊的高溫要求
Bryan Lu 安森美電源方案部汽車(chē)主驅(qū)逆變器半導(dǎo)體中國(guó)區(qū)負(fù)責(zé)人
Bryan Lu先生為安森美汽車(chē)主驅(qū)逆變器半導(dǎo)體中國(guó)區(qū)負(fù)責(zé)人,負(fù)責(zé)安森美車(chē)規(guī)IGBT和SiC功率模塊的開(kāi)發(fā)管理,同時(shí)負(fù)責(zé)支持亞太區(qū)電驅(qū)功率模塊的支持、推廣。他在霍爾傳感器設(shè)計(jì)應(yīng)用、電機(jī)驅(qū)動(dòng)、電動(dòng)助力轉(zhuǎn)向 (EPS) ,功能安全,汽車(chē)功率模塊封裝和可靠性測(cè)試等汽車(chē)應(yīng)用領(lǐng)域擁有16年以上的豐富專(zhuān)業(yè)經(jīng)驗(yàn)。
點(diǎn)個(gè)星標(biāo),茫茫人海也能一眼看到我


-
安森美
+關(guān)注
關(guān)注
32文章
1704瀏覽量
92158
原文標(biāo)題:干貨解讀SiC Traction模塊的可靠性基石AQG324
文章出處:【微信號(hào):onsemi-china,微信公眾號(hào):安森美】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
什么是MOSFET柵極氧化層?如何測(cè)試SiC碳化硅MOSFET的柵氧可靠性?
瞻芯電子參與編制SiC MOSFET可靠性和動(dòng)態(tài)開(kāi)關(guān)測(cè)試標(biāo)準(zhǔn)

新品 | 符合AQG324標(biāo)準(zhǔn)的車(chē)載充電用CoolMOS? CFD7A 650V EasyPACK?模塊

第三代功率半導(dǎo)體器件動(dòng)態(tài)可靠性測(cè)試系統(tǒng)
PCB高可靠性化要求與發(fā)展——PCB高可靠性的影響因素(上)
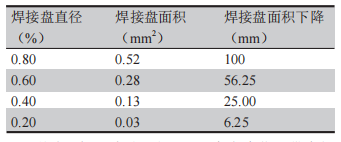
瞻芯電子交付碳化硅(SiC)MOSFET逾千萬(wàn)顆 產(chǎn)品長(zhǎng)期可靠性得到驗(yàn)證

使用故障保護(hù)多路復(fù)用器提高模擬輸入模塊的可靠性

SiC功率器件性能和可靠性的提升
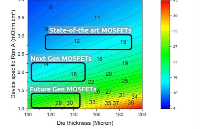
合作案例|鈞聯(lián)電子自主研發(fā)的SiC功率模塊順利通過(guò)AQG-324認(rèn)證

AC/DC電源模塊的可靠性設(shè)計(jì)與測(cè)試方法

碳化硅模塊(SiC模塊/MODULE)大電流下的驅(qū)動(dòng)器研究
第三代SiC功率半導(dǎo)體動(dòng)態(tài)可靠性測(cè)試系統(tǒng)介紹
瞻芯電子推出一款車(chē)規(guī)級(jí)1200V SiC三相全橋塑封模塊IVTM12080TA1Z





 干貨解讀SiC Traction模塊的可靠性基石AQG324
干貨解讀SiC Traction模塊的可靠性基石AQG324
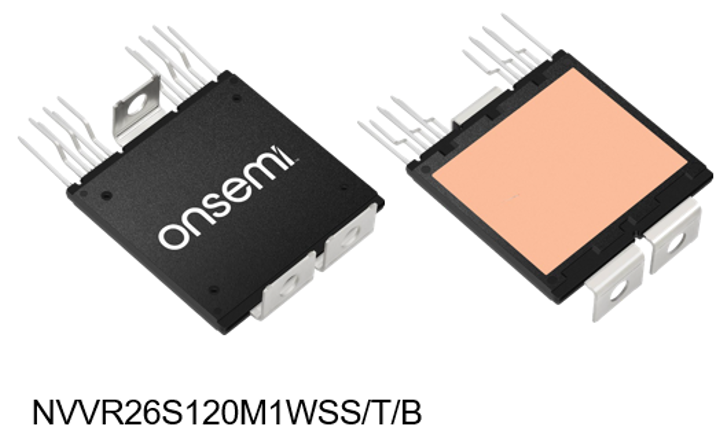











評(píng)論