GaN材料由于其所具有的優良光電性能,而成為固態照明、數字處理、光電器件、功率器件等半導體材料與器件領域的研究熱點。金屬與半導體接觸可以形成肖特基接觸,也可以形成非整流的接觸,即歐姆接觸。歐姆接觸不產生明顯的附加阻抗,而且不會使半導體內部的平衡載流子濃度發生顯著的改變。
室溫下n-GaN的電子親和勢為4.11eV。在金屬材料中Ti和Al的功函數較低,適用于和GaN形成歐姆接觸。常用膜層Ti/Al/Ni/Au。


好的歐姆接觸必須有一個勢壘層L1,這一層是最接近n-GaN的,必須是自然情況下為金屬化的,而且要有可以忽略不計的電阻,它的功函數應該很小。勢壘層提供了一個阻擋層使得那些比它功函數大的金屬擴散到n-GaN表面。在眾多難熔的和過渡金屬化合物中,硼化物、碳化物、氮化物是在化學以及熱力學上十分穩定的化合物。氮化物有TiN、TaN、ZrN等。過去TiN被用于阻擋Ti-Pt間的互擴散。而在n-GaN的歐姆接觸中,TiN、TaN、ZrN等氮化物成為首選。因為他們十分容易通過勢壘層金屬M1與n-GaN中的N原子的固相化學反應獲得。在眾多的勢壘層金屬中,Ti是一種非常高活性且難熔的金屬。它比Co還有活躍。勢壘層L1是M1N化合物,是n-GaN中的氮原子外擴散與勢壘層金屬M1反應所形成的化合物。氮原子從n-GaN中的向外擴散來形成這些金屬化合物,在n-GaN中留下氮空位VN,可以起到淺施主的作用,非常有利于形成歐姆接觸。
M2成為覆蓋層,其作用是催化劑,促進N原子與勢壘層M1的固相化學反應,且和M1形成功函數低而且致密性好的合金。
低功函數金屬Al是很好的覆蓋層金屬,因為它即不會產生高功函數合金也不會合金產生厚的寬帶隙材料。勢壘層和覆蓋層金屬都不應該外擴散到接觸表面形成氧化物/氫氧化物,因為氧化物和氫氧化物是絕緣的,會引起接觸性能明顯退化。但是勢壘層金屬和覆蓋層金屬都容易氧化。因此需要在覆蓋層上再加一層或多層的帽層,帽層金屬可以是單層金屬(M4)或是兩層難熔金屬M3、M4。引入帽層能夠降低接觸系統總的自由能。帽層金屬常用穩定的Au,但是Au和Al很容易發生互擴散達到GaN表面,不利于歐姆接觸。因此在Al和Au之間常加入Ni作為隔離層,阻止Au向GaN表面擴散。隔離層也可以選用Ti、Cr、Pt、Pd、Mo等,Ni是常見的一種。總之,金屬層M1、M2、M3、M4并不會在n-GaN/M1/M2/M3/M4系統中自動建立化學平衡。因此,必須采用快速熱退火(RTA)使得金屬間互擴散,從而發生固相界面反應形成一系列金屬間化合物。通過這樣的方法,絕大多數的金屬在反應中消失了,取而代之的反應產物是由薄的低電阻,低功函數金屬勢壘層L1A、L1B等以及勢壘層L1上面的熱穩定金屬間合金組成的。這些層的實際構成取決于RTA時間,RTA溫度以及各層金屬的厚度。因此,優化這些參數對于獲得低阻抗,熱穩定金屬合金及其重要。
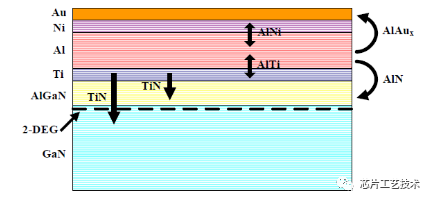
Ti/Al/Ni/Au=50A/1000A/200A/2000A
Ti/Al/Ni/Au高溫退火過程中與AlGaN/GaN所發生的各種反應。第一,Al熔點僅為660℃,在高溫退火過程中首先液化,一部分液態Al會和下層的Ti發生反應形成Ti-Al二元相,Ti-Al二元相熔點和電阻率要比Ti低,可以促進Ti與AlGaN/GaN中N原子反應。第二,液態Al會與AlGaN/GaN中的N發生反應形成AlN,進而產生更多的N空位。第三,液態Al和Ni也會發生反應,反應程度隨著Al比例增長或溫度升高而逐漸深化,同時該反應抑制了液態Al繼續向上擴散。第四,高溫下Ti和AlGaN/GaN發生替位反應,替換掉Ga元素,反應形成TiN,在這一過程中Ga元素向外擴散,晶格中會出現大量的Ga空位并引發電荷不平衡,為緩解這種不平衡,附近的N原子將填補Ga空位,進而產生N空位。Au在反應過程中主要作用為保護Ti和Al,防止其在高溫下被氧化。整個反應過程直接決定了直接接觸能否形成和隧穿機制的效率。各層金屬的比例以及退火溫度、時間等條件均會影響高溫退火反應過程,直觀反映在歐姆接觸電阻的大小上。
另一個歐姆接觸的主要影響因素是氮空位在n-GaN表面的大量堆積。如果氮空位和鎵空位在RTA或者表面處理中產生,氮空位一定要比鎵空位多。n-GaN表面處理包括等離子體刻蝕或濕法刻蝕。表面處理要在金屬化前進行。Mohammad指出了n-GaN的表面處理對于制造低阻接觸十分重要,有幾個原因:1. 可以消除GaN表面的氧化物和氫氧化物,甚至是殘留的鎵,形成了少氮GaN表面2. 刻蝕后粗糙的GaN表面增大了接觸面積,易于金屬與GaN表面的黏附3. 刻蝕后金屬半導體表面的勢壘高度低于肖特基勢壘高度4. 在GaN表面產生大量的氮空位。
鍍金屬電極前簡單的濕法處理比如泡稀鹽酸進行表面處理。金屬淀積前處理。將樣品放入濃度為25%的鹽酸溶液中浸泡1分鐘,去除表面自然氧化層,也有用氨水浸泡的。
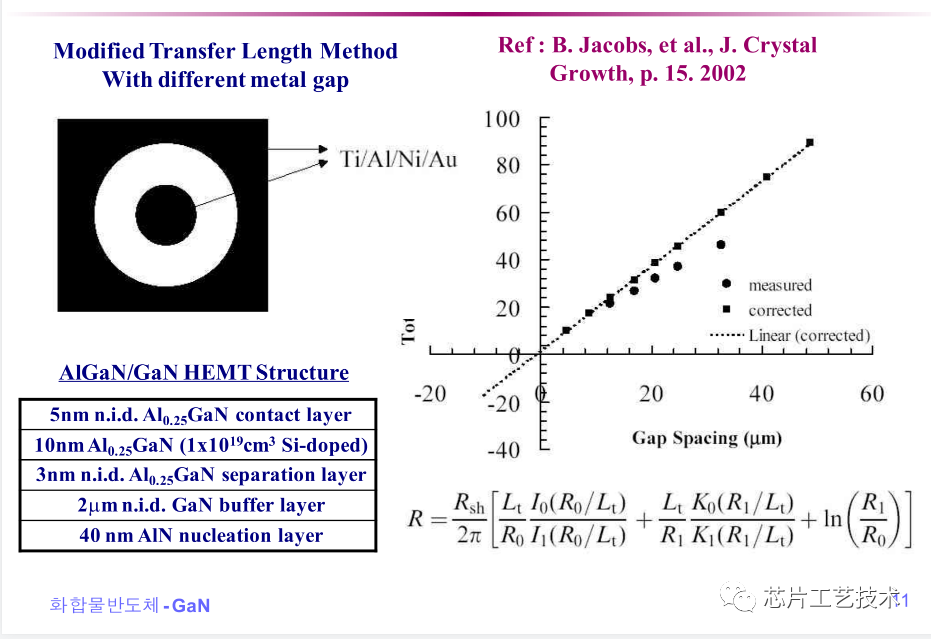
估計試驗推薦Ti/Al/Ni/Au=200A/1200A/550A/1000A作為N-GaN的電極,RTA條件采用氮氣環境,10s內升到850℃,保持30s,然后自然冷卻,歐姆接觸達到10-6次方。
審核編輯:湯梓紅
-
半導體
+關注
關注
334文章
27703瀏覽量
222637 -
歐姆
+關注
關注
0文章
82瀏覽量
21094 -
光電器件
+關注
關注
1文章
180瀏覽量
18603 -
功率器件
+關注
關注
41文章
1796瀏覽量
90642 -
GaN
+關注
關注
19文章
1965瀏覽量
74238
原文標題:GaN的歐姆接觸實驗
文章出處:【微信號:dingg6602,微信公眾號:芯片工藝技術】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
通過EPC的GaN EPC2032的電路設計實驗
AlGaN/GaN的光電化學蝕刻工藝
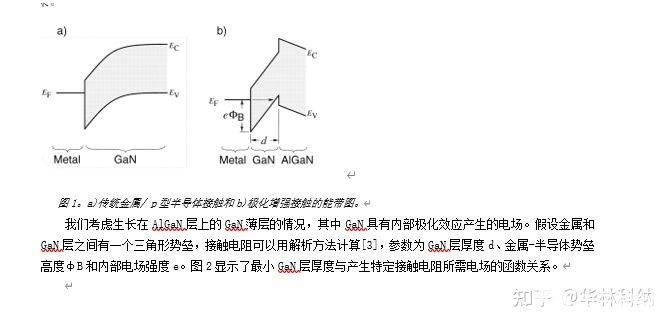
n型高阻單晶硅 歐姆接觸工藝
n型高阻單晶硅歐姆接觸工藝
n型高阻單晶硅歐姆接觸工藝
什么是GaN透明晶體管?
4H-SiC離子注入層的歐姆接觸的制備
GaN射頻器件是如何制作的呢?
絕緣柵Si基GaN平面器件關鍵工藝
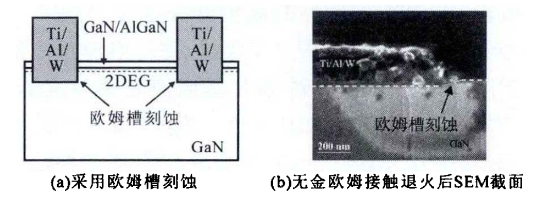
6.4.2.2 n型SiC的歐姆接觸∈《碳化硅技術基本原理——生長、表征、器件和應用》

6.4.2.3 p型SiC的歐姆接觸∈《碳化硅技術基本原理——生長、表征、器件和應用》

一文詳解肖特基接觸和歐姆接觸





 GaN的歐姆接觸實驗
GaN的歐姆接觸實驗

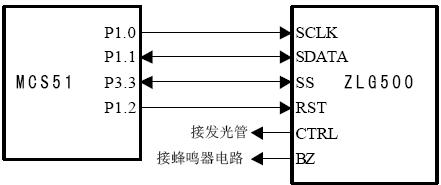











評論