BGA(Ball Grid Array,球柵陣列)封裝是一種表面安裝的封裝方式,以其高密度、高性能的特點在電子行業中得到了廣泛應用。然而,在BGA封裝焊接過程中,可能會出現各種缺陷和異常。讓我們一起來看看這些常見的問題及其產生的原因。
焊球斷裂:焊球斷裂是BGA焊接過程中常見的問題,主要原因是焊接溫度的不適當控制或設備振動。如果焊接溫度過高,焊球可能會過度膨脹,導致焊球斷裂;如果設備振動過大,也可能導致焊球的機械應力增大,從而引發斷裂。
焊接虛焊:虛焊是另一個常見的問題,主要表現為焊接點未能形成良好的金屬連接。虛焊的主要原因包括焊錫的濕潤性差,焊接溫度低于錫膏的熔點,或焊錫在焊接過程中受到污染。
焊球偏移:在焊接過程中,由于熱膨脹、表面張力不均等因素,焊球可能會發生偏移,導致連接質量下降。特別是在高密度BGA封裝中,焊球的微小偏移都可能導致嚴重的性能問題。
橋聯:如果焊錫過多或焊錫過度流動,可能會形成橋聯,即兩個或更多的焊接點之間形成了不應存在的電氣連接。橋聯的出現不僅影響電路的正常工作,還可能引發短路,對設備造成損壞。
焊接后裂紋:焊接后裂紋是指焊接過程中或焊接后出現的裂紋,這是由于焊接應力、熱循環應力或機械振動引起的。這種裂紋可能會導致電路斷路,影響設備的可靠性。
外觀缺陷:在BGA焊接過程中,可能會出現焊錫表面的不均勻、焊錫顏色變暗等外觀缺陷。這些缺陷一般是由于焊接工藝參數設置不當、環境溫濕度控制不佳或焊錫質量問題引起的。雖然這些缺陷不一定會直接影響電路板的功能,但可能會影響電路板的壽命和可靠性。
內部缺陷:使用X光或其他無損檢測技術,可能會發現BGA焊接的內部缺陷,如焊球內部的孔洞、裂紋等。這些內部缺陷可能由于焊接過程中氣體產生和困困然后導致,或者是由于焊錫冷卻過程中收縮不均勻引起的。這些內部缺陷可能會影響電路的電性能,并降低其抗疲勞和抗振動的性能。
焊接后不良的電氣性能:有些缺陷可能無法直接通過視覺或X光檢測發現,只有在電性能測試中才能發現。例如,如果焊接質量差,可能會導致電阻增大、電流擾動、信號延遲等問題。這些問題可能會嚴重影響電路板的性能,甚至導致電路板無法正常工作。
BGA封裝焊接的常見缺陷和異常有很多,每一種缺陷和異常都可能影響到電路板的性能和可靠性。因此,對BGA焊接過程的控制非常重要,需要有嚴格的工藝參數設置,優質的焊接材料,精密的焊接設備,以及嚴格的質量檢測和控制。通過深入理解BGA封裝焊接的常見缺陷和異常,可以幫助我們更好地控制焊接過程,提高電路板的質量和可靠性。
-
封裝
+關注
關注
127文章
7992瀏覽量
143403 -
貼片機
+關注
關注
9文章
652瀏覽量
22603
發布評論請先 登錄
相關推薦
BGA芯片焊接全攻略:從準備到實戰的詳盡指南

常見BGA芯片故障及解決方案
BGA芯片的焊接技術與流程
BGA芯片的封裝類型 BGA芯片與其他封裝形式的比較
如何進行BGA封裝的焊接工藝
不同BGA封裝類型的特性介紹
BGA封裝常見故障及解決方法
BGA封裝與其他封裝形式比較
BGA封裝技術的發展 BGA封裝的優勢與應用
BGA焊接產生不飽滿焊點的原因和解決方法

大研智造激光焊錫機:為BGA封裝提供高效焊接的智能化選擇
請問含有BGA封裝的板子怎么焊接?
淺談BGA、CSP封裝中的球窩缺陷
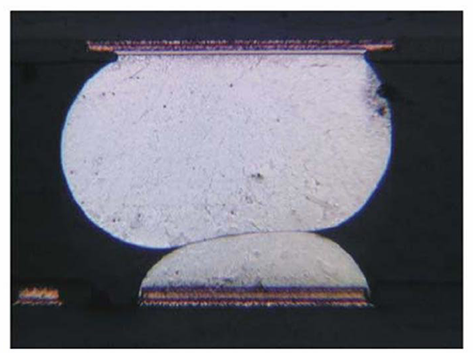




 探究BGA封裝焊接:常見缺陷與異常解析
探究BGA封裝焊接:常見缺陷與異常解析












評論