摘要:為解決智能手機使用的大功率芯片中非均勻分布熱點的散熱問題,本文采用手機芯片作為熱源,利用軟件使手機滿載工作以模擬實際的高溫場景,采用具有各向異性導熱系數的導熱層和用于小型散熱系統的熱沉以提高熱電制冷器的制冷效率, 在此基礎上建立了制冷效率可控的熱管理系統。此外,為減少熱電制冷器熱端的熱量積累,設計了一種周期性電源控制器。結果表明: 熱管理系統將芯片溫度從 48 ℃降至 34 ℃,提高了約 20%的滿載芯片利用率,有效提升了手機流暢度,為解決非均勻分布熱點的散熱問題提供了指導。
關鍵詞:熱電制冷器; 芯片; 熱管理系統; 導熱系數
隨著科技的發展,手機已經成為人們日常生活中不可或缺的一部分。然而,高功率、高算力的芯片所產生的非均勻分布熱點將導致電子器件的熱衰竭,并嚴重影響其效率、穩定、安全運行和使用壽命。當手機芯片滿負荷工作時,如果芯片的溫度不能有效降低,芯片就必須采取降頻策略來降低芯片的溫度,以防止芯片損壞。據報道,降低芯片頻率的 策略會使手機運行速度變慢約 3 倍。為了調控芯片溫度,手機需要配套的制冷系統,且該制冷系統須滿足高集成度和高散熱量的特點。大多數手機散熱技術如石墨烯散熱技術、真空腔均熱板散熱技術( VC 液冷) ,均為被動散熱技術。石墨烯散熱技術是依靠石墨烯良好的導熱性將熱量及時導出。VC 液冷是一個內壁具有微細結構的真空腔體,通常由銅制成。當熱量由熱源傳導至 VC 腔體時,腔體里的冷卻液受熱后開始產生氣化現象,液體汽化吸熱,當氣相工質接觸到較冷的區域時便會產生凝結的現象,借由凝結釋放出之前吸收的熱量。凝結后的冷卻液會借由微結構的毛細管道再回到蒸發熱源處,該過程將在腔體內周而復始進行。VC 液冷原理上類似于熱管,散熱效果提升有限,且散熱能力受環境溫度影響較大。熱電制冷器( thermoelectric cooler,TEC) 是一種體積小、制冷量高的主動制冷器件,在手機制冷方面具有很高的應用前景。
TEC 是一種主動制冷裝置,在電流的驅動下可以將熱量從制冷器的冷端傳遞至熱端。然而,隨著熱量在 TEC 熱端迅速積累,熱端溫度升高,TEC 的制冷效率將會下降。因此,在應用 TEC 時,應在其熱端增 加散熱設計。H. S. Huang 等采用循環水冷 系統作為 TEC 熱端散熱裝置,該制冷系統比傳統水 冷系統的制冷效率更高。Wang Jing 等提出一種 將 TEC 和電暈風冷系統耦合的制冷裝置。+vx:fggc08 S. AlShehri 等開發了一種應用于計算機芯片的熱管理系統。在該系統中,TEC 熱端溫度由熱沉和風扇的組合進行調控。但該制冷系統體積較大,難以應用于手機制冷系統。此外,在上述研究中,熱源均以恒定發熱體替代,且大多為溫度分布均勻的熱源。因此,有必要根據實際芯片的熱點分布設計熱電制冷系統。通常,研究者使用 TEC 時,會將其冷端直接附著在熱源表面,這種直接連接的方式并不能充分發揮熱電制冷器的制冷效率,反而會增加設備的功耗。因此,設計熱源與冷端之間的導熱層是提高熱電制冷系統制冷效率的最有效途徑。利用 TEC 解決微芯片散熱問題的研究逐漸受到關注,但目前對于非均勻分布熱點問題的研究還很少。微尺寸( 約 1 mm) 的 TEC 雖然可以針對性地解決該問題,但其設計和制造過程較為復雜、造價十分昂貴,短期內還不能用于手機芯片制冷。因此,本文將采用小尺寸 ( 12. 1 mm×11. 2 mm) TEC 構建熱管理系統。
為增強 TEC 在小空間中的制冷效果,本文基于有限元仿真,對熱電制冷系統中各向異性導熱層和熱端熱沉進行設計。根據仿真結果,建立了基于 TEC 的熱管理系統,并采用周期性供電系統來降低熱沉溫度和功耗。為了保證實驗的真實性,以手機芯片作為熱源并搭建相應的測試環境,采用開源程序使手機滿載運行并實時監控其芯片利用率。
1 實驗1.1 基于 Peltier 效應的熱電制冷器
構建了如圖 1 所示的芯片模型,該模型參考一般芯片的微結構,由不同材料堆疊而成的多層組合。各層模型的尺寸如表 1 所示,模型中的所有材料參數均為實際材料的平均屬性,如表 2 所示。該模型用于研究芯片滿載時的溫度場。此外,還構建了適用于該芯片模型的小型 TEC 模型,通過多物理場耦合和有限元數值分析的方法進行實體建模和單因素分析,以指導 TEC 在手機芯片制冷中的應用。
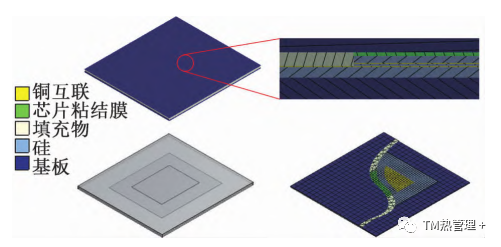
圖 1 芯片模型及網格劃分表 1 芯片模型尺寸

1.2 熱管理系統
手機滿負荷工作時,溫度迅速升高。為解決手機芯片散熱問題,設計了基于仿真結果的熱管理系統。該系統由 TEC、控制器、熱沉和電源組成。TEC 的冷端與芯片通過導熱層相連,熱端與銅制熱沉相連。電源和控制器為 TEC 提供可控能源。通過測量芯片的溫度及芯片利用率來檢驗熱管理系統對手機芯片的散熱效果。
2 結果與討論
2. 1 芯片溫度場
為研究芯片滿載時的溫度場分布,建立了芯片仿真模型。芯片的基板和填充物的網格尺寸為 0. 5 mm,其余結構的網格尺寸為 0. 2 mm。在本仿真中,+vx:fggc08 環境溫度設置為 25 ℃,對流傳熱系數設置為 300 W/( m2·℃ ) ; 外部硅層 A 的光譜輻射力設置為 2. 5 W/mm3,外部硅層 B 的光譜輻射力設置為 0. 05 ~ 3 W/mm3,非均勻分布。TEC 模型及芯片模型溫度場如圖 2 所示。由溫度場模擬結果( 圖 2( a) ) 可知, 硅層的溫度最高,最高溫度達到 102. 8 ℃,這將破壞 手機的大部分電子器件。為降低芯片溫度,采用 TEC 對芯片進行制冷。基于現有工藝,設計了尺寸為 12. 1 mm×11. 2 mm×1. 95 mm 的塊狀熱電器件( 圖 2 ( b) ) 。由圖 2( c) 可知,當環境溫度為 25 ℃ 時,TEC 輸入電流設置為 300 mA,芯片的最高溫度降至 72. 5 ℃,TEC 成功地將芯片的熱轉移至熱端。但如圖 2 ( c) 中截面圖所示,芯片溫度呈現非均勻分布,TEC 的冷端溫度也呈現相同的分布。因此,本文將探索一 種解決非均勻分布熱點的方法,以提高制冷效率。
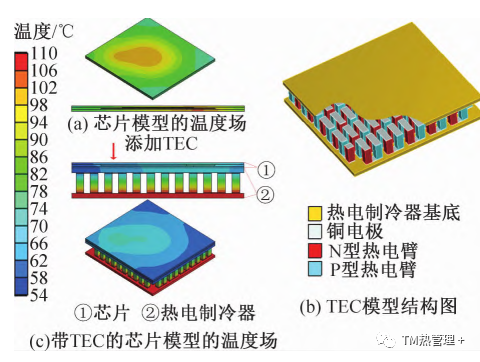 圖 2 TEC 模型及芯片模型溫度場2. 2 導熱層設計
圖 2 TEC 模型及芯片模型溫度場2. 2 導熱層設計
上述結果表明,TEC 的引入降低了芯片的溫度, 但還未能解決熱點分布不均勻的問題。為了提高制冷系統的效率并改善芯片溫度場分布,本文探索了導熱層的設計。添加導熱層后芯片模型的溫度場如圖 3 所示。如圖 3( a) 所示,導熱層是一片厚度為 0. 1 mm,導熱系數為 1 W/( m·℃ ) 的薄片,導熱層的加入 進一步降低了芯片的溫度,但熱分布的均勻性并未得到很大的改善。因此,改變了導熱層的面外與面內導熱系數,試圖影響熱傳導的過程,從而改善芯片的熱分布。
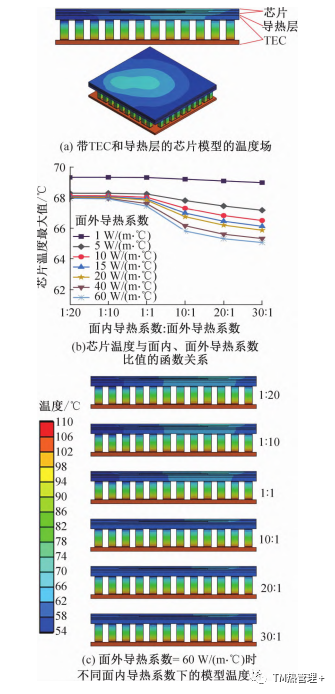 圖 3 添加導熱層后芯片模型的溫度場
圖 3 添加導熱層后芯片模型的溫度場
圖 3( b) 所示為面內與面外導熱系數的比值對芯片溫度的影響。當該比值大于 1 時,芯片溫度降幅較 大,且在相同比例下,隨著面外導熱系數的增大,降溫幅度也在增大。當面外導熱系數從 1 W/( m·℃ ) 增 至 5 W/( m·℃ ) 時,芯片溫度顯著下降,但進一步增加面外導熱系數并不會使芯片溫度發生太大變化。當數值超過 5 W/( m·℃ ) 時,面內導熱系數的增加對制冷效果的影響比面外導熱系數更顯著。
由圖 3( c) 可知,當面外導熱系數為 60 W/( m·℃) 時,芯片溫度隨面內面外導熱系數比值的增加而降 低。此外,芯片的熱點集中在光譜輻射力數值較大的區域,熱點的尺寸隨著比值的增加而減小,特別是當 比值大于 1 時,溫度分布基本是均勻的,有效緩解了熱點分布不均勻的問題。提高導熱系數可使芯片溫度分布更均勻,有效緩解了分布式熱點問題,并使芯片溫度保持在較低的水平,且在實際應用中,由于面內導熱系數的增加對制冷效果的影響比面外導熱系數更顯著,應重點尋找面內導熱系數大的導熱層材料。
2. 3 熱沉設計
由 2. 2 節的仿真結果可知,雖然芯片溫度降低 了,+vx:fggc08 但 TEC 的熱端溫度非常高( 約 100 ℃ ) ,這對 TEC 是不利的,會降低 TEC 的效率。因此,設計了一種小尺寸的熱沉以降低熱端溫度。圖 4 所示為添加熱沉后的溫度分布,熱沉為導熱系數為 400 W/( m·℃ ) 的矩形塊體,此外,2. 2 節設計的導熱層面外導熱系數為 60 W/( m·℃) 、面內導熱系數為 1 800 W/( m·℃) 。與圖 3 中的溫度場對比可知,增加了熱沉后 TEC 熱端溫度得到降低,芯片溫度隨熱端溫度的降低而進一步降低。結果表明,熱沉對熱電制冷系統的制冷效果非常重要。為進一步優化制冷效果,對不同尺寸的熱沉進行了研究。
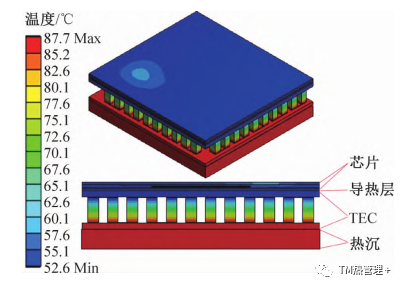 圖 4 帶 TEC、導熱層和熱沉模型溫度場
圖 4 帶 TEC、導熱層和熱沉模型溫度場
圖 5 所示為改變熱沉厚度及其底面面積后芯片和熱沉溫度的變化,可知,溫度隨熱沉厚度和面積的增加而降低。考慮到熱管理系統的應用基礎是小型電子設備,仿真中熱沉厚度的變化范圍較小。在相同底面面積下,熱沉厚度從 0. 5 mm 增 至 1. 5 mm,芯片溫度的下降不超過 1 ℃ ,熱沉溫度下降不超過 2 ℃ 。而在厚度相同的情況下,當熱沉底面面積從 98 mm2增至 1800 mm2時,芯片溫度下降超過 18 ℃ ,熱沉溫度下降超過 45 ℃ 。結果表明,在小型電子設備中,增加熱沉面積可以進一步提高 TEC 的制冷效率。
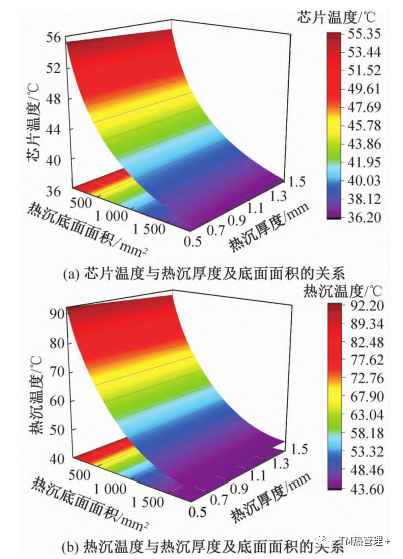 圖 5 熱沉厚度和底面面積對制冷效果的影響
圖 5 熱沉厚度和底面面積對制冷效果的影響
2. 4 熱管理系統的驗證
基于仿真結果,設計了一種高效的 TEC,并應用于熱管理系統以檢驗熱管理系統的制冷效果。熱管理系統及測試系統如圖 6 所示,TEC 與仿真模型同尺寸,且擁有 65 對熱電對,最大制冷量為 6. 3 W,相關參數如表 3 所示。在實驗中,熱管理系統由帶有導熱 層的 TEC、熱沉和控制器( Arduino UNO 開發板及其 外圍電路) 組成。TEC 的冷端以導熱硅膠與導熱層連接,再貼合在手機芯片上,最后,將熱沉附在 TEC 的熱側。導熱層采用石墨烯復合膜,該產品具有膠面,+vx:fggc08 便于直接貼附在手機芯片表面并且可以起到聯接 TEC 的作用; 根據出廠參數可知,導熱層面內導熱系數 為 1500 W/( m·℃) ,面外導熱系數為 60 W/( m·℃) 。此外,熱沉采用邊長為 45 mm 的矩形薄銅片。控制器用于調節 TEC 的工作狀態。在測試系統中,采用直流穩壓電源為控制器供電,采用多路溫度計監控芯片和熱沉的溫度。
 圖 6 熱管理系統及測試系統表 3 TEC 參數
圖 6 熱管理系統及測試系統表 3 TEC 參數
在測試中,利用應用程序使芯片滿負荷工作,并通過 TEC 系統調控芯片的溫度。由于芯片的自主保護策略,芯片的利用率在較高的溫度下會受到限制以防止芯片熱衰竭,隨著芯片溫度的下降限制將逐漸解除。此外,對采用被動散熱的芯片進行了溫度測量。測試結果如圖 7 所示。由圖 7( a) 可知,被動散熱的芯片保持在約 40 ℃。當使用 TEC 時,芯片溫度隨著電流的增加而迅速下降,當 TEC 通入的電流達到 300 mA 時,芯片溫度降至 30 ℃。但隨著時間的推移,芯片的溫度逐漸升高。此外,如圖 7( c) 中紫色線條結果所示,熱沉的溫度急劇上升,這表明熱沉在快速積累熱量,即 TEC 熱端溫度快速上升,導致制冷效率的下降和芯片溫度的上升。為了解決熱積累問題,為 TEC 設計了周期性的供電策略,測量芯片和熱沉在不同占空比下的溫度。如圖 7( b) 所示,芯片的溫度迅速下降,然后在一個小范圍內波動。+vx:fggc08 隨著供電周期占空比的減小,芯片溫度在達到最低溫度后趨于穩定。但當占空比小于 50% 時,芯片溫度超過 38 ℃,散熱效率較差。如圖 7( c) 所示,在 TEC 不工作的情況下,熱沉溫度為 36. 9 ℃。在 TEC 開始工作后,熱沉溫度迅速上升,導致 TEC 冷卻效果逐漸下降,芯片溫度升高。溫升速率隨占空比的減小而減小,說明減小占空比可以優化 TEC 的應用效果。由于手機是手持設備,熱沉的溫度需要控制到一定程度,否則會影響使用體驗。

圖 7 實測結果
通過手機應用監控芯片利用率,結果如圖 7( d) 所示。在連續輸入 300 mA 電流的情況下,芯片的利用率先快速增加后持續下降。而采用周期性供電策略時,雖然降低了芯片的最大利用率,但提高了芯片的穩定性。+vx:fggc08 此外,綜合考慮散熱效果和熱沉的溫度,采用占空比為 75%的周期電源是制冷效果最為良好且穩定的策略。結果表明,采用基于 TEC 的熱管理系統降低了芯片溫度,提高了芯片利用率,提高了手機的流暢性。TEC 是一種主動制冷裝置,通過調控輸入電流,制冷量會隨之改變,為精確調控目標溫度奠定了基礎。本文中采用的器件,其制冷量可達到 6. 3 W,是被動制冷無法企及的。但在帶來可觀制冷量的同時,該器件需要通入 1. 2 A、9. 6 V 的直流電流,這對于小型移動設備是較大的負荷,因此,采用周期性供電策略,一方面減少了 TEC 熱端熱量的積累,另一方面減少了約 25%電功耗。
3 結論
本文通過有限元分析方法討論了導熱層和熱沉對 TEC 制冷效率的影響,基于仿真設計開發了用于手機芯片的熱電型熱管理系統,得到如下結論:
1) 在 TEC 與熱點的接觸面中添加導熱層可以降低芯片溫度,且導熱層的面內導熱系數越大,芯片的溫度分布越均勻。
2) 在 TEC 熱端添加熱沉可以有效降低 TEC 熱端的溫度,從而提高 TEC 的制冷效果; 熱沉面積越大,制冷效果提升越大,但在 0. 5 ~ 1. 5 mm 范圍內熱沉厚度的變化對制冷效果影響較小。
3) 室溫條件下,使用周期性供電策略,可以在不降低 TEC 響應速率的前提下有效降低 TEC 熱端的熱 積累速率。
4) 該熱管理系統能使手機芯片的溫度降至 34 ℃,成功解決了手機芯片的散熱問題。與傳統的手機散熱方案相比,基于 TEC 的熱管理系統散熱效率高,可控性好,還可以用于解決各種小芯片散熱問題。
TEC 是一種無活動性部件、體積小的主動制冷裝置,為高度集成提供了可能性。另一方面,TEC 制冷量十分可觀,但對于手機這類需要不斷充電的移動設備,TEC 制的功耗較大,在今后的工作中需要深入探索,進一步優化制冷系統的能耗,在能耗和高效制冷之間尋求最佳平衡。
來源:制冷學報
作者:張錦揚 曹麗莉 繆 旻
北京信息科技大學信息與通信工程學院 光電測量技術與儀器教育部重點實驗室
-
芯片
+關注
關注
456文章
51183瀏覽量
427281 -
熱管理
+關注
關注
11文章
449瀏覽量
21872
發布評論請先 登錄
相關推薦
大功率PCB設計思路與技巧

IP5385為智能手機提供快充方案的30W到100W大功率電源管理芯片

芯片在智能手機中扮演什么角色?
IP5365M專為移動充電寶設計的22.5W大功率快充電源管理SOC芯片

Tips:大功率電源PCB繪制注意事項
Tips:大功率電源PCB繪制注意事項

SOC芯片在智能手機中的應用
大功率晶閘管模塊的熱管理與散熱解決方案
大功率開關電源芯片的作用和應用
加裝德國進口高精度主軸 智能手機殼「高質量高效率」鉆孔銑槽

大功率器件散熱裝置設計探討

24V/8A大功率低功耗高效率同步整流升壓芯片
EV電動汽車熱管理系統研究及二維氮化硼材料導熱方案





 智能手機大功率芯片制冷效率可控的熱管理系統研究
智能手機大功率芯片制冷效率可控的熱管理系統研究











評論