
1、陶瓷封裝:在陶瓷封裝中,通常采用金屬膏狀印刷電路板作為粘接區(qū)和封蓋區(qū)。在這些材料表面電鍍鎳和金之前,采用金徠等離子清洗,可以去除有機(jī)污染物,顯著提高鍍層質(zhì)量。
2、引線框架的表面處理:引線框架的塑料封裝形式仍是微電子封裝領(lǐng)域的主流。主要采用導(dǎo)熱、導(dǎo)電、加工性能好的銅合金材料作為引線框架。銅氧化物和其他有機(jī)污染物會(huì)導(dǎo)致密封模具和銅引線框架之間的分層,導(dǎo)致密封性能差和包裝后的慢性漏氣。同時(shí),也會(huì)影響芯片的鍵合和引線鍵合的質(zhì)量,保證引線框架的超清潔。保證包裝可靠性和成品率的關(guān)鍵。金徠技術(shù)等離子處理可以達(dá)到超凈化和活化引線框架表面的效果。與傳統(tǒng)濕法清洗相比,成品率有較大提高。
3、芯片鍵合前處理:芯片與封裝基板之間的鍵合往往是兩種性質(zhì)不同的材料。這種材料的表面通常是疏水性和惰性的,其表面粘結(jié)性能較差,粘結(jié)過(guò)程中容易出現(xiàn)界面。空洞的產(chǎn)生給封裝芯片帶來(lái)了很大的安全隱患。對(duì)芯片和封裝基板表面進(jìn)行等離子處理,可以有效地提高表面活性,大大提高表面粘接環(huán)氧樹(shù)脂的流動(dòng)性。提高芯片與封裝基板的粘接潤(rùn)濕性,減少芯片與基板之間的分層,提高導(dǎo)熱系數(shù),提高IC封裝的可靠性和穩(wěn)定性,提高產(chǎn)品的使用壽命。在倒裝芯片封裝方面,對(duì)芯片和封裝載體進(jìn)行等離子處理,不僅可以得到超清潔的焊接表面,而且大大提高了焊接表面的活性,可以有效防止虛焊,減少空洞,提高焊接可靠性,同時(shí)可以增加邊緣高度和填料的公差,提高包裝的機(jī)械強(qiáng)度,降低因不同材料熱膨脹系數(shù)在界面間形成的內(nèi)部剪切力,提高產(chǎn)品的可靠性和使用壽命。
4、引線鍵合:集成電路引線鍵合的質(zhì)量對(duì)微電子器件的可靠性有著決定性的影響。粘合區(qū)域必須沒(méi)有污染物并且具有良好的粘合特性。氧化物和有機(jī)殘留物等污染物的存在將嚴(yán)重削弱引線鍵合的拉力值。傳統(tǒng)的濕法清洗不能完全去除或不能去除粘合區(qū)域的污染物。等離子清洗能有效去除鍵合區(qū)的表面污染,活化表面,顯著提高引線的鍵合張力。大大提高了封裝設(shè)備的可靠性
聲明:本文內(nèi)容及配圖由入駐作者撰寫(xiě)或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點(diǎn)僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場(chǎng)。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問(wèn)題,請(qǐng)聯(lián)系本站處理。
舉報(bào)投訴
相關(guān)推薦
生電子共享或原子的相互擴(kuò)散,從而使兩種金屬間實(shí)現(xiàn)原子量級(jí)上的鍵合。圖1在IC封裝中,芯片和引線框架(基板)的連接為電源和信號(hào)的分配提供了電路
![的頭像]() 發(fā)表于
發(fā)表于 01-06 12:24
?229次閱讀

引線鍵合檢測(cè) 引線鍵合完成后的檢測(cè)是確保產(chǎn)品可靠性和后續(xù)功能測(cè)試順利進(jìn)行的關(guān)鍵環(huán)節(jié)。檢測(cè)項(xiàng)目全面且細(xì)致,涵蓋了從外觀到內(nèi)部結(jié)構(gòu)的多個(gè)方面。 以下是對(duì)各項(xiàng)檢測(cè)項(xiàng)目的詳細(xì)分述: 目檢 球的推力測(cè)試 拉線
![的頭像]() 發(fā)表于
發(fā)表于 01-02 14:07
?221次閱讀
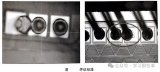
引線鍵合是一種將裸芯片的焊墊與封裝框架的引腳或基板上的金屬布線焊區(qū)通過(guò)金屬引線(如金線、銅線、鋁線等)進(jìn)行連接的工藝。 這一步驟確保了芯片
![的頭像]() 發(fā)表于
發(fā)表于 01-02 10:18
?306次閱讀

合,這種鍵合是通過(guò)電子共享或原子擴(kuò)散實(shí)現(xiàn)的。引線鍵合與封裝技術(shù)在集成電路(IC)封裝中,
![的頭像]() 發(fā)表于
發(fā)表于 12-24 11:32
?630次閱讀

在微電子封裝領(lǐng)域,鍵合絲作為芯片與封裝引線之間的連接材料,扮演著至關(guān)重要的角色。隨著科技的進(jìn)步和
![的頭像]() 發(fā)表于
發(fā)表于 11-25 10:42
?429次閱讀

共賞好劇引線鍵合之DOE試驗(yàn)歡迎掃碼添加小編微信掃碼加入知識(shí)星球,領(lǐng)取公眾號(hào)資料
原文標(biāo)題:引線鍵合之
![的頭像]() 發(fā)表于
發(fā)表于 11-01 11:08
?436次閱讀
根部損傷的制程因素:不同型號(hào)鋁帶劈刀端面設(shè)計(jì)對(duì)鍵合點(diǎn)根部損傷的影響;鋁帶劈刀端面沾污積鋁會(huì)導(dǎo)致鍵合點(diǎn)根部損傷加劇;導(dǎo)線管高度過(guò)高會(huì)導(dǎo)致第一焊點(diǎn)鍵
![的頭像]() 發(fā)表于
發(fā)表于 11-01 11:08
?1593次閱讀

要求,傳統(tǒng)互聯(lián)技術(shù)如引線鍵合、倒裝芯片鍵合和硅通孔(TSV)鍵合等,正逐步顯露其局限。在這種背景
![的頭像]() 發(fā)表于
發(fā)表于 10-18 17:54
?556次閱讀

引線鍵合廣泛應(yīng)用于電子設(shè)備、半導(dǎo)體行業(yè)和微電子領(lǐng)域。它實(shí)現(xiàn)了集成電路(IC)中芯片與其他電子元件(如晶體管和電阻)之間的互連。引線鍵合通過(guò)在芯片的焊盤(pán)與
![的頭像]() 發(fā)表于
發(fā)表于 10-16 09:23
?741次閱讀
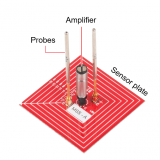
DieBound芯片鍵合,是在封裝基板上安裝芯片的工藝方法。本文詳細(xì)介紹一下幾種主要的芯片
![的頭像]() 發(fā)表于
發(fā)表于 09-20 08:04
?1049次閱讀

金絲鍵合強(qiáng)度測(cè)試儀是測(cè)量引線鍵合強(qiáng)度,評(píng)估鍵合強(qiáng)度分布或測(cè)定鍵
![的頭像]() 發(fā)表于
發(fā)表于 07-06 11:18
?752次閱讀

引線鍵合是微電子封裝領(lǐng)域中的一項(xiàng)關(guān)鍵技術(shù),它負(fù)責(zé)實(shí)現(xiàn)芯片與封裝基板或其他芯片之間的電氣連接。隨著集成電路技術(shù)的不斷進(jìn)步,
![的頭像]() 發(fā)表于
發(fā)表于 04-28 10:14
?1333次閱讀

隨著科技的發(fā)展,精確測(cè)量和控制成為重要的研究課題。引線拉力測(cè)試儀是一種用于精確測(cè)量材料和零件的設(shè)備,可以用來(lái)測(cè)量材料的強(qiáng)度、彈性、疲勞強(qiáng)度和韌性等性能指標(biāo)。引線鍵合測(cè)試背后的原理是將鉤子定位在引線
![的頭像]() 發(fā)表于
發(fā)表于 04-02 17:45
?857次閱讀
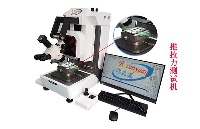
任務(wù)要求:
了解微電子封裝中的引線鍵合工藝,學(xué)習(xí)金絲引線鍵合原理,開(kāi)發(fā)引線鍵合工藝仿真方法,通過(guò)數(shù)據(jù)統(tǒng)計(jì)分析和仿真結(jié)果,分析得出引線鍵合工序
發(fā)表于 03-10 14:14
共讀好書(shū) 熊化兵,李金龍,胡 瓊,趙光輝,張文烽,談侃侃 (中國(guó)電子科技集團(tuán)公司) 摘要: 研究了 18 、25 、 30 μ m 三種金絲和 25 、 32 、 45 μ m 三種硅鋁絲鍵合引線在
![的頭像]() 發(fā)表于
發(fā)表于 02-25 17:05
?649次閱讀



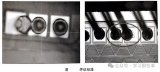



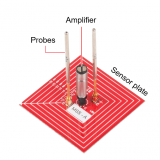


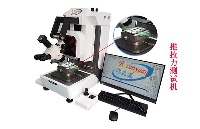





 等離子清洗機(jī)在陶瓷封裝、引線框架、芯片鍵合、引線鍵合的應(yīng)用
等離子清洗機(jī)在陶瓷封裝、引線框架、芯片鍵合、引線鍵合的應(yīng)用













評(píng)論