封裝的熱特性對(duì)于IC應(yīng)用的性能和可靠性至關(guān)重要。本文介紹標(biāo)準(zhǔn)的熱封裝特性:熱阻(稱為“θ”或 Θ)、ΘJA、ΘJC 和 ΘCA。提供了熱計(jì)算和有關(guān)熱管理的更多信息的參考。
介紹
在選擇封裝時(shí)應(yīng)考慮熱管理,以確保高產(chǎn)品可靠性。所有IC在通電時(shí)都會(huì)產(chǎn)生熱量。因此,為了將器件的結(jié)溫保持在允許的最大值以下,從IC通過封裝到環(huán)境的有效熱流至關(guān)重要。本文可幫助設(shè)計(jì)人員和客戶了解基本的IC熱管理概念。在討論封裝傳熱時(shí),它定義了熱表征的重要術(shù)語,從熱阻及其各種“θ”表示開始。本文還提供了熱計(jì)算和數(shù)據(jù),以確保正確的結(jié)(芯片)、外殼(封裝)和電路板溫度。
熱阻的重要性
半導(dǎo)體的熱管理涉及熱阻,這是描述材料傳熱特性的重要品質(zhì)因數(shù)。在計(jì)算中,熱阻被識(shí)別為“Theta”,源自希臘語中的熱“熱水瓶”。我們特別感興趣的是熱阻。
IC封裝的熱阻是衡量封裝將IC(芯片)產(chǎn)生的熱量傳遞到電路板或環(huán)境的能力的指標(biāo)。給定兩點(diǎn)的溫度,從一個(gè)點(diǎn)到另一個(gè)點(diǎn)的熱流量完全由熱阻決定。通過了解封裝的熱阻,可以計(jì)算給定功耗下的IC結(jié)溫及其參考溫度。
定義
以下部分定義了 Theta (Θ) 和 Psi (Ψ),這是 IC 封裝熱表征中使用的標(biāo)準(zhǔn)術(shù)語。
ΘJA是從結(jié)點(diǎn)到環(huán)境的熱阻,測(cè)量單位為°C/W。 環(huán)境被視為熱“接地”。 ΘJA取決于封裝、電路板、氣流、輻射和系統(tǒng)特性。一般來說,輻射的影響可以忽略不計(jì)。ΘJA值僅針對(duì)自然慣例條件(無強(qiáng)制空氣)列出。
ΘJC是從結(jié)到外殼的熱阻。外殼是包裝外表面上的指定點(diǎn)。ΘJC取決于封裝材料(引線框架、模塑料、芯片粘接粘合劑)和特定的封裝設(shè)計(jì)(芯片厚度、裸露焊盤、內(nèi)部熱通孔和所用金屬的導(dǎo)熱性)。
對(duì)于引線封裝,ΘJC 外殼上的參考點(diǎn)是引腳 1 從塑料中出現(xiàn)的位置。對(duì)于標(biāo)準(zhǔn)塑料封裝,ΘJC 在引腳 1 的拐角處測(cè)量。它是在裸焊盤封裝的裸焊盤表面的中心測(cè)量的。The Θ杰克通過將封裝直接連接到“無限散熱器”來完成測(cè)量,“無限散熱器”通常是液冷銅塊,可以吸收任何數(shù)量的熱流而沒有熱阻。測(cè)量表示純粹通過傳導(dǎo)將熱量從芯片傳遞到封裝表面。
注意 Θ杰克僅考慮到封裝表面的熱流路徑的阻力。因此,ΘJC 始終小于 ΘJA.因此,ΘJC 代表特定的、導(dǎo)電的熱路徑熱阻,而 ΘJA表示傳導(dǎo)、對(duì)流和輻射熱路。
ΘCA是從外殼到環(huán)境的熱阻。ΘCA包括從封裝外部到環(huán)境的所有熱路徑的熱阻。
鑒于上述定義,我們看到:
ΘJA = ΘJC + ΘCA
ΘJB是從結(jié)到電路板的熱阻。Θ新山量化結(jié)到板熱路徑,通常在靠近引腳1(距離封裝邊緣1mm<<>mm)附近的電路板上進(jìn)行測(cè)量。Θ新山包括來自兩個(gè)來源的熱阻:從IC的結(jié)點(diǎn)到封裝底部的參考點(diǎn),以及通過封裝下方的電路板。
測(cè)量 ΘJB,來自封裝頂部的對(duì)流被阻擋,并且冷板附著在與封裝位置相對(duì)的電路板遠(yuǎn)側(cè)。請(qǐng)參見下面的圖 1。
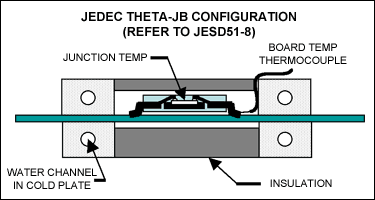
圖1.θ JB 測(cè)量過程圖示。
ΨJB是結(jié)到板熱特性參數(shù),以°C/W為單位進(jìn)行測(cè)量。JESD51-12《封裝熱信息報(bào)告和使用指南》闡明了熱特性參數(shù)與熱阻不同。相反,ΨJB測(cè)量流經(jīng)多個(gè)熱路徑而不是單個(gè)直接路徑的組件功率,如熱阻,ΘJB.因此,ΨJB熱路徑包括來自封裝頂部的對(duì)流,這一事實(shí)使ΨJB對(duì)客戶應(yīng)用更有用。
設(shè)計(jì)人員可以確定 ΘJB和 ΨJB通過熱建模或直接測(cè)量的值。在任一情況下,請(qǐng)按照以下步驟操作:
控制適合 ΘJB 或 ΨJB 的功耗條件。
確定芯片溫度,通常使用片上二極管。
確定距離封裝邊緣 < 1mm 處的 PCB 溫度。
確定功耗。
ΨJT是測(cè)量結(jié)溫與封裝頂部溫度之間的溫度變化的表征參數(shù)。ΨJT可用于在已知封裝頂部溫度和功耗時(shí)估算結(jié)溫。
熱計(jì)算
結(jié)溫
TJ = 結(jié)溫
TA= 環(huán)境溫度,以及
P = 功耗(瓦特)
TJ 也可以通過使用 ΨJB 或 ΨJT 值作為來計(jì)算。TJ = TB + (ΨJB × P)
其中:
TB = 在封裝 1mm 范圍內(nèi)測(cè)得的電路板溫度
TJ = TT + (ΨJT × P)
其中:
TT = 在封裝頂部中心測(cè)量的溫度。
注意:產(chǎn)品數(shù)據(jù)手冊(cè)規(guī)定了每個(gè)器件的最大允許結(jié)溫。
最大允許功耗
Pmax = (TJ-max - TA) / ΘJA
Maxim列出的最大允許功率假設(shè)環(huán)境溫度為+70°C,最大允許結(jié)溫為+150°C。
減額功能
此功能描述在+70°C以上每°C環(huán)境溫度下必須降低多少功耗。 減額函數(shù)以 mW/°C 表示。
減額函數(shù)= P / (TJ - TA)
其中:
TA 通常為 +70°C(商用)
和:
TJ是最高允許結(jié)溫,通常為+150°C。
要找到環(huán)境溫度高于 +70°C 時(shí)的最大允許功率(例如,擴(kuò)展溫度范圍內(nèi)的 +85°C),請(qǐng)執(zhí)行以下操作:
Pmax85C = Pmax70C - (Deration Function × (85 - 70))
熱表征和測(cè)量條件
IC封裝的熱性能必須使用JEDEC標(biāo)準(zhǔn)的方法和設(shè)備進(jìn)行測(cè)量。使用特定應(yīng)用的電路板進(jìn)行表征可能會(huì)產(chǎn)生不同的結(jié)果。還可以理解,JEDEC 定義的配置并不代表典型的實(shí)際系統(tǒng)。相反,JEDEC 配置允許標(biāo)準(zhǔn)化的熱分析和測(cè)量以保持一致性;它們對(duì)于比較封裝變化之間的熱品質(zhì)因數(shù)最有用。
JEDEC 規(guī)范標(biāo)題
JESD51:元件封裝的熱測(cè)量方法(單半導(dǎo)體器件)
JESD51-1:集成電路熱測(cè)量方法—電氣測(cè)試方法(單半導(dǎo)體器件)
JESD51-2: 集成電路熱測(cè)試方法環(huán)境條件—自然對(duì)流(靜止空氣)
JESD51-3: 用于引線表面貼裝封裝的低效導(dǎo)熱測(cè)試板
JESD51-4:熱測(cè)試芯片指南(引線鍵合型芯片)
JESD51-5:直接熱連接機(jī)制封裝熱測(cè)試板標(biāo)準(zhǔn)的擴(kuò)展
JESD51-6:集成電路熱測(cè)試方法環(huán)境條件—強(qiáng)制對(duì)流(流動(dòng)空氣)
JESD51-7: 用于引線表面貼裝封裝的高效導(dǎo)熱測(cè)試板
JESD51-8:集成電路熱測(cè)試方法環(huán)境條件—結(jié)到板
JESD51-9: 面陣表面貼裝封裝熱測(cè)量測(cè)試板
JESD51-10: 用于通孔周界引線封裝熱測(cè)量的測(cè)試板
JEDEC51-12:報(bào)告和使用電子封裝熱信息指南
JEDEC 散熱多層測(cè)試板規(guī)范 JESD51-7 摘要
用于引線表面貼裝封裝的高效導(dǎo)熱測(cè)試板
JESD51-7規(guī)范中描述的熱測(cè)試板最適合Maxim IC應(yīng)用。
材料:FR-4
層:兩個(gè)信號(hào)(正面和背面)和兩個(gè)平面(內(nèi)部)
成品厚度:1.60±0.16毫米
金屬厚度:
正面和背面:2oz銅(0.070mm成品厚度)
兩個(gè)內(nèi)部平面:1盎司銅(0.035mm成品厚度)
介電層厚度:0.25毫米至0.50毫米
電路板尺寸:76.20mm x 114.30mm ±0.25mm,適用于側(cè)面小于27mm的封裝
組件側(cè)跡線設(shè)計(jì)
走線的布局應(yīng)使測(cè)試設(shè)備在電路板上居中。走線必須從封裝主體邊緣延伸至少 25 毫米。對(duì)于 0.25mm 或更大間距封裝,走線寬度應(yīng)為 10.0 ±5%。對(duì)于間距較細(xì)的封裝,走線寬度應(yīng)等于引線寬度。走線模式和走線端接要求在JESD51-7中規(guī)定。
背面走線設(shè)計(jì)
端接通孔的元件側(cè)走線可以通過走線或電線(22 AWG 或更小的銅線)連接到邊緣連接器。JESD51-7規(guī)定了不同導(dǎo)線尺寸的電流限值。
電源和接地層必須不間斷,但通孔隔離間隙模式除外。平面不得出現(xiàn)在邊緣連接器圖案的 9.5mm 范圍內(nèi)。
裸焊盤封裝
裸焊盤 (EP) 封裝(如 QFN、DFN(雙扁平封裝無引線)和 EP-TQFP)對(duì)熱性能的一個(gè)關(guān)鍵要求是裸焊盤焊點(diǎn)下的熱通孔設(shè)計(jì)。在典型的熱特性板設(shè)計(jì)中,有 4、9 或 16 個(gè)熱通孔陣列連接到最近的接地層。熱改善在 25 個(gè)過孔以上變得漸近。了解電路板熱通孔與系統(tǒng)熱性能之間的直接關(guān)系至關(guān)重要。請(qǐng)參考JESD51-5,了解裸焊盤封裝的電路板設(shè)計(jì)增強(qiáng)功能。
焊料覆蓋范圍
當(dāng)客戶表征他們的電路板焊接工藝時(shí),他們應(yīng)該以焊點(diǎn)覆蓋率達(dá)到 90% 或更高的目標(biāo)。當(dāng)焊點(diǎn)空隙接近50%或更多時(shí),由此產(chǎn)生的熱通孔斷開將對(duì)熱阻產(chǎn)生災(zāi)難性影響。
熱建模
FLOTHERM 和其他熱分析軟件程序可實(shí)現(xiàn)準(zhǔn)確的封裝和系統(tǒng)熱預(yù)測(cè)。當(dāng)適當(dāng)?shù)臒崮P团c經(jīng)驗(yàn)數(shù)據(jù)相結(jié)合時(shí),用戶可以高度確信結(jié)果準(zhǔn)確反映了實(shí)際應(yīng)用。
電氣設(shè)計(jì)工具(如PSPICE或Cadence工具)可用于制作封裝的簡(jiǎn)單熱模型。封裝元件表示為電阻器網(wǎng)絡(luò)中連接到電路板的電阻器。當(dāng)確認(rèn)封裝模型與經(jīng)驗(yàn)數(shù)據(jù)一致時(shí),該模型可用于預(yù)測(cè)封裝變化,包括:芯片尺寸、裸焊盤尺寸、熔絲引線或連接到平面的接地?cái)?shù)。這些“假設(shè)”模型可以相當(dāng)準(zhǔn)確地預(yù)測(cè)自定義配置。
審核編輯:郭婷
-
芯片
+關(guān)注
關(guān)注
456文章
51170瀏覽量
427250 -
散熱器
+關(guān)注
關(guān)注
2文章
1057瀏覽量
37761 -
輻射
+關(guān)注
關(guān)注
1文章
604瀏覽量
36429
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
基于EFM32的無磁熱表的方案
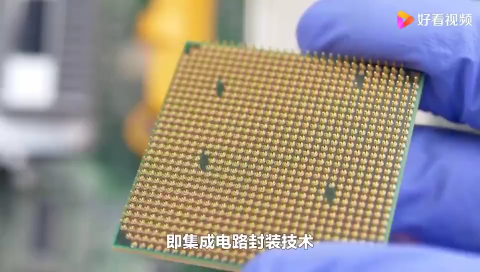
基于89C2051單片機(jī)的熱表通訊模塊的設(shè)計(jì)
IC封裝原理是什么?
半導(dǎo)體芯片封裝新載體—IC封裝基板
如何建立準(zhǔn)確的IC封裝模型

無需電池表征的精確電量計(jì)IC
ic封裝測(cè)試是做什么?ic封測(cè)是什么意思?芯片封測(cè)是什么?
冷熱表高精度溫度測(cè)量參考設(shè)計(jì)應(yīng)用說明





 IC封裝的熱表征
IC封裝的熱表征











評(píng)論