從下圖中可以看出結(jié)合使用XeF2氣流和氯離子轟擊的刻蝕速率最高,明顯高于這兩種工藝單獨(dú)使用時(shí)的刻蝕速率總和。原因在于氯離子轟擊會(huì)打斷表面硅原子的化學(xué)鍵形成懸浮鍵。
表面上帶有懸浮鍵的硅原子比沒(méi)有斷裂的硅原子更易于和氟自由基形成四氟化硅。由于離子轟擊以垂直方向?yàn)橹鳎虼舜怪狈较虻目涛g速率比水平方向高,所以RIE具有非等向性刻蝕輪廓。
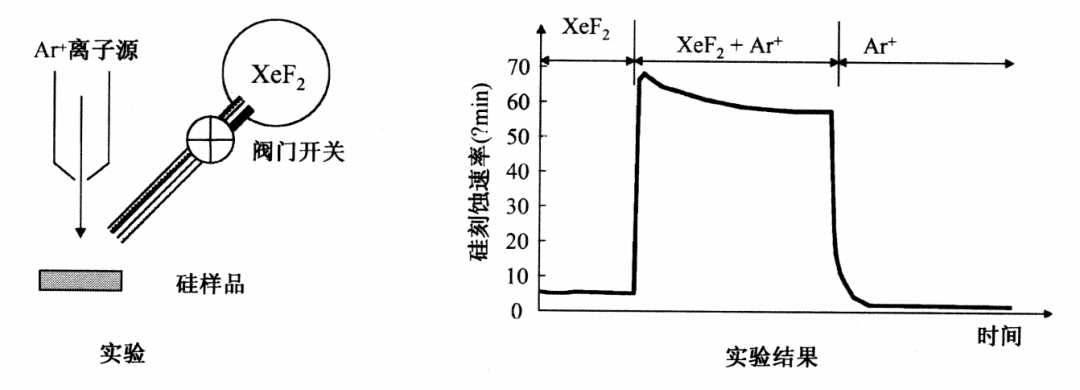
先進(jìn)的半導(dǎo)體制造中,幾乎所有的圖形化刻蝕都是RIE過(guò)程。RIE的刻蝕速率和刻蝕選擇性可以控制,刻蝕輪廓是非等向性且可控的,下表給出了這三種刻蝕工藝的比較。

刻蝕工藝原理
等離子體刻蝕中,首先將刻蝕氣體注入真空反應(yīng)室。當(dāng)壓力穩(wěn)定后再利用射頻產(chǎn)生輝光放電等離子體。部分刻蝕劑受高速電子撞擊后將分解產(chǎn)生自由基,接著自由基擴(kuò)散到邊界層下的晶圓表面并被表面吸附。
在離子轟擊作用下,自由基很快和表面的原子或分子發(fā)生反應(yīng)而形成氣態(tài)的副產(chǎn)品。從晶圓表面脫附而岀的易揮發(fā)性副產(chǎn)品擴(kuò)散穿過(guò)邊界層進(jìn)入對(duì)流氣流中,并從反應(yīng)室中排出。整個(gè)等離子體刻蝕過(guò)程如下圖所示。

等離子體刻蝕由于具有等離子體的離子轟擊,所以能達(dá)到非等向性的刻蝕輪廓,非等向性原理有兩種:損傷機(jī)制和阻絕機(jī)制,這兩者都和離子轟擊有關(guān)。
對(duì)于損傷機(jī)制,有力的離子轟擊將打斷晶圓表面上原子之間的化學(xué)鍵,帶有懸浮鍵的原子就會(huì)受到刻蝕自由基的作用。這些原子容易和刻蝕劑的自由基產(chǎn)生化學(xué)鍵而形成揮發(fā)性的副產(chǎn)品,并從表面移除掉。由于離子轟擊的方向垂直于晶圓表面,因此垂直方向的刻蝕速率遠(yuǎn)高于水平方向,所以等離子體刻蝕能形成非等向性的刻蝕輪廓。釆用損傷機(jī)理刻蝕是一種接近于物理刻蝕的RIE工藝。下圖顯示了非等向性刻蝕的損傷機(jī)理。
電介質(zhì)刻蝕包括二氧化硅、氮化硅和低左介質(zhì)層刻蝕,是傾向于物理刻蝕的RIE技術(shù)。使用損傷機(jī)制的刻蝕如果要增強(qiáng)非等向性輪廓就必須增加離子轟擊。低壓和高射頻采用重離子轟擊,能夠得到接近理想的垂直刻蝕輪廓。然而此舉會(huì)使等離子體造成器件的損壞,尤其對(duì)于多晶硅柵刻蝕,因此一般常選擇另一種離子轟擊較少的非等向性刻蝕機(jī)制。
當(dāng)發(fā)展單晶硅刻蝕時(shí),在進(jìn)行硅刻蝕之前,沒(méi)有將二氧化硅硬遮蔽層圖形化的光刻膠去除(一般要求硅刻蝕之前先去光刻膠以避免污染),接著刻蝕的結(jié)果導(dǎo)致了另一種非等向性刻蝕機(jī)制,這就是阻擋機(jī)制。在等離子體刻蝕工藝中,離子轟擊會(huì)濺鍍一些光刻膠進(jìn)入空洞中。當(dāng)光刻膠沉積在側(cè)壁時(shí)就阻擋側(cè)壁方向的刻蝕,沉積在底層的光刻膠會(huì)逐漸被等離子體的離子轟擊移除,所以使底部的晶圓表面暴露在刻蝕劑中,因此這種刻蝕過(guò)程以垂直方向?yàn)橹鳎ㄒ娤聢D)。
這種刻蝕很長(zhǎng)時(shí)間被用來(lái)發(fā)展各種非等向性刻蝕技術(shù),如非等向性刻蝕中所產(chǎn)生的化學(xué)沉積物將會(huì)保護(hù)側(cè)壁,并且阻擋水平方向的刻蝕。使用阻擋機(jī)制的刻蝕所需的離子轟擊比使用損傷機(jī)制少,從而可以達(dá)到非等向刻蝕的目的。單晶硅刻蝕、多晶硅刻蝕和金屬刻蝕一般都釆用這種機(jī)制,它們屬于接近化學(xué)刻蝕的RIE過(guò)程。對(duì)于側(cè)壁的沉積物則需要通過(guò)干法/濕法清洗,或者二者并用的清洗方式來(lái)處理。
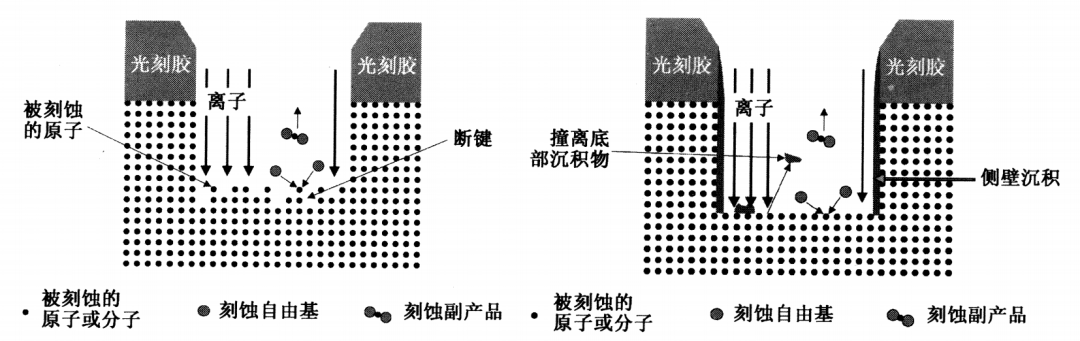
審核編輯:劉清
-
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27703瀏覽量
222628 -
晶圓
+關(guān)注
關(guān)注
52文章
4973瀏覽量
128313 -
光刻膠
+關(guān)注
關(guān)注
10文章
321瀏覽量
30346
原文標(biāo)題:半導(dǎo)體行業(yè)(一百五十七)之刻蝕工藝(八)
文章出處:【微信號(hào):FindRF,微信公眾號(hào):FindRF】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
列數(shù)芯片制造所需設(shè)備
comsol電化學(xué)燃燒電池,等離子體,光電年會(huì)
TDK|低溫等離子體技術(shù)的應(yīng)用
等離子體應(yīng)用
中微等離子體刻蝕設(shè)備Primo AD-RIE(TM)運(yùn)抵中芯國(guó)際
中微推出電感耦合等離子體刻蝕設(shè)備用于批量生產(chǎn)存儲(chǔ)芯片和邏輯芯片前道工序
中微半導(dǎo)體自主研制的5納米等離子體刻蝕機(jī)獲臺(tái)積電驗(yàn)證
中微發(fā)布了第一代電感耦合等離子體刻蝕設(shè)備
半導(dǎo)體制造之等離子工藝詳解
低溫等離子體技術(shù)的應(yīng)用

半導(dǎo)體干法刻蝕技術(shù)解析





 半導(dǎo)體制造中的等離子體刻蝕過(guò)程
半導(dǎo)體制造中的等離子體刻蝕過(guò)程












評(píng)論