對于如今的半導體產業而言,EUV光刻機是打造下一代邏輯和DRAM工藝技術的關鍵所在,為了在未來的工藝軍備競賽中保持優勢,臺積電、三星和英特爾等廠商紛紛花重金購置EUV光刻機。
然而,當這些來自荷蘭造價上億的龐大機器到位并組裝好后,并不意味著EUV光刻機的生產工作完全準備就緒。隨著先進工藝晶圓制造中圖案化策略和分辨率重視程度的攀升,為了滿足這些需求,與EUV光刻技術相關的材料同樣需要納入考量,尤其是光刻膠和防護膜。
EUV光刻膠
大家最為熟知的一大光刻材料自然就是光刻膠了,光刻膠為晶圓生產帶來的不僅是高分辨率,同樣也是控制隨機缺陷的關鍵。極紫光透過光掩膜透明的部分在光刻膠上曝光,接著去掉曝光的光刻膠,蝕刻曝光的材料,最終去掉所有光刻膠留下光刻后的圖案,而我們常說的分辨率也就是光刻膠所能產生的最小尺寸了。
與此同時,在ASML看來,下一代高NA EUV光刻機為光刻膠再度帶來了挑戰,更少的隨機效應、更高的分辨率和更薄的厚度。首先傳統的正膠和負膠肯定是沒法用了,DUV光刻機上常用的化學放大光刻膠(CAR)也開始在5nm之后的分辨率和敏感度上出現瓶頸,所以光刻膠上的創新已經成了2023年/2024年后高NA EUV光刻機的必要條件。
2020年,泛林集團宣布在ASML和imec的戰略合作下,已經研究出了用于EUV光刻機圖案化的干式光刻膠技術,這種干式光刻膠技術可以顯著提高EUV的敏感度和分辨率優勢,而且其生產工藝耗能更少,所用的原材料也比傳統光刻膠工藝少上5到10倍,從而改善了每次處理EUV晶圓所需的總成本。近日,泛林集團宣布將與三菱化學旗下Gelest以及Entegris這兩大材料公司合作,共同推進EUV干式光刻膠的量產。

線寬粗糙度增加下厚度減少的金屬氧化物光刻膠 / imec
而imec和JSR這樣的廠商則選擇了在金屬氧化物光刻膠(MOR)上下注,在他們的研究評估中,MOR光刻膠擁有更好的圖案轉移能力,能夠實現更高的分辨率,并把光刻膠做得更薄。不過雖然這類光刻膠已經被一票光刻膠廠商、晶圓廠看好,但目前在量產上還是存在一些問題的,比如在制備過程中需要將金屬污染等級降低至傳統行業等級之下。
EUV防護膜
對于利用EUV光刻機制造芯片來說,其實EUV防護膜的使用并不是必要的,這個材料的存在更多是為了保證光掩膜的清潔。盡管如今龐大的EUV都被放置在遵循嚴格標準的無塵潔凈室里,基本杜絕了外部顆粒的污染,然而在EUV光刻機的曝光過程中,要想做到零顆粒是不可能的,依照ASML的說法,約摸1萬次曝光就會有一個雜質顆粒的出現。
部分廠商對此或許并不在意,比如三星就一直在推遲防護膜的使用,以至于最后干脆自己投資并開發EUV防護膜。因為這些雜質的存在或許會對良率產生一定影響,但如果為光掩膜貼上透射率不高的防護膜,那么就會吸收部分13.5nm波長的極紫光,屆時影響了的就是產量了。EUV光刻機開始普及使用的那段時期,恰好遇上了全球半導體產能短缺,自然保產量才是各大晶圓廠的首要目標。
不過如今產能情況逐漸轉好,EUV防護膜的開發與普及也是時候提上議程了。要想不對EUV光刻機的產能輸出造成太大的影響,晶圓廠都希望防護膜的透射率能做到90%以上。從去年開始,已經有一批企業打造出了90%透射率以上的防護膜了。比如Canatu打造的碳納米管EUV防護膜,就可以做到97%的透射率。

全尺寸EUV防護膜 / imec
既然如此,這些晶圓廠已經早已經跟進了才對,為何防護膜至今仍然沒有受到臺積電、三星等廠商的青睞,難不成他們在等更低成本的方案不成?其實不然,光刻過程中還有一個問題也在影響EUV防護膜的普及,那就是材料壽命。
雖然這些防護膜已經實現了90%的透射率,但隨著新一代EUV光刻機的光源功率已經超過了250W,未來的高NA EUV光刻機的功率還將進一步提升,光源帶來的熱應力會破壞這些防護膜,所以在選擇防護膜的同時還得考慮耐熱性,否則不會有晶圓廠想要頻繁替換防護膜的。所以大部分防護膜廠商即便實現了90%以上的透射率,也還在推進具有可觀壽命防護膜的大規模量產,至于這些EUV防護膜的廣泛使用,還需要等待材料和工藝上后續創新。
然而,當這些來自荷蘭造價上億的龐大機器到位并組裝好后,并不意味著EUV光刻機的生產工作完全準備就緒。隨著先進工藝晶圓制造中圖案化策略和分辨率重視程度的攀升,為了滿足這些需求,與EUV光刻技術相關的材料同樣需要納入考量,尤其是光刻膠和防護膜。
EUV光刻膠
大家最為熟知的一大光刻材料自然就是光刻膠了,光刻膠為晶圓生產帶來的不僅是高分辨率,同樣也是控制隨機缺陷的關鍵。極紫光透過光掩膜透明的部分在光刻膠上曝光,接著去掉曝光的光刻膠,蝕刻曝光的材料,最終去掉所有光刻膠留下光刻后的圖案,而我們常說的分辨率也就是光刻膠所能產生的最小尺寸了。
與此同時,在ASML看來,下一代高NA EUV光刻機為光刻膠再度帶來了挑戰,更少的隨機效應、更高的分辨率和更薄的厚度。首先傳統的正膠和負膠肯定是沒法用了,DUV光刻機上常用的化學放大光刻膠(CAR)也開始在5nm之后的分辨率和敏感度上出現瓶頸,所以光刻膠上的創新已經成了2023年/2024年后高NA EUV光刻機的必要條件。
2020年,泛林集團宣布在ASML和imec的戰略合作下,已經研究出了用于EUV光刻機圖案化的干式光刻膠技術,這種干式光刻膠技術可以顯著提高EUV的敏感度和分辨率優勢,而且其生產工藝耗能更少,所用的原材料也比傳統光刻膠工藝少上5到10倍,從而改善了每次處理EUV晶圓所需的總成本。近日,泛林集團宣布將與三菱化學旗下Gelest以及Entegris這兩大材料公司合作,共同推進EUV干式光刻膠的量產。

線寬粗糙度增加下厚度減少的金屬氧化物光刻膠 / imec
而imec和JSR這樣的廠商則選擇了在金屬氧化物光刻膠(MOR)上下注,在他們的研究評估中,MOR光刻膠擁有更好的圖案轉移能力,能夠實現更高的分辨率,并把光刻膠做得更薄。不過雖然這類光刻膠已經被一票光刻膠廠商、晶圓廠看好,但目前在量產上還是存在一些問題的,比如在制備過程中需要將金屬污染等級降低至傳統行業等級之下。
EUV防護膜
對于利用EUV光刻機制造芯片來說,其實EUV防護膜的使用并不是必要的,這個材料的存在更多是為了保證光掩膜的清潔。盡管如今龐大的EUV都被放置在遵循嚴格標準的無塵潔凈室里,基本杜絕了外部顆粒的污染,然而在EUV光刻機的曝光過程中,要想做到零顆粒是不可能的,依照ASML的說法,約摸1萬次曝光就會有一個雜質顆粒的出現。
部分廠商對此或許并不在意,比如三星就一直在推遲防護膜的使用,以至于最后干脆自己投資并開發EUV防護膜。因為這些雜質的存在或許會對良率產生一定影響,但如果為光掩膜貼上透射率不高的防護膜,那么就會吸收部分13.5nm波長的極紫光,屆時影響了的就是產量了。EUV光刻機開始普及使用的那段時期,恰好遇上了全球半導體產能短缺,自然保產量才是各大晶圓廠的首要目標。
不過如今產能情況逐漸轉好,EUV防護膜的開發與普及也是時候提上議程了。要想不對EUV光刻機的產能輸出造成太大的影響,晶圓廠都希望防護膜的透射率能做到90%以上。從去年開始,已經有一批企業打造出了90%透射率以上的防護膜了。比如Canatu打造的碳納米管EUV防護膜,就可以做到97%的透射率。

全尺寸EUV防護膜 / imec
雖然這些防護膜已經實現了90%的透射率,但隨著新一代EUV光刻機的光源功率已經超過了250W,未來的高NA EUV光刻機的功率還將進一步提升,光源帶來的熱應力會破壞這些防護膜,所以在選擇防護膜的同時還得考慮耐熱性,否則不會有晶圓廠想要頻繁替換防護膜的。所以大部分防護膜廠商即便實現了90%以上的透射率,也還在推進具有可觀壽命防護膜的大規模量產,至于這些EUV防護膜的廣泛使用,還需要等待材料和工藝上后續創新。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
半導體
+關注
關注
334文章
27711瀏覽量
222651 -
EUV光刻機
+關注
關注
2文章
128瀏覽量
15186
發布評論請先 登錄
相關推薦
如何提高光刻機的NA值
本文介紹了如何提高光刻機的NA值。 為什么光刻機希望有更好的NA值?怎樣提高? ? 什么是NA值? ? 如上圖是某型號的光刻機配置,每代光刻機的NA值會比上一代更大一些。NA,又名

組成光刻機的各個分系統介紹
納米級別的分辨率。本文將詳細介紹光刻機的主要組成部分及其功能。 光源系統 ? 光源系統是光刻機的心臟,負責提供曝光所需的能量。早期的光刻機使用汞燈作為光源,但隨著技術的進步,目前多采用深紫外(DUV)或極紫外(
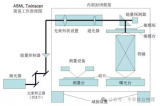
日本首臺EUV光刻機就位
據日經亞洲 12 月 19 日報道,Rapidus 成為日本首家獲得極紫外 (EUV) 光刻設備的半導體公司,已經開始在北海道芯片制造廠內安裝極紫外光刻系統。 它將分四個階段進行安裝,設備安裝預計在
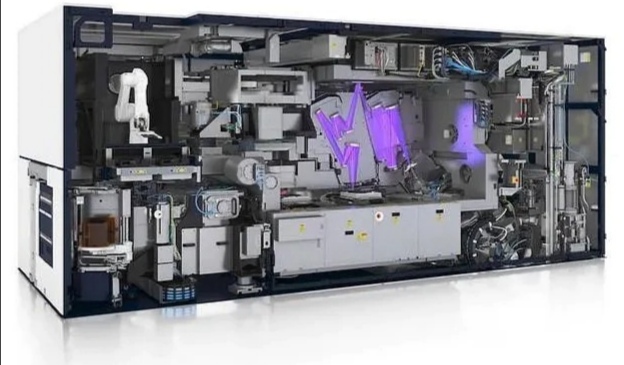
用來提高光刻機分辨率的浸潤式光刻技術介紹
? 本文介紹了用來提高光刻機分辨率的浸潤式光刻技術。 芯片制造:光刻技術的演進 過去半個多世紀,摩爾定律一直推動著半導體技術的發展,但當光刻機的光源波長卡在193nm,芯片制程縮小至6

光刻機的工作原理和分類
,是半導體產業皇冠上的明珠。芯片的加工過程對精度要求極高,光刻機通過一系列復雜的技術手段,將光束透射過畫著線路圖的掩模,經物鏡補償各種光學誤差,將線路圖成比例縮小后映射到硅片上,然后使用化學方法顯影,得到刻在硅片上的電路圖
俄羅斯首臺光刻機問世
據外媒報道,目前,俄羅斯首臺光刻機已經制造完成并正在進行測試。 俄羅斯聯邦工業和貿易部副部長瓦西里-什帕克(Vasily Shpak)表示,已組裝并制造了第一臺國產光刻機,作為澤廖諾格勒技術生產線
Rapidus對首代工藝中0.33NA EUV解決方案表示滿意,未采用高NA EUV光刻機
在全球四大先進制程代工巨頭(包括臺積電、三星電子、英特爾以及Rapidus)中,只有英特爾明確表示將使用High NA EUV光刻機進行大規模生產。
臺積電A16制程采用EUV光刻機,2026年下半年量產
據臺灣業內人士透露,臺積電并未為A16制程配備高數值孔徑(High-NA)EUV光刻機,而選擇利用現有的EUV光刻機進行生產。相較之下,英特爾和三星則計劃在此階段使用最新的High-N
ASML發貨第二臺High NA EUV光刻機,已成功印刷10nm線寬圖案
ASML公司近日宣布發貨了第二臺High NA EUV光刻機,并且已成功印刷出10納米線寬圖案,這一重大突破標志著半導體制造領域的技術革新向前邁進了一大步。
英特爾突破技術壁壘:首臺商用High NA EUV光刻機成功組裝
英特爾的研發團隊正致力于對這臺先進的ASML TWINSCAN EXE:5000 High NA EUV光刻機進行細致的校準工作,以確保其能夠順利融入未來的生產線。
光刻機的發展歷程及工藝流程
光刻機經歷了5代產品發展,每次改進和創新都顯著提升了光刻機所能實現的最小工藝節點。按照使用光源依次從g-line、i-line發展到KrF、ArF和EUV;按照工作原理依次從接觸接近式光刻機
發表于 03-21 11:31
?6796次閱讀
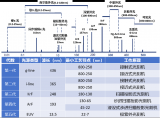
ASML 首臺新款 EUV 光刻機 Twinscan NXE:3800E 完成安裝
3 月 13 日消息,光刻機制造商 ASML 宣布其首臺新款 EUV 光刻機 Twinscan NXE:3800E 已完成安裝,新機型將帶來更高的生產效率。 ▲ ASML 在 X 平臺上的相關動態





 EUV光刻機就位后仍需解決的材料問題
EUV光刻機就位后仍需解決的材料問題












評論