HTOL(High temperature operation life test):高溫壽命試驗,需要上電,用帶測試向量(Pattern)的老化爐(比如:H160,Incal Echo, LM2100,DI,MCC等),需定做老化板BIB和老化socket,至少77顆/lot,通常會多幾顆,比如80顆/lot, 可以1個lot,也可以3個lot,老化時間通常為1000小時(中間會在168小時,500小時兩個readpoint拿出來做功能回測)。
相關標準:
JESD22-A108B:Temperature, Bias, and Operating Life。
JESD85:METHODS FOR CALCULATING FAILURE RATES IN UNITS OF FITS。
JESD47K:Stress-Test-Driven Qualification of Integrated Circuits。
JESD74:Early Life Failure Rate Calculation Procedure for Semiconductor Components。
失效模式:
典型浴缸曲線(Bathtub Curve)分成早夭期(Infant Mortality)、可使用期(Useful Life)及老化期(Wear out),對于不同區段的故障率評估,皆有相對應的試驗手法。

從浴缸曲線(Bathtub Curve) 三個區段,其故障率的統計數據及失效原因,歸納如下:
早夭期(Infant Mortality ):故障率由高而快速下降- 失效原因為設計缺失/制程缺失。
可使用期(Useful Life):故障率低且穩定-失效原因隨機出現(如EOS 故障)
老化期(Wear Out):故障率會快速增加-失效原因為老化造成。
加速因子:
1.電壓加速:電壓高于使用電壓Vmax 才獲得電壓加速。
計算公式:


2.溫度加速:HTOL溫度高于使用溫度獲得溫度加速。
計算公式:


總加速:

LTOL:Low temperature operation life test):低溫壽命試驗,需要上電,基本與HTOL一樣,只是爐溫是低溫,一般用來尋找熱載流子引起的失效,或用來試驗存儲器件或亞微米尺寸的器件。
相關標準:
JESD22-A108B:Temperature, Bias, and Operating Life
JESD47K:Stress-Test-Driven Qualification of Integrated Circuits
大多數可靠性實驗表明,環境溫度越高,器件退化越嚴重。熱載流子注入效應的情況相反,溫度越低,熱載流子注入效應越明顯。對應于LTOL來說溫度越低老化加速越厲害。
LTOL的測試條件,JESD47是參考Tj<50℃,但一般會用Ta=-40℃,低溫仍然滿足Tj<50℃,測試結果適用范圍相對較廣。車規驗證,operation ambient temperature range也是從Ta=-40℃開始。
使用機臺:DI機臺的一款DL602可以支持低溫老化實驗,LTOL一般使用的PCB板跟正常HTOL可以兼容,使用板材和元器件一般都可以滿足-40℃低溫條件。

原文標題:HTOL與LTOL的一些基本概念
文章出處:【微信公眾號:上海季豐電子】歡迎添加關注!文章轉載請注明出處。
審核編輯:劉清
-
PCB板
+關注
關注
27文章
1449瀏覽量
51953 -
存儲器
+關注
關注
38文章
7528瀏覽量
164340 -
EOS
+關注
關注
0文章
126瀏覽量
21247
原文標題:HTOL與LTOL的一些基本概念
文章出處:【微信號:zzz9970814,微信公眾號:上海季豐電子】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
連接器的失效模式和改善對策
電阻失效模式總結
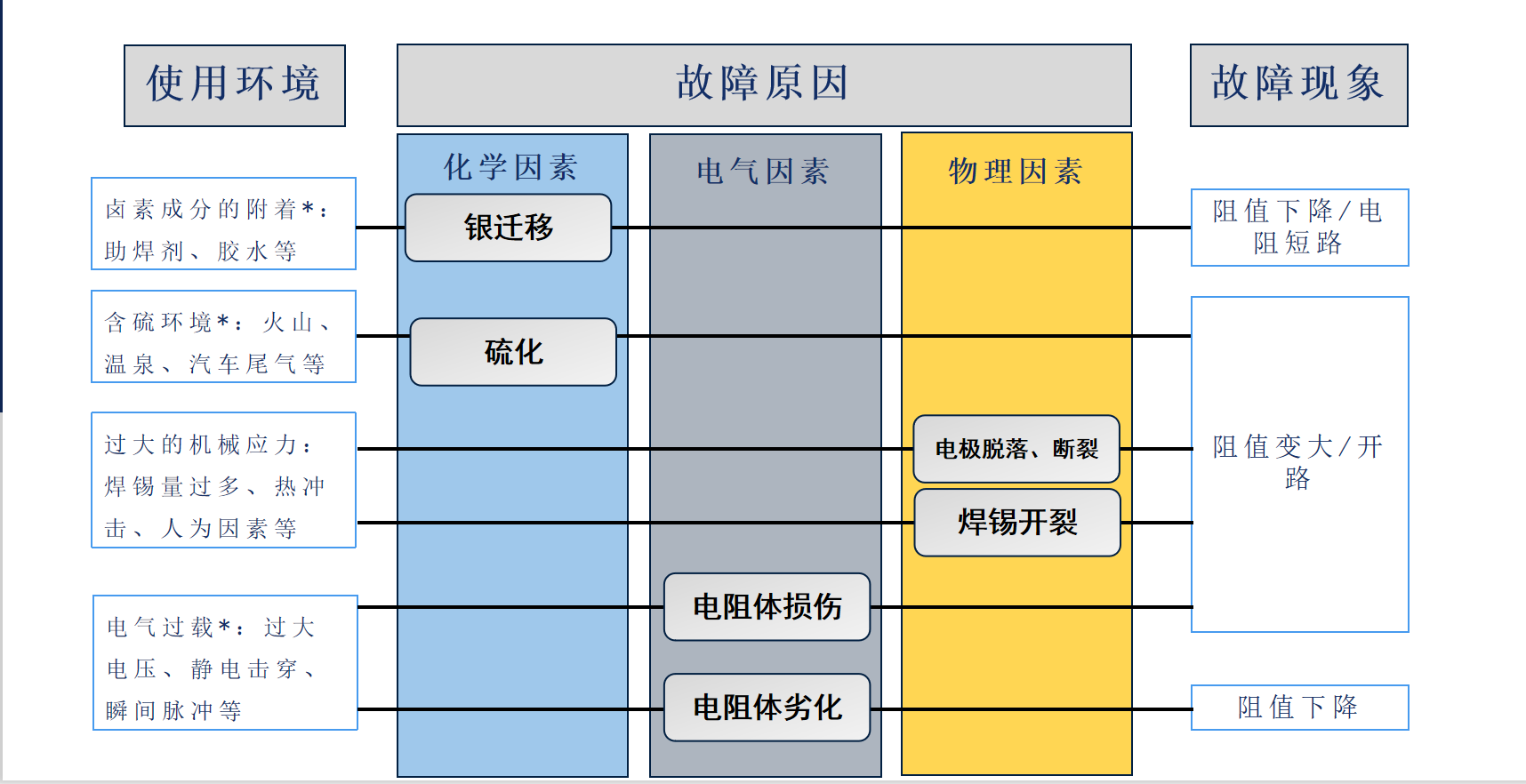
瓷介電容器失效模式分析方法
簡述繼電器觸點失效
MOS管的幾種失效模式
晶閘管的失效模式與機理
連接器的三類失效模式
IGBT器件失效模式的影響分析





 HTOL與LTOL的相關標準與失效模式詳解
HTOL與LTOL的相關標準與失效模式詳解














評論