引言
將ZnO:Al薄膜織構(gòu)化與沉積條件的依賴性分開是優(yōu)化ZnO作為太陽能電池中的光散射、透明接觸的一個(gè)重要方面。對(duì)于給定的多晶ZnO:Al薄膜,凹坑的密度和形狀可以通過改變各種酸的溫度和濃度來控制。凹坑密度通常隨著溫度的升高、濃度的降低或通過在小分子大小的弱酸中蝕刻而增加。觀察到的多晶ZnO:Al膜的腐蝕趨勢(shì)在ZnO單晶上得到證實(shí)。我們從蝕刻速率和凹坑形成的角度詳細(xì)討論了蝕刻過程。根據(jù)最近提出的ZnO腐蝕模型解釋了結(jié)果,并給出了可能的物理解釋。
介紹
織構(gòu)化的ZnO:Al薄膜可用于在硅薄膜太陽能電池中同時(shí)實(shí)現(xiàn)前接觸、窗口層和光捕獲源的作用。對(duì)于濺射的ZnO:Al膜,在通過化學(xué)蝕刻沉積后引入表面紋理。雖然單獨(dú)的沉積和紋理化步驟表面上允許單獨(dú)優(yōu)化光電和光散射特性,但事實(shí)證明實(shí)現(xiàn)起來很困難,因?yàn)樽罱K蝕刻坑的大小和形狀也取決于制備條件。
ZnO具有纖鋅礦晶體結(jié)構(gòu),因此它不具有沿c軸的反轉(zhuǎn)對(duì)稱性。
(1)(01)和(00-1)平面分別是Zn-和O-封端的。Zn-O鍵主要是離子鍵,這些極性鍵導(dǎo)致帶正電的鋅和帶負(fù)電的氧原子的平面垂直于c軸。幾十年前報(bào)道了ZnO單晶的蝕刻,并且可以基于懸掛鍵模型進(jìn)行解釋:酸性溶液中的水合氫離子容易蝕刻O-端接側(cè),而蝕刻僅發(fā)生在Zn-端接側(cè)的缺陷處[9]。然而,多晶ZnO薄膜的詳細(xì)蝕刻模型是最近發(fā)展的結(jié)果[10]。該模型的基礎(chǔ)包括以下三個(gè)假設(shè)。
濺射的ZnO:Al生長(zhǎng)為Zn封端的,并且像Zn封端的單晶一樣,該(001)晶面不被蝕刻,但是每個(gè)晶界都有可能被蝕刻,然而,因?yàn)槲g刻劑可以接觸到其他平面。如我們之前關(guān)于蝕刻模型的論文中所定義的,這種蝕刻潛力描述了特定位置在蝕刻時(shí)作為成核中心形成凹坑的可能性,并歸因于晶界的致密性。
(2)蝕刻劑溶液和條件限定了蝕刻閾值。蝕刻電位高于閾值的晶界被更積極地蝕刻。
(3)垂直和水平蝕刻速率也由溶液決定。垂直蝕刻速率沿著晶界進(jìn)行,蝕刻電位高于溶液的閾值,并且受到晶界的性質(zhì)以及蝕刻劑的流動(dòng)性和尺寸的限制。水平蝕刻速率受到蝕刻劑濃度和晶體結(jié)構(gòu)的限制,蝕刻在(101)面停止。
結(jié)果
鹽酸(HCl)
圖1 (a)和(b)分別給出了不同濃度下作為HCl溶液溫度的函數(shù)的ZnO:Al薄膜蝕刻速率和不同溫度下作為HCl溶液濃度的函數(shù)的相同數(shù)據(jù)。蝕刻速率隨著溫度和濃度而增加。指數(shù)函數(shù)和線性函數(shù)分別用作圖1 (a)和(b)中的擬合曲線。指數(shù)擬合很好地代表了實(shí)驗(yàn)溫度依賴性。濃度大于1 w/w%時(shí),觀察到偏離線性行為;在線性擬合中忽略1 w/w%以上的濃度,并在圖1 (b)中用粉紅色標(biāo)記。具有大蝕刻速率(高于40 nm/s)的樣品的誤差條變得相當(dāng)大,因?yàn)楦哌_(dá)一秒的假定誤差是總蝕刻時(shí)間的25 %。
圖2顯示了按HCl溶液的溫度和濃度組織的光學(xué)顯微鏡圖像矩陣。請(qǐng)注意,圖像幀的顏色代碼提供了右側(cè)刻度給出的蝕刻速率范圍。光學(xué)圖像沒有給出表面的精確表示,因?yàn)榉直媛什粔蚋撸蛔阋杂^察小的特征,并且光學(xué)對(duì)比度不一定揭示特征的形狀。然而,即使低于微米范圍的凹坑的密度和尺寸分布也容易檢測(cè)。通過提高HCl溫度和降低HCl濃度,所得凹坑的密度增加。
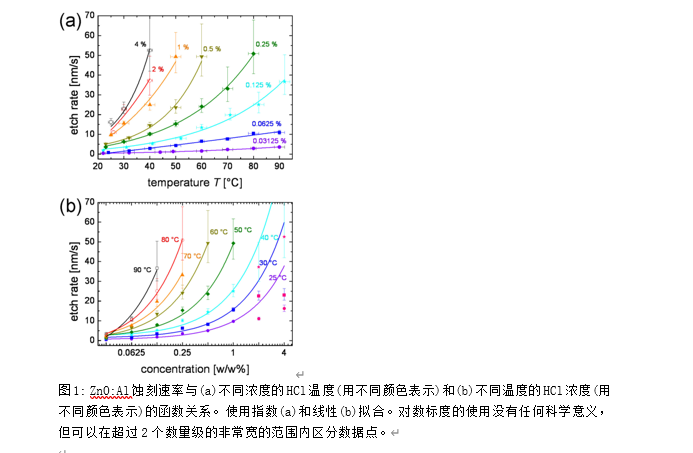
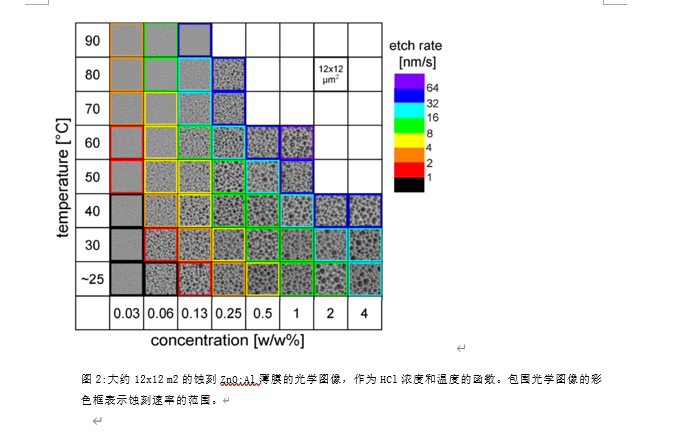
為了更精確地觀察不同溫度和濃度下表面結(jié)構(gòu)的差異,進(jìn)行了三個(gè)系列的AFM測(cè)量。首先,當(dāng)溫度變化時(shí),HCl濃度保持恒定在0.125 w/w%。第二,溫度在室溫下保持恒定,而HCl濃度變化。第三,當(dāng)溫度和濃度變化時(shí),蝕刻速率保持恒定在約25 nm/s(如圖1所示)。圖3給出了三個(gè)AFM系列的統(tǒng)計(jì)評(píng)估(恒溫、濃度和蝕刻速率)。在圖3 (a)和(b)中分別給出了作為溫度和濃度的函數(shù)的凹坑密度(左軸)和平均凹坑面積(右軸)。圖3 (c)和(d)分別給出了均方根粗糙度與溫度和濃度的函數(shù)關(guān)系。這四個(gè)圖表還包括蝕刻速率恒定但溫度和濃度變化的系列的統(tǒng)計(jì)數(shù)據(jù)。隨著鹽酸溫度的升高,觀察到凹坑密度從3.4m-2增加到28 m-2,凹坑尺寸從0.3m-2減少到0.04m-2,均方根粗糙度從100減少到26 nm(圖2和圖3 (a)和(c))。隨著HCl濃度的增加,觀察到凹坑密度從21m-2減少到1.9 m-2,凹坑尺寸從0.05m-2增加到0.6m-2,RMS粗糙度從26nm增加到130 nm(圖2和圖3 (b)和(d))。以恒定速率蝕刻的樣品顯示出相似的趨勢(shì);然而,溫度和濃度的影響通過相應(yīng)的其它參數(shù)的調(diào)整而復(fù)合。具體來說,在高溫低濃度HCl中蝕刻的樣品比在低溫高濃度HCl中蝕刻的樣品具有更高密度的小凹坑(圖2和圖3 (a-d))。
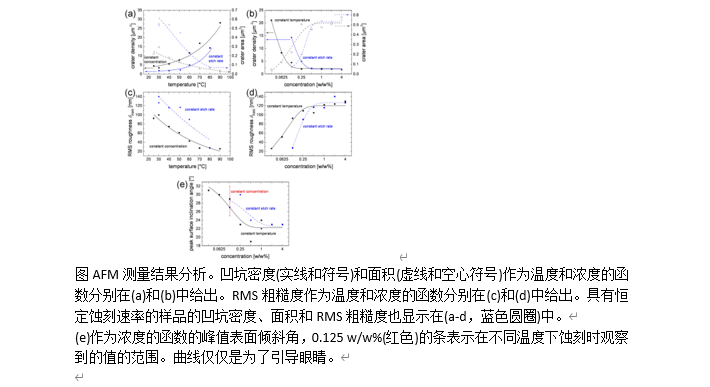
結(jié)論
我們已經(jīng)表明,對(duì)于給定的具有固定晶界蝕刻電位分布的多晶ZnO:Al薄膜,可以通過改變酸的類型、溫度和濃度來控制凹坑覆蓋范圍。根據(jù)最近開發(fā)的多晶ZnO:Al蝕刻模型解釋了這些結(jié)果[10]。晶界腐蝕電位的建議閾值與由腐蝕速率確定的假活化能有關(guān)。對(duì)于強(qiáng)離解酸(HCl)或大的弱離解有機(jī)酸(CH3CO2H),升高溫度或降低濃度會(huì)降低蝕刻閾值,導(dǎo)致更高的凹坑密度。這些蝕刻特性在單晶ZnO晶片上得到證實(shí)。還表明,通過降低少量弱解離酸(HF)的濃度,彈坑形狀可以從水平限制變?yōu)榇怪毕拗啤?duì)每一種腐蝕行為給出了可能的物理解釋。
審核編輯:湯梓紅
-
薄膜
+關(guān)注
關(guān)注
0文章
300瀏覽量
29736 -
蝕刻
+關(guān)注
關(guān)注
9文章
419瀏覽量
15508 -
晶片
+關(guān)注
關(guān)注
1文章
403瀏覽量
31575
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
碳化硅薄膜沉積技術(shù)介紹
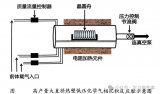
RS-ALD技術(shù)制備的Al2O3薄膜在TOPCon電池邊緣鈍化中的應(yīng)用研究

多晶氧化物中的晶界和異質(zhì)界面概念、形成機(jī)理以及如何表征

氮化硅薄膜的特性及制備方法

濕法蝕刻的發(fā)展

薄膜電容的頻率特性

薄膜電容的頻率特性
玻璃電路板表面微蝕刻工藝
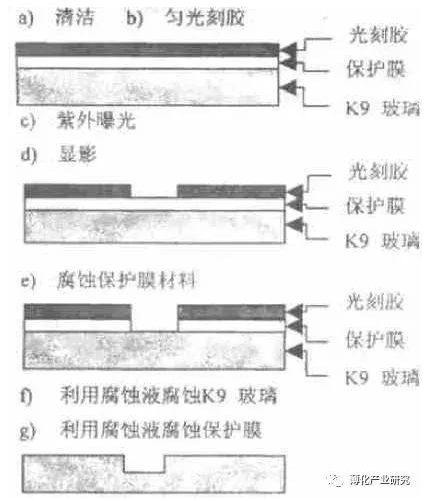
Molex薄膜電池具有哪些產(chǎn)品特性?-赫聯(lián)電子
ZnO電阻片在低電場(chǎng)區(qū)域的泄漏電流及其電阻的負(fù)溫度系數(shù)
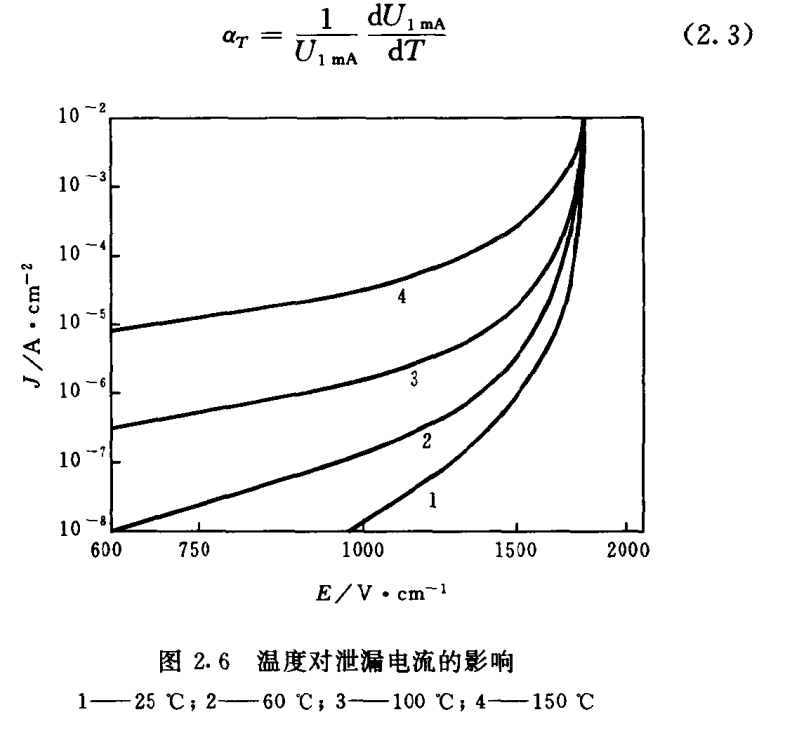
直流輸電系統(tǒng)氧化鋅ZnO電阻設(shè)計(jì)方案
影響pcb蝕刻性能的五大因素有哪些?

沖擊電流作用下氧化鋅電阻片的動(dòng)態(tài)伏安特性
怎么區(qū)分電阻是薄膜還是厚膜
沉積溫度和濺射功率對(duì)ITO薄膜性能的影響研究





 多晶ZnO:Al薄膜的蝕刻特性研究
多晶ZnO:Al薄膜的蝕刻特性研究










評(píng)論