我們測量了硅化物膜(CoSi2、NiSi2、TiSi2和WSi)的濺射刻蝕速率,并研究了離子能量的依賴性,發(fā)現(xiàn)它們與二氧化硅薄膜的相對濺射刻蝕速率幾乎與濺射離子能量無關(guān),從相對濺射蝕刻速率和計算的Ni和Si的截面比率來估計Ni的表面結(jié)合能,并發(fā)現(xiàn)由相對濺射刻蝕速率決定的表面結(jié)合能與眾所周知的值一致。
薄膜(Cosi2,Nisi2,Tisi2,WSi)通過濺射方法在n型Si (100)基板上沉積約200 納米,這些是由表面分析研究組提供的,它是多晶的,所以說一個的深度是用一個臺階總和來衡量的。
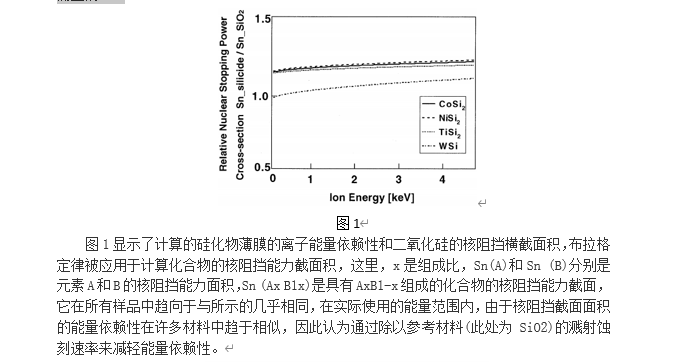
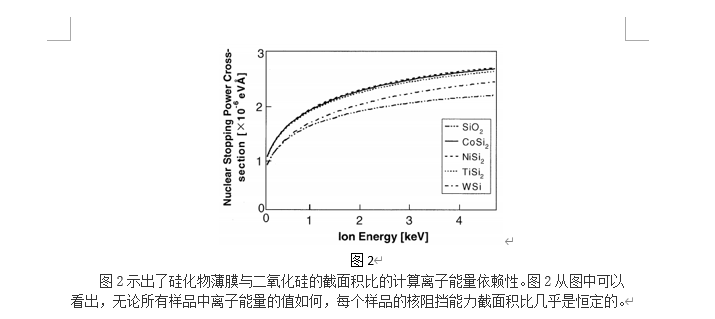

由本實驗求出的鎳對硅的相對濺射蝕刻速率的離子能量依賴性,用最小二乘法擬合核可阻止截面積比和濺射蝕刻速率,得到硅的離子能量依賴性,根據(jù)這些結(jié)果,可以認為通過實測不知道表面鍵能的物質(zhì)、表面鍵能和原子密度已知的物質(zhì)和相對濺射蝕刻速率,計算核阻止能截面積的比,可以推測某物質(zhì)的表面鍵能。
測量濺射坑的深度,并且測量硅化物薄膜的濺射蝕刻速率,并且檢查這些樣品的相對蝕刻速率對SiO2的能量依賴性,可以發(fā)現(xiàn),硅化物薄膜相對于SiO2的相對蝕刻速率具有很小的能量依賴性,如從核阻擋能力橫截面積的計算中所預(yù)期的,并且能量依賴性放松是實際的優(yōu)點,因為它可以估計尚未測量的能量下的值,此外,樣品的近似表面結(jié)合能可以從相對濺射蝕刻速率和核阻擋能力截面比來估計。
審核編輯:湯梓紅
聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報投訴
相關(guān)推薦
的刻蝕劑(諸如酸性、堿性或氧化性溶液)與半導(dǎo)體材料之間發(fā)生的化學(xué)反應(yīng)。這些反應(yīng)促使材料轉(zhuǎn)化為可溶性化合物,進而溶解于刻蝕液中,達到材料去除的目的。 2 刻蝕速率的精細調(diào)控:
![的頭像]() 發(fā)表于
發(fā)表于 01-08 16:57
?318次閱讀
等離子體刻蝕和濕法刻蝕是集成電路制造過程中常用的兩種刻蝕方法,雖然它們都可以用來去除晶圓表面的材料,但它們的原理、過程、優(yōu)缺點及適用范圍都有很大的不同。 ? ? 1. 刻蝕原理和機制的
![的頭像]() 發(fā)表于
發(fā)表于 01-02 14:03
?280次閱讀
)與半導(dǎo)體材料發(fā)生化學(xué)反應(yīng),形成可溶性產(chǎn)物。這些產(chǎn)物隨后被溶解在刻蝕液中,從而實現(xiàn)材料的去除。 刻蝕速率的控制:刻蝕速率由反應(yīng)動力學(xué)和溶液中
![的頭像]() 發(fā)表于
發(fā)表于 01-02 13:49
?130次閱讀
芯片濕法刻蝕方法主要包括各向同性刻蝕和各向異性刻蝕。為了讓大家更好了解這兩種方法,我們下面準備了詳細的介紹,大家可以一起來看看。 各向同性刻蝕 定義:各向同性
![的頭像]() 發(fā)表于
發(fā)表于 12-26 13:09
?225次閱讀
提高濕法刻蝕的選擇比,是半導(dǎo)體制造過程中優(yōu)化工藝、提升產(chǎn)品性能的關(guān)鍵步驟。選擇比指的是在刻蝕過程中,目標(biāo)材料與非目標(biāo)材料的刻蝕速率之比。一個高的選擇比意味著可以更精確地控制
![的頭像]() 發(fā)表于
發(fā)表于 12-25 10:22
?225次閱讀
”工藝則是在圖形化掩膜(多為光刻膠)的幫助下,通過各種復(fù)雜的物理和化學(xué)作用將被刻蝕材料層特定位置的材料去除或改性,實現(xiàn)對被刻蝕材料層的精細加工和雕刻。刻蝕工藝作為IC
![的頭像]() 發(fā)表于
發(fā)表于 12-16 15:03
?517次閱讀

液體將不要的材料去除。 1?干法刻蝕 干法刻蝕方式: ①濺射與離子束銑蝕 ②等離子刻蝕(Plasma Etching) ③高壓等離子刻蝕 ④
![的頭像]() 發(fā)表于
發(fā)表于 12-06 11:13
?493次閱讀

、過刻蝕、刻蝕速率、鉆蝕、選擇比、均勻性、深寬比以及各向同性/異性刻蝕。 ? ? 不完全刻蝕 不完全刻蝕
![的頭像]() 發(fā)表于
發(fā)表于 12-05 16:03
?757次閱讀

,影響刻蝕速率和選擇性。溫度影響聚合物的沉積速率和穩(wěn)定性,高溫可使沉積層分解或減少,低溫則會增加聚合物沉積。 ? 選擇性 :刻蝕材料和掩膜材
![的頭像]() 發(fā)表于
發(fā)表于 12-03 10:48
?493次閱讀

? ? ? 本文介紹了干法刻蝕工藝的不同參數(shù)。 干法刻蝕中可以調(diào)節(jié)的工藝參數(shù)有哪些?各有什么作用? 1,溫度:晶圓表面溫度,溫度梯度 晶圓表面溫度:控制刻蝕表面的化學(xué)反應(yīng)速率和產(chǎn)物的揮
![的頭像]() 發(fā)表于
發(fā)表于 12-02 09:56
?667次閱讀
表示,單位通常是納米/秒(nm/s)或埃/秒(?/s)。厚度可用膜厚儀、臺階儀或SEM等表征。 刻蝕速率=△d/t (?/min) △d=去掉的材料厚度(?或um) t=刻蝕
![的頭像]() 發(fā)表于
發(fā)表于 11-15 10:15
?742次閱讀

? ? ? 本文介紹了磁控濺射鍍膜工藝參數(shù)對薄膜的影響。 磁控濺射鍍膜工藝參數(shù)對薄膜的性能有著決定性的影響。這些參數(shù)包括濺射氣壓、濺射功率、靶基距、基底溫度、偏置電壓、
![的頭像]() 發(fā)表于
發(fā)表于 11-08 11:28
?649次閱讀
原理、工藝和應(yīng)用場景上有所不同。 濕法刻蝕 濕法刻蝕是利用化學(xué)溶液(如氫氧化鈉、氫氟酸等)與PDMS發(fā)生化學(xué)反應(yīng),從而去除PDMS材料的一種方法。該方法通常在常溫或加熱條件下進行,刻蝕速率
![的頭像]() 發(fā)表于
發(fā)表于 09-27 14:46
?320次閱讀
刻蝕過程中形成幾乎完全垂直于晶圓表面的側(cè)壁,是一種各向異性的刻蝕。刻蝕后的側(cè)壁非常垂直,底部平坦。這是理想的刻蝕形態(tài),它能夠非常精確地復(fù)制掩膜
發(fā)表于 03-27 10:49
?786次閱讀

刻蝕機的刻蝕過程和傳統(tǒng)的雕刻類似,先用光刻技術(shù)將圖形形狀和尺寸制成掩膜,再將掩膜與待加工物料模組裝好,將樣品置于刻蝕室內(nèi),通過化學(xué)腐蝕或物理
![的頭像]() 發(fā)表于
發(fā)表于 03-11 15:38
?1.1w次閱讀
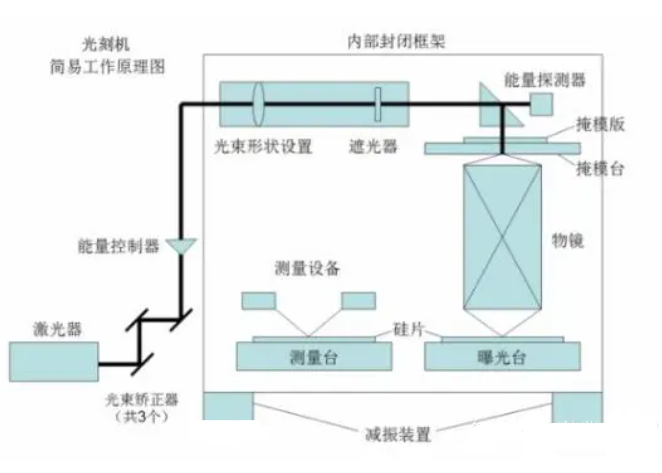
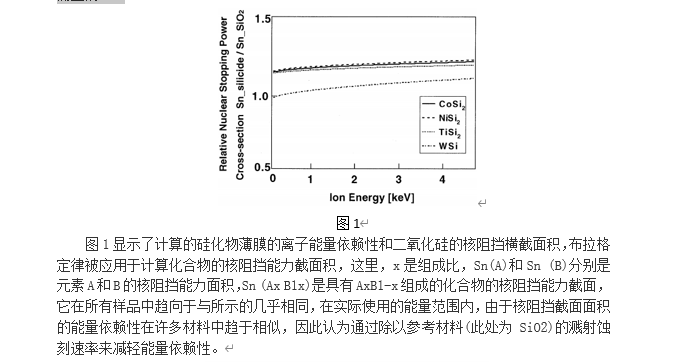
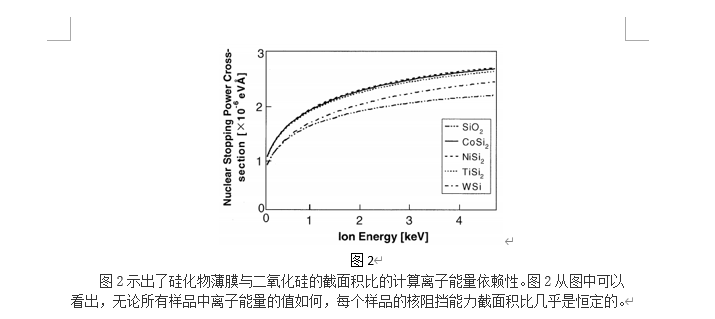




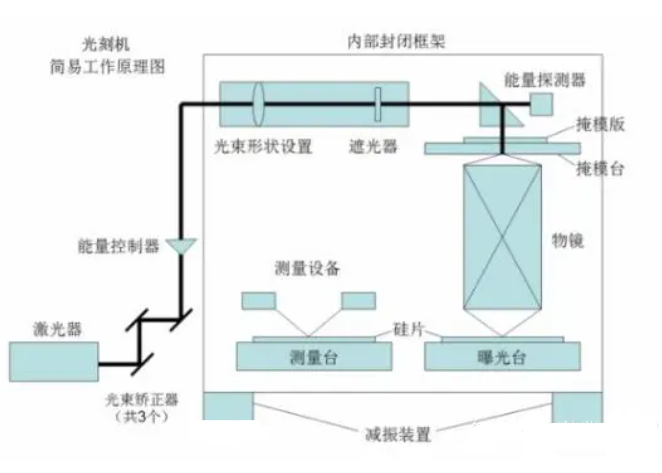




 硅化物膜的濺射刻蝕速率研究
硅化物膜的濺射刻蝕速率研究













評論