引言
半導(dǎo)體晶片上的粒子沉積是集成電路制造中的一個(gè)重要問(wèn)題。隨著集成電路的特征尺寸接近亞微米的尺寸,晶片上的顆粒沉積是造成產(chǎn)品損失的主要原因。我們開(kāi)發(fā)了一種用于檢測(cè)半導(dǎo)體晶片上顆粒沉積的靈敏方法。該方法包括產(chǎn)生單分散熒光氣溶膠,在層流室中將已知尺寸的單分散氣溶膠沉積在晶片上,并使用熒光技術(shù)分析沉積的顆粒。在1.0 pm的顆粒直徑以上,單分散的鈾標(biāo)記的油酸氣溶膠由振動(dòng)孔發(fā)生器產(chǎn)生。測(cè)試晶片是直徑3.8厘米的硅,將晶片水平放置在保持20厘米自由流速度的垂直層流室中。在實(shí)驗(yàn)過(guò)程中,使用凝聚核計(jì)數(shù)器和光學(xué)粒子計(jì)數(shù)器獲得測(cè)試截面中的粒子濃度分布,并監(jiān)測(cè)氣溶膠濃度的穩(wěn)定性。結(jié)果表明,在0.15 ~ 8.0 μm的顆粒尺寸范圍內(nèi),測(cè)量的顆粒在晶片上的沉積速度與Liu和Ahn (1987j)的理論非常一致。沉積速度在顆粒直徑約0.25 qm時(shí)表現(xiàn)出最小值,并且由于擴(kuò)散沉積和重力沉降而分別隨著顆粒尺寸的變小和變大而增加。
這項(xiàng)研究的目的是開(kāi)發(fā)測(cè)量半導(dǎo)體晶片上顆粒沉積速度的方法。然后將實(shí)驗(yàn)結(jié)果與最近的理論計(jì)算進(jìn)行比較。
實(shí)驗(yàn)
圖2顯示了用于研究半導(dǎo)體晶片上顆粒沉積的實(shí)驗(yàn)系統(tǒng)的示意圖。該系統(tǒng)由兩個(gè)產(chǎn)生單分散測(cè)試氣溶膠的氣溶膠發(fā)生器、一個(gè)放置測(cè)試晶片的層流測(cè)試室、兩個(gè)連續(xù)濃度檢測(cè)器和一個(gè)熱膜風(fēng)速計(jì)組成,用于監(jiān)測(cè)測(cè)試氣溶膠的穩(wěn)定性并掃描測(cè)試截面的速度和濃度分布。每個(gè)組件的細(xì)節(jié)描述如下:
單分散氣溶膠產(chǎn)生:
使用了兩個(gè)氣溶膠發(fā)生器來(lái)產(chǎn)生單分散測(cè)試氣溶膠。對(duì)于尺寸在0.1到1.0 ym之間的顆粒。如圖2所示,通過(guò)霧化由溶解在稀氨水中的熒光素粉末組成的溶液,首先產(chǎn)生多分散的熒光素氣溶膠。然后在微分遷移率分析儀中根據(jù)電遷移率對(duì)多分散氣溶膠進(jìn)行分類。“等遷移率”氣溶膠顆粒隨后在85-Kr放射性去充電器中中和,隨后在進(jìn)入一級(jí)微孔沖擊器之前與干凈的干燥空氣混合。撞擊器用于清除那些大顆粒,由于它們帶有多重電荷,因此它們與所需尺寸的單電荷顆粒在同一遷移率通道中通過(guò)了直接存儲(chǔ)器存取。輸出是從直接存儲(chǔ)器存取的操作條件獲得的已知尺寸的真正單分散氣溶膠。
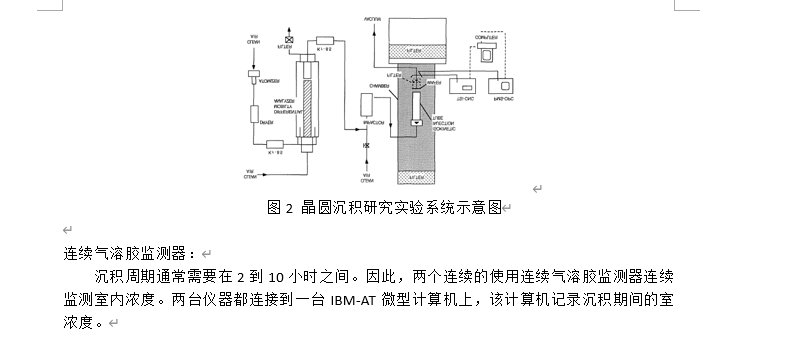
結(jié)果和討論
本實(shí)驗(yàn)的粒子沉積機(jī)制預(yù)計(jì)為對(duì)流、布朗擴(kuò)散、沉積和慣性碰撞。由于晶片是電接地的,單分散氣溶膠粒子被放射性源中和,靜電效應(yīng)可以忽略。在目前的實(shí)驗(yàn)條件下,實(shí)驗(yàn)中使用的最大尺寸粒子8公里粒子的斯托克斯數(shù)估計(jì)為< 0.002。因此,與其他沉積機(jī)制相比,慣性撞擊被認(rèn)為不太重要。實(shí)驗(yàn)系統(tǒng)給出的流場(chǎng)是軸向的對(duì)稱的。在該實(shí)驗(yàn)中測(cè)量的沉積速度是整個(gè)晶片上的平均沉積速度,而不是駐點(diǎn)周圍的小區(qū)域。所有這些實(shí)驗(yàn)條件都與劉和安的理論中使用的假設(shè)相匹配。
結(jié)果給出了粒子沉積速度與粒徑的函數(shù)關(guān)系。粒子在晶片上的沉積速度Vd定義為顆粒通量與晶圓的沉積數(shù)量(單位面積和單位時(shí)間)J與晶圓N上方的體積介質(zhì)中空氣中顆粒濃度的比值。
在典型運(yùn)行中,單分散氣溶膠由兩個(gè)氣溶膠發(fā)生器中的一個(gè)產(chǎn)生,并輸送到等速注射探針。流出注射探針的氣溶膠濃度首先由等速過(guò)濾取樣器收集。然后將測(cè)試晶片放置在注射探針下方,并暴露于均勻濃度的單分散測(cè)試氣溶膠中。沉積期結(jié)束時(shí),取另一個(gè)等速過(guò)濾器樣品。收集熒光,然后將來(lái)自過(guò)濾器和晶片的重新標(biāo)記的顆粒溶解在單獨(dú)的清洗溶液中。
圖6顯示了用這個(gè)系統(tǒng)得到的實(shí)驗(yàn)結(jié)果。對(duì)于3.8cm直徑的晶片和20 cm/s的自由流速度。在該實(shí)驗(yàn)中遇到的一個(gè)測(cè)量困難是沖擊器基底可以在短時(shí)間內(nèi)裝載粒子。盡管基底表面涂有油脂以防止顆粒反彈,但是重顆粒負(fù)載將很快提供促進(jìn)顆粒反彈的固體表面。這一效果如圖6所示。運(yùn)行2和3是通過(guò)分別在20分鐘和10分鐘內(nèi)相對(duì)于基板旋轉(zhuǎn)沖擊器噴嘴而獲得的。運(yùn)行4的特點(diǎn)是使用電動(dòng)機(jī)連續(xù)旋轉(zhuǎn)噴嘴-基底。數(shù)據(jù)顯示,隨著噴嘴基底的旋轉(zhuǎn)越來(lái)越頻繁,由于有新的潤(rùn)滑表面,顆粒反彈減少。

總結(jié)
我們已經(jīng)成功地開(kāi)發(fā)了一種測(cè)量半導(dǎo)體晶圓上粒子沉積的新方法。這將允許獲得一個(gè)數(shù)據(jù)庫(kù),以便與各種理論模型進(jìn)行比較。實(shí)驗(yàn)結(jié)果表明,實(shí)測(cè)沉積數(shù)據(jù)與理論吻合。目前正在制定計(jì)劃,將沉積速率考慮到粒子電荷、電場(chǎng)以及熱梯度的影響,來(lái)測(cè)量沉積速率。
審核編輯:湯梓紅
-
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27719瀏覽量
222685 -
實(shí)驗(yàn)
+關(guān)注
關(guān)注
0文章
121瀏覽量
23042 -
晶片
+關(guān)注
關(guān)注
1文章
404瀏覽量
31582
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
半導(dǎo)體薄膜沉積技術(shù)的優(yōu)勢(shì)和應(yīng)用
RIGOL高能粒子物理實(shí)驗(yàn)數(shù)據(jù)采集系統(tǒng)的應(yīng)用案例

半導(dǎo)體行業(yè)工藝知識(shí)

半導(dǎo)體研究所在量子點(diǎn)異質(zhì)外延技術(shù)上取得重大突破

一文詳解半導(dǎo)體薄膜沉積工藝
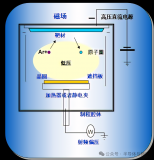
晶片的主要原料是什么物質(zhì)
英特爾擬成立半導(dǎo)體研究中心
半導(dǎo)體靶材:推動(dòng)半導(dǎo)體技術(shù)飛躍的核心力量

有機(jī)半導(dǎo)體研究為能源技術(shù)開(kāi)辟了新途徑
走進(jìn)半導(dǎo)體重點(diǎn)實(shí)驗(yàn)室,感受科技前沿的震撼

硅晶片清洗:半導(dǎo)體制造過(guò)程中的一個(gè)基本和關(guān)鍵步驟
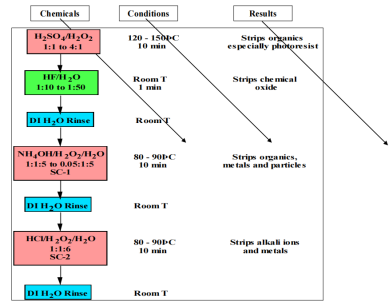
流量控制器在半導(dǎo)體加工工藝化學(xué)氣相沉積(CVD)的應(yīng)用





 半導(dǎo)體晶片上粒子沉積的實(shí)驗(yàn)研究
半導(dǎo)體晶片上粒子沉積的實(shí)驗(yàn)研究













評(píng)論