導(dǎo)讀:對于工程設(shè)計人員來講,IGBT芯片的性能,可以從規(guī)格書中很直觀地得到。但是,系統(tǒng)設(shè)計時,這些性能能夠發(fā)揮出來多少,就要看“封裝“了,畢竟夏天穿著棉襖工作任誰也扛不住,因此,對于怕熱的IGBT芯片來講,就是要穿得“涼快”。
電動汽車逆變器的應(yīng)用上,國際大廠還是傾向于自主封裝的IGBT,追求散熱效率的同時,以最優(yōu)化空間布局,匹配系統(tǒng)需求。
IGBT制造流程
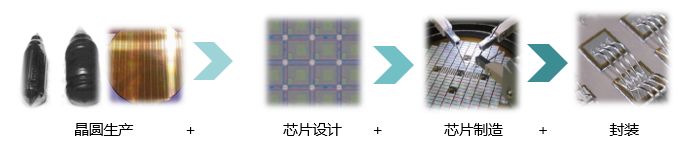
晶圓生產(chǎn):包含硅提煉及提純、單晶硅生長、晶圓成型三個步驟,目前國際主流是8英寸晶圓,部分晶圓廠12英寸產(chǎn)線逐步投產(chǎn),晶圓尺寸越大,良品率越高,最終生產(chǎn)的單個器件成本越低,市場競爭力越大
芯片設(shè)計:IGBT制造的前期關(guān)鍵流程,目前主流的商業(yè)化產(chǎn)品基于Trench-FS設(shè)計,不同廠家設(shè)計的IGBT芯片特點不同,表現(xiàn)在性能上有一定差異
芯片制造:芯片制造高度依賴產(chǎn)線設(shè)備和工藝,全球能制造出頂尖光刻機(jī)的廠商不足五家;要把先進(jìn)的芯片設(shè)計在工藝上實現(xiàn)有非常大的難度,尤其是薄片工藝和背面工藝,目前這方面國內(nèi)還有一些差距
器件封裝:器件生產(chǎn)的后道工序,需要完整的封裝產(chǎn)線,核心設(shè)備依賴進(jìn)口
IGBT芯片以英飛凌IGBT芯片發(fā)展歷程為例
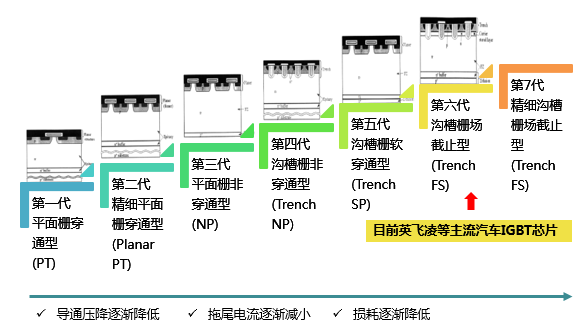
不同廠商技術(shù)路線略有不同IGBT封裝看圖:
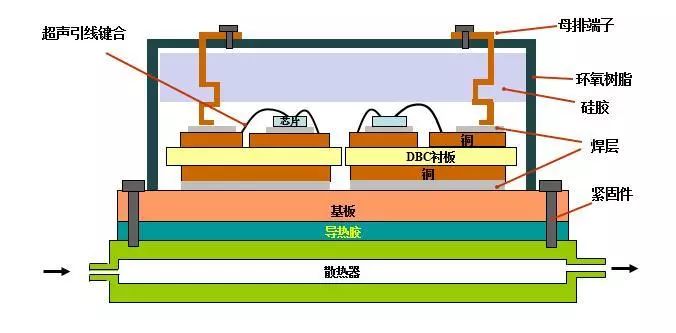
IGBT模塊的典型封裝工序:芯片和DBC焊接綁線——》DBC和銅底板焊接——》安裝外殼——》灌注硅膠——》密封——》終測01 DBC(Direct Bonding Copper)DBC(覆銅陶瓷基板)的作用:絕緣、導(dǎo)熱,銅箔上可以刻蝕出各種圖形,方便走電流
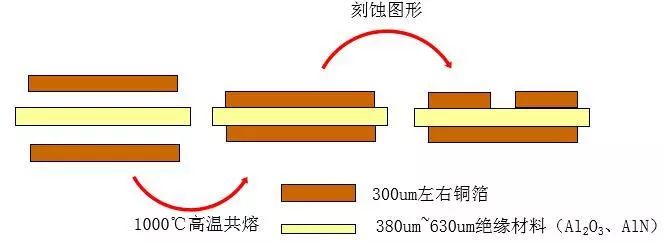
對導(dǎo)熱陶瓷的基本要求是導(dǎo)熱、絕緣和良好的機(jī)械性能,目前常用的導(dǎo)熱陶瓷材料參數(shù):

IGBT模塊常用的DBC散熱陶瓷材料是氧化鋁,應(yīng)用最為成熟,為了繼續(xù)提升模塊的散熱性能,部分模塊廠商在高性能產(chǎn)品上采用氮化鋁或氮化硅陶瓷基板,顯著增加散熱效率,提升模塊的功率密度02 電流路徑剛開始接觸IGBT模塊的人,打開IGBT或許會有點迷惑,這里簡單普及一下對于模塊,為了提升通流能力,一般會采用多芯片并聯(lián)的方式
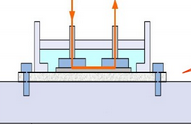
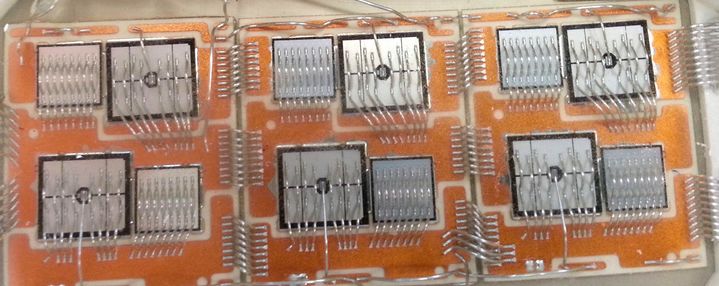
03 散熱路徑單面散熱模塊散熱路徑如下圖所示,芯片為發(fā)熱源,通過DBC、銅底板傳導(dǎo)至散熱器
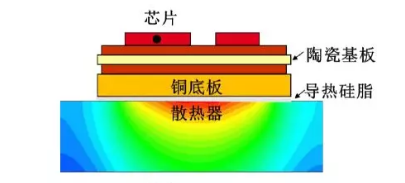
散熱路徑的熱阻越低越好,除了DBC采用熱導(dǎo)率更高的高導(dǎo)熱陶瓷材料之外,IGBT模塊制造商在焊接工藝上下了不少功夫目前最成熟的焊接工藝采用的焊料是錫,為了滿足高性能場合的應(yīng)用,部分產(chǎn)品芯片與DBC的焊接部分采用銀燒結(jié)技術(shù),增強散熱路徑的導(dǎo)熱性和可靠性對于單管方案,單管與散熱底板的燒結(jié)逐漸成為趨勢典型案例:
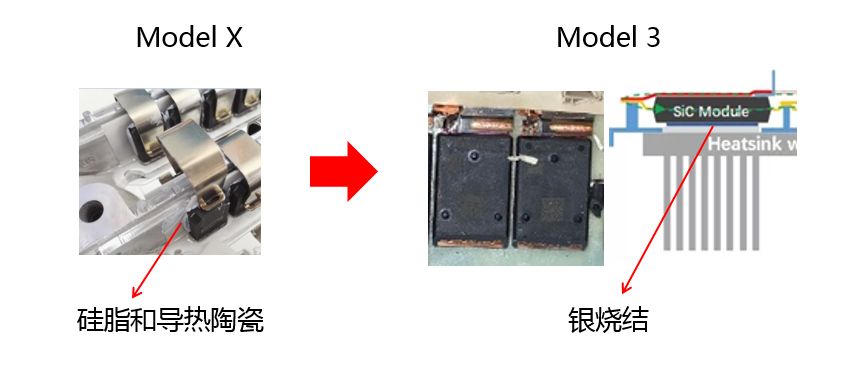
單管功率模組的散熱原理與模塊類似。Model 3的SiC單管與散熱器的焊接采用銀燒結(jié)的方式,與Model X相比,顯著提高了功率模塊散熱路徑的散熱效率和可靠性
老化失效一般采用加速老化試驗對IGBT模塊的可靠性進(jìn)行驗證,功率循環(huán)(PC)試驗最為常用功率循環(huán)過程中,芯片結(jié)溫波動時,由于材料膨脹系數(shù)(coefficient of thermal expansion,CTE)不同產(chǎn)生熱應(yīng)力,模塊長期工作在熱循環(huán)沖擊下導(dǎo)致材料疲勞和老化,最終導(dǎo)致模塊失效如鋁引線脫落、焊接層斷裂分層01 鍵合線失效一般通過PCsec(秒級功率循環(huán))試驗來驗證鍵合性能,循環(huán)次數(shù)越多越好,鍵合引線的疲勞老化通過飽和導(dǎo)通壓降Vcesat來評估,循環(huán)過程中,Vcesat會有輕微上升趨勢焊料層和鍵合引線及鍵合處受到功率循環(huán)產(chǎn)生的熱應(yīng)力的反復(fù)沖擊,導(dǎo)致焊料層因材料疲勞出現(xiàn)裂紋,裂紋生長甚至出現(xiàn)分層(空洞或氣泡),導(dǎo)致鍵合引線的剝離、翹曲或熔斷功率模塊中各芯片均通過多根引線并聯(lián)引出。而實際運行中,一根引線的脫落會導(dǎo)致電流重新均流,加速其它引線相繼脫落
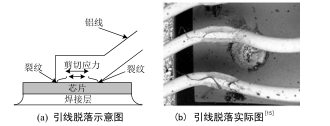
02 焊接層疲勞般通過PCmin(分鐘級功率循環(huán))試驗來驗證焊接層性能,焊料層疲勞老化程度與結(jié)-殼熱阻Rthjc正相關(guān)功率模塊由異質(zhì)材料構(gòu)成多層結(jié)構(gòu),在熱循環(huán)過程中不同熱膨脹系數(shù)的材料會產(chǎn)生交變應(yīng)力,使材料彎曲變形并發(fā)生蠕變疲勞,從而導(dǎo)致硅芯片與基板之間以及基板與底板之間的焊接層中產(chǎn)生裂紋并逐漸擴(kuò)散,最終導(dǎo)致失效或分層
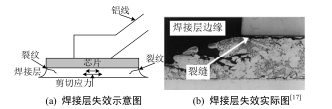
總 結(jié)對于應(yīng)用工程師來講,上邊的內(nèi)容重點關(guān)注封裝及老化失效部分,怎么樣根據(jù)系統(tǒng)的需求選擇合適的IGBT模塊,怎么樣通過科學(xué)的散熱設(shè)計把系統(tǒng)效率和功率密度做的更高在做功率模塊設(shè)計的時候,應(yīng)用工程師還是不要太受制于自己的經(jīng)驗,要以物理第一性的原則去做理論上的最優(yōu)設(shè)計,以目標(biāo)為導(dǎo)向去克服路徑上的困難,這樣才能不跟在別人屁股后邊走。
編輯:lyn
-
封裝
+關(guān)注
關(guān)注
127文章
7996瀏覽量
143410 -
逆變器
+關(guān)注
關(guān)注
288文章
4753瀏覽量
207705 -
IGBT
+關(guān)注
關(guān)注
1269文章
3834瀏覽量
250080
原文標(biāo)題:技術(shù) | IGBT模塊結(jié)構(gòu)及老化簡介
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
深度了解第8代1800A/1200V IGBT功率模塊

IGBT模塊的驅(qū)動電路設(shè)計

RC-IGBT的結(jié)構(gòu)、工作原理及優(yōu)勢
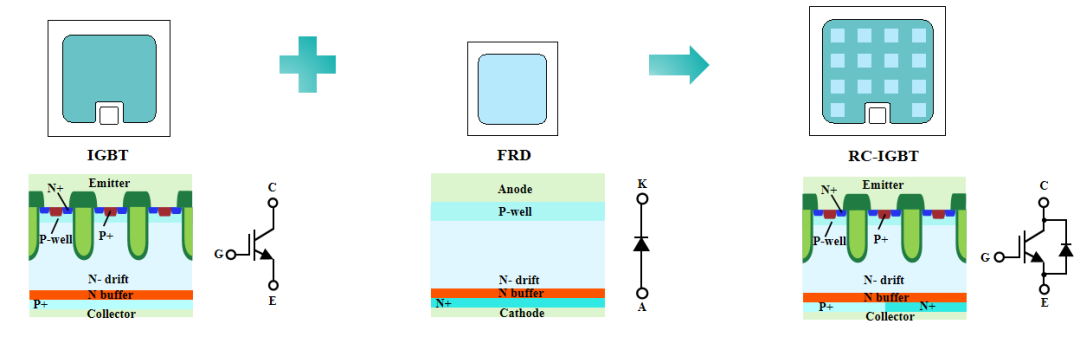
IGBT器件的基本結(jié)構(gòu)和作用
PIM模塊是什么意思?和IGBT有什么區(qū)別?
IGBT芯片與IGBT模塊有什么不同
IGBT老化后結(jié)電容會變化嗎
igbt模塊的作用和功能有哪些
igbt模塊和igbt驅(qū)動有什么區(qū)別
IGBT器件失效模式的影響分析

DC電源模塊的設(shè)計與制造流程

關(guān)于IGBT模塊的散熱設(shè)計





 關(guān)于IGBT制造流程與模塊結(jié)構(gòu)及老化簡介
關(guān)于IGBT制造流程與模塊結(jié)構(gòu)及老化簡介












評論