《碳化硅產(chǎn)品級別的質(zhì)量認(rèn)證》
1. 根據(jù)實(shí)際應(yīng)用條件進(jìn)行超越當(dāng)前標(biāo)準(zhǔn)的測試
對分立器件和模塊,均按相關(guān)標(biāo)準(zhǔn)進(jìn)行常規(guī)檢測,其中包括HTRB、H3TRB和HTGS。這些試驗(yàn)對于技術(shù)的發(fā)布是必不可少的,結(jié)果被記錄在發(fā)布每種產(chǎn)品主頁上的PQR(產(chǎn)品合格報(bào)告)中。
為確保英飛凌新的CoolSiC MOSFET具有超越這些標(biāo)準(zhǔn)的運(yùn)行可靠性,所有標(biāo)準(zhǔn)試驗(yàn)一次至少進(jìn)行3000h,以檢驗(yàn)英飛凌的新技術(shù)在遠(yuǎn)遠(yuǎn)超出必要的標(biāo)準(zhǔn)條件時(shí)所具有的可靠性。在任何這些試驗(yàn)中都未發(fā)現(xiàn)系統(tǒng)的EoL機(jī)制,這表明英飛凌的CoolSiC MOSFET具有很高的可靠度。
近些年,許多應(yīng)用開始要求器件具備超越標(biāo)準(zhǔn)H3TRB條件的濕度穩(wěn)定性。必須采取芯片級別的措施來防止功率器件因?yàn)闈穸仍虬l(fā)生退化,且必須設(shè)計(jì)實(shí)驗(yàn)來加快驗(yàn)證這些措施的有效性。在IGBT模塊中可以看到在這些條件下的不同退化機(jī)制,如金屬腐蝕或枝晶生長。在標(biāo)準(zhǔn)的H3TRB質(zhì)量認(rèn)證試驗(yàn)中,根據(jù),是在T=85°C、相對濕度RH=85%及VDS=80V的條件下確保器件能夠不受這些失效機(jī)制的影響。
如前所述,這些試驗(yàn)條件不足以確保所有應(yīng)用在長期內(nèi)保持可靠。如果分析應(yīng)用條件時(shí)發(fā)現(xiàn)存在極端惡劣的條件,則必須進(jìn)行附加試驗(yàn)。如今是在80%的最高漏源極電壓下進(jìn)行濕度試驗(yàn)(HV-H3TRB),以確保器件能夠長期可靠地運(yùn)行。對于IGBT模塊,文獻(xiàn)指出進(jìn)行1000h的這些試驗(yàn)足以確保使用壽命達(dá)到25年。
由于SiC器件的終端尺寸變小——因?yàn)椴牧系淖钄嗄芰Ω鼜?qiáng),所以必須使用足夠可靠的特殊鈍化技術(shù),它們不僅要能承受在這些試驗(yàn)中使用的極端條件,還要能在實(shí)際應(yīng)用中正常運(yùn)行。為證明英飛凌的SiC芯片在整個(gè)生命周期中擁有可靠的性能,在對英飛凌的CoolSiC MOSFET進(jìn)行質(zhì)量認(rèn)證時(shí)進(jìn)行了H3TRB和HV-H3TRB。無論是在H3TRB還是在更具挑戰(zhàn)性的HV-H3TRB試驗(yàn)中,都未發(fā)現(xiàn)退化機(jī)制。例如,在HV-H3TRB試驗(yàn)之前和之后的I-V曲線顯示在圖24中。
漏電流的增長不超過1uA。在圖24右側(cè)顯示的漏電流監(jiān)測中也可以看到這一點(diǎn),它通常也被用作表明開始退化的指標(biāo)。由于漏電流不隨應(yīng)力增大,所以器件顯然沒有顯示出在應(yīng)力下開始退化的跡象。為了找出英飛凌SiC器件潛在的新失效機(jī)制,利用由300顆芯片組成的大統(tǒng)計(jì)樣本進(jìn)行最長達(dá)到3000h的試驗(yàn),其中沒有發(fā)現(xiàn)系統(tǒng)的EoL機(jī)制。如果用Si芯片的資料推算的話,則有超過75年的安全現(xiàn)場運(yùn)行時(shí)間。
此外,我們還在脈沖高壓濕度條件(PHV-H3TRB或動(dòng)態(tài)HTRB)下檢驗(yàn)了我們的器件,其中沒有發(fā)現(xiàn)退化跡象。由于HV-H3TRB所用的固定電壓更高,因而被視為更嚴(yán)苛的試驗(yàn),所以在產(chǎn)品發(fā)布前沒必要進(jìn)行PHV-H3TRB。
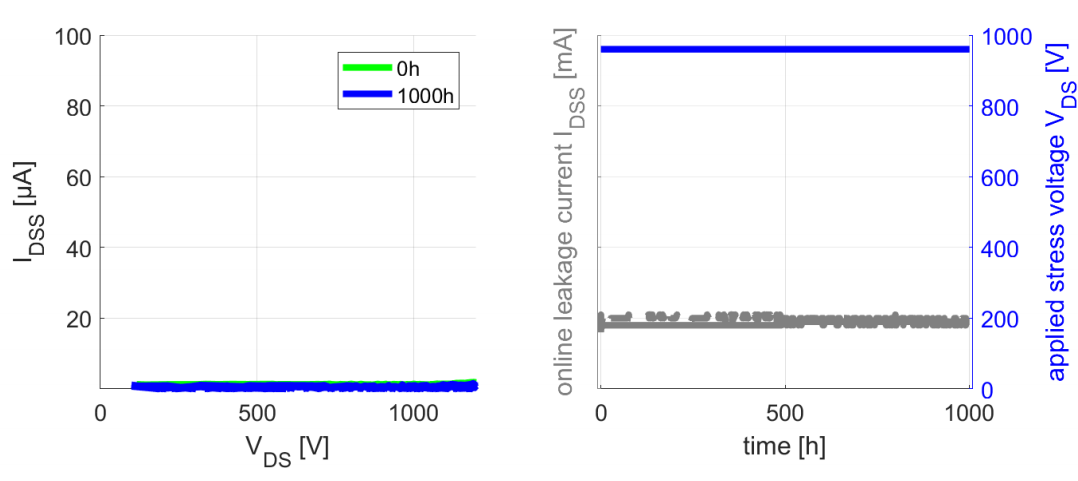
圖24.左圖顯示的是施加應(yīng)力之前(藍(lán)色)和之后(綠色)的漏電流。右圖顯示的是在施加應(yīng)力期間實(shí)測的漏電流。

表1總結(jié)了英飛凌對含有SiC MOSFET的功率模塊進(jìn)行的所有長期可靠性試驗(yàn)。通過在更長時(shí)間內(nèi)進(jìn)行這些試驗(yàn),英飛凌已經(jīng)證明,我們新的CoolSiC MOSFET在表1所示的試驗(yàn)條件下未被觸發(fā)出未知的失效模式。為保證在現(xiàn)場條件下能夠可靠地運(yùn)行,驗(yàn)證的應(yīng)力時(shí)間結(jié)合嚴(yán)格的通過/失效標(biāo)準(zhǔn)足以滿足要求。
對于采用分立器件進(jìn)行的可靠性試驗(yàn),高運(yùn)行溫度或模壓化合物可能對器件在應(yīng)力作用下的長期穩(wěn)定性產(chǎn)生額外的影響。因此,進(jìn)行了許多超越標(biāo)準(zhǔn)條件(如JEDEC或AEC指南)的應(yīng)力試驗(yàn)。特別要提到的是,動(dòng)態(tài)應(yīng)力試驗(yàn)很重要,因?yàn)樗鼈兛赡苡|發(fā)在遵循標(biāo)準(zhǔn)的靜態(tài)試驗(yàn)中觀察不到的失效機(jī)制。例如,給柵極氧化層施加負(fù)柵-源極電壓應(yīng)力的HTRB,或者給終端施加應(yīng)力的高dv/dt試驗(yàn),在施加應(yīng)力之后未能顯示出對器件性能的任何顯著影響。試驗(yàn)結(jié)果表明,CoolSiC MOSFET技術(shù)對溫度、電壓、濕度和動(dòng)態(tài)應(yīng)力都有很好的耐受性。下列表2總結(jié)了對采用TO247封裝的CoolSiC MOSFET進(jìn)行的試驗(yàn)。

表2.采用TO247封裝的、1200V電壓等級的CoolSiC MOSFET進(jìn)行的可靠性試驗(yàn)。在所有試驗(yàn)中都未發(fā)現(xiàn)任何系統(tǒng)的壽命終期失效機(jī)制。
2. AC-HTC試驗(yàn)方法
根據(jù)文獻(xiàn)中的報(bào)告,SiC器件甚至還有無法通過(擴(kuò)展)標(biāo)準(zhǔn)試驗(yàn)觸發(fā)的額外失效機(jī)制。它們與SiC的特殊材料屬性和特定應(yīng)用條件有關(guān)。
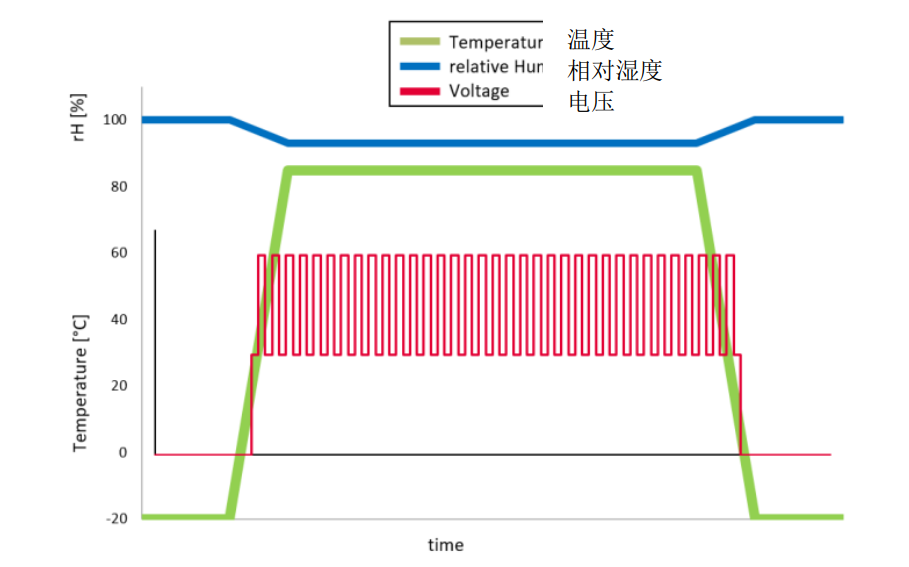
圖25.AC-HTC試驗(yàn)周期的系統(tǒng)應(yīng)力條件。
相比在Ta=85°C/rH=85%條件下進(jìn)行的標(biāo)準(zhǔn)試驗(yàn)是為了防止在實(shí)際芯片表面出現(xiàn)冷凝,AC-HTC試驗(yàn)則是引發(fā)冷凝,并通過在終端接區(qū)形成冷凝水層觸發(fā)額外的、與應(yīng)用有關(guān)的失效模式。根據(jù)文獻(xiàn)中的報(bào)告,這些失效模式對于SiC器件有非常重要的意義。英飛凌的SiC器件可以抵抗這種新的、與材料有關(guān)的失效模式。這一點(diǎn)可以通過進(jìn)行并成功通過AC-HTC試驗(yàn)(交流-濕度和溫度循環(huán))來證明,該試驗(yàn)是與應(yīng)用專家緊密合作開發(fā)出的,能夠模擬光伏系統(tǒng)應(yīng)用的運(yùn)行模式。系統(tǒng)的應(yīng)力條件顯示在圖25中。持續(xù)數(shù)小時(shí)的試驗(yàn)周期可以分成兩個(gè)不同的階段:
a)Ta<0°C:低溫、高濕度,導(dǎo)致芯片表面出現(xiàn)冷凝水,模塊中的濕度很大。為防止發(fā)生自加熱進(jìn)而導(dǎo)致冷凝水變干,在本階段不施加電壓。
b)Ta>0°C:當(dāng)溫度上升到最高85°C時(shí),以類似于在實(shí)際應(yīng)用中使用的較高頻率和電壓打開處于應(yīng)力條件下的器件。
如果終端區(qū)的鈍化處理不夠充分,則終端將出現(xiàn)退化,導(dǎo)致在試驗(yàn)期間和實(shí)際應(yīng)用中過早失效。處于模塊中的所有SiC器件因此都配備有新的疊層鈍化膜,用于在這些惡劣的條件下保護(hù)器件表面,并成功通過持續(xù)120天的AC-HTC試驗(yàn),而不出現(xiàn)任何明顯的退化。
總之,對于英飛凌的SiC二極管,當(dāng)采用的鈍化處理、終端概念和失效率都與Si技術(shù)相當(dāng)時(shí),長時(shí)間的HV-H3TRB、AC-HTC試驗(yàn)結(jié)果和多年的現(xiàn)場經(jīng)驗(yàn)都能證明,我們的CoolSiC MOSFET在濕度高且惡劣的現(xiàn)場環(huán)境條件下也是可靠的器件。
3. 秒級功率循環(huán)試驗(yàn)
在計(jì)算半導(dǎo)體器件在實(shí)際應(yīng)用中的預(yù)期使用壽命時(shí),必須考慮到內(nèi)部連接技術(shù)的老化。這需要通過秒級功率循環(huán)試驗(yàn)進(jìn)行評估,其中,器件被主動(dòng)加熱使得溫度變化ΔT較大,能夠改變焊接和/或鍵合連接,直至RDS(on)或Rth(j-c)達(dá)到預(yù)定的變化,也就是所謂的壽命終期(EoL)標(biāo)準(zhǔn)。基于公認(rèn)的模型,這些結(jié)果可與應(yīng)用條件關(guān)聯(lián)起來,正如英飛凌應(yīng)用說明中所述利用Si器件進(jìn)行的試驗(yàn)。
從原則上講,SiC模塊也是經(jīng)歷這個(gè)過程。但因?yàn)镾iC擁有的楊氏模量比Si更大,所以位于功率模塊中的SiC芯片在溫度循環(huán)期間會(huì)在焊接點(diǎn)中誘發(fā)更大數(shù)量的塑性應(yīng)變。因此,在位于模塊中焊接的SiC芯片的老化機(jī)制中,鍵合連接退化并無很大的影響,影響最大的是焊接層退化,它會(huì)導(dǎo)致Rth增大。正是因?yàn)檫@個(gè)原因,SiC的秒級功率循環(huán)能力才比采用相同互連技術(shù)的Si更低。
功率循環(huán)曲線(可從您本地的英飛凌應(yīng)用工程團(tuán)隊(duì)獲取)考慮了這一改變的老化機(jī)制,使得能夠按照功率循環(huán)應(yīng)用說明中的解釋,根據(jù)最高結(jié)溫Tvj和溫度變化ΔT來計(jì)算預(yù)期使用壽命。為估算完整的應(yīng)用條件,還必須考慮到老化與負(fù)載脈沖持續(xù)時(shí)間ton的關(guān)系。在我們最近發(fā)表的文章中有講到這一關(guān)系,其中表明,我們的SiC器件可以使用與Si相同的計(jì)算模型。圖26中還給出了直至壽命終止的循環(huán)與負(fù)載脈沖持續(xù)時(shí)間的關(guān)系。
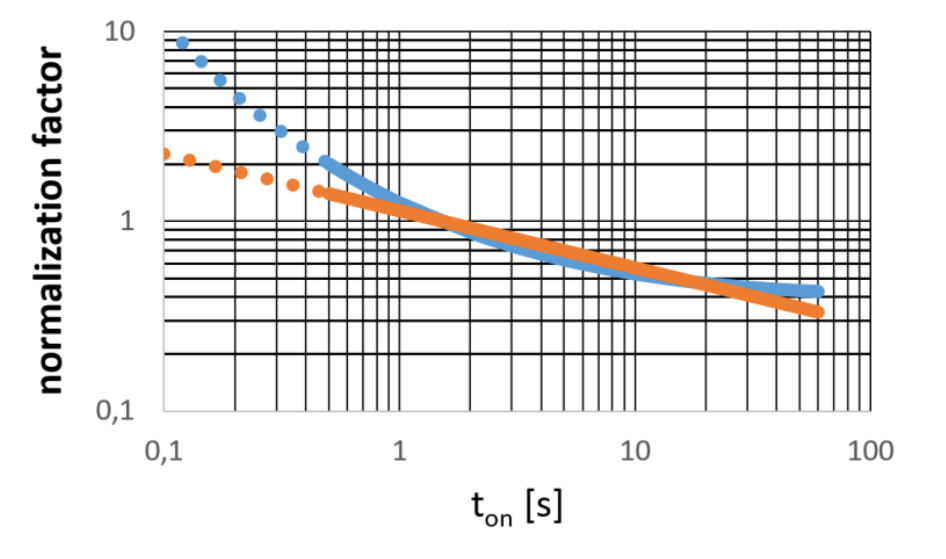
圖26.CIPS模型(橙色)在參考導(dǎo)通時(shí)間ton=1.5s時(shí)的N次循環(huán)超時(shí)、以及自適應(yīng)的包含飽和的模型(藍(lán)色)的關(guān)聯(lián)因子。
圓點(diǎn)所代表的數(shù)值是推算得到的,只應(yīng)用作參考。
所有SiC技術(shù)所用的互連技術(shù)和生產(chǎn)線,都與我們在控制這些工藝和模塊組裝方面積累了幾十年經(jīng)驗(yàn)的英飛凌Si IGBT和二極管相同。英飛凌CoolSiC MOSFET技術(shù)的另一個(gè)優(yōu)勢是,我們無需使用額外的反向并聯(lián)二極管,而能夠在同步整流模式下使用CoolSiC MOSFET的體二極管。這能打造出具備以下優(yōu)勢的應(yīng)用:器件沿兩個(gè)方向傳送電流,芯片在一個(gè)負(fù)載周期的正和負(fù)傳導(dǎo)階段都能產(chǎn)生功率,從而使得每顆芯片相比使用Si IGBT和二極管時(shí)的溫度變化減小。
對于在壽命終期之前在功率循環(huán)中需要更多次循環(huán)的應(yīng)用,英飛凌也已改進(jìn)分立器件的互連技術(shù),如擴(kuò)散焊,這在未來如果加以利用,將能讓我們的CoolSiC MOSFET能被用到其他應(yīng)用中。
針對分立器件的功率循環(huán)研究仍然是個(gè)處于初期的研究領(lǐng)域。因此,英飛凌近年來進(jìn)行了更深入的研究,以了解在功率循環(huán)應(yīng)力期間發(fā)生的失效機(jī)制。一個(gè)重要發(fā)現(xiàn)是,與功率模塊不同,在分立器件中,只要裸片連接是通過傳統(tǒng)的焊接法完成的,則脫線是目前最主要的失效模式。為了對退化的相關(guān)參數(shù)進(jìn)行數(shù)學(xué)描述,得出一個(gè)與功率模塊所用公式類似的公式。無論是采用哪種芯片技術(shù)(Si IGBT或SiC MOSFET),分立器件都能用同樣的公式來描述。許多器件特性對功率循環(huán)穩(wěn)定性都有影響,所以沒有哪一個(gè)參數(shù)集能夠籠統(tǒng)地描述所有產(chǎn)品。根據(jù)器件特性,可能有必要使用單獨(dú)的參數(shù)集。如欲了解某一個(gè)器件的功率循環(huán)能力,請向您本地的英飛凌應(yīng)用工程師發(fā)出申請,他能幫您評估預(yù)期使用壽命。
SiC MOSFET的應(yīng)用領(lǐng)域非常廣泛,包括電動(dòng)車充電站、太陽能逆變器或電機(jī)驅(qū)動(dòng)等。大多數(shù)應(yīng)用都可以簡化為一些基本拓?fù)洌鼈冇兄诖_定長期應(yīng)用試驗(yàn)。下表列出了最主要的基本拓?fù)洹?/p>
▼基本拓?fù)涓庞[

主要關(guān)注的是硬開關(guān)配置,因?yàn)樗鼈兺ǔJ菍β拾雽?dǎo)體要求最高的。英飛凌已經(jīng)開發(fā)出許多試驗(yàn)臺,它們可對采用上述每種配置的SiC MOSFET施加應(yīng)力。這些試驗(yàn)臺使我們能夠在效仿現(xiàn)實(shí)應(yīng)用的條件下運(yùn)行。為了更好地了解長期行為,可靠性試驗(yàn)的持續(xù)時(shí)間從典型的1000h延長至運(yùn)行6–12月。研究表明,在這些實(shí)際運(yùn)行條件下,SiC MOSFET未顯示出熱載流子注入跡象,也未顯示出系統(tǒng)的EOL失效機(jī)制。
責(zé)任編輯:xj
原文標(biāo)題:SiC MOSFET產(chǎn)品質(zhì)量認(rèn)證與壽命評估方法
文章出處:【微信公眾號:英飛凌工業(yè)半導(dǎo)體】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
-
MOSFET
+關(guān)注
關(guān)注
147文章
7242瀏覽量
214282 -
SiC
+關(guān)注
關(guān)注
29文章
2892瀏覽量
62948 -
碳化硅
+關(guān)注
關(guān)注
25文章
2829瀏覽量
49276
原文標(biāo)題:SiC MOSFET產(chǎn)品質(zhì)量認(rèn)證與壽命評估方法
文章出處:【微信號:yflgybdt,微信公眾號:英飛凌工業(yè)半導(dǎo)體】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
碳化硅薄膜沉積技術(shù)介紹
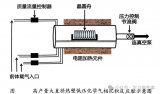
碳化硅在半導(dǎo)體中的作用
碳化硅襯底的特氟龍夾具相比其他吸附方案,對于測量碳化硅襯底 BOW/WARP 的影響

產(chǎn)SiC碳化硅MOSFET功率模塊在工商業(yè)儲(chǔ)能變流器PCS中的應(yīng)用
什么是MOSFET柵極氧化層?如何測試SiC碳化硅MOSFET的柵氧可靠性?
碳化硅逆變焊機(jī)基本產(chǎn)品介紹
碳化硅在新能源領(lǐng)域的應(yīng)用 碳化硅在汽車工業(yè)中的應(yīng)用
碳化硅的應(yīng)用領(lǐng)域 碳化硅材料的特性與優(yōu)勢

碳化硅功率器件的工作原理和應(yīng)用

基本半導(dǎo)體碳化硅MOSFET通過AEC-Q101車規(guī)級認(rèn)證
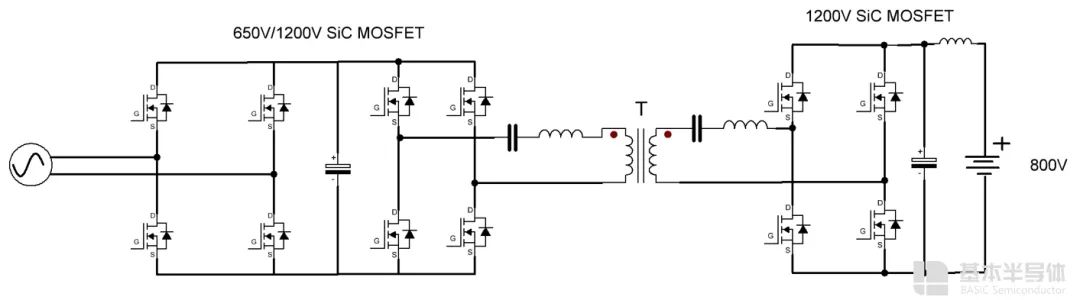
碳化硅功率器件的優(yōu)點(diǎn)和應(yīng)用
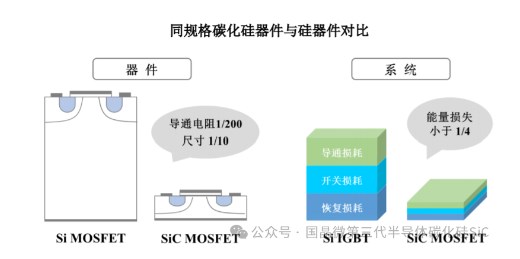
碳化硅晶圓和硅晶圓的區(qū)別是什么





 碳化硅產(chǎn)品級別的質(zhì)量認(rèn)證
碳化硅產(chǎn)品級別的質(zhì)量認(rèn)證










評論