2020年9月15日,SYNAPS 2020 &第七屆華進開放日在無錫新湖鉑爾曼成功舉辦。本次研討會由華進和Yole共同主辦,由SPTS、BESI、百賀、Moldex3D、ERS、LexisNexis IP、首鐳激光、KNS、北方華創、HANMI、JSR、ASM傾情贊助,芯師爺、半導體芯科技聯合宣傳。
活動贊助商及媒體合作伙伴
由于摩爾定律減緩和異質集成帶來的強勁動力,加上5G、AI、HPC、IoT等大趨勢,先進封裝市場在整個半導體市場中所占的份額正在不斷增加。截至2025年,它將占據總市場的近50%。當前先進封裝正從封裝基板平臺轉向硅平臺,這一重大轉變為臺積電、英特爾和三星這樣的巨頭帶來巨大的機遇。
SYNAPS和華進開放日作為華進的品牌活動,關注全球行業趨勢,為業界同仁提供了一個分享行業觀點、評估新興方案、開拓市場機遇的專業平臺。由于疫情影響,2020年SYNAPS和華進開放日合并召開,現場人氣依然高漲。本次會議共有嵌入式技術及系統級封裝、高端封裝及3D、存儲封裝、玻璃封裝四個議題,由華進技術總監姚大平博士和孫鵬博士主持,華進副總經理肖克和Yole分析師Richard Li致歡迎詞,矽品高級總監C. Key Chung博士、海思何洪文博士、Evatec 先進封裝事業部負責人Ewald Strolz、華進研發總監王啟東博士、長電科技工程總監沈國強、華天科技技術市場總監劉衛東、武漢新芯COO&高級副總裁孫鵬、EVG業務開拓總監Thomas Uhrmann、Formfactor CMO Amy Leong、ASM銷售經理林德榮、Camtek COO Ramy Langer、Corning 產品線經理Varun Singh、廈門云天CEO于大全博士以及Yole首席分析師Santosh Kumar等十八位重量級嘉賓與會報告,呈現一場半導體先進封裝的技術盛宴。
主活動現場
嵌入式技術和系統級封裝
矽品高級總監C. Key Chung博士介紹了一種可擴展的小芯片(chiplet)封裝技術,即扇出嵌入式橋(FOEB)。該解決方案具有低成本、延展性佳、傳輸損耗低、設計靈活、熱翹曲低等優勢。
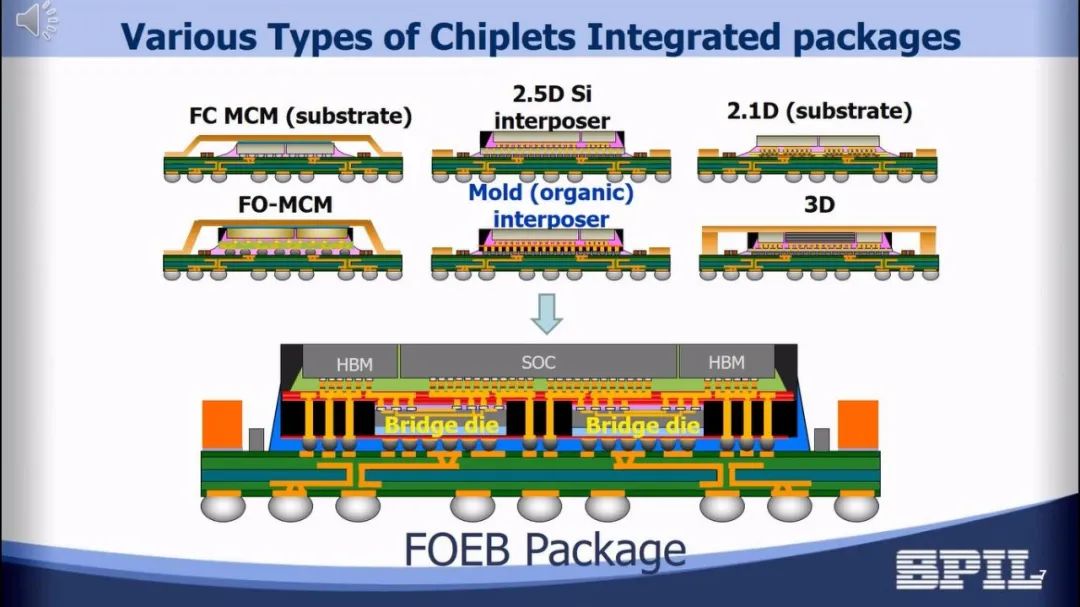
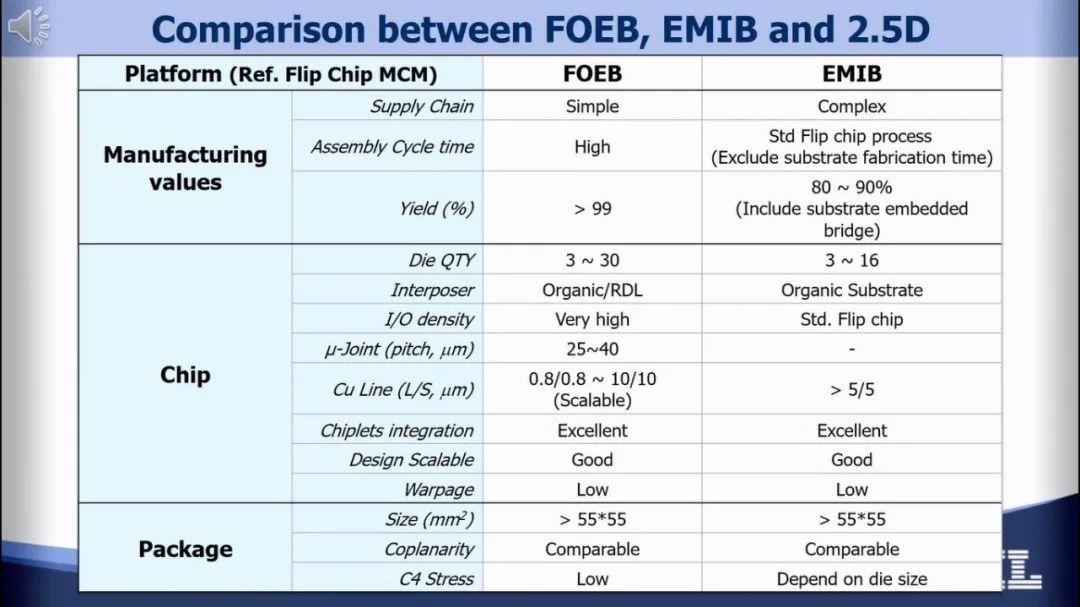
矽品報告
ASM Assembly System高級產品經理Sylvester Demmel認為隨著嵌入式工藝的滲透,無疑為貼片設備在拿持大尺寸薄基板和貼裝大量不同類型的芯片和被動元件時增加復雜性和挑戰。ASM與終端用戶合同,從軟件、面板處理、支持系統以及載板設計等方面入手解決這些挑戰。Evatec工藝開發負責人Ewald Strolz提到大規模面板工藝需要解決翹曲或凹陷問題,介紹了晶圓級&PCB/IC基板技術的融合以及一種面板級PVD種子層工具。SPTS 執行副總裁&總經理David Butler為大家介紹了HD FOWLP PVD研發進展,討論了物理氣相沉積(PVD)下凸點和RDL金屬層過程中優化產量和生產率的解決方案。
華進半導體研發總監王啟東博士為觀眾介紹了華進半導體先進基板的研發進展。作為國內唯一一條全面的先進基板研發線,華進先進基板線具有FCBGA、嵌入式、UHDIE以及Coreless等工藝能力。
海思何洪文
華進王啟東
Evatec報告
SPTS報告
存儲封裝
長電科技工程總監沈國強和華天科技技術市場總監劉衛東分別介紹了企業在存儲封裝領域的進展及布局。沈國強強調盡管受新冠疫情影響,2020年存儲IC市場仍將突破1240億美元。存儲封裝的特色是多芯片堆疊和混合封裝,會面臨很多挑戰,如翹曲、剝落等。長電集團和國內外客戶在NOR Flash、NAND Flash、DRAM、DDR4、EMMC/EMCP等領域有深入合作。劉衛東介紹了華天科技存儲工藝路線圖及產品線(3D NAND-SSD、eMMC/UFS、2D NAND、FC DDR等),與Micron、Intel、三星、鎧俠、長江存儲都有深入合作。

存儲組裝/測試趨勢
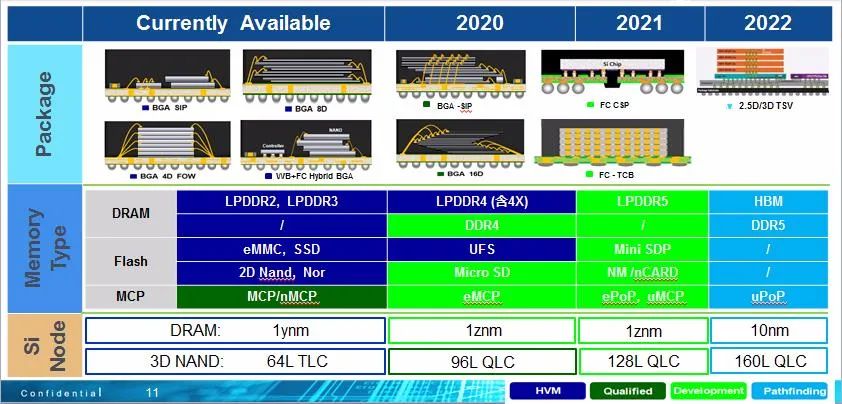
華天技術路線圖
長電科技 沈國強
華天科技 劉衛東
高端封裝及3D
隨著5G、AI和數據中心的快速發展,高帶寬、大容量和低功耗成為制約芯片性能的關鍵因素。晶圓級3D集成電路技術作為后摩爾時代的解決方案已經成熟,如晶圓鍵合、透硅通孔(TSV)和混合鍵合工藝。武漢新芯COO&高級副總裁孫鵬博士介紹了武漢新芯3DLinkTM生態體系,詳細介紹了S-stacking——一種領先的高密度微節距3D互連技術,M-stacking——一種晶圓堆疊HBM方案,以及Hi-stacking——一種實現晶圓和 die 堆疊的解決方案。
EVG業務開拓總監Thomas Uhrmann分享了Die to Wafer混合鍵合方案。BESI CTO Ruurd Boomsma認為封裝和后道技術在半導體價值鏈中愈發重要,混合鍵合技術無疑將成為下一代主流鍵合技術,但是需要更高的清潔度和精度;此外塑封技術也在復雜的SiP封裝和晶圓級封裝中體現優勢。KNS高級經理王瓊安和ASM Pacific Technology銷售經理Percy Lam分別介紹了異質集成的挑戰與解決方案。FormFactor CMO Amy Leong和Camtek COO Ramy Langer分別介紹了針對2.5D/3D異質集成量測和先進封裝檢查/計量的挑戰與解決方案。
武漢新芯 孫鵬
ASM Percy Lam
BESI報告
KNS 王瓊安
玻璃封裝
Corning產品線經理Varun Singh分享了Corning的最新創新成果——實現機械拆解和的玻璃載片方案,還介紹晶圓減薄玻璃載片的優勢。廈門云天CEO于大全博士分享了5G應用的3D WLP和集成技術進展,5G通訊的快速發展給先進封裝提出了更高要求,晶圓級封裝對于5G器件集成非常重要。晶圓級扇入技術可用于濾波器、IPDs和射頻模塊,晶圓級扇出可用于射頻模塊和毫米波芯片。近年來,采用玻璃穿孔(TGV)技術和嵌入式玻璃扇出(GFO)技術的玻璃圓片級封裝越來越成熟,可用于IPD、mmWave、RF模塊的三維集成。玻璃圓片封裝具有體積小、成本低、工藝簡單、電性能好等優點。針對各種5G應用的晶圓級系統集成技術開發仍有大量創新工作。會議最后,Yole首席分析師Santosh Kumar為大家做了針對半導體器件和先進封裝應用的玻璃基板趨勢的報告。
廈門云天 于大全
Corning報告
作為國家級封測/系統集成先導技術研發中心,華進肩負著促進國內外產學研合作,推動中國集成電路產業做大做強的使命。SYNAPS和華進開放日是全球獨一無二的平臺,更是業界企業和專家之間的獨特紐帶。經過多年積累,已成為行業認可的最專業的先進封裝技術交流平臺,獲得好評無數。本次活動共吸引超百家半導體企業參會,接待了專業觀眾200余人(含在線觀眾),包括設計公司、OSAT、IDM、OEM、終端用戶、設備及材料供應商等,相信未來將有更多的半導體追夢人們在此相遇相知,帶著共同的信念為集成電路事業做出巨大貢獻。
(華進戰略部)
原文標題:SYNAPS 2020 &第七屆華進開放日圓滿落幕
文章出處:【微信公眾號:華進半導體】歡迎添加關注!文章轉載請注明出處。
責任編輯:haq
-
半導體
+關注
關注
334文章
27719瀏覽量
222699 -
5G
+關注
關注
1356文章
48506瀏覽量
566041
原文標題:SYNAPS 2020 &第七屆華進開放日圓滿落幕
文章出處:【微信號:NCAP-CN,微信公眾號:華進半導體】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
海康威視亮相第七屆全國森林消防裝備展會暨應急救援裝備展
機械革命亮相第七屆進博會
中科創達精彩亮相第七屆進博會
宇通全力護航第七屆進博會
中科創達第七屆智能汽車閉門研討會成功舉辦
晶發電子榮獲第七屆“藍點獎”誠信企業榮譽!

憶聯受邀亮相第七屆數字中國建設峰會,賦能新質生產力
CET中電技術邀您參加2024第七屆綠色工廠廠務大會





 第七屆華進開放日在無錫成功舉辦
第七屆華進開放日在無錫成功舉辦










評論