1 SMT平行封焊原理及工藝過程
1.1 平行封焊原理
平行封焊屬于電阻焊,在封焊時,電極在移動的同時轉動(通過電極輪),在一定的壓力下電極之間斷續(xù)通電,由于電極與蓋板及蓋板與焊框之間存在接觸電阻,根據(jù)能量公式(Q=I2Rt),焊接電流將在這2個接觸電阻處產(chǎn)生焦耳熱量,使其蓋板與焊框之間局部形成熔融狀態(tài),凝固后形成焊點,從它的封焊軌跡看像一條封,所以也稱為“縫焊”。
封裝形式有方形封、圓形封和陣列封。對方形管殼而言,當管殼前進通過電極完成其兩邊的焊接后,工作臺自動旋轉90°,繼續(xù)前進通過電極,再焊兩條對邊,這樣就形成了管殼的整個封裝;而對圓形管殼來說,只需工作臺旋轉180°即可完成整個管殼的封裝。
1.2 平行封焊工藝過程
(1)預操作
器件表面的氧化物、污垢、油和其它雜質增大了接觸電阻,影響各個焊點加熱的不均勻性,使焊接質量波動,因此徹底清潔器件表面是保證優(yōu)質焊接的必要條件。
封焊之前,要對待封器件進行加熱和抽真空等預操作,從而降低器件腔內的濕度和氧氣含量,使芯片不受外界因素的影響而損壞并對芯片起到保護作用。
(2)焊接操作
焊接模式分為方形焊和圓形焊2種。方形焊模式是先經(jīng)過點焊然后再進行兩對邊的封焊完成焊接,主要是針對方形管殼;圓形焊模式是旋轉180°完成焊接,主要是針對圓形管殼,但由于采用圓形焊模式電極與管殼接觸比較穩(wěn)定,也被用在長寬比例不大的方形管殼焊接。焊接流程見圖2。
在封正品之前,必須先對管座進行試封,在確保機器性能比較穩(wěn)定,各個封焊工藝參數(shù)都比較匹配的情況下,再對正品進行封焊,使其封焊成品率盡可能達到最高。
(3)檢漏
通常我們把溫度設為25℃,在高壓一側為1個大氣壓(101.33 kPa)、低壓一側壓力不大于0.013 kPa時,單位時間內從高壓一側流過細微漏孔進入封裝結構的腔體中的干燥空氣量,稱為標準漏氣速率,其表示單位用Pa·cm3/s或Pa·m3/s。檢漏包括細檢和粗檢,通常要求泄漏率低于1×10-8Pa·m3/s。
① 細檢。采用以氦氣為示蹤氣體的氦質譜儀,借助質譜的分析方法,通過測定真空系統(tǒng)中氦氣分壓強的變化來檢查封裝結構的細微漏孔。測試時首先向封焊好的器件內壓入氦氣,然后在真空狀態(tài)下抽出氦氣,測定所抽出氦氣的量來判定氣密性。
②粗檢。采用碳氟化合物液體進行檢測,測試時在盛放高溫(125℃±5℃)碳氟化合物液體的容器內放入封焊好的器件(30~60 s),根據(jù)氣泡的有無來判定氣密性。此方法只能檢查是否有孔、穴等漏洞。
檢測時應該先做細檢再做粗檢,因為如果有比較大的漏洞,先做粗檢會使氦氣無法保持在管殼內。
2 平行封焊工藝參數(shù)
封焊工藝參數(shù)主要包括,焊接電流(電壓、功率)、焊接速度、焊接壓力等。
2.1 焊接電流
焊接電流是由焊接電源決定的,焊接電源主要有單相交流式、電容儲能式、晶體管式和逆變式4種,由于逆變焊接電源體積小、重量輕、節(jié)能省材,而且控制性能好,動態(tài)響應快,易于實現(xiàn)焊接過程的實時控制,是焊接電源的發(fā)展方向。
根據(jù)能量公式可知,形成焊點所需的熱量與焊接電流的平方成正比。若電流太小,則不能形成熔焊點,影響氣密性;若電流太大,管殼受到的熱沖擊太大則可能會把蓋板燒壞。
為了減小方形管殼角部焊接能量,電流波形宜采用斜率控制方式,具體實現(xiàn)如圖3所示;為了使采用圓形焊方式焊方形管殼時保持焊接能量的一致性,電流波形宜采用功率調制控制方式,具體實現(xiàn)如圖4所示。
2.2 焊接速度
焊接速度太小,焊接總時間延長,焊接熱量大,管殼溫升高,且焊封軌跡不平整,有小的凹痕。焊接速度過大,焊封不連續(xù),有可能漏氣。
2.3 焊接壓力
壓力的改變,會改變接觸電阻,由能量公式可知,焊點強度隨著焊接壓力的增大而減小,解決的辦法是在增大壓力的同時,增大焊接電流。
2.4 其它
除了以上工藝參數(shù)以外,影響平行封焊的因素還有夾具的設計、電極的位置、蓋板質量和蓋板與管殼的匹配等,另外封焊設備本身的可靠性也是影響封焊質量的因素之一。
夾具的中心最好與轉臺中心一致,夾具夾牢管殼,否則焊接過程中電極可能會把管殼粘起來;左、右電極位置保持在同一高度和同一水平線上且盡量對稱;電極滾輪要定期打磨和更換,否則會影響焊接均勻性;蓋板尺寸不能太大或太小,而且拐角最好有倒角,因為方形管殼的焊接電極與蓋板角接觸兩次,焊接熱量會影響焊接效果;采用階梯形蓋板,焊接時錯位的可能性會大大減小。
沒有絕對的工藝參數(shù),只有優(yōu)化工藝參數(shù),才能提高焊接質量。在封焊完器件后,對封裝過程中出現(xiàn)的現(xiàn)象進行適當?shù)目偨Y,有待封裝技術的進一步提高。
結論
工藝和設備是緊密聯(lián)系的整體,設備開發(fā)是為了滿足工藝要求,而只有深入研究工藝,進而改進設備,設備開發(fā)才能更貼近用戶的需要,才更具有市場競爭力。
責任編輯:Ct
-
smt
+關注
關注
40文章
2927瀏覽量
69688 -
華強pcb線路板打樣
+關注
關注
5文章
14629瀏覽量
43178
發(fā)布評論請先 登錄
相關推薦
SMT貼片加工中的回流焊:如何打造完美焊接
SMT貼片空焊異常
SMT貼片加工虛焊現(xiàn)象:原因分析與解決步驟全解析
SMT錫膏貼片虛焊假焊不良原因分析

SMT錫膏貼片中的回流焊主要作用是什么?

SMT錫膏回流焊出現(xiàn)BGA空焊,如何解決?

SMT貼片加工中避免導通孔與焊盤的連接不良的有效方法
SMT貼片過回流焊用什么錫膏比較好?

在smt貼片加工廠中選擇性波峰焊存在的作用和意義
連焊如何在SMT加工過程中發(fā)生的?

SMT貼片焊盤設計要求
SMT加工廠用選擇性波峰焊有什么優(yōu)點嗎?
氮氣在SMT回流焊中的應用:優(yōu)缺點一覽無余





 SMT平行封焊原理是怎樣的
SMT平行封焊原理是怎樣的
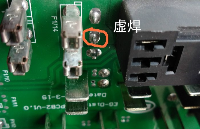










評論