目前汽車安全產業需要降低元件數的小型組件,縮小尺寸及減少元件數的需求,促使半導體供應商加入更多耗電的功能,造成元件溫度升高,降低穩定性,同時也影響汽車安全。若在設計階段早期優化晶片配置及電源脈衝時間,設計人員即可降低硅測試次數,縮短開發時間。本文首先將說明半導體散熱封裝的功能,與如何使用模型模擬軟體協助電源元件及系統設計,包括一般汽車設計難題的討論、模型建立技巧、散熱模型驗證及系統提升。
汽車電子產品產業使用各種半導體封裝,封裝類型從小型單一功能電晶體,到100多個接腳及特殊散熱功能的復雜電源封裝等。半導體封裝能夠保護晶粒、提供裝置與系統外部被動元件之間的電子連接,并管理散熱。本文將討論半導體封裝如何讓晶片散熱。
在接腳封裝(leaded package)中,晶粒黏著于晶粒座的金屬片上。這個晶粒座在構裝期間支撐晶粒,并提供良好的熱導體表面。在汽車產業中,常用的半導體封裝類型是外露焊墊封裝(exposed pad),也就是PowerPAD封裝。在這類封裝中,晶粒座的底部外露,直接焊接于印刷電路板(PCB),使晶粒直接散熱至PCB,透過焊接于電路板的外露焊墊向下散熱,然后透過PCB散熱至環境中。
外露焊墊封裝能夠透過底部,將80%的熱度散入PCB。另外20%的熱度則從裝置接腳及封裝側邊散出。只有不到1%的熱度是從裝置頂部散出。
非外露焊墊封裝也是接腳封裝,但晶粒座由塑膠完全包覆,無法直接散熱至PCB。在標準接腳封裝概念中(見圖1),大約58%的熱度是從接腳集封裝各邊散出,40%是從封裝底部散出,大約2%是從封裝頂部散出。散熱透過叁種方式進行:傳導、對流及輻射。對于汽車半導體封裝,散熱的主要是透過傳導至PCB及對流至周圍空氣。輻射佔散熱相當小的比例。

圖 1. 標準接腳封裝及 PowerPAD 封裝的散熱及散熱途徑。
為什么散熱建立模型相當重要?
為什么建立模型對于散熱相當重要?對于大多數半導體應用而言,必須使晶粒快速對外散熱,以防止硅晶粒過熱。硅晶粒的一般運作溫度是105℃~150℃。溫度升高時,容易出現金屬擴散(metal diffusion)的現象,最終導致裝置因短路而故障。晶粒的穩定性取決于高溫下運作的時間。雖然硅晶粒可暫時承受比表列溫度更高的瞬間高溫,但裝置的可靠度會越來越低,電源需求與溫度限制必須達到平衡,因此散熱模型建立對于汽車應用而言相當重要。

表 1. 汽車應用的環境溫度上限
散熱難題
在現今汽車的運作、安全及舒適系統中,半導體扮演重要的角色。半導體普片應用在車體電子裝置、安全氣囊、空調、收音機、方向盤(steering)、被動式開關、防盜系統、胎壓監測等。雖然新應用日漸增加,還是可歸結至叁個傳統的環境需求:駕駛室內部、汽車防火墻(panel firewall)及發動機艙(underhood)。在汽車環境需求的設計挑戰有叁個關鍵,就是環境高溫、高功率及特定材料散熱性質。
高溫
汽車環境中特別是,車體可能出現極高的溫度。一般消費性電子產品溫度約為25℃,上限約為70℃。然而在車內乘客座艙環境中,內部電子裝置或面板應用溫度需求高達85℃。第二個環境是防火墻(firewall)應用,其中的電子裝置位于引擎與汽車駕駛艙之間。位于此區域的裝置可能接觸高達105℃的環境溫度。但最嚴苛的是發動機艙應用,需要在高達125℃的環境溫度中運作。
散熱考量對于安全系統特別重要,例如方向盤(steering)、安全安全氣囊及防鎖死(anti-lock)剎車。在煞車及安全安全氣囊應用,功率可能在1毫秒內達到100W。功能需求增加且過度集中在同一晶粒上,都會使功率提高。特定汽車應用半導體的溫度可能短時間高達175℃至185℃,而這也是汽車裝置的因過熱而失去功能的上限。
安全功能增加,散熱需求也隨之增加。舉例來說,十多年來安全安全氣囊一直是汽車常見的配備,現在有些汽車配備高達12個安全氣囊。相較于傳統單一安全氣囊,裝設過程造成更大的散熱難題,而高溫會影響重要系統的可靠度。
材質
和其他產業一樣,汽車組裝也尋求降低成本。塬先金屬材質的模組和PCB機殼逐漸改為塑膠材質。塑膠機殼的生產成本較低,而且重量較輕,缺點是散熱效能降低。因為塑膠材質的導熱性相當低,介于0.3至1W/mK的範圍內,因此成為熱絕緣體。改用塑膠材質不利于系統散熱,由于系統散熱的效率降低,造成半導體裝置的散熱負載增加。
為何需要建立模型?
對于汽車半導體而言,單一裝置的散熱效能及設計通常是建立模型的重點,必須審慎簡化,才能取得建立模型資料。去除模型中多余的低功率裝置、簡化PCB銅線佈線、假設基座對在固定溫度散熱,加速完成散熱模型,才能準確呈現熱阻抗網路。
封裝層級散熱模型建立能在不需要高成本的開發和測試狀況下,進一步檢視可能的封裝設計變更,進而免除材料建置。因為半導體封裝設計可以改變,依據應用需求達到最的散熱效果。在汽車半導體元件中,PowerPAD等外露焊墊封裝可使晶粒快速散熱到PCB。加大的晶粒座、改良的PCB連接或基座設計等封裝都是為了達到更有效的散熱效能。散熱模型建立也用于檢查裝置中材料變換所造成的潛在影響。封裝材料的導熱性有極大的差異,從0.4W/mK(熱絕緣體)到300W/mK(熱良導體)不等。建立散熱模型有助于兼顧產品成本與效能平衡。
建立模型驗證
對于重要的系統而言,審慎的實驗數據分析可決定散熱效能及運作溫度,但實驗測量這些系統相當費時且耗成本。散熱模型能夠確實符合系統的散熱及運作要求,在半導體產業中,散熱模型已經成為概念測試及硅晶設計過程的前置作業,理想的散熱模型建立流程會在晶片生產前幾個月進行。積體電路設計人員和散熱工程人員負責先檢查裝置的晶片配置及電源耗損,然后散熱模型工程人員依據檢查結果,建立散熱模型,一旦散熱模型結果備齊,設計人員及建立模型工程人員將檢查數據并調整模型,以準確反映可能的應用情形。
汽車半導體產業多年來使用散熱模型提升產品設計,由其是有限元素分析(finite element analysis; FEA)驗證的模型。TI的塬則是先比較散熱建立模型結果與系統的實體測量,以進行相關分析。這些相關分析著重于潛在誤差,包括材質、電源定義及尺寸簡化。沒有任何模型能夠完全呈現實際的系統,因此必須注意建立模型期間所做的假設,以確實呈現最準確的系統。
對于材質而言,發佈的數據通常呈現特定材料的容積傳導率,不過應用材料表面的反應會影響散熱效能。必須注意模型中呈現的功率,因為運作期間施加于裝置的功率會隨著時間而變化。電路板或系統其他區域的電源耗損可能也會影響晶片表面的實際功率。
建立模型類型
針對特定專案的散熱狀況,汽車半導體的散熱模型主要分為四種,可用以了解和驗證散熱效能:系統等級、封裝等級、晶粒等級和晶粒暫態分析。
系統層級散熱建立模型相當重要,因為模型可呈現特定裝置在某些系統中運作的效能。基本上,汽車半導體散熱建立模型將PCB納入考量,因為PCB是大多數半導體封裝的主要散熱器。PCB的銅層和散熱孔結構都必須包含在散熱模型中,才能準確判斷散熱行為。如果系統使用嵌入式散熱器之類的元件,及螺絲或鉚釘作金屬連接,都必須納入模型中,以判斷對于裝置的散熱效能所產生的影響。
強制對流(forced airflow)及PCB周圍的空氣流通對于系統導熱也相當重要。半導體的散熱模型通常是針對單一高功率裝置,但PCB的其他電源元件對于系統的整體效能也相當重要。若要簡化這些封裝的輸入,并維持準確度,通常可使用精簡模型。精簡模型是簡化的熱阻抗網路,合理估算PCB上的較不重要的裝置所達到的散熱效能。
在低接腳數的小型裝置中(見圖2),可使用其他方法提升散熱效能。將多個封裝接腳接在裝置的基座之后,即可大幅改善整體的接點溫度,而不影響裝置的運作。
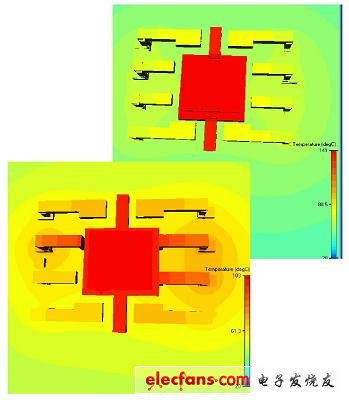
圖2:對于 8 接腳 SOIC 封裝,將多個接腳接在基座之后,接點溫度最低可達 25°C。
建立模型假設
晶粒分析首先需要準確呈現硅晶配置,包括晶粒上任何用電的區域。簡單來說,可以假設電源平均分配到晶片的各個區域,不過,對于大多數的晶片配置而言,皆會因為功能而出現供電不平均的情況,這種現象對于裝置的整體散熱效能至關重要。針對重視散熱功能的裝置而言,必須特別注意晶片的用電結構。
在某些散熱軟體程式中,可使用逗號分隔變數(.csv)來輸入晶片配置,如圖3所示。如此即可在晶粒配置與散熱模型軟體之間輕鬆傳輸資訊。視裝置的復雜度及用電量而定,這些用電區域可能有兩到叁處,甚至數百處。散熱模型工程人員應該與IC設計人員密切合作,找出哪些用電區域應該納入散熱模型。考量裝置的整體用電時,通常可以將用電量較小的小區域合併為大區域,以簡化散熱模型。在散熱模型中,也可以在晶粒表面使用背景功耗或靜態功耗,以考量大部份的非重要低功耗晶粒結構。
裝置功能通常需要比晶粒上的小區域更高的電源。這些高用電區域會導致該區域過熱,溫度明顯比周圍高。相鄰的中度用電晶粒可能造成受測的晶粒出現殘余熱度及熱應力,散熱模組也可顯現這些散熱問題。
模型也可用于協助放置或調整嵌入式溫度感測器的位置。溫度感測器適合放在最高用電量的區域,不過由于配置限制,這通常不可能達成。如果不放在用電區域的中央,溫度感測器無法讀取裝置的實際最高溫度。散熱模型可用于判斷晶粒上的熱梯度,包括在感測器的位置。感測器可加以調整,以因應最高溫區域與感測器區域之間的溫差。
假設前文提及的模型類型全部以穩定的DC電源輸入,在實際運作中,裝置電源會隨著時間和配置而變動。如果設計散熱系統解決最不理想的用電情況,散熱負載將變得相當嚴重。有許多方法可用來觀察暫態散熱反應,最簡單的方法是假設晶片上的直流電源,然后追蹤裝置隨時間變化所呈現的散熱反應。第二種方法是輸入不同的電源,然后使用散熱軟體判斷最終的穩定狀態溫度。第叁種最為實用的暫態模型建立方法是觀察晶片的不同位置上,電源隨時間所產生的變化,如圖4所示。使用這種方法,可以了解裝置之間在正常運作下無法呈現的互動過程。暫態模型也有助于觀察正常裝置運作之外,某個晶片運作的全部過程,例如裝置的通電或斷電模式。

圖3:散熱模型軟體使用逗號分隔變數輸入產生詳細的晶粒配置,并顯示晶粒表面的潛在熱點位置。

圖4:半導體裝置表面上的散熱反應隨著時間而變化。在此情況下,晶粒的不同區域是以交錯的方式獲得電源。散熱模型可供更密切觀察隨時間變化的晶粒溫度。
在煞車制動或安全氣囊配置等許多汽車系統中,裝置用電量在裝置使用壽命期間都相當低。對于安全氣囊系統,電源脈衝會短時間升高。
改善之道
對于汽車半導體產業,散熱建立模型的目的是設計優化及降低整體溫度。只要降低運作晶片接點溫度,即可提升裝置的可靠性。系統、電路板、封裝或晶粒的小幅度改善能夠大幅改善最終的溫度。但裝置及系統限制可能會使得其中一些選項無法適用,本文仍列舉系統降溫的幾個最佳實務做法。
有許多方法可改善系統或PCB的散熱效能,包括空氣流通、導熱途徑或外部散熱器。提供更多金屬區域進行散熱能夠改善散熱效能,這包括外部散熱器、基座的金屬連接、印刷電路板的更多分層或更密集的銅層、基于散熱用途而連接的銅層及散熱通孔。
位于裝置的外露焊墊下方的散熱通孔將裝置內部的熱度散出,使得電路板的其他部份加速散熱。半導體裝置封裝的設計能夠使晶粒快速對外散熱。半導體封裝的散熱改善包括傳導性更高的材料、PowerPAD等直接附加于PCB的做法、接在晶粒座的接腳或外部散熱器的黏接位置。半導體晶粒本身有許多方法可降低整體溫度,降低溫度的最佳方法就是減少用電量。
對于半導體電路設計及配置,良好的散熱做法包括擴大散熱區域、找出晶片邊緣外的用電區域、使用狹長形用電區域而非方形區域,及使高用電量區域之間有充足的間隔距離。硅本身是熱良導體,導熱性約為117W/mK。只要用電區域周圍有最多的硅,即可改善裝置的散熱效果。對于晶粒上的暫態電源,只要將電源脈衝交錯而降低瞬間功耗,使電源脈衝的間隔時間加長,讓熱度能夠散出,或者將高用電量元件分配在不同區域,即可降低整體溫度。
這些暫態變化能夠使散熱系統降溫。只要審慎設計晶粒、封裝、PCB及系統,即可大幅改善裝置的散熱效能。
本文小結
汽車產業對于高可靠度有獨特的需求。安全、舒適及娛樂方面的車用電子元件數不斷增加,由于汽車半導體裝置的電子裝置縮小尺寸并增加復雜度,因此新款裝置的溫度比舊款更高。散熱模型能夠確保充分滿足散熱需求。在設計階段早期將晶粒配置及電源優化,并且在封裝及系統層級進行散熱改善,設計人員即可為客戶提供最佳的設計。

表 1. 汽車應用的環境溫度上限
 電子發燒友App
電子發燒友App












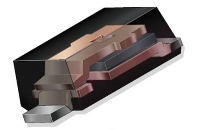
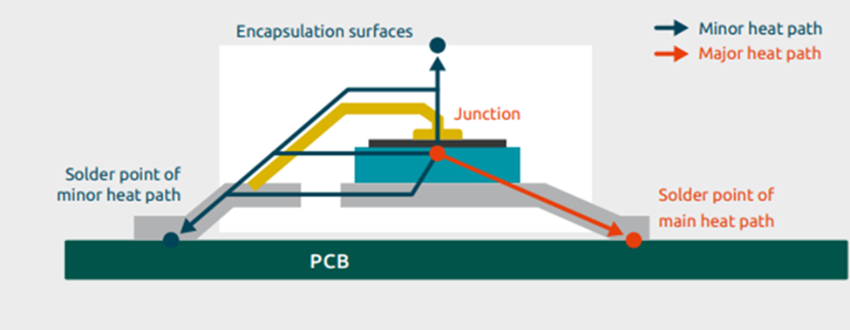











評論