?
一. 序言
在2002年初,Denso(デンソ)公司開發成功一種多層板的摩擦工藝技術及其產品,當它一問世,就成為了在2002年中,被日本及世界PCB業最為關注的焦點之一。不少專家將它認為是下代的多層板新技術的代表。這項技術就是被稱為PALUP(Patternde Prepreg Lap Up Process),即“用已進行了圖形加工的薄片,通過一次層壓形成多層板的工藝”。
Denso公司的一位高層管理人員是這樣評價PALUP基板的:”它繼承了過去全貫通孔和積層板的各種優點,全部各層中都體現了通孔直列層間排列的結構及可再循環化、低成本的特點。”(引自花井嶺朗先生語)。
之所以PALUP一出臺就引起業界的“轟動“,主要因為它表現出了以下三方面的鮮明特點:
21世紀,可被看作是“環境技術”的時代。在安裝技術的領域,“無鹵化基板”、“無鉛焊材料”等的開發及應用,說明了安裝業界對環保的越來越重視。在電子產品中,應將來環保要求的發展,采用了與目前的無鹵化、無鉛焊 材料技術路線有所差異的制造技術。它是在“使原材料可再循環”的前提下進行開發的。所用的絕緣基材是可再生的熱塑性樹脂,采用的導體材料是高熔點金屬。由于這樣的材料構楊,可實現材料的分離和再生特性。使所制造出的電子產品將不會廢棄,而可再利用。
伴隨著電子產品的發展趨向,多層板將與IC封裝的多引腳化發展相適應,而加速它的高密度化進展。為此,按過去的全貫通孔和積層法多層板工藝法去制造的多層板,將是“更加復雜的多層板”。PALUP針對上述的發展趨勢具有前瞻性的對多層板工藝法進行了重大改革,它的制造過程只是將一片片單面基板疊合在一起,進行一次性的層壓成型加工制成多層板。使用得原來多層板的復雜工藝就了簡易工藝。并且在層壓加工過程中,也就形成了可任意設定的疊加通孔、形成了可不受層數限制的配線層。
PALUP是多廠家共同合作的成功典范,它是五個與基板制造相關的廠家聯合奮斗的結果。
二、PALUP基板的結構特征
PALUP基板的結構特征如圖1所示。
在基板的表面有連接盤,而所有的這種連接盤都連接在通孔之上。板的所有布線都設置在內層中。在導通孔的形成上是十分自由的。導通孔在層間可以實現對任意層的連接。層的厚度可以按不同的要求,任意選擇。又珈通孔由于采用了垂直排列,而確保了連接可靠性縮短了設計與制造的周期(見表1所示).基板材料使用均一產高耐熱性熱塑性樹脂布線層的制法,很近似于陶瓷基板.只不過用具有柔性的熱塑性樹脂代替了氧化鋁陶瓷材料,用銅金屬布線材料代替了鎢金屬材料.由于這種結構特征,PALUP基板可以制作到50層.
圖2表示了PALUP基板的開發目標.在圖中橫坐標 表示連接通孔的高密切度化進展:各種通孔連接在多慨板內所占據的空間在該圖上定性的表達而出.發展高密度化的依次順序是: 金屬化全貫通孔、各種分支排列的積層法多層板通孔、PALUP基板中的疊加通孔。在圖2中的縱坐標則表示可靠性進展。在可靠性方面,使用各種電鍍法代表了不同的金屬結合方式和特性;使用各種糊膏填埋法代表了不同的通孔連接方式和特性。金屬化全貫通孔技術在的金屬結合上是可靠性高的,但這種方式不利于高密度化。在積層法多層陶板技術的基礎上,發展起的”含有多成分組合的疊加通孔”連接方式。
三 PALUP用的在板材料
PALUP用的基板材料是使用了高耐熱性熱塑性樹脂構成。它是由デンソ公司與三菱樹脂公司共同聯合研制出一種熱塑性樹脂——聚醚酮醚(Polyether Enter Ketone,PEEK)所制成的薄膜,它被稱為“IBUK”。還有由ヅャパンゴァテックス 公司所提供的液日聚合物類材料“PAL-CLAD”。還類熱塑性樹脂可滿足以下三方面的要求:
1. 高尺寸精度
2. 確保焊接耐熱性;
3. 基板XY方向的線膨脹系數能接近銅的線膨脹系數。
所采用熱塑性樹脂——聚醚酮醚它具有高耐熱性(最高工作溫度為2700C)高占粘接性、低價電常數性( )、并可實現板的薄型化、板面的高滑性。另外,表2還示出了與ヅャパンゴァテックス公司共同開發的“PAL—CLAD”的材料特性。
??
總之,在絕緣層中采用這類熱塑性樹脂使基板可具有低介電常數,低吸濕性,由于它在絕緣層中不含有玻璃纖維,使更加有利于微細通孔的形成,而另一方面它又具有保持剛性強度的特性。
四.制造工藝
PALUP基板的制造工藝過程在圖3中表示。積層法多層板工藝特點,是它的積層法層形成是要逐層的反復層壓加工才完成的。因此,積層法多層板工藝還存在著加工時間長、產品合格率低等問題。它在制造過程中,由于樹脂受到熱應力的影響,而引起基板的尺寸發生變化較大。這樣,要想用積層法多層板法去制作出微細的疊加通孔的基板是十分困難的。
PALUP采用了熱塑性樹脂,使基板有一定的柔韌性。在受到熱沖擊時產生剛性的熱應力較小。在板的層數增加時,可以通過一次的層壓就完成多層的成型加工,因而可獲得優異的尺寸精度。這種多層板的“半固化片”是單面溶接著銅箔的熱塑性樹脂薄片。在銅箔上先加工上電路圖形,連接部位用激光加工出有底的通孔,并對加工出的通孔進行金屬糊膏的填埋。
在層間的連接技術中,在有底的通孔中填埋金屬糊膏是一項非常重要的技術。通常的金屬糊膏是由金屬作為填料、熱固性樹脂作為粘接劑而組成的。電容量問題和連接可靠性問題一直成為該方面技術中的重要課題。若用熱塑性樹脂(并且沒有玻璃纖維作增加)作金屬糊膏的粘接劑,由于它的Z軸方向(基板的厚度方向)的線膨脹系數通常較大,這樣就無法保證通孔的連接可靠性。通過該公司的不斷的研制,開發了低溫的“擴散接合”方法來實現金屬結合。即所開發的金屬糊膏,是在多層層壓加工中,同時與銅箔達到擴散接合。通過該公司的不斷的研制,開發了低溫的“擴散接合”方法來實現金屬結合。即所開發的金屬糊膏,是在多層層壓加工中,同時也與銅箔達到擴散接合。通過激光形成有底通孔,進行金屬糊膏的填埋—這項工作是較難的。本技術是開發了專用的設備解決了此問題。
在激光加工的通孔內填埋了金屬糊膏的薄片,通過擺過擺放位置上的對位重合、接合后,進行層壓加工。此時,糊膏的燒結、擴散接合、對多層的連接也同時進行。圖4中所示了在31層的高多層板剖面情況。它是由剖面照相和X光照相來反映的。其中,圖中在通孔的放大照片上,顯示了直列通孔的實際情況。在X 光照相的照片上,可看到在層間上的許多黑點,就是一個一個的通孔的燒結金屬。
綜上所述,PALUP基板有以下幾點是制造技術的關鍵:
1. 要保證高耐熱性和高尺寸精度的“單面覆銅箔的熱塑性樹脂薄片”的開發。
2. 低溫燒成、擴散接合型的金屬糊膏的開發。
3. 激光形成有底通孔,進行金屬糊膏的填埋技術的開發。
4. 一次多層的層壓技術。
這種基板的全金屬配線結構,必須要達到疊加通孔的高連接可靠性。圖5所示了PALUP基板的可靠性實驗結果(對疊加6個通孔的評價結果).可以通過此實驗看出:氣態下的冷熱循環實驗,液態下冷熱循環實驗中,該種基板保持著低的電阻變化.很好的確保它的可靠性.
??
五.PALUP基板的特性與課題
PALUP基板的主要特性見表3表示
由表3可以看出:PALUP基板所用的基板材料—熱塑性樹脂,表現出低介電常數、介質損失因數、低吸濕性的特性。所制出的基板可以滿足整機產品的高頻化的要求。并可以高
由表3可以看出:PALUP基板所用的基板材料—熱塑性樹脂,表現出低介電常數、低介質損失因數、低吸濕性的特性。所制出的基板可以滿足整機產品的高頻化的要求。并可以滿足高密度化的多層板性能需求,特別是適用于多引腳的封裝作為基板。
另外,不含玻璃纖維的熱塑性樹脂作為這種基板的絕緣基材,很適合于當前以至今后的安裝技術發展的要求,例如,它的剛性板形態在安裝的場合下,可以降低再流焊時基板的翹曲,并起到保持由銅箔構成的接地層和電路層的剛性強度作用,這種熱塑性樹脂的熔點在3400C以上,它可以抵御低于此溫度的熱沖擊。
六.PALUP基板所適用的產品和今后發展方向
PALUP基板目前憶在試驗線上進行了少量的生產。計劃在2003年4月正式開始大生產。PALUP技術的問世,主要面對的是有高可性、高多層電路要求的基板產品 ,還有高頻高速信號傳輸電路要求的基板。另外,它可代替原有的環氧樹脂類基板和陶瓷基材類基板使用。
PALUP工藝技術,不但適用于剛性多層板制造,而且還可以用此工藝去制作多層撓性印制工藝技術制造三維立體型的基板、內藏元器件的基板,系統封裝(SIP)基板等。
在PALUP基板用樹脂中,不含對環境有害的物質。樹脂中只含有C(碳)H(氫)O(氧)N(氮)的元素.它屬于”自消火型熱塑性樹脂”,也是一種無鹵化阻燃性的樹脂.并且在加熱到它的熔點以上時,樹脂就可以熔化.有了這個特性,使它可以進行再利用,可以很容易的將金屬與樹脂進行分離.
綜上所述,PALUP基板無論在技術上,還是在市場上都有廣闊的發展前景.它將帶動整個PCB技術有更大的質的飛躍.??
??
?
?
 電子發燒友App
電子發燒友App










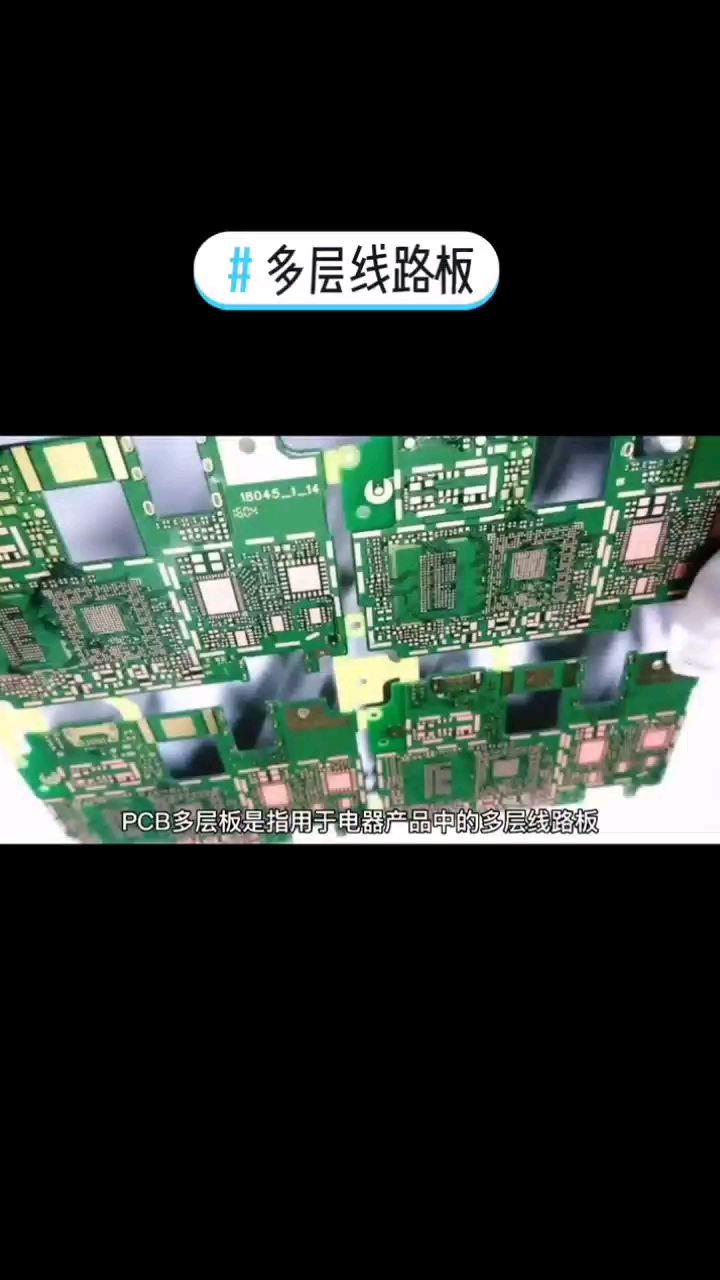













評論