本內(nèi)容介紹了IGBT模塊的檢測方法,以兩單元為例:用模擬萬用表測量,判斷IGBT的方法
2011-12-21 10:30:26 8505
8505 本文首先介紹了IGBT的概念與結(jié)構(gòu),其次對IGB模塊原理電路進(jìn)行了分析以及介紹了變頻器IGBT模塊常見故障處理,最后介紹了變頻器IGBT模塊檢測方法以及IGBT模塊的靜態(tài)測量。
2018-05-22 09:15:53 9392
9392 、Miner 線性累 積損傷準(zhǔn)則等評估整車壽命周期內(nèi) IGBT 模塊的熱疲勞壽命,最后結(jié)合電機(jī)控制器總成的試驗(yàn)現(xiàn)狀,提出總成級試 驗(yàn)中進(jìn)行 IGBT 加速試驗(yàn)的可行性方案。
2023-05-05 10:34:52 892
892 
? 針對汽車 IGBT 模塊的主要失效原理和引線鍵合壽命短板,結(jié)合仿真分析進(jìn)行了功率循環(huán)試驗(yàn)設(shè)計(jì),結(jié)溫差?ΔTj 和流經(jīng)鍵合線的電流 IC 是影響鍵合點(diǎn)壽命的主要加速因子,中間溫度(Tjm
2023-08-08 10:59:38 772
772 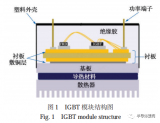
? IGBT模塊內(nèi)部 雜散電感的定義 IGBT半橋逆變電路工作原理以及當(dāng)IGBT1開通關(guān)斷時(shí)的電壓電流波形如圖1所示,Lσ代表整個(gè)換流回路(條紋區(qū)域內(nèi))所有的雜散電感之和(電容器,母排,IGBT模塊
2023-08-18 09:08:18 2225
2225 
驅(qū)動部分最核心的元件IGBT(InsulatedGateBipolarTransistor絕緣柵雙極型晶體管芯片)。從零了解汽車電控IGBT模塊電驅(qū)系統(tǒng)和IGBT
2023-11-20 16:44:43 1158
1158 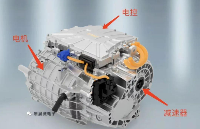
由于IGBT模塊自身有一定的功耗,IGBT模塊本身會發(fā)熱。在一定外殼散熱條件下,功率器件存在一定的溫升(即殼溫與環(huán)境溫度的差異)。
2024-03-22 09:58:08 249
249 
,如圖6所示,優(yōu)化的組裝技術(shù)顯著改善了功率循環(huán)(PC)周期。這至少能確保在工作結(jié)溫增大的情況下,輸出電流增大,但功率器件壽命不變。 圖6:1200V標(biāo)準(zhǔn)模塊的功率循環(huán)(PC)可靠性圖和搭載IGBT
2018-12-07 10:23:42
IGBT模塊是由哪些模塊組成的?IGBT模塊有哪些特點(diǎn)?IGBT模塊有哪些應(yīng)用呢?
2021-11-02 07:39:10
IGBT模塊的有關(guān)保護(hù)問題-IGBT模塊散熱器 對IGBT模塊散熱器的過流檢測保護(hù)分兩種情況: (1)、驅(qū)動電路中無保護(hù)功能。這時(shí)在主電路中要設(shè)置過流檢測器件。對于小容量變頻器,一般是把電阻R直接
2012-06-19 11:26:00
能有著重要的影響。 河北工業(yè)大學(xué)省部共建電工裝備可靠性與智能化國家重點(diǎn)實(shí)驗(yàn)室的研究人員,針對現(xiàn)階段仍存在的問題,對于不同功率循環(huán)下的IGBT的熱退化特性進(jìn)行了研究。設(shè)計(jì)了動態(tài)實(shí)驗(yàn),對不同的工作模式下IGBT模塊的退化
2020-12-10 15:06:03
IGBT作為電力電子領(lǐng)域的核心元件之一,其結(jié)溫Tj高低,不僅影響IGBT選型與設(shè)計(jì),還會影響IGBT可靠性和壽命。因此,如何計(jì)算IGBT的結(jié)溫Tj,已成為大家普遍關(guān)注的焦點(diǎn)。由最基本的計(jì)算公式Tj=Ta+Rth(j-a)*Ploss可知,損耗Ploss和熱阻Rth(j-a)是Tj計(jì)算的關(guān)鍵。
2019-08-13 08:04:18
各位大神好,想請教一個(gè)問題。我現(xiàn)在手上有一個(gè)IGBT模塊,型號是FF150RT12R4。我現(xiàn)在想找一個(gè)驅(qū)動這個(gè)IGBT模塊的驅(qū)動模塊,是驅(qū)動模塊,不是驅(qū)動芯片,我在網(wǎng)上查找到了EXB840,但是這個(gè)驅(qū)動年份有些久遠(yuǎn),所以想問有沒有類似的新產(chǎn)品,求推薦型號。
2021-01-04 10:40:43
IGBT模塊或者單管應(yīng)用于變頻器的制造,在做變頻器的短路實(shí)驗(yàn)時(shí),在IGBT開通時(shí)刻做出短路動作,IGBT的CE電壓會從零逐漸升高到最大之然后回到母線電壓的一半后達(dá)到穩(wěn)定。
但是在具體波形時(shí),IGBT
2024-02-21 20:12:42
IGBT英飛凌的模塊,用著怎么樣啊,求指導(dǎo)。
2018-04-17 15:27:54
我們計(jì)劃在我們的項(xiàng)目中使用英飛凌的藍(lán)牙模塊之一。
AIROC 藍(lán)牙模塊的使用壽命是多少(壽命終止)? 我們正在尋找一款支持經(jīng)典藍(lán)牙配置文件或支持雙模式(經(jīng)典和 BLE)的模塊。
我們正在尋找一款理想情況下可以獲得5年技術(shù)支持的藍(lán)牙模塊。 3年也是一個(gè)不錯(cuò)的術(shù)語。
2024-03-01 13:57:03
電壓為 1200V、額定電流范圍為 50A-200A 的 IGBT 模塊)中的 ISO5852S 進(jìn)行性能評估。評估的一些重要功能和性能包括使用 DESAT 檢測的短路保護(hù)、軟關(guān)斷、在不同逆變器 dv
2018-12-27 11:41:40
大量回收富士IGBT模塊 收購富士IGBT模塊 全國各地區(qū)高價(jià)回收IGBT模塊、英飛凌、西門康、富士、三菱-天津高價(jià)收購IGBT模塊系列,BGA,內(nèi)存,單片機(jī),繼電器,二三極管,電容,電感,保險(xiǎn)絲
2021-11-01 18:13:51
大量回收各種型號英飛凌IGBT模塊富士模塊本公司高價(jià)回收英飛凌IGBT,回收富士IGBT,回收三菱IGBT等,本公司資金雄厚、現(xiàn)金交易、電話151-5220-9946QQ2360670759高價(jià)回收
2021-01-09 18:20:52
大量收購IGBT模塊夏條綠已密,朱萼綴明鮮。深圳帝歐高價(jià)回收IGBT模塊,大量收購IGBT模塊。帝歐趙生***QQ1816233102/879821252郵箱dealic@163.com。深圳帝歐
2021-03-22 18:19:34
大量收購IGBT模塊深圳帝歐高價(jià)回收IGBT模塊,大量收購IGBT模塊。帝歐趙生***QQ1816233102/879821252郵箱dealic@163.com。深圳帝歐電子長期高價(jià)回收IGBT
2021-08-06 19:20:24
專業(yè)上門回收ABBIGBT模塊天津誠信回收新舊IGBT模塊,回收IGBT模塊、IGBT模塊山東浙江江蘇安徽江西高價(jià)回收三菱IGBT模塊收購英飛凌IGBT模塊二手IGBT模塊全國各地區(qū)高價(jià)回收IGBT
2021-10-25 21:49:20
專業(yè)長期回收IGBT模塊 拆機(jī)IGBT模塊回收 全國收購IGBT模塊 專業(yè)長期回收IGBT模塊 拆機(jī)IGBT模塊回收 全國收購IGBT模塊 專業(yè)長期回收IGBT模塊 拆機(jī)IGBT模塊回收電話
2020-07-30 13:20:09
現(xiàn)急需FF1200R17IP5英飛凌原廠的IGBT模塊,有誰有渠道的幫幫忙!
2020-01-12 10:47:52
,但部分活動是在實(shí)驗(yàn)室中完成的。在未來的開發(fā)過程中,機(jī)械特性、熱性能和電氣特性等數(shù)據(jù)可能略有變化。可靠性和使用壽命在一定程度上,但未最終獲得IGBT模塊認(rèn)可。 最終數(shù)據(jù)基于最終元件。制作過程在考慮了用于
2018-12-05 09:50:30
浙江回收IGBT模塊浙江杭州收購IGBT模塊長期大量回收二手IGBT模塊,包括三菱IGBT模塊,英飛凌IGBT模塊,富士IGBT模塊,高價(jià)回收IGBT模塊的電話151-5220-9946 微信同步 QQ2360670759
2021-09-11 15:54:33
如何增加中間端子的雜散電感?電磁場對IGBT模塊并聯(lián)的影響是什么?
2021-06-15 08:26:38
各位大佬,請教一下 IGBT 模塊的絕緣耐壓如何測試?
2023-10-23 10:19:00
如何實(shí)現(xiàn)IGBT模塊的驅(qū)動設(shè)計(jì)?在設(shè)計(jì)驅(qū)動電路時(shí),需要考慮哪些問題?IGBT下橋臂驅(qū)動器件HCPL-316J的主要特征有哪些?上橋臂驅(qū)動器HCPL-3120的主要特征有哪些?
2021-04-20 06:24:18
怎么解決IGBT模塊在并聯(lián)時(shí)的降額問題?
2021-04-08 06:21:04
重慶專業(yè)收購IGBT模塊重慶高價(jià)回收IGBT模塊,高價(jià)收購IGBT模塊,深圳帝歐高價(jià)回收IGBT模塊,帝歐電子趙生***,QQ:764029970//1816233102,mail
2021-11-16 19:19:46
三菱igbt模塊資料
三菱電機(jī)第5代IGBT模塊和IPM模塊應(yīng)用手冊
Mitsubishi ElectricThe 5th Generation IGBT Modules & IPM ModulesApplication Note
2007-12-22 10:58:18 197
197 東芝igbt模塊資料
2007-12-22 11:04:10 63
63 :介紹了IGBT 擴(kuò)容的并聯(lián)方法,分析了導(dǎo)致IGBT 模塊并聯(lián)運(yùn)行時(shí)不均流的各種因素,提出了相應(yīng)的解決措施,并進(jìn)行了仿真分析和實(shí)驗(yàn)驗(yàn)證。關(guān)鍵詞:絕緣柵雙極晶體管; 并聯(lián)/ 靜態(tài)均流
2009-05-01 09:56:56 56
56 HiPakTM高壓SPT IGBT 模塊的SOA 新基準(zhǔn)
摘要院介紹了電壓額定值從2.5kV到6.5kV的新型高壓HiPakTM IGBT模塊系列遙新系列HiPakTM模塊采用了ABB最新研制的高壓SPT IGBT 和二
2009-11-11 10:38:53 6
6 根據(jù)加速極電源模塊IGBT 工作頻率不高的特點(diǎn),設(shè)計(jì)RCD 吸收回路對IGBT 串聯(lián)均壓是可行的.其IGBT 驅(qū)動模塊采用2SD315A 并給出它的工作原理。從得到的實(shí)驗(yàn)結(jié)果表明該電路的設(shè)計(jì)
2009-12-19 13:30:12 16
16 三菱電機(jī)第5代IGBT模塊和IPM模塊應(yīng)用手冊Mitsubishi Electric The 5th Generation IGBT Modules & IPM Modules
2010-02-19 11:10:01 681
681 IGBT模塊的使用要點(diǎn):IGBT為電壓控制器件,其導(dǎo)通壓降隨正驅(qū)動電壓的升高而降低。
2010-03-14 18:51:58 71
71 根據(jù)加速極電源模塊IGBT工作頻率不高的特點(diǎn),設(shè)計(jì)RCD吸收回路對IGBT串聯(lián)均壓是可行的.其IGBT驅(qū)動模塊采用2SD315A并給出它的工作原理。從得到的實(shí)驗(yàn)結(jié)果表明該電路的設(shè)計(jì)是合理的且
2010-07-14 16:20:48 57
57 東芝IGBT系列模塊
2007-12-22 11:10:15 924
924 
西門康IGBT系列模塊
2007-12-22 11:11:29 1025
1025 
三菱IGBT系列模塊
2007-12-22 11:11:51 1093
1093 
創(chuàng)新的IGBT內(nèi)部封裝技術(shù)
英飛凌推出創(chuàng)新的IGBT內(nèi)部封裝技術(shù)。該技術(shù)可大幅延長IGBT模塊的使用壽命。全新的.XT技術(shù)可優(yōu)化IGBT模
2010-05-11 17:32:47 2392
2392 英飛凌全新.XT技術(shù)大幅延長IGBT模塊使用壽命
2010年5月6日,德國Neubiberg訊——英飛凌科技股份公司在紐倫堡舉行的2010 PCIM歐洲展會(2010年5月4日至6日
2010-05-13 09:16:10 1061
1061 英飛凌推出了完整的三相逆變器系統(tǒng)解決方案(基于HybridPACK 2 IGBT模塊的HybridKIT),可減少設(shè)計(jì)人員在(H)EV逆變器結(jié)構(gòu)設(shè)計(jì)階段的工作量,并幫助他們對英飛凌的HybridPACK2 IGBT功率模塊
2010-06-30 16:52:39 1218
1218 
本內(nèi)容提供了富士電機(jī)IGBT模塊應(yīng)用手冊 1 元件的構(gòu)造與特性 2 富士電機(jī)電子設(shè)備技術(shù)的IGBT 3 通過控制門極阻斷過電流 4 限制過電流功能 5 模塊的構(gòu)造 6 IGBT模塊電路構(gòu)造
2011-04-15 16:25:31 264
264 諸如高環(huán)境溫度、暴露于機(jī)械沖擊以及特定的驅(qū)動循環(huán)等環(huán)境條件,要求對IGBT功率模塊的機(jī)械和電氣特性給予特別的關(guān)注,以便在整個(gè)使用壽命期間能確保其性能得到充分發(fā)揮,并保持
2012-10-09 14:06:40 4116
4116 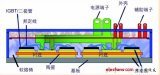
電子資料論文:高溫下IGBT可靠性與在線評估
2016-07-06 15:14:47 0
0 翅柱式IGBT水冷散熱器的熱仿真與實(shí)驗(yàn)_丁杰
2017-01-08 10:30:29 2
2 IGBT單管和IGBT模塊的控制電路是一樣的,它們的作用和工作原理基本一樣,IGBT模塊可以看成是多個(gè)IGBT單管集成的模塊。IGBT模塊封裝技術(shù)拓展了IGBT的運(yùn)用領(lǐng)域和功能。IGBT是集功率
2017-05-14 15:02:34 12273
12273 
了,由穿透型發(fā)展到非穿透型。IGBT模塊也在此基礎(chǔ)上同步發(fā)展,單管模塊,半橋模塊,6管模塊,到現(xiàn)在的7管模塊。IGBT驅(qū)動設(shè)計(jì)上比較復(fù)雜,需要考慮較多的因素,諸如合理的選擇驅(qū)動電壓Uge和門極驅(qū)動電阻Rg,過流過壓保護(hù)等都是很重要的。IGBT模塊
2017-11-14 14:20:20 25
25 IGBT模塊是由IGBT(絕緣柵雙極型晶體管芯片)與FWD(續(xù)流二極管芯片)通過特定的電路橋接封裝而成的模塊化半導(dǎo)體產(chǎn)品;封裝后的IGBT模塊直接應(yīng)用于變頻器、UPS不間斷電源等設(shè)備上;IGBT
2017-11-23 10:07:39 74851
74851 
的長期隨機(jī)變化。因此,本文建立了一種能夠綜合計(jì)及IGBT模塊熱載荷的復(fù)雜時(shí)間常數(shù)特性影響的壽命評估模型。分析了實(shí)際風(fēng)電場中不同時(shí)間常數(shù)熱載荷的壽命消耗特點(diǎn),以及風(fēng)速分布與壽命消耗之間的關(guān)系。研究了不同氣溫等效方法對壽
2018-01-26 11:26:00 0
0 壓接式絕緣柵極雙極性晶體管( IGBT)模塊因優(yōu)越的電氣性能和封裝設(shè)計(jì),受到柔性直流輸電等大功率應(yīng)用場合的青睞,其模塊可靠性也成為大功率應(yīng)用場合研究的重點(diǎn),而IGBT模塊結(jié)溫是影響器件可靠性
2018-02-01 10:20:49 9
9 在一些電力電子應(yīng)用場合,不僅需要高壓IGBT模塊有優(yōu)異的性能,還需要具有相當(dāng)高的可靠性;為了滿足實(shí)際需求,希望高壓IGBT模塊的壽命能達(dá)到30年,所以,高壓IGBT模塊的壽命預(yù)估非常重要。
2018-03-13 16:34:42 10729
10729 IGBT模塊動態(tài)參數(shù)是評估IGBT模塊開關(guān)性能如開關(guān)頻率、開關(guān)損耗、死區(qū)時(shí)間、驅(qū)動功率等的重要依據(jù),本文重點(diǎn)討論以下動態(tài)參數(shù):模塊內(nèi)部柵極電阻、外部柵極電阻、外部柵極電容、IGBT寄生電容參數(shù)、柵極充電電荷、IGBT開關(guān)時(shí)間參數(shù),結(jié)合IGBT模塊靜態(tài)參數(shù)可全面評估IGBT芯片的性能。
2020-11-17 08:00:00 24
24 車輛運(yùn)行時(shí),特別實(shí)在擁堵的路況時(shí)的頻繁啟停,此時(shí)控制器的IGBT模塊工作電流會相應(yīng)的頻繁升降,從而導(dǎo)致IGBT的結(jié)溫快速變化,對于IGBT模塊的壽命是個(gè)很大的考驗(yàn);
2021-02-01 13:58:03 4411
4411 
IGBT模塊封裝及車用變流器設(shè)計(jì)與驗(yàn)證說明。
2021-05-19 14:52:22 37
37 igbt模塊散熱的過程依次為igbt在結(jié)上發(fā)生功率損耗;結(jié)上的溫度傳導(dǎo)到igbt模塊殼上;igbt模塊上的熱傳導(dǎo)散熱器上;散熱器上的熱傳導(dǎo)到空氣中。
2022-03-11 11:20:17 6503
6503 
這是賽晶半導(dǎo)體自主技術(shù)IGBT模塊的首個(gè)批量訂單,標(biāo)志公司IGBT模塊取得客戶認(rèn)可并開始批量銷售和應(yīng)用
2022-02-14 16:34:46 1055
1055 
IGBT是電力電子裝置的CPU,在電力電子變流和控制中起著舉足輕重的作用。變頻器中,IGBT模塊更為重要。但是,IGBT模塊會經(jīng)常出現(xiàn)爆炸的情況。
2022-02-16 10:24:21 12262
12262 為了計(jì)算IGBT的功率循環(huán)壽命,英飛凌在線仿真平臺IPOSIM新推出了壽命評估服務(wù),只需輕輕點(diǎn)擊幾次,即可獲取功率模塊的壽命。
2022-04-07 17:36:19 2048
2048 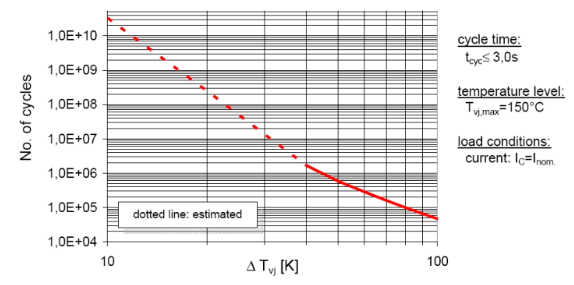
已全部加載完成
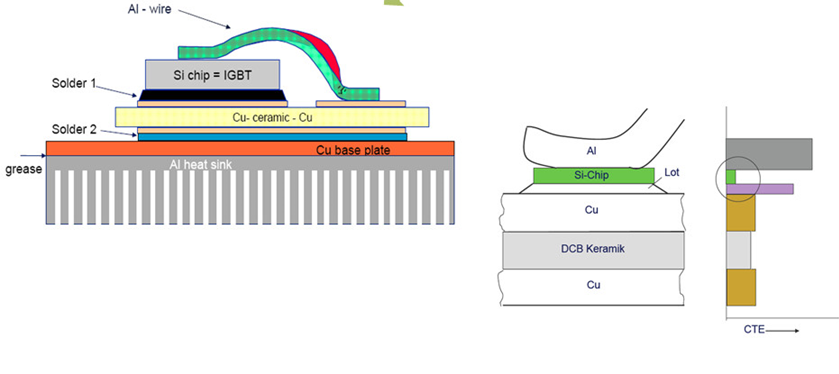
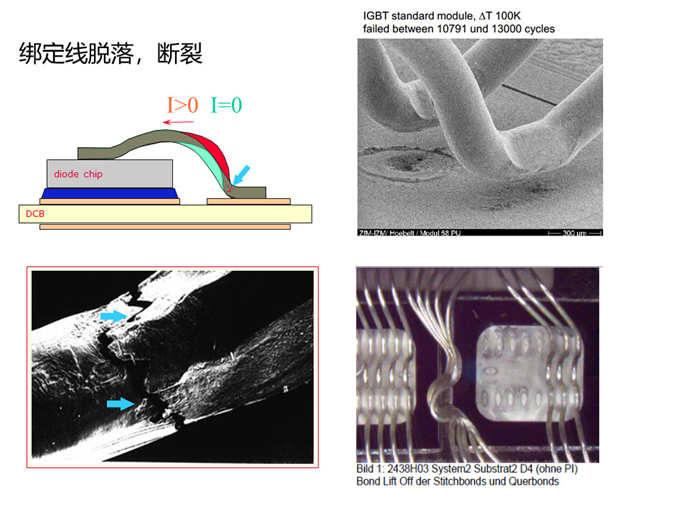
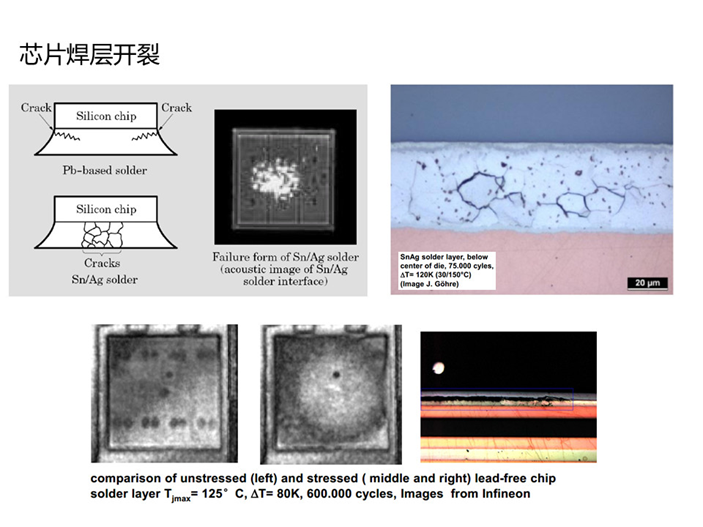

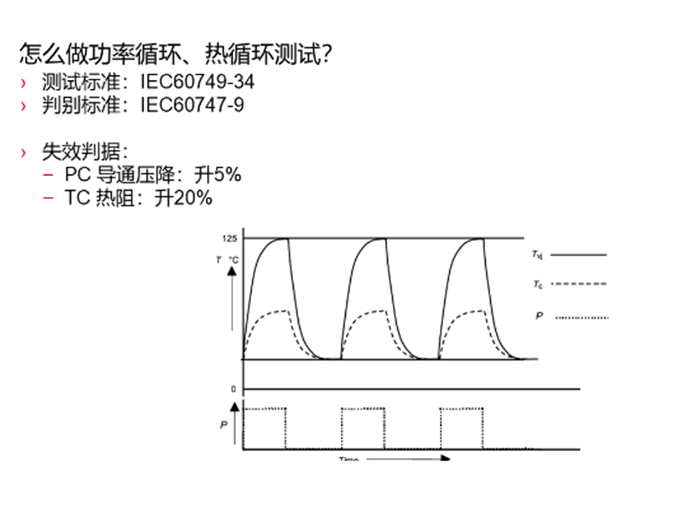
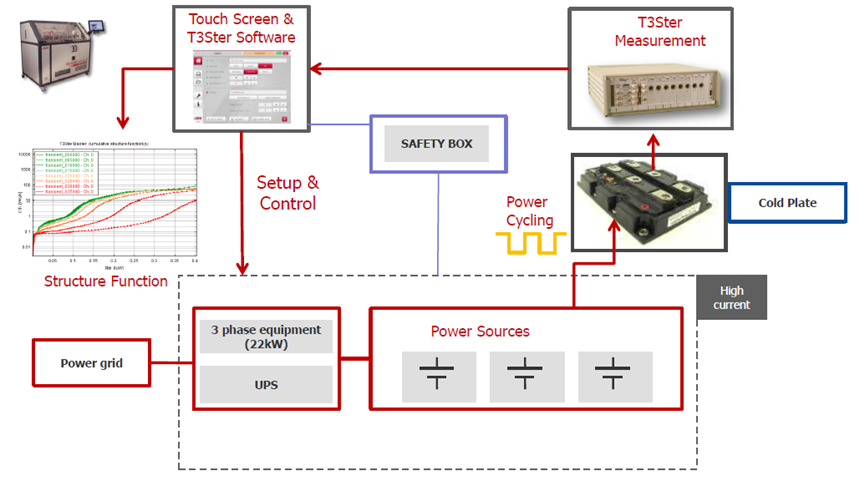




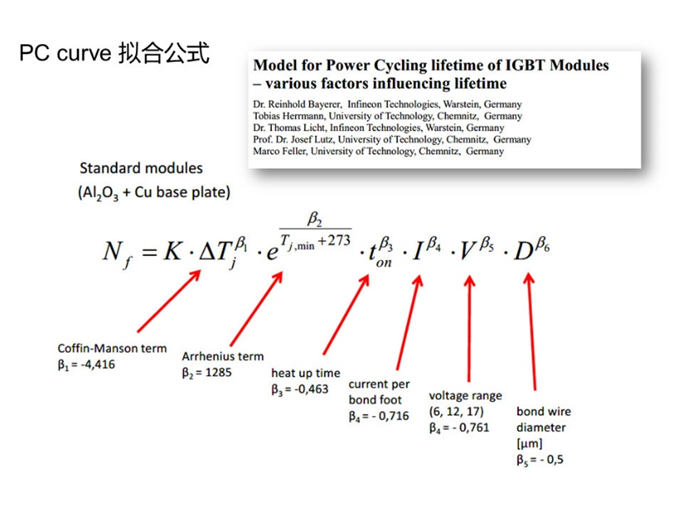
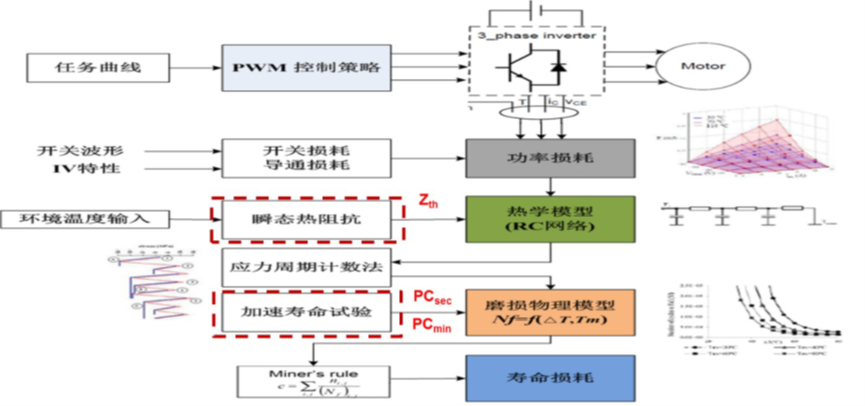
 電子發(fā)燒友App
電子發(fā)燒友App










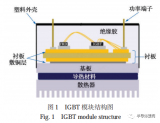

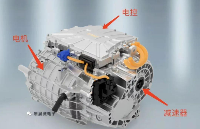






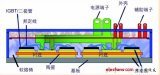





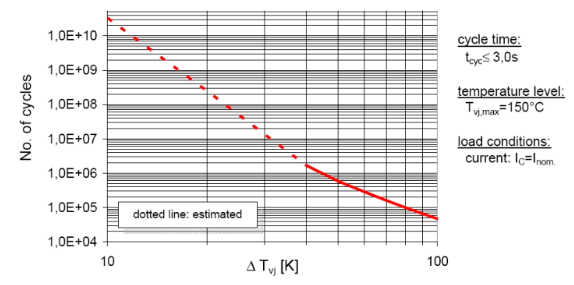
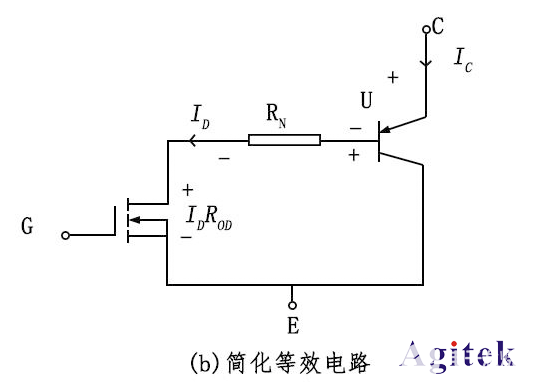
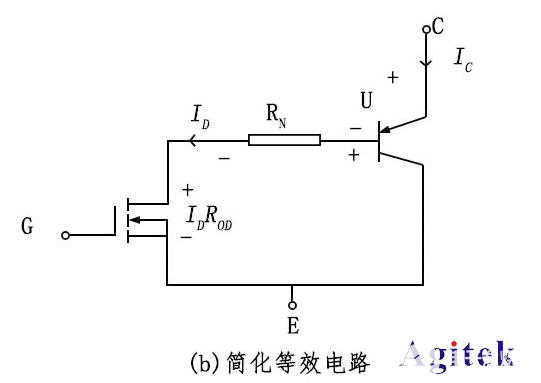
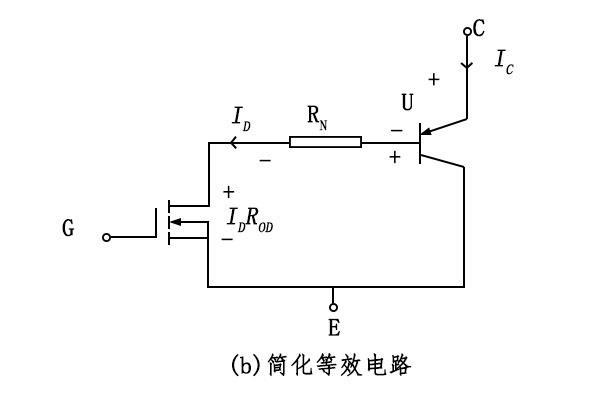

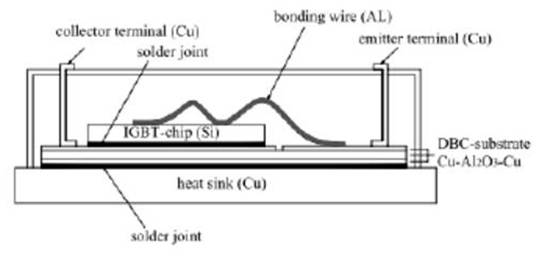
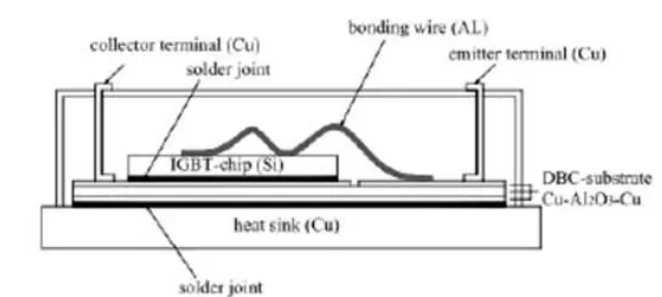
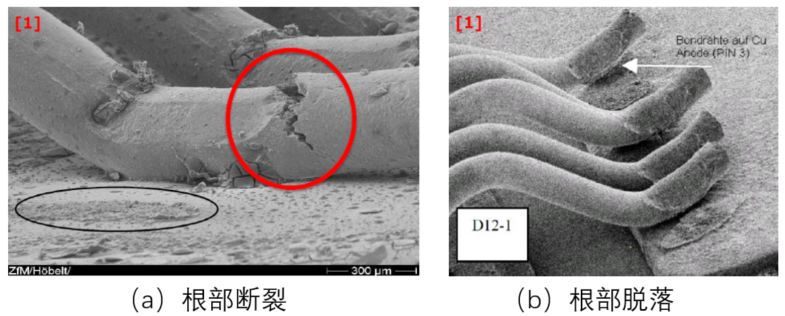


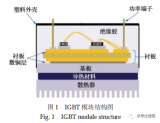


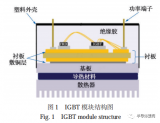


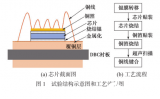
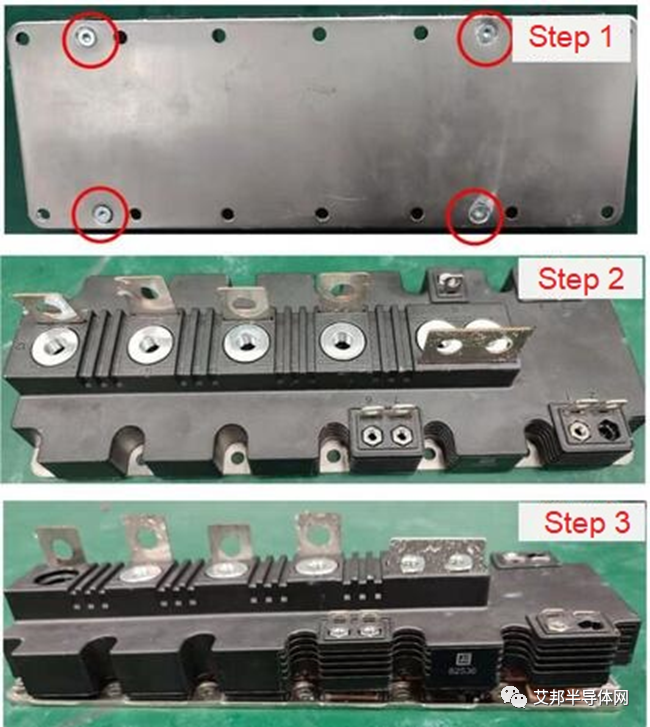










評論